集成電路制造中,一片晶圓(wafer)一般含有成千上萬(wàn)顆晶粒(die,或者稱作裸晶),晶圓經(jīng)過(guò)減薄、切割形成晶粒,最終將晶粒封裝為集成電路的芯片。通常,芯片需要經(jīng)過(guò)測(cè)試區(qū)分出良品和不良品,良品也要滿足一定的可靠性標(biāo)準(zhǔn)才能上市,不良品最終做報(bào)廢處理。集成電路工業(yè)不僅需要保證芯片的質(zhì)量和可靠度,也需要持續(xù)的提升良率,降低成本;因此就需要對(duì)測(cè)試不良品或失效芯片進(jìn)行分析定位,找到失效的根因,反饋并推動(dòng)晶圓廠和封測(cè)廠持續(xù)提升。因此,對(duì)不良品(或失效芯片)進(jìn)行失效分析(failure analysis,F(xiàn)A)是芯片制造業(yè)的一個(gè)關(guān)鍵步驟。
在對(duì)不良品(或失效芯片)進(jìn)行失效分析過(guò)程中,數(shù)據(jù)排查往往是最先要完成的一環(huán),如分析芯片制造各環(huán)節(jié)(wafer測(cè)試、芯片封裝、芯片測(cè)試)的加工和測(cè)試數(shù)據(jù),分析各制造環(huán)節(jié)是否引入了異常。對(duì)于一顆失效芯片來(lái)說(shuō),先要排查它的最終測(cè)試數(shù)據(jù)是否有異常,再查上游的封裝過(guò)程是否有異常,最后,排查芯片封裝的晶粒在晶圓上是否是良品。但如前所述,一片晶圓上往往有成千上萬(wàn)顆晶粒,因此就需要對(duì)晶粒在晶圓上的位置進(jìn)行標(biāo)識(shí)以做區(qū)分。
通常,當(dāng)晶粒包含存儲(chǔ)單元(例如寄存器電路單元)時(shí),晶粒的位置信息數(shù)據(jù)可以直接燒寫到存儲(chǔ)單元中,在后續(xù)需要的時(shí)候,通過(guò)接口可以讀取之前燒寫的位置信息數(shù)據(jù)。或者,也可以通過(guò)物理方式在晶粒上制作出光學(xué)可視的位置標(biāo)識(shí),對(duì)于后者通常需要對(duì)現(xiàn)有芯片制造工藝作出改進(jìn)以在晶粒上制作出位置標(biāo)識(shí),而晶粒上圖形的制作工藝主要采用類似攝影方法的光刻工藝,將光罩(mask)上的圖形轉(zhuǎn)印到晶粒上。制作單獨(dú)的光罩在晶粒上制作位置標(biāo)識(shí)通常會(huì)增大成本,尤其是高分辨率的光罩制作成本會(huì)非常高。因此如何兼容現(xiàn)有制作工藝的基礎(chǔ)上,在晶粒上制作位置標(biāo)識(shí)有待研究。
12月9日,華為最新公開了一件專利,提供一種晶粒、晶圓及晶圓上晶粒位置的標(biāo)識(shí)方法,能夠兼容現(xiàn)有制作工藝的基礎(chǔ)上,在晶粒上制作位置標(biāo)識(shí),有效地控制了成本。
專利號(hào):CN202080100160.7
專利名稱:晶粒、晶圓及晶圓上晶粒位置的標(biāo)識(shí)方法
數(shù)據(jù)來(lái)源:大為innojoy全球?qū)@麛?shù)據(jù)庫(kù)
該專利提供一種晶粒。晶粒包含制作于晶粒上的位置標(biāo)識(shí);位置標(biāo)識(shí)用于指示晶粒在晶圓上的位置;位置標(biāo)識(shí)包括第一位置標(biāo)識(shí)及第二位置標(biāo)識(shí);第一位置標(biāo)識(shí)用于指示第二光罩在晶圓上覆蓋區(qū)域的位置,其中,第二位置標(biāo)識(shí)由第二光罩制作于覆蓋區(qū)域內(nèi)的晶粒上;第二位置標(biāo)識(shí)用于指示晶粒在覆蓋區(qū)域內(nèi)的位置;其中,第一位置標(biāo)識(shí)采用第一光罩通過(guò)一次曝光工藝制作,同一個(gè)覆蓋區(qū)域內(nèi)的晶粒上的第二位置標(biāo)識(shí)采用第二光罩通過(guò)一次曝光工藝制作;第一位置標(biāo)識(shí)和第二位置標(biāo)識(shí)分別制作于晶粒上的不同層的材料層。
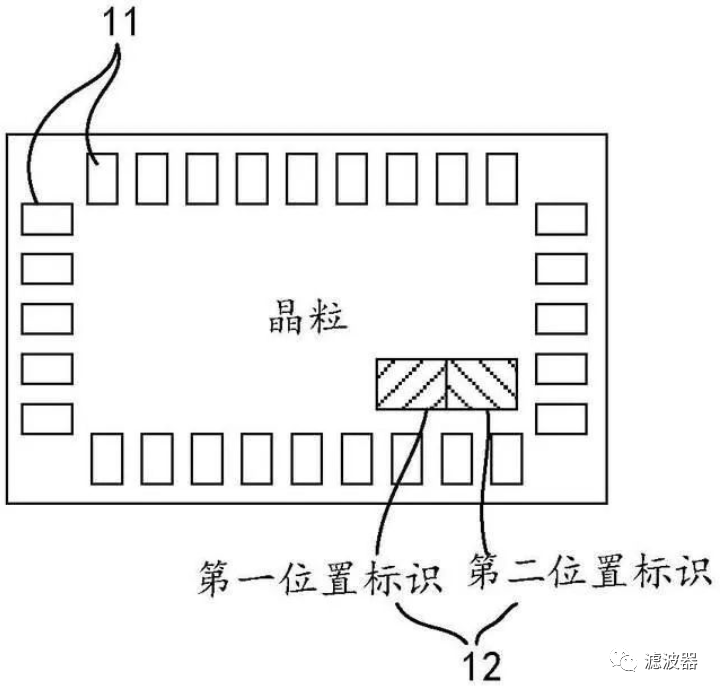
由于每個(gè)晶粒在第二光罩的覆蓋區(qū)域內(nèi)的位置相對(duì)固定,因此,可以選用某一層材料層的光罩作為第二光罩,在第二光罩上每個(gè)晶粒對(duì)應(yīng)的位 置制作該晶粒在覆蓋區(qū)域內(nèi)的第二位置標(biāo)識(shí),則通過(guò)該第二光罩對(duì)覆蓋區(qū)域內(nèi)的晶粒曝光,即可制作出第二位置標(biāo)識(shí);然而,每一次曝光,第二光罩在晶圓上的覆蓋區(qū)域是不同的,這樣不同的覆蓋區(qū)域內(nèi)的晶粒的第一位置標(biāo)識(shí)是不同的才能區(qū)別各個(gè)覆蓋區(qū)域的位置,因此并不能用相同的第二光罩制作第一位置標(biāo)識(shí),原因是如果采用類似使用第二光罩制作第二位置標(biāo)識(shí)的方式制作第一位置標(biāo)識(shí)的話,由于每個(gè)第一位置標(biāo)識(shí)不同,即每個(gè)覆蓋區(qū)域都需要一張單獨(dú)的第二光罩,則需要制作多張第二光罩,并且每次曝光需要更換一次第二光罩,效率很低,其成本會(huì)很高,無(wú)量產(chǎn)使用價(jià)值。
因此,本申請(qǐng)的實(shí)施例中使用第一光罩通過(guò)一次單獨(dú)的曝光工藝在晶圓上所有晶粒上制作第一位置標(biāo)識(shí);這樣同一個(gè)覆蓋區(qū)域內(nèi)的晶粒上的第一位置標(biāo)識(shí)全部相同;對(duì)于不同覆蓋區(qū)域的晶粒,第一位置標(biāo)識(shí)不相同。并且通過(guò)第二光罩對(duì)整片晶圓上的不同覆蓋區(qū)域依次曝光,制作晶粒上的第二位置標(biāo)識(shí),通過(guò)第一位置標(biāo)識(shí)和第二位置標(biāo)識(shí)組合為位置標(biāo)識(shí)來(lái)標(biāo)識(shí)晶粒在晶圓上的位置,第一位置標(biāo)識(shí)和第二位置標(biāo)識(shí)分別制作于晶粒上的不同層的材料層,兼容現(xiàn)有制作工藝的同時(shí),有效控制了成本的增加。
審核編輯 :李倩
-
芯片
+關(guān)注
關(guān)注
463文章
54010瀏覽量
466185 -
集成電路
+關(guān)注
關(guān)注
5452文章
12572瀏覽量
374584 -
寄存器
+關(guān)注
關(guān)注
31文章
5608瀏覽量
130003 -
晶圓
+關(guān)注
關(guān)注
53文章
5410瀏覽量
132300 -
晶粒
+關(guān)注
關(guān)注
0文章
30瀏覽量
4219
原文標(biāo)題:華為晶粒、晶圓及晶圓上晶粒位置標(biāo)識(shí)方法專利公開,降低FA成本
文章出處:【微信號(hào):Filter_CN,微信公眾號(hào):濾波器】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄

瑞樂(lè)半導(dǎo)體——AMS晶圓型多功能測(cè)試片核心優(yōu)勢(shì)#晶圓檢測(cè) #晶圓制造過(guò)程 #晶圓測(cè)試
「直驅(qū)技術(shù)」破解晶圓測(cè)試精度瓶頸:雅科貝思超精密運(yùn)動(dòng)平臺(tái)如何實(shí)現(xiàn)±0.5um重復(fù)定位?


瑞樂(lè)半導(dǎo)體——TCWafer晶圓測(cè)溫系統(tǒng)維修 #晶圓測(cè)溫 #晶圓制造過(guò)程 #晶圓檢測(cè)

瑞樂(lè)半導(dǎo)體——主要產(chǎn)品有TC Wafer晶圓測(cè)溫系統(tǒng)等#晶圓檢測(cè) #晶圓測(cè)溫 #晶圓制造過(guò)程

瑞樂(lè)半導(dǎo)體——RTD Wafer晶圓測(cè)溫系統(tǒng)#晶圓檢測(cè) #晶圓測(cè)溫 #晶圓制造過(guò)程

瑞樂(lè)半導(dǎo)體—AGS 無(wú)線晶圓間隙測(cè)量校準(zhǔn)片#晶圓測(cè)溫 #晶圓制造過(guò)程 #晶圓檢測(cè)

瑞樂(lè)半導(dǎo)體——晶圓測(cè)溫系統(tǒng)和晶圓校準(zhǔn)測(cè)量產(chǎn)品適配場(chǎng)景廣,覆蓋全工藝鏈 #晶圓測(cè)溫 #晶圓檢測(cè)

瑞樂(lè)半導(dǎo)體——AVLS無(wú)線校準(zhǔn)測(cè)量晶圓系統(tǒng)發(fā)現(xiàn)制造設(shè)備微小振動(dòng)和水平偏差 #晶圓制造過(guò)程 #晶圓檢測(cè) #晶圓
晶圓制造中的Die是什么
晶圓清洗機(jī)怎么做晶圓夾持

瑞樂(lè)半導(dǎo)體——4寸5點(diǎn)TCWafer晶圓測(cè)溫系統(tǒng)#晶圓測(cè)溫 #晶圓測(cè)試 #晶圓檢測(cè) #晶圓制造過(guò)程
提高鍵合晶圓 TTV 質(zhì)量的方法


瑞樂(lè)半導(dǎo)體——12寸TC Wafer晶圓測(cè)溫系統(tǒng)#晶圓測(cè)溫 #晶圓檢測(cè) #晶圓測(cè)試 #晶圓制造
降低晶圓 TTV 的磨片加工方法




 一種晶粒、晶圓及晶圓上晶粒位置的標(biāo)識(shí)方法
一種晶粒、晶圓及晶圓上晶粒位置的標(biāo)識(shí)方法




評(píng)論