光收發一體模塊由三大部分組成,它們分別是光電器件(TOSA/ROSA)、貼有電子元器件的電路板(PCBA)和LC、SC、MPO等光接口(外殼)。
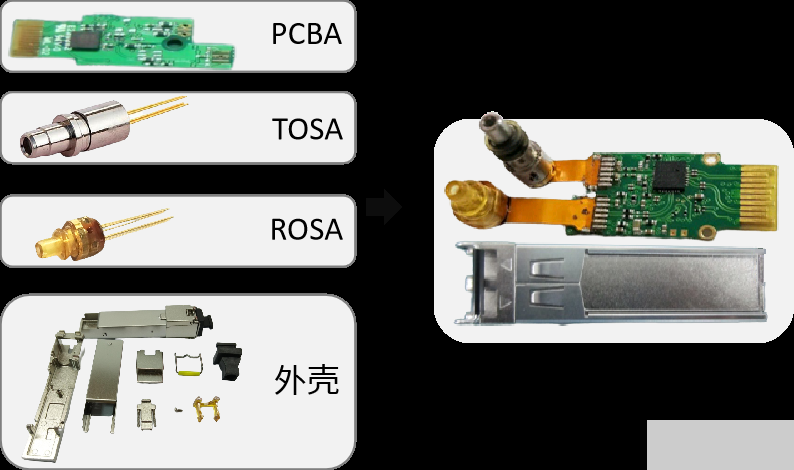
光發射部分
光發射部分由光源、驅動電路、控制電路(如APC)三部分構成,主要測試光功率、消光比這兩個參數。

光接收部分
光接收部分以PIN為例,是由PINTIA(InGaAs PIN和跨阻放大器)和限幅放大器組成。將輸入的光信號通過PIN管轉換成光電流,光電流又通過跨阻放大器轉換成電壓信號。電壓信號經限幅放大,并通過整形濾波器與限幅放大器產生差分DATA與DATA的數據信號交流輸出。并具有無光告警功能,當光功率不足以維持模塊正常工作時,SD端產生邏輯低信號,產生告警。
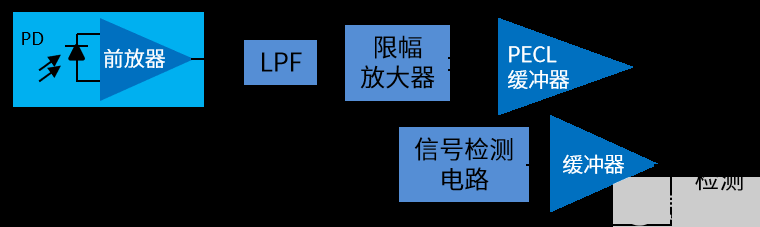
封裝
光模塊封裝的基本結構為光發射側模塊(TOSA)和驅動電路,光接收側模塊是(ROSA)和接收電路。TOSA、ROSA中的技術壁壘主要在于兩方面:光芯片和封裝技術,這也正是易飛揚的核心競爭力。
一般ROSA中封裝有分光器、光電二極管(將光信號轉換成電壓)和跨阻放大器(放大電壓信號),TOSA中封裝有激光驅動器、激光器和復用器。TOSA、ROSA的封裝工藝主要有以下四種:
TO-CAN同軸封裝
TO-CAN同軸封裝:殼體通常為圓柱形,因為其體積小,難以內置制冷,散熱困難,難以用于大電流下的高功率輸出,故而難以用于長距離傳輸。目前最主要的用途還在于2.5Gbit/s及10Gbit/s短距離傳輸。但成本低廉,工藝簡單。
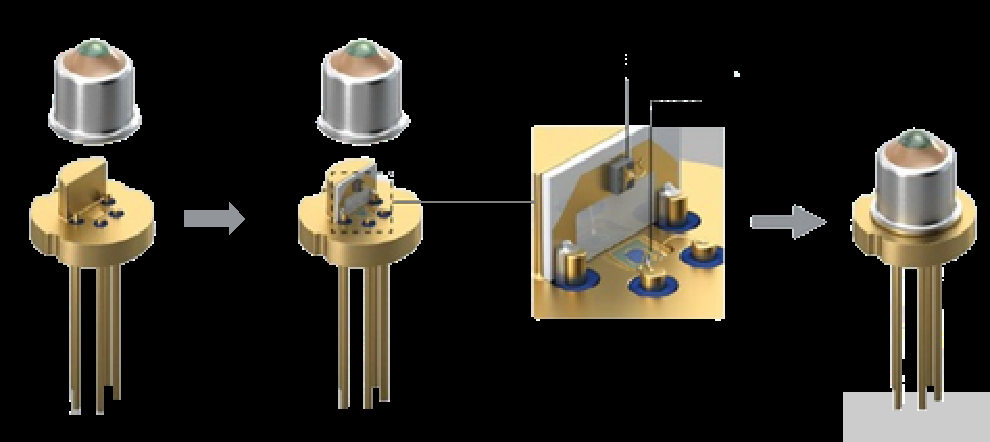
TO-CAN同軸封裝

易飛揚采用TO-CAN同軸封裝工藝制作的10G SFP+ AOC產品(爆炸圖)
蝶形封裝
蝶形封裝:殼體通常為長方體,結構及實現功能通常比較復雜,可以內置制冷器、熱沉、陶瓷基塊、芯片、熱敏電阻、背光監控,并且可以支持所有以上部件的鍵合引線。殼體面積大,散熱好,可以用于各種速率及80km長距離傳輸。
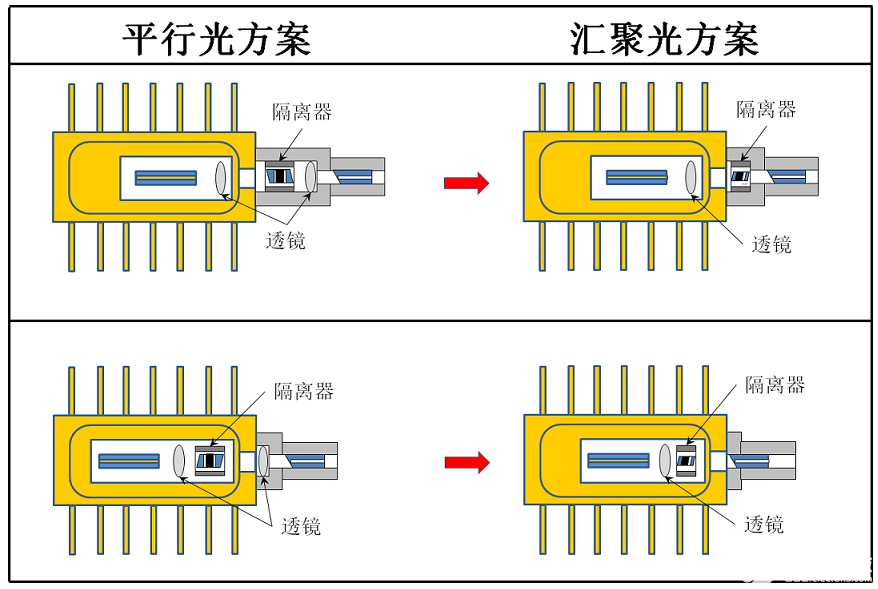
蝶形封裝
BOX封裝
BOX封裝屬于蝶形封裝,用于多通道并行封裝。

BOX封裝

易飛揚采用BOX封裝工藝制作的100G QSFP28 LR4光模塊
COB(Chip On Board)封裝
COB封裝即板上芯片封裝,將激光芯片粘附在PCB基板上,可以做到小型化、輕型化、高可靠、低成本。
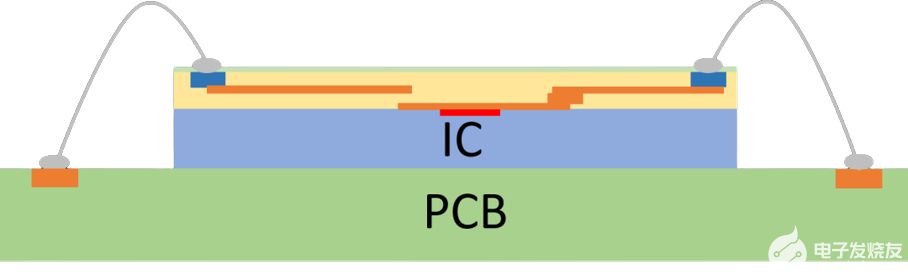
COB封裝
傳統的單路10Gb/s或25Gb/s速率的光模塊采用SFP封裝將電芯片和TO封裝的光收發組件焊接到PCB板上組成光模塊。而100Gb/s光模塊,在采用25Gb/s芯片時,需要4組組件,若采用SFP封裝,將需要4倍空間。COB封裝可以將TIA/LA芯片、激光陣列和接收器陣列集成封裝在一個小空間內,以實現小型化。技術難點在于對光芯片貼片的定位精度(影響光耦合效果)和打線質量(影響信號質量、誤碼率)。

易飛揚采用COB工藝制作的10G SFP+ AOC產品(爆炸圖)
易飛揚擁有一整套COB工藝制程設備,在手動耦合滿足定制化,而自動耦合則滿足批量的一致性要求:

易飛揚COB工藝制程設備
總結
25G及以下速率光模塊多采用單通道TO或蝶形封裝,有標準的制程和自動化設備,技術壁壘低。但對于40G及以上速率的高速光模塊,受激光器速率限制(多為25G),主要通過多通道并行實現,如40G由4×10G實現,而100G則由4×25G實現。高速光模塊的封裝對并行光學設計、高速率電磁干擾、體積縮小、功耗增加下的散熱問題提出了更高的要求。
易飛揚在封裝技術工藝上擁有一整套完備的技術平臺,可用于各封裝工藝類型的研發、生產,保證產品交付的效率、可靠性和穩定性。


易飛揚生產制程關鍵工藝平臺
審核編輯 黃昊宇
-
封裝
+關注
關注
128文章
9249瀏覽量
148628 -
光器件
+關注
關注
9文章
95瀏覽量
17515 -
封裝工藝
+關注
關注
3文章
69瀏覽量
8288
發布評論請先 登錄

SK海力士HBS存儲技術,基于垂直導線扇出VFO封裝工藝

激光錫焊工藝在光模塊 ROSA 器件中的應用
提升功率半導體可靠性:推拉力測試機在封裝工藝優化中的應用

半導體封裝工藝流程的主要步驟

濕熱與光老化條件下,封裝工藝對碳基鈣鈦礦電池降解機理的影響

芯片封裝工藝詳解
最全最詳盡的半導體制造技術資料,涵蓋晶圓工藝到后端封測
先進封裝工藝面臨的挑戰
半導體貼裝工藝大揭秘:精度與效率的雙重飛躍




 干貨來襲,這里有最全的光器件封裝工藝介紹!
干貨來襲,這里有最全的光器件封裝工藝介紹!








評論