成果展示
直接電化學雙-電子氧還原(2e ORR)制備過氧化氫(H2O2),為原位綠色生產H2O2提供了一種較好的替代蒽醌氧化技術的方法。由于有利于H2O2形成途徑的含氧官能團,氧化碳材料已顯示出其優異的2e ORR活性。然而,由于O含量相當低(<15%),O摻雜碳催化劑的2e ORR性能受到O誘導的活性位點密度的阻礙。 基于此,香港城市大學支春義教授(通訊作者)等人報道了一種以葡萄糖(C6H12O6)作為碳(C)源,制備出具有高氧/碳(O/C)原子比的碳量子點(carbon quantum dot, CQD)催化劑,其O含量為30.4 at%。實驗測試發現,富氧CQD催化劑表現出優異的H2O2生產催化性能,選擇性接近100%,超過了所有報道的O摻雜碳催化劑。此外,CQD催化劑在H2O2的實際生產中表現出巨大的潛力,其產率高達10.06 mg cm-2 h-1,法拉第效率(FE)為97.7%,并且在10 h內具有良好的穩定性。實驗和理論研究證實,CQD催化劑中醚基(C-O-C)的絕大部分C-O鍵,C-O鍵的碳原子是2e ORR最活躍的位點。該工作為設計用于可持續電合成H2O2的高效無金屬碳基催化劑提供了一種有效且簡便的策略。
背景介紹
過氧化氫(H2O2)作為一種重要的防腐劑和氧化劑,在化學和醫療行業中發揮著至關重要的作用。然而,傳統的工業生產H2O2的蒽醌工藝存在能耗高、成本高的問題。電催化雙-電子氧還原(2e ORR)生成H2O2為綠色合成H2O2提供了一種有前景的替代方案,但2e ORR受到競爭性四-電子氧還原(4e ORR)的阻礙,因此開發高活性和選擇性的電催化劑至關重要。 目前,無金屬碳基催化劑十分具有吸引力,因為碳基材料的電子構型和配位環境可通過雜原子摻雜劑(O、N等)進行調整。但是,已報道的碳基催化劑中O含量(大多低于15 at%)受到碳(C)源和制備途徑的限制。非均相電催化是指表面電化學過程,其反應速率與催化劑的表面活性位點密切相關。因此,通過高比面積暴露更多的活性位點對于電催化劑加速電催化過程具有重要意義。碳量子點(CQDs)作為準零維(0D)碳具有極高的比面積,為雜原子的功能化提供了大量的缺陷位點和顯著暴露了多相電催化的豐富活性位點。
圖文解讀
理論計算與表征密度泛函理論(DFT)計算發現,*OOH吸附能與活性位點的電荷呈線性關系:更多的電荷導致更高的*OOH 吸附能。隨著電荷的增加,ΔG*OOH的值從0.360 eV增加到4.72 eV,表明含O官能團可通過調節活性位點的電荷狀態來有效調節ΔG*OOH。此外,ΔG*OOH與極限電位(UL)呈火山型關系,其中火山圖的頂點表明將電催化2eORR為H2O2所需的過電位為0 V。需注意,基面中的C-O-C基團對H2O2的產生具有最佳活性,過電位為0.02 V,ΔG*OOH為4.23 eV。因此,在超高C-O含量下,CQD催化劑對H2O2的生成具有良好的選擇性和活性。

圖1. DFT計算

圖2. CQD催化劑的制備與表征

圖3. CQD催化劑的結構表征催化性能電化學活性表面積(ECSA)與催化活性呈正相關性,與CS(2.89 cm2)和rGQD(20.53 cm2)相比,CQDs的ECSA最大(20.82 cm2),表明CQDs的催化性能最好。催化劑的H2O2選擇性用氧還原和H2O2氧化電流來定量。CQD催化劑的H2O2選擇性明顯高于CSs和rGQD:在0.2至0.65 V內,CQD的平均選擇性超過90%,最大值達到97.5%。此外,CQD的Tafel斜率為212.6 mV dec-1,低于CS(230.8 mV dec-1)和rGQD(252.4 mV dec-1),表明CQD具有更快的反應動力學。因此,CQD在H2O2選擇性方面表現出最好的催化2eORR活性。
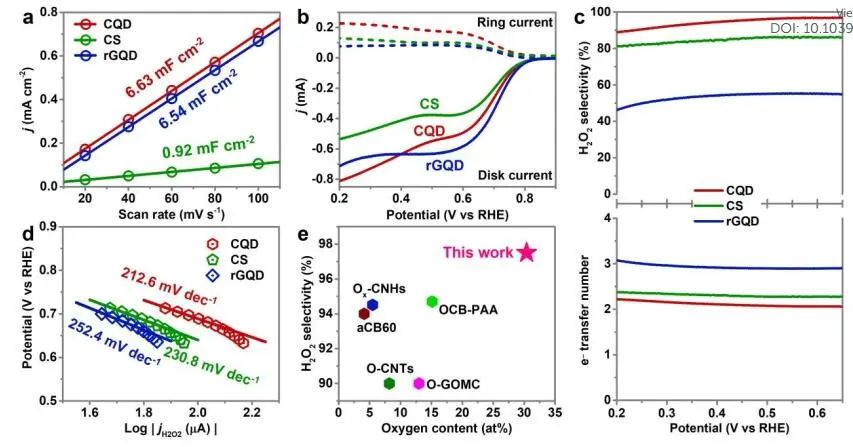
圖3.CQD催化劑的催化性能實際性能體極化曲線表明,在0.2-0.8 V的電位范圍內,在O2飽和溶液中記錄的三種催化劑的電流明顯大于在Ar飽和溶液中記錄的電流。隨著工作電位的負移,CQD的H2O2產量逐漸增加,并在0.3 V vs RHE時達到最大值10.06 mg cm-2 h-1。同時,CQD的平均H2O2法拉第效率(FE)超過95%,最高FE為97.7%。值得注意的是,這兩個值高于CSs和rGQDs,表明CQD的優異2eORR活性得益于高O含量。與CS和CQD相比,rGQD由于其低氧含量,其H2O2產率和FE較差,表明碳基材料中的含氧物種對提高電化學H2O2生產的催化活性和選擇性的積極作用。在經過10 h的長期測試,CQD的H2O2產率和FE的波動幾乎為零,表明富氧CQD催化劑具有良好的穩定性。
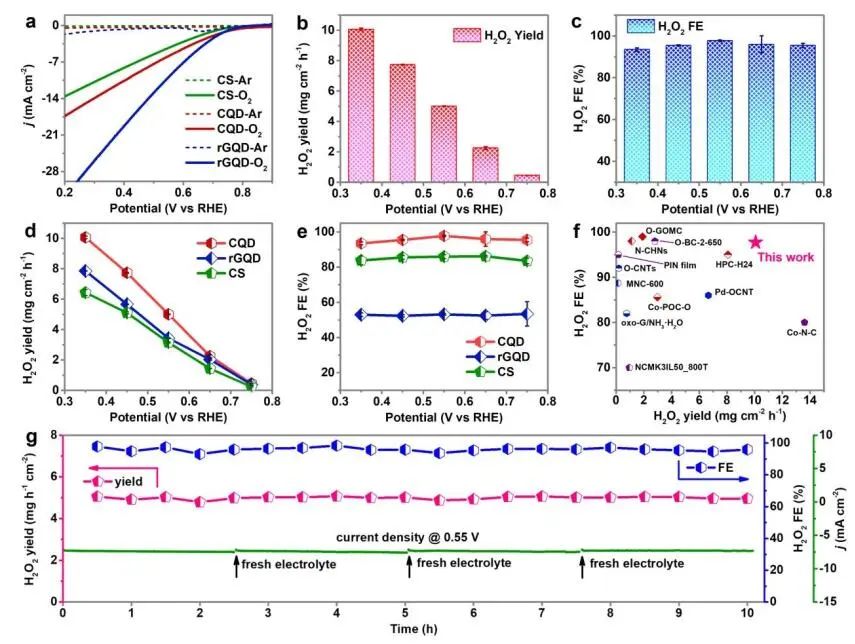
圖5. CQD催化劑的實際性能
文獻信息
Ultrahigh Oxygen-doped Carbon Quantum Dots for Highly Efficient H2O2 Production via Two-Electron Electrochemical Oxygen Reduction. Energy Environ. Sci.,2022, DOI: 10.1039/D2EE01797K. https://doi.org/10.1039/D2EE01797K.
審核編輯 :李倩
-
電荷
+關注
關注
1文章
665瀏覽量
37354 -
催化劑
+關注
關注
0文章
94瀏覽量
10786 -
量子點
+關注
關注
7文章
250瀏覽量
27075
原文標題:支春義EES:氧摻雜碳量子點用于過氧化氫電合成
文章出處:【微信號:清新電源,微信公眾號:清新電源】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
SPM 溶液清洗:半導體制造的關鍵清潔工藝

SPM在工業清洗中的應用有哪些

半導體清洗中SPM的最佳使用溫度是多少
如何選擇合適的SC1溶液來清洗硅片

sc-1和sc-2可以一起用嗎

半導體rca清洗都有什么藥液

瞬態吸收助力理解AQ(蒽醌)在H??ORR光催化過程中的作用機制




 氧摻雜碳量子點用于過氧化氫電合成
氧摻雜碳量子點用于過氧化氫電合成







評論