電子元件和電路的適當(dāng)熱管理是確保系統(tǒng)在所有操作條件下正確運(yùn)行和可靠性的基本要求。當(dāng)前電子設(shè)備逐漸小型化的趨勢(shì)以及對(duì)功率密度的需求不斷增加,將熱管理問題置于前臺(tái),特別是對(duì)于最新一代的功率設(shè)備,例如由氮化鎵 (GaN) 和碳化硅 (SiC)。基于 GaN 和 SiC 的器件可以提供最新一代電源應(yīng)用所需的高性能。然而,它們極高的功率密度應(yīng)該得到適當(dāng)?shù)墓芾恚@使得創(chuàng)新的熱管理技術(shù)成為一個(gè)需要考慮的關(guān)鍵方面。
為了充分發(fā)揮寬帶隙 (WBG) 半導(dǎo)體的潛力,設(shè)計(jì)人員必須了解使用這些材料所帶來(lái)的挑戰(zhàn)。在更高的開關(guān)頻率和更高的功率密度下運(yùn)行,可以實(shí)現(xiàn)無(wú)源元件(電感器和電容器)的尺寸減小并制造更輕更小的系統(tǒng)。然而,這些較小的無(wú)源元件在較高頻率下工作的行為很難預(yù)測(cè),并且可能會(huì)出現(xiàn)熱管理問題。WBG 半導(dǎo)體需要仔細(xì)設(shè)計(jì),因?yàn)榕c硅基器件支持的溫度相比,它們?cè)诟叩臏囟认鹿ぷ鳌TO(shè)計(jì)過程考慮了更大的熱應(yīng)力,這會(huì)對(duì)系統(tǒng)的可靠性產(chǎn)生不利影響。
在“熱管理進(jìn)展 2021 ”這一完全在線舉辦的活動(dòng)中,GaN 和 SiC 技術(shù)的三位主要專家提供了有關(guān)熱模型、封裝、熱分析和熱界面材料技術(shù)的寶貴信息。該小組由電力電子新聞主編 Maurizio Di Paolo Emilio 主持,并邀請(qǐng)了來(lái)自 Efficient Power Conversion (EPC)、UnitedSiC 和 STMicroelectronics 等主要公司的行業(yè)名人。
總承包
EPC 的首席執(zhí)行官兼聯(lián)合創(chuàng)始人 Alex Lidow 以提到芯片級(jí) GaN 的熱管理開始了演講。據(jù) Lidow 稱,EPC 基于 GaN 的功率器件已經(jīng)生產(chǎn)了大約 11 年。在談話中,他說(shuō)由于 GaN 器件比它們所取代的功率 MOSFET 小得多(小 5 到 10 倍),一個(gè)常見的誤解是它們會(huì)引起熱管理問題。令人驚訝的是,它們?cè)谏岱矫娴男侍岣吡?5 到 10 倍。讓我們考慮進(jìn)入 PC 板的設(shè)備的熱阻。Lidow 表示,這些設(shè)備面朝下(倒裝芯片)安裝,所有有源元件都在設(shè)備表面,而且它們真的很靠近 PC 板。從器件結(jié)到焊點(diǎn)底部的熱阻 (R θJB),具有相同的表面,在硅和 GaN 之間沒有太大區(qū)別。然而,正如 Lidow 所說(shuō),如果我們考慮相反的方向——從結(jié)到外殼的熱阻(R θJC ),或者通過側(cè)壁或背面離開器件的熱阻——它表明 GaN 大約是比具有相同管芯面積的硅器件高 6 倍的熱效率。因此,經(jīng)常看到 PC 板上的器件面朝下放置。這些結(jié)果可以通過在基于 GaN 的功率器件和散熱器之間放置隔熱層來(lái)實(shí)現(xiàn),如圖 1 所示。
“在隔熱材料和凝膠方面有了很大的改進(jìn);在短短幾年內(nèi),我們已經(jīng)從大約 6 W/mK 一路上升到大約 17 W/mK,”Lidow 說(shuō)。“我們的解決方案不僅允許從 PC 板到散熱器的熱傳導(dǎo),而且還允許從設(shè)備側(cè)面?zhèn)鲗?dǎo)熱,這樣您就可以通過側(cè)壁冷卻獲得更大的好處。”
Lidow 評(píng)論說(shuō),在 4 毫米2代表性設(shè)備上執(zhí)行的模擬顯示了 EPC 已經(jīng)能夠通過實(shí)驗(yàn)確認(rèn)和實(shí)現(xiàn)的內(nèi)容。特別是,更好的熱管理已經(jīng)能夠在 6W 功耗下將熱阻降低到大約 3.9°C/W。
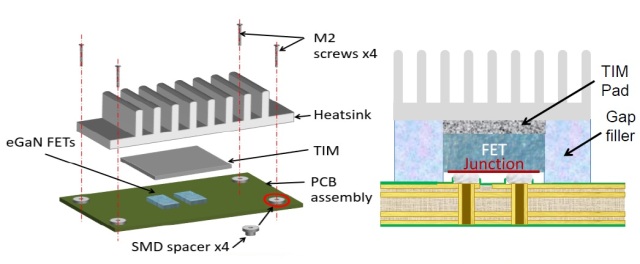
圖 1:結(jié)殼熱阻的減少
“我們?yōu)榭蛻籼峁┝艘环N工具,可以讓設(shè)計(jì)師對(duì)整個(gè)系統(tǒng)進(jìn)行熱建模,”Lidow 說(shuō)。“可以配置各種元件,例如間隙填充物、隔熱墊、散熱器、散熱器和散熱孔。”
聯(lián)合碳化硅
UnitedSiC 的首席應(yīng)用工程師 Jonathan Dodge 就熱管理的趨勢(shì)以及對(duì) SiC 的考慮發(fā)表了演講。正如道奇所說(shuō),導(dǎo)通電阻的降低絕對(duì)是未來(lái)幾年將持續(xù)的趨勢(shì),這將開辟一些有趣的應(yīng)用,否則功率半導(dǎo)體將無(wú)法真正處理這些應(yīng)用。“因此,我們還提高了每個(gè)分立器件的功率處理能力,”道奇說(shuō)。
“碳化硅可以減小芯片尺寸,但芯片單位面積的功率仍然相關(guān),這意味著我們更多地依賴于封裝和散熱器來(lái)提供熱質(zhì)量,”他補(bǔ)充道。
在他的演講中,道奇強(qiáng)調(diào)了兩個(gè)應(yīng)用分支,它們對(duì)熱管理提出了嚴(yán)峻的設(shè)計(jì)挑戰(zhàn)。第一個(gè)包括具有被動(dòng)冷卻的固態(tài)斷路器和繼電器,而另一個(gè)包括需要更積極冷卻的大功率轉(zhuǎn)換器和電機(jī)驅(qū)動(dòng)器。這兩種應(yīng)用都需要一個(gè)能夠處理所需功率水平的封裝。廣泛使用的封裝(例如 TO-247)具有嚴(yán)重的局限性。它們的引腳很小,考慮到在電機(jī)驅(qū)動(dòng)應(yīng)用中,我們可能會(huì)運(yùn)行超過 100 A RMS通過他們。然后,如圖 2 所示,有一個(gè)浪費(fèi)的區(qū)域,因?yàn)榕c封裝相比,SiC 芯片的面積相對(duì)較小,但體積很大。道奇評(píng)論說(shuō),爬電距離和電氣間隙也是另一個(gè)問題,因?yàn)樵摲庋b不是為我們現(xiàn)在使用的高電壓而設(shè)計(jì)的。這就是為什么許多設(shè)計(jì)師更喜歡帶有陶瓷隔離器的夾子安裝座,因?yàn)樘沾刹粫?huì)磨損。
“我認(rèn)為未來(lái)的趨勢(shì)實(shí)際上將是表面貼裝:它成本低、非常可靠,并且無(wú)論是頂部冷卻還是底部冷卻,”道奇說(shuō)。“我們需要能夠處理多個(gè)表面貼裝設(shè)備、800 V 甚至更高電壓的隔離熱界面材料,并符合小型 SMT 組裝變化。”

圖 2:TO-247 封裝對(duì)最大電流有嚴(yán)格的限制。
STMicroelectronics 集團(tuán)副總裁兼總經(jīng)理 Salvatore Coffa 結(jié)束了本次會(huì)議,并討論了功率器件中的熱管理技術(shù),并考慮了牽引逆變器應(yīng)用的熱管理設(shè)計(jì)。
Coffa 指出,每當(dāng)我們談?wù)摴β势骷阅艿膭?chuàng)新時(shí),我們都會(huì)看到向更高功率密度以及更低功率和傳導(dǎo)損耗的演變。這對(duì)于硅來(lái)說(shuō)是正確的,對(duì)于像 SiC 和 GaN 這樣的 WBG 半導(dǎo)體來(lái)說(shuō)更是如此。
“創(chuàng)新之路不僅是前端、材料、結(jié)構(gòu)或設(shè)備的創(chuàng)新,而且封裝所扮演的角色越來(lái)越重要,”Coffa 說(shuō)。
為了在 EV 動(dòng)力總成的功率模塊中實(shí)現(xiàn)這一點(diǎn),Coffa 表示,我們需要實(shí)現(xiàn)低靜態(tài)和動(dòng)態(tài)損耗,提高熱阻 R th(流體結(jié)點(diǎn)),并在最終實(shí)現(xiàn)成本、性能和可靠性之間的優(yōu)化權(quán)衡。應(yīng)用。
Coffa 認(rèn)為,電源模塊封裝設(shè)計(jì)的方法是基于仿真,使用諸如 CAD/CAE 建模之類的工具。這非常有幫助,因?yàn)樗紤]了設(shè)備的屬性、損耗和熱機(jī)械約束。如圖 3 所示,Coffa 分析的這種方法允許從具有相關(guān)操作條件的初始包裝設(shè)計(jì)開始,通過功率損耗、熱機(jī)械問題和其他損壞的理論模型來(lái)估算產(chǎn)品壽命。Coffa 補(bǔ)充說(shuō),最終的包裝設(shè)計(jì)是根據(jù)拓?fù)浠蛐螒B(tài)優(yōu)化方法迭代流程的結(jié)果。并且所有模型都必須事先通過實(shí)驗(yàn)進(jìn)行校準(zhǔn)和驗(yàn)證,即使在不同的設(shè)計(jì)中也是如此。

圖 3:建模方法
“我們進(jìn)行了大量 CAD/CAE 建模,將器件的電氣特性與熱材料的特性結(jié)合起來(lái),我們還進(jìn)行了大量實(shí)驗(yàn)工作,以便從我們使用的材料中選擇合適的參數(shù),”科法說(shuō)。
用于電動(dòng)汽車牽引逆變器的 SiC MOSFET 需要對(duì)芯片和封裝進(jìn)行適當(dāng)?shù)膮f(xié)同設(shè)計(jì),同時(shí)考慮到最終應(yīng)用中的所有相關(guān)熱機(jī)械方面。專門為汽車領(lǐng)域設(shè)計(jì)的 SiC 功率器件被認(rèn)為通常通過非常規(guī)的芯片連接技術(shù)進(jìn)行安裝。新的 SiC 芯片專門設(shè)計(jì)為通過燒結(jié)組裝,底部和頂部都用于夾子燒結(jié)。在活性金屬釬焊上或直接在散熱器上燒結(jié)芯片,利用這種 WBG 材料的卓越電氣和熱性能,并在溫度波動(dòng)下提供卓越的可靠性。
審核編輯:郭婷
-
半導(dǎo)體
+關(guān)注
關(guān)注
339文章
31129瀏覽量
266009 -
氮化鎵
+關(guān)注
關(guān)注
67文章
1910瀏覽量
120042 -
碳化硅
+關(guān)注
關(guān)注
26文章
3526瀏覽量
52626
發(fā)布評(píng)論請(qǐng)先 登錄
有限元分析(FEA)在 SiC模塊構(gòu)建的固斷SSCB 熱管理中的應(yīng)用

機(jī)器人熱管理技術(shù)體系與方案

CHA6154-99F三級(jí)單片氮化鎵(GaN)中功率放大器
車規(guī)級(jí)單通道低邊驅(qū)動(dòng)器SiLM27531M,助力GaN/SiC功率系統(tǒng)高效運(yùn)行
光隔離探頭在SiC/GaN測(cè)試中的應(yīng)用
Neway第三代GaN系列模塊的生產(chǎn)成本
在實(shí)際網(wǎng)關(guān)設(shè)計(jì)中,如何利用電容的高紋波電流能力進(jìn)行熱管理優(yōu)化?
適用于SiC/GaN器件的雙通道隔離驅(qū)動(dòng)方案SLMi8232BDCG-DG介紹
Si、SiC與GaN,誰(shuí)更適合上場(chǎng)?| GaN芯片PCB嵌埋封裝技術(shù)解析

熱管理技術(shù)設(shè)計(jì)革命:主動(dòng)散熱與被動(dòng)散熱

麥積電子集成式熱管理控制器方案連獲殊榮
交流充電樁負(fù)載能效提升技術(shù)
GaN與SiC功率器件深度解析

新能源汽車熱管理系統(tǒng),從電容、傳感器到功率器件的全面創(chuàng)新
汽車電芯的熱管理設(shè)計(jì)




 GaN和SiC熱管理的進(jìn)展
GaN和SiC熱管理的進(jìn)展




評(píng)論