隨著芯片不斷向微型化發展,工藝制程開始向著更小的5nm、3nm推進,已經越來越逼近物理極限,付出的代價也將越來越大,因此摩爾定律屢屢被傳將走到盡頭,迫切需要另辟蹊徑推動技術進步。
業界普遍認為,先進封裝會成為下一階段半導體技術的重要發展方向。廈門大學特聘教授、云天半導體創始人于大全博士就曾指出,隨著摩爾定律發展趨緩,通過先進封裝技術來滿足系統微型化、多功能化成為了集成電路產業發展的新引擎。 封裝技術是伴隨集成電路發明應運而生的,主要功能是完成電源分配、信號分配、散熱和物理保護。而隨著芯片技術的發展,封裝正在不斷革新,供應鏈迎來大考。
群雄競逐先進封裝
先進封裝技術能夠相對輕松地實現芯片的高密度集成、體積的微型化和更低的成本等需求,符合高端芯片向尺寸更小、性能更高、功耗更低演進的趨勢。
尤其是CoWoS(Chip On Wafer On Substrate)、FOWLP(扇出晶圓級封裝)以及WoW等 高密度先進封裝(HDAP) ,它們在提升芯片性能方面展現出的巨大優勢,成功吸引了各大主流芯片封測、代工以及設計廠商的關注,開始在該領域持續投資布局。
例如CoWoS,這是臺積電推出的2.5D封裝技術,被稱為晶圓級封裝。CoWoS針對高端市場,連線數量和封裝尺寸都比較大。
自2012年開始量產CoWoS以來,臺積電就通過這種芯片間共享基板的封裝形式,把多顆芯片封裝到一起,而平面上的裸片通過Silicon Interposer互聯,這樣達到了封裝體積小,傳輸速度高,功耗低,引腳少的效果。 此外,FOWLP,這是一項被預言將成為下一代緊湊型、高性能電子設備基礎的技術。根據Yole數據,FOWLP全球總產值有望在2022年超過23億美金,2019-2022年間CAGR(復合年均增長率)接近20%。
據悉,第一代扇出型封裝是采用英飛凌(Infineon)的嵌入式晶圓級球閘陣列(eWLB)技術,此為2009年由飛思卡爾(Freescale,現為恩智浦)所推出。但是,集成扇出型封裝(InFO)在此之前就只有臺積電能夠生產。 臺積電的InFO技術是最引人注目的高密度扇出的例子,三星電子(Samsung Electronics)系統LSI事業部認為正是此技術,導致臺積電搶下蘋果(Apple)A10處理器代工訂單。為此三星電機(Semco)跨足半導體封裝市場,與三星電子合作研發FOWLP技術,以期在新一輪客戶訂單爭奪賽中,全面迎戰臺積電。
Techsearch International指出,這些HDAP技術推動了行業對設備與封裝協同設計以及新流程的需求。目前代工廠開始將一部分限制產能用于做先進封測,傳統的封測廠商也在逐漸向先進封測提升。 雖然目前為止,代工廠與封測廠商還沒有完全交叉的業務,在各自的領域獨立為戰。但未來雙方一定會越來越多地向中間重合領域進軍,先進封裝將成為兵家必爭之地。
HDAP,想說愛你不容易
然而,想要實現類似的HDAP仍然存在一些挑戰。
資料顯示,首先,HDAP具有異構性。即使上游EDA廠商已經修改了傳統工具來處理多種新技術,這些新技術也需要物理驗證,例如設計規則檢查(DRC)、版圖和線路圖對照檢查(LVS)等。在HDAP中,必須通過一個中介層或某種類型的互連技術做連接,在這種情況下,它會影響系統的互連特性,同時這些特性之間還會相互影響,同時影響可制造性特征的設計。
其次,新的HDAP技術要求設計團隊共同努力來優化整個系統,而不僅僅是單個元件。例如芯片和封裝/中介層未對齊、元器件和基地之間的連接錯誤等問題帶來的工程成本增加;制造數據的質量或誤差導致的制造延遲;以及信號和電源完整性性能不佳、2.5D裝配的熱穩定性不合格等問題帶來的功能故障等問題。
再者,HDAP也讓設計復雜度顯著提高,需要描述從芯片到基板、從中介層到基板、基板到電路板、基板到測試板的所有互連。這在傳統的封裝行業來看非常難以控制,目前有許多要靠手工集成,夾雜一些零碎的檢查。
HDAP作為一個全新的方向,也開始給半導體的設計流程帶來影響。這些新技術能夠對整體設計做分區,就像一種具有芯片外部特征的互連,這與芯片的內部特征非常相似。先進封裝使廠商有了集成不同技術(工藝)的能力,但同時也為傳統的設計工具帶來了相關挑戰。
在此基礎上,傳統的封裝設計已經無法滿足市場日益變化的需求,如何高效的完成設計并得到驗證,這將給EDA工具帶來全新的挑戰。市場迫切需要更為高效的全新流程、方法和設計工具。
Mentor的利器
Mentor是一家極為關注先進封裝技術的EDA廠商, Mentor 亞太區技術總監Lincoln Lee提到,作為一家EDA廠商,其產品本身就貫穿設計和封裝的各個方面。
早在10多年前(2007年),Mentor就看見了封裝市場的潛在機遇,并開始為領先客戶設計應對方案。他強調,半導體行業發展很快,先進封裝正在逐漸成為主力,如果不能很快適應客戶的要求,就將被拋在身后。發力先進封裝領域,對于Mentor與其客戶來說是雙贏。
2013年,Mentor正式推出了Xpedition Package Integrator(XPI) 高密度先進封裝(HDAP)流程,該流程是業內率先針對當今先進的 IC 封裝設計和驗證的綜合解決方案。
資料顯示,XPI產品已經具有高集成度,但基于整個設計過程中的分工需要, Mentor將XPI的兩個功能拆分為Xpedition Substrate Integrator工具和 Xpedition Package Designer技術。獨特的Xpedition Substrate Integrator(xSI)工具可快速實現異構基底封裝組件的定義和優化。針對物理封裝實施的新型 Xpedition Package Designer(xPD)技術可確保設計Signoff與驗證的數據同步。Calibre 3D Stack技術可針對各種2.5D和3D疊層芯片組件進行完整的Signoff DRC/LVS驗證。
在不斷優化的過程中,Xpedition可以多人協同工作,無需拆分,避免多次合并,從而實現最大限度地提高團隊工作效率。目前,Mentor正在全力解決多晶片封裝的功耗、散熱、性能問題。Lincoln解釋道,大家都希望將更多功能“塞”到同一顆芯片里,但這么多高效能的芯片放在一起,將產生極高的熱密度。因此,熱分析是非常關鍵的步驟。
目前做芯片的公司數量正在不斷減少,很大程度上是由于先進工藝行列所需要的成本十分昂貴,因此先進的設計工具就顯得尤為重要。Lincoln提到,Mentor的優勢在于擁有非常全面的工序,全新的解決方案能夠為IC設計廠商提供便利,可以在一定程度上滿足其需求。
Mentor與中國
現在,中國大陸市場中已經有不少廠商開始關注先進封裝,尤其是封測企業。近幾年,海外并購讓中國封測企業快速獲得了技術、市場,彌補了一些結構性的缺陷,極大地推動了中國封測產業的向上發展。
中國半導體協會數據顯示,大陸封測市場規模從2012年的1034億元增長至2018年的2196億元。在2019年封測市場,中國大陸占比達到28%,僅次于中國臺灣。
Lincoln指出,早在1989年,Mentor就已經進入中國大陸。盡管當時市場主要以PCB板級設計為主,中國大陸本土的IC產業仍在襁褓之中,整個市場的體量也沒有現在這么龐大,但Mentor絲毫沒有輕視中國市場和其未來的發展潛力。 此外,Mentor還跟地方政府、孵化平臺、高校和研究所合作,降低創新和創業的成本,積極地扶持未來的明星企業。
這些年來,Mentor見證了中國本土IC產業不斷強大,尤其是封測領域。Lincoln表示,近年中國本土先進封測廠商通過自主研發和兼并收購,已基本形成先進封裝的產業化能力,但從先進封裝營收占總營收的比例和高密度集成等先進封裝技術發展上來說,中國總體先進封裝技術水平與國際領先水平還有一定的差距。
在此基礎上,Mentor正在不斷支持中國廠商在先進封裝領域的發展,助力中國廠商在性能以及功耗等方面提升。同時,Lincoln也提到,在同等級的芯片中,使用Mentor HDAP設計環境的產品,異構集成能助力其效能更優化。
總結
在2020年,圍繞先進封裝的戰火繼續升級,先進芯片制造商正在不斷加碼,探索更廣闊的芯片創新空間。 盡管這些技術方法的核心細節有所不同,但大家各展謀略,都是為了持續提升芯片密度、實現更為復雜和靈活的系統級芯片,以滿足客戶日益豐富的應用需求。
這種情況下,隨著制程工藝逼近極限,成本無限提升,Mentor憑借在此領域豐富的經驗,其作用將越來越大,更加不可或缺。
責任編輯:tzh
-
芯片
+關注
關注
463文章
54010瀏覽量
466065 -
半導體
+關注
關注
339文章
30737瀏覽量
264126 -
IC
+關注
關注
36文章
6411瀏覽量
185632 -
封裝
+關注
關注
128文章
9249瀏覽量
148624
發布評論請先 登錄
【轉】告別容量與體積的妥協:永銘固態電容助力移動電源實現“小體積大容量”

告別容量與體積的妥協:永銘固態電容助力移動電源實現“小體積大容量”

華宇電子分享在先進封裝技術領域的最新成果
詳解先進封裝中的混合鍵合技術

突破!華為先進封裝技術揭開神秘面紗
英特爾先進封裝,新突破
3C消費電子智能化浪潮下,PD+(MCU)如何成為廠商“必爭之地”?
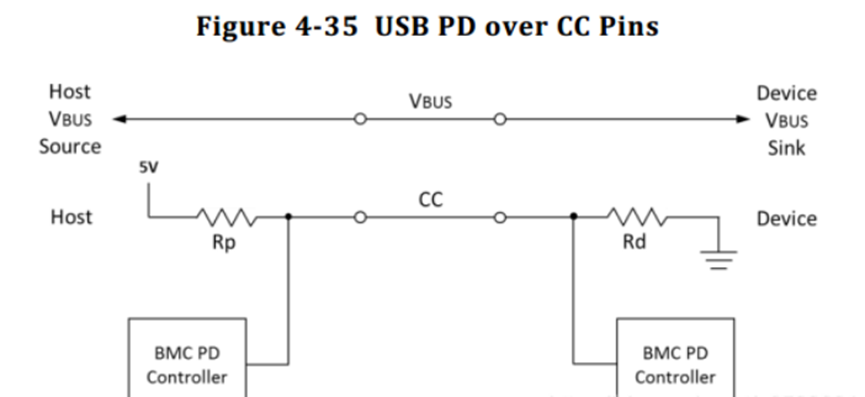
射頻系統先進封裝技術研究進展
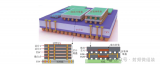
千視P3系列重大升級!直連USB Camera功能上線,USB相機秒變專業直播機

IC封裝產線分類詳解:金屬封裝、陶瓷封裝與先進封裝




 先進封裝技術將成為兵家必爭之地
先進封裝技術將成為兵家必爭之地








評論