前言
在現代ULSI電路中溝道熱載流子 (CHC) 誘導的退化是一個重要的與可靠性相關的問題。載流子在通過MOSFET通道的大電場加速時獲得動能。當大多數載流子到達漏極時,熱載流子(動能非常高的載流子)由于原子能級碰撞的沖擊電離,可以在漏極附近產生電子—空穴對。其他的可以注入柵極通道界面,打破Si-H鍵,增加界面態密度。CHC的影響是器件參數的時間相關的退化,如VT、IDLIN和IDSAT。
這種通道熱載流子誘導的退化(也稱為HCI或熱載流子注入)在NMOS和PMOS器件上都可以看到,并會影響所有區域的器件參數,如VT、亞閾值斜率、Id-on、Id-off、Ig等。每個參數隨應力時間的退化速率取決于器件的布局和所使用的工藝。

圖1. 通道熱載流子退化
CHC退化測試的過程
一個典型的通道熱載流子測試過程包括一個被測試器件(DUT)的初始化表征,然后是一個應力和測量循環[1](圖2)。在這個循環中,器件承受的電壓高于正常工作電壓的壓力。器件參數包括IDLIN、IDSAT、VT、Gm等,在應力之間進行監測,并將這些參數的退化繪制為累積應力時間的函數。在進行此應力和測量循環之前,將測量同一組器件參數作為基線值。

圖2. 典型的CHC測試過程
應力條件是基于最壞情況下的退化條件,這對于NMOS和PMOSFET是不同的。通常,對于漏極電壓應力,它應小于源極漏極擊穿電壓的90%。然后,在漏極應力電壓下,柵極應力電壓因晶體管類型和柵極長度而不同。表1顯示了使用不同技術[2]創建的NMOS和PMOSFET的最壞情況退化條件。

表1. NMOS和PMOS FETs的最壞情況應力條件
使用4200A-SCS半導體表征系統上的ITM可以很容易地確定最壞情況下的應力條件。
器件連接
在單個晶體管上執行CHC測試很容易。然而,每個CHC測試通常需要很長時間才能完成,所以希望有許多dut并行施加壓力,然后在應力之間按順序進行表征,以節省時間。為了實現這一點,需要一個開關矩陣來處理并行應力和應力之間的順序測量。圖3顯示了針對多個DUT的典CHC測試的硬件配置。4200A-SCS提供了應力電壓和測量能力,而開關矩陣支持并行應力和多個器件的順序測量。
根據被測試器件的數量,使用可容納一個矩陣開關(12個器件引腳)的708主機,或者使用最多6個矩陣開關(最多72個引腳)的707主機。不同柵極和漏極應力值的總數受到系統中SMU數量的限制。圖4說明了使用8個SMU(總共8個不同的漏極和柵極應力偏差)加上一個接地單元(接地端子)并聯20個晶體管對器件進行壓力測試的連接圖。

圖3. 硬件配置連線圖

圖4. 使用8個SMU并行施加壓力20個器件的示例。公共端子使用單獨的接地單元(GNDU)。
確定器件參數
被監測的熱載流子參數包括VTH、GM、IDLIN和 IDSAT。這些參數在應力之前首先測量,并在每個累積應力時間后重新測量。IDLIN是器件在線性區域測量漏極電流,而IDSAT是器件在飽和區域測量漏極電流。VTH和GM可以用恒流法或內插 / 外插法來確定。在內插 / 外插法中,VTH是由IDS- VDS曲線的最大斜率來確定。
4200A-SCS的公式編輯器工具大大簡化了這些參數的提取。內置函數包括微分獲得GM,MAX函數獲得最大的GM(Gmext),以及最小二乘線擬合函數提取 VTH(Vtext)。計算這些參數的公式可以在4200A-SCS提供的HCI項目中找到,并在測試庫中的相應的測試中找到。這些公式的一些例子包括:
GM = DIFF(DRAINI,GATEV)
GMEXT = MAX(GM)
VTEXT = TANFITXINT(GATEV,DRAINI,MAXPOS(GM))
最后一個公式(VTEXT)是ID-VG曲線在最大GM點處的切線擬合的x截距。圖5說明了公式編輯器的界面。

圖5. 4200A-SCS的公式編輯器界面
一旦這些參數從各個測試中計算出來,它們就可以通過選中“輸出值”選項中的復選框來導出,以監測應力時間的退化。對于每個測試,都可以選擇退出選項,允許系統跳過該器件,或者在器件出現故障時停止整個CHC測試。有關這些選項的更多詳細信息,請參閱完整的4200A-SCS參考手冊。
設置應力條件
在4200A-SCS軟件的吉時利Clarius版本中增強的功能之一是項目樹結構中可以增加一個應力循環,可以施加電壓和電流應力。用戶可以利用應力循環在預設時間上設置直流應力。每個周期的應力時間可以以線性或對數的方式進行設置(見圖6)。該特性用于 CHC/HCI、NBTI、EM(電遷移率)和電荷捕獲應用,以提供恒定的直流應力(電壓或電流)。在應力 / 測量模式下,用戶可以為被測器件的每個終端設置應力條件(圖7)。在每個應力周期之后,4200A-SCS經過一個測量序列,其中可以包括任意數量和類型的用戶定義的測試和參數提取。這些參數隨時間的退化情況被繪制在應力圖中。4200A-SCS的“工具包”體系結構為用戶在創建測試序列和壓力測量方面提供了巨大的靈活性。
對于關鍵參數,可以設置一個目標退化值(圖7)。一旦該參數的退化超過了目標值,特定的測試將停止。通過消除不必要的壓力和測量故障器件上的周期,將會節省了大量的時間。

圖6. 應力循環設置頁面

圖7. 器件應力 / 引腳連接 / 退化目標值設置窗口
如果項目中定義了多個DUT,則可以使器件壓力設置窗口中的“上一個器件”和“下一個器件”按鈕在器件之間進行切換(圖7)。“復制”和“粘貼”按鈕可以用于將壓力設置從一個器件復制到另一個器件中,而不需要在所有輸入字段中重新輸入所有信息。由于多個器件在不同的應力配置中并行施加應力,因此很難將所需的不同應力的數量和可用于應用它們的SMU的數量聯系起來。按下“檢查資源”按鈕,可以很容易地確定是否有足夠的SMU來處理所有涉及的壓力,并查看這些SMU是如何分配給每個不同的壓力的。如果開關矩陣連接到系統上,并且如果終端上的應力為0V,則默認使用接地單元。
圖8a顯示了一個單獨的數據表(圖8a),它可以合并到相應的應力設置窗口中,以保存有關周期指數、應力時間和從應力之間的測量中提取的監測參數的信息,如ID和VT。數據將以Excel文件格式(.xls)自動保存在項目目錄中,將數據以文本或Excel文件的形式導出到其他位置。如果系統處于應力 / 測量模式,監測參數相對于預應力測量的退化會自動計算,并可以繪制在圖8b中。有關更多壓力測量的信息,在Clarius中提供的功能,請查閱完整的4200A-SCS參考手冊。

a)

b)
圖8. a) 應力數據表存儲所有應力信息,包括應力期間的測量結果和應力之間測量的選定參數。b) 退化百分比數據作為應力時間函數的圖
建立CHC項目
下面的步驟概述了構建CHC項目的典型過程。有關每個步驟的詳細信息,請參考完整的4200A-SCS參考手冊。
1. 創建項目結構
a. 確定開關矩陣是否可用
b. 確定是否有足夠的SMU可用
c. 構建項目結構
2. 在應力之間建立測試
a. 如果使用了開關矩陣,進行開關連接。
b. 使用(ITMs)構建新的測試
c. 使用公式器工具計算器件參數
d. 在合理條件下設置退出
e. 對于監測退化,導出監測的參數值
f. 重復步驟b到步驟e,以監控更多的參數
3. 如果有多個DUT,則重復步驟2。
4. 在子項目中,設置應力條件。
a. 設置壓力時間
b. 設置器件應力條件
i. 應力電壓
ii. 引腳連接
iii. 目標退化值
iv. 進入下一個器件
5. 運行項目并檢查退化數據
參數退化數據和原始測量數據在項目運行期間自動以Excel文件格式保存。因此,即使項目在完成前就停止了,也已經捕獲了測量數據。應力之間的原始I-V曲線可以疊加在應力循環上,所以很容易看到I-V是如何作為應力時間的函數而退化的。圖9顯示了覆蓋21個應力循環后的Vgs-Id曲線。

圖9. 多個應力的疊加數據圖
圖10是一個在晶圓片上測試五個位置的CHC項目的例子。4200A-SCS通過與市場上最常見的半自動探針臺兼容的內置驅動程序控制探針臺的移動。

圖10. 晶圓級CHC測試的范例
結論
Clarius中增強的應力測量循環可以輕松設置CHC測試。結合交互式測試界面、公式工具和強大的圖形功能,Clarius使4200A-SCS成為評估器件可靠性參數的理想工具,如CHC誘導的MOSFETs退化,以及它在器件表征中更廣為人知的作用。
參考
[1] JEDEC標準28-A,“Procedure for Measuring N-Channel MOSFET Hot-Carrier-Induced Degradation Under DC Stress”,2001。
[2] Vijay Reddy,“An introduction to CMOS semiconductor Reliability”,IRPS教程,2004年。
-
測試
+關注
關注
9文章
6229瀏覽量
131413 -
MOSFET
+關注
關注
151文章
9688瀏覽量
233782 -
半導體
+關注
關注
339文章
30799瀏覽量
264653 -
PMOS
+關注
關注
4文章
272瀏覽量
31626
原文標題:熱載流子效應如何影響 MOSFET 可靠性?CHC 退化測試解析
文章出處:【微信號:泰克科技,微信公眾號:泰克科技】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
SiC MOSFET中的交流應力退化

光熱電效應的創新研究
IGBT模塊瞬態熱特性退化分析
MOSFET開態熱載流子效應可靠性

pMOS器件的熱載流子注入和負偏壓溫度耦合效應

應力誘導載流子存儲效應被提出
功率二極管晶閘管載流子存儲效應和開關特性

8月22日|泰克云上大講堂—半導體可靠性熱載流子效應測試詳解
SiC模塊解決儲能變流器PCS中SiC MOSFET雙極性退化失效痛點
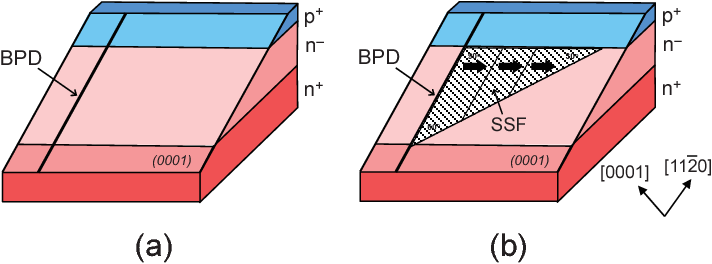
石墨烯量子霍爾效應:載流子類型依賴性及其計量學應用

熱載流子注入效應對芯片有什么危害
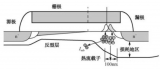
熱載流子注入效應深度解析
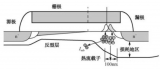



 MOSFET熱載流子效應退化測試解析
MOSFET熱載流子效應退化測試解析

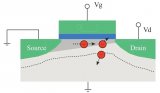





評論