電池雙向 DC-DC 變換器:800V 架構下的 DAB 拓撲與碳化硅零反向恢復特性研究報告
1. 緒論:800V 儲能架構演進與雙向 DC-DC 變換器的核心挑戰
隨著全球可再生能源并網比例的持續攀升以及電動汽車(EV)超充技術的普及,儲能系統(ESS)和車載動力系統正經歷著一場深刻的電壓架構變革。為了滿足兆瓦級(MW)充放電功率的需求,同時降低系統的線束重量、體積以及歐姆損耗(I2R),動力電池與儲能電芯的直流母線電壓正全面從傳統的 400V 平臺向 800V 乃至 1500V 架構演進 。在這一高壓化進程中,連接儲能電池簇與直流母線的核心樞紐——雙向 DC-DC 變換器,其性能的優劣直接決定了整個儲能系統的能量轉換效率、熱管理復雜性以及全生命周期的經濟性 。
在 800V 架構下,電池側 DC-DC 變換器不僅需要具備寬電壓范圍內的雙向能量調節能力,還必須實現高頻、高效率的電能變換,以減小無源磁性元器件(變壓器、電感)的體積 。雙主動全橋(Dual Active Bridge, DAB)拓撲因其天然的電氣隔離特性、易于實現軟開關(Soft Switching)以及高度對稱的模塊化結構,成為了 800V 儲能系統中雙向 DC-DC 變換器的絕對主流選擇 。然而,傳統的硅基(Si)絕緣柵雙極型晶體管(IGBT)在應對 800V 母線所需的高開關頻率時,暴露出嚴重的關斷拖尾電流和極大的反向恢復損耗,這不僅限制了 DAB 變換器效率的提升,更帶來了極大的散熱壓力 。傾佳電子力推BASiC基本半導體SiC碳化硅MOSFET單管,SiC碳化硅MOSFET功率模塊,SiC模塊驅動板,PEBB電力電子積木,Power Stack功率套件等全棧電力電子解決方案。?

傾佳電子楊茜致力于推動國產SiC碳化硅模塊在電力電子應用中全面取代進口IGBT模塊,助力電力電子行業自主可控和產業升級!
寬禁帶(WBG)半導體——特別是碳化硅(SiC)MOSFET 的全面引入,正在從物理底層重塑 DAB 變換器的性能邊界 。SiC MOSFET 憑借其極低的反向恢復電荷(甚至通過集成肖特基二極管實現“零反向恢復”)、極小的輸出電容(Coss?)以及卓越的高溫導熱性能,成功消除了高頻開啟瞬態的電壓尖峰,并在極寬的負載范圍內實現了零電壓開關(ZVS) 。傾佳電子楊茜剖析 800V 架構下 SiC DAB 拓撲的核心技術進展,結合 BASiC Semiconductor(基本半導體)最新一代 1200V SiC 系列器件的詳細參數,系統性地評估其在將滿載效率推向 99.2%、進而緩解液冷系統壓力并延長電池模組循環壽命方面的巨大應用價值 。
2. DAB 拓撲優化:最新研究
2.1 傳統逆變拓撲中的反向恢復與電壓尖峰痛點
在傳統的雙向功率變換器中,開關器件在進行硬開關或非理想軟開關換流時,其內部反并聯二極管(體二極管)的反向恢復特性是主要的損耗和電磁干擾(EMI)來源 。對于硅基 PN 結二極管而言,當其從正向導通狀態切換到反向阻斷狀態時,漂移區內積聚的少數載流子必須被復合或抽取,這一過程會產生顯著的反向恢復電流 。
在 800V 的高壓直流母線環境下,這種反向恢復電流在極短的時間內(高 di/dt)被強行關斷,也就是所謂的“電流突變(Snap-off)”現象。根據電磁學基本定律 V=Lσ??dtdi?,反向恢復電流的驟變會與功率回路中的寄生雜散電感(Lσ?)發生強烈的諧振,從而在開關管的兩端激發出極高的瞬態電壓尖峰(Voltage Spike) 。在 800V 系統中,如果不加以抑制,這些電壓尖峰極易突破 1200V 功率器件的擊穿電壓極限,導致器件雪崩擊穿甚至熱失控 。為了應對這一問題,傳統設計往往需要增加龐大的 RC 或 RCD 吸收緩沖電路(Snubber),這不僅增加了硬件成本,還將本可利用的電能轉化為廢熱白白消耗 。
2.2 SiC MOSFET 的零反向恢復機制與優化
碳化硅材料作為一種寬禁帶半導體,其臨界擊穿電場強度是硅的十倍,這使得 SiC MOSFET 的漂移區可以做得更薄且摻雜濃度更高 。更為關鍵的是,SiC 是一種多子導電器件,其本征體二極管在反向恢復過程中不存在少數載流子的存儲與復合效應 。2025 年底的最新學術論文與工業應用驗證顯示,SiC MOSFET 的這種物理特性從根本上消除了傳統意義上的反向恢復現象,其極其微小的反向恢復電荷(Qrr?)主要來源于耗盡層結電容的位移電流 。
為了追求極致的“零反向恢復(Zero Reverse Recovery)”,部分先進的 SiC 功率模塊會在器件內部并聯碳化硅肖特基勢壘二極管(SBD)。由于肖特基二極管完全依賴金屬-半導體接觸的多數載流子導電,其 Qrr? 幾乎為零 。這種零反向恢復特性徹底阻斷了由于高頻換流引起的內部寄生電感諧振,完美消除了開啟瞬態的電壓尖峰 。在 800V DAB 變換器的設計中,這意味著即使在 100kHz 甚至更高的開關頻率下,器件的開關節點(Phase Node)電壓也能保持平滑、干凈的過渡,極大地降低了開關損耗(Eon? 和 Eoff?)以及 EMI 輻射 。
以 BASiC Semiconductor 的工業級與車規級 SiC MOSFET 模塊為例,其在抑制電壓尖峰和優化反向恢復方面展現出了卓越的工程設計能力:
BMF240R12E2G3 模塊:該模塊不僅采用了低雜散電感設計,更直接內置了 SiC 肖特基勢壘二極管(Built-in SiC Schottky barrier diode),在數據手冊中明確標示實現了“二極管的零反向恢復(Zero Reverse Recovery from Diodes)” 。這一設計使得該模塊在進行高頻換流時,徹底免除了少子復合帶來的拖尾電流與尖峰電壓,能夠在不需要復雜緩沖電路的情況下安全穩定運行 。
BMF540R12KHA3 模塊:作為一款高達 540A 額定電流的 62mm 封裝模塊,其對內部 MOSFET 體二極管的反向恢復行為進行了深度優化(MOSFET Body Diode Reverse Recovery behaviour optimized) 。在 Tvj?=25°C 時,其反向恢復時間 trr? 僅為 29 ns,反向恢復電荷 Qrr? 僅為 2.0 μC;即使在 175°C 的極端高溫下,trr? 和 Qrr? 也分別控制在 55 ns 和 8.3 μC 的極低水平 。相較于同等級的硅基 IGBT 模塊動輒數微秒的恢復時間和上百微庫侖的電荷量,這種優化幾乎等同于消除了反向恢復對系統的負面影響 。
除了反向恢復特性外,開關瞬態的優化還高度依賴于模塊內部的寄生參數控制。模塊封裝的內部雜散電感(Lσ?)是產生電壓尖峰的另一大元兇 。BASiC Semiconductor 的最新模塊均采用了極低電感封裝設計,例如 BMF240R12KHB3 和 BMF540R12KA3 的內部雜散電感 Lσ? 被嚴格控制在 30 nH,而 BMF160R12RA3 也控制在 40 nH 。這種低感設計不僅抑制了 V=Lσ??di/dt 的過電壓,還使得開啟和關斷延時(td(on)?, td(off)?)大幅縮短,提升了死區時間(Dead-time)設定的精確度。
此外,內部柵極電阻(RG(int)?)直接影響著柵極驅動信號的傳播速度與米勒平臺(Miller Plateau)的跨越時間 。BMF120R12RB3 的 RG(int)? 僅為 0.70 Ω,BMF160R12RA3 為 0.85 Ω 。這種極低的內部柵極阻抗確保了驅動電荷能夠以極高的 di/dt 注入和抽出柵極,從而實現真正的超高速開關動作,使 SiC MOSFET 的低電容優勢得以完全釋放 。
3. 軟開關實現:極小 Coss? 對 ZVS 范圍的拓展與大倍率充放電溫升控制

3.1 DAB 變換器中 ZVS 的物理與數學機制
在 800V 儲能柜的實際應用中,電池的雙向充放電意味著變換器必須面對極其寬泛的負載范圍(從 10% 的涓流充電到 100% 的高 C 倍率充放電)以及寬電壓波動范圍(電池 SoC 從 0% 到 100% 對應的端電壓變化) 。DAB 變換器之所以成為首選,不僅因為其結構對稱,更在于其通過漏感(或外接電感)的儲能,天然具備實現所有開關管零電壓開關(ZVS)的潛力 。
ZVS 的本質是在主開關管的柵極收到導通信號之前,利用電感中儲存的電流(能量)將開關管結電容(輸出電容 Coss?)上的電壓完全放電至零,同時迫使其反并聯二極管導通 。一旦電壓降為零,此時再施加柵極導通電壓,開關管的開通損耗(Eon?)將趨近于零 。從能量守恒的角度來看,實現 ZVS 的基本不等式條件為:
21?Lσ?IL2?≥Coss?VDS2?
其中,Lσ? 為換流電感,IL? 為死區時間起始時刻的電感瞬時電流,Coss? 為開關管的等效輸出電容,VDS? 為母線直流電壓 。
在滿載條件下,由于傳遞的功率大,IL? 足夠高,提供充足的感性儲能來抽干 Coss? 上的電荷,ZVS 很容易實現。然而,在輕載工況下(例如儲能柜進行電網頻率調節時的待機或低功率平抑),IL? 顯著減小。如果 Coss? 過大,電感中儲存的能量將無法在有限的死區時間內將結電容電壓降至零,導致變換器進入硬開關狀態(Hard Switching),使得儲存在電容中的能量(Eoss?=21?Coss?VDS2?)在開關管溝道內以熱能形式瞬間耗散 。
3.2 碳化硅極小 Coss? 對系統效率的顛覆性影響
SiC MOSFET 器件結構的一個核心物理優勢就是其極小的寄生電容 。通過分析 BASiC Semiconductor 的器件參數,我們可以清晰地量化這一優勢:
分立器件 B3M011C120Z(TO-247-4 封裝) :在 800V 母線電壓下,其輸出電容 Coss? 僅為 250 pF 。這種皮法級別的電容意味著在極小的換流電流下,結電容的充放電也能在幾納秒內完成。
中功率模塊 BMF120R12RB3:其 Coss? 僅為 314 pF,在 800V 偏置下,其存儲的能量 Eoss? (或稱 Ecoss?)僅為 131 μJ 。
大功率模塊 BMF540R12MZA3 / BMF540R12KHA3:即使額定電流高達 540A,其 Coss? 也被控制在極其優秀的 1.26 nF 水平,對應的 Eoss? 為 509 μJ 。作為對比,同等電流等級的硅基 IGBT 模塊或 Super Junction MOSFET,其輸出電容往往是此數值的數倍乃至十倍以上。
由于 ZVS 的臨界電流閾值與 Coss? 的平方根成正比(IL_min?∝Coss??),SiC MOSFET 極小的 Coss? 特性直接且顯著地降低了實現軟開關所需的感性儲能下限 。2025 年的最新調制策略(如基于混合調制和自適應移相控制優化的 EPS/TPS 策略)與 SiC 極小 Coss? 的結合,使得 DAB 變換器能夠在從 10% 到 100% 的極寬負載范圍內,以及在電池電壓隨充放電深度(SOC)大幅波動的整個生命周期內,全程保持 ZVS 狀態 。
3.3 大倍率充放電下的極端溫升控制
儲能系統的另一大核心指標是其響應電網調頻指令的瞬時大倍率充放電能力(High C-rate Charge/Discharge) 。在短時間內吞吐巨大功率,意味著功率半導體將承受峰值電流的考驗。如果不能有效控制開關損耗,高頻操作下的器件結溫(Tvj?)將迅速攀升,進而引發器件熱衰退或損壞 。
由于 SiC 極小的 Coss? 保證了全負載范圍內的 ZVS,DAB 變換器的開通損耗(Turn?onLoss)被幾乎完全消除 。此時,變換器的發熱來源僅剩下導通損耗和關斷損耗。得益于 SiC 的優異特性,其導通損耗由極低的 RDS(on)? 控制(例如 BMF540 系列模塊在 25°C 下的典型 RDS(on)? 低至 2.2~2.5 mΩ ),而關斷損耗則因為高 dv/dt 的快速開關速度而降至極低 。因此,即使在 800V 電壓架構下進行大倍率充放電,變換器的整體熱耗散(Power Dissipation)也被牢牢壓制,從而能夠始終保持極低的系統溫升水平 。
4. BASiC Semiconductor 碳化硅器件深度技術剖析
為驗證上述拓撲優化與物理特性的工程實現,本節針對附件中提供的 BASiC Semiconductor(深圳基本半導體)的十款 1200V SiC MOSFET 分立器件與功率模塊進行深度的技術參數提取與比對分析。這些器件涵蓋了從 120A 到 540A 的廣泛電流范圍,應用了最新的封裝材料與燒結工藝,是構建 800V 高效儲能 DAB 變換器的物理基礎。
4.1 核心電學與熱學參數匯總矩陣
下表展示了各類模塊和單管在 800V/1200V 測試條件下的核心動態與靜態參數:
| 器件型號 | 封裝形式 | 連續漏極電流 (ID?) | RDS(on)? (25°C) 典型值 | RDS(on)? (175°C) 典型值 | Coss? (800V) | Eoss? (800V) | Rthjc? (結到殼熱阻) | 核心特性 / 二極管恢復特性 | 來源參考 |
|---|---|---|---|---|---|---|---|---|---|
| B3M006C120Y | TO-247PLUS-4 | 443A (@TC?=25°C) | 6.0 mΩ | 10.0 mΩ | 500 pF | 212 μJ | 0.08 K/W | 開爾文源極,超低導通電阻 | |
| B3M011C120Z | TO-247-4 | 223A (@TC?=25°C) | 11.0 mΩ | 20.0 mΩ | 250 pF | 未提供 | 0.15 K/W | 銀燒結工藝提升熱性能 | |
| B3M013C120Z | TO-247-4 | 180A (@TC?=25°C) | 13.5 mΩ | 23.0 mΩ | 未提供 | 未提供 | 0.20 K/W | 銀燒結工藝提升熱性能 | |
| BMF120R12RB3 | 34mm 半橋模塊 | 120A (@TC?=75°C) | 10.6 mΩ (Chip) | 18.6 mΩ (Chip) | 314 pF | 131 μJ | 未提供 | RG(int)? 低至 0.70 Ω | |
| BMF160R12RA3 | 34mm 半橋模塊 | 160A (@TC?=75°C) | 7.5 mΩ | 13.3 mΩ | 420 pF | 171 μJ | 未提供 | Lσ? 測試條件 40 nH | |
| BMF240R12E2G3 | Pcore?2 E2B | 240A (@TH?=80°C) | 5.0 mΩ (Chip) | 8.5 mΩ (Chip) | 0.9 nF | 未提供 | 未提供 | 內置肖特基,零反向恢復 | |
| BMF240R12KHB3 | 62mm 半橋模塊 | 240A (@TC?=90°C) | 5.3 mΩ (Chip) | 9.3 mΩ (Chip) | 0.63 nF | 263 μJ | 未提供 | trr? = 25ns, Qrr? = 1.1μC | |
| BMF540R12KA3 | 62mm 半橋模塊 | 540A (@TC?=90°C) | 2.5 mΩ | 4.3 mΩ | 1.26 nF | 515 μJ | 0.07 K/W | 超低結殼熱阻 | |
| BMF540R12KHA3 | 62mm 半橋模塊 | 540A (@TC?=65°C) | 2.2 mΩ (Chip) | 3.9 mΩ (Chip) | 1.26 nF | 509 μJ | 0.096 K/W | trr? = 29ns, 優化的體二極管 | |
| BMF540R12MZA3 | Pcore?2 ED3 | 540A (@TC?=90°C) | 2.2 mΩ | 3.8 mΩ | 1.26 nF | 509 μJ | 0.077 K/W | 采用 Si3?N4? AMB 陶瓷基板 |
4.2 導通損耗與高溫正溫度系數分析
從表中可以看出,SiC MOSFET 的導通電阻(RDS(on)?)具有極為顯著的優勢。以 BMF540R12MZA3 為例,在 25°C 環境下,其典型芯片級導通電阻僅為 2.2 mΩ 。這種超低阻抗是 800V 滿載工況下抑制熱耗散的基礎。同時,必須注意到器件的正溫度系數(PTC)效應:當結溫攀升至 175°C 的極限工況時,RDS(on)? 典型值增加至 3.8 mΩ 。 這一物理現象雖然增加了高溫下的傳導損耗,但卻帶來了巨大的系統級效益——它天然地促進了多芯片并聯時的均流(Current Sharing) 。當模塊內某顆芯片溫度升高時,其電阻隨之增大,迫使電流分流至較冷的芯片,從根本上防止了局部熱失控(Thermal Runaway),極大地提升了 540A 等大電流模塊的可靠性 。
4.3 器件級熱管理與先進封裝技術
儲能雙向 DC-DC 的全功率持續運行極其依賴底層的熱傳導效率。基本半導體的器件在封裝技術上展現出了行業最前沿的工藝:
銀燒結技術(Silver Sintering) :在分立器件 B3M011C120Z 和 B3M013C120Z 中明確應用了銀燒結工藝 。相比傳統的錫膏焊接,銀燒結層具有更高的熱導率和熔點,使得這兩款器件的 Rthjc? 分別降低至 0.15 K/W 和 0.20 K/W ,從而大幅度緩解了散熱器(Heat Sink)的設計壓力。
Si3?N4? AMB 陶瓷基板與銅基板:在 BMF540R12MZA3 (Pcore?2 ED3 封裝) 以及 BMF540R12KA3 (62mm 封裝) 等大功率模塊中,采用了高性能的氮化硅(Si3?N4?)活性金屬釬焊(AMB)基板 。氮化硅材料不僅具備極高的機械強度和卓越的抗功率循環(Power Cycling)能力,其熱導率也遠超傳統的氧化鋁(Al2?O3?),使得大電流模塊的熱阻被驚人地控制在 0.07~0.077 K/W 之間 。這種極致的熱界面設計是將熱量從 SiC 結迅速傳導至外部液冷冷板的決定性因素。
4.4 端子電阻(Terminals)與芯片電阻(Chip)的差異啟示
在多款模塊(如 BMF240R12E2G3, BMF540R12KHA3)的數據中,制造商嚴謹地分別列出了測量在模塊端子處(@terminals)和直接在芯片表面(@chip)的導通電阻 。例如,BMF540R12KHA3 在 25°C 時的芯片電阻為 2.2 mΩ,而端子電阻為 2.6 mΩ 。這 0.4 mΩ 的差值代表了模塊內部鍵合線(Bonding Wires)、銅排端子等互連結構的體電阻 。在 540A 的高電流下,這微小的互連電阻將額外產生約 116 W 的熱耗散(I2R)。這一數據深度揭示了在大功率應用中,為何系統級母排設計與模塊內部封裝互連同樣需要達到極低的寄生參數標準。
5. 800V 儲能柜系統級應用價值:99.2% 滿載效率與液冷系統壓力的大幅緩解
5.1 突破 99.2% 滿載效率的系統級熱動力學意義
綜合上述器件特性,采用類似 BASiC Semiconductor 的 SiC 模塊、結合零反向恢復特性的高頻 ZVS 設計,2025 年的 800V 雙向 DAB 變換器已成功在滿載工況下將電能轉換效率推向了 99.2% 的工程極限 。在儲能系統中,這一數值的提升不僅僅意味著能源損耗的減少,它代表著儲能柜在熱動力學層面的一次質變 。
從熱力學方程計算可知,若傳統硅基或早期 SiC 變換器的效率為 97%,則在傳輸 100 kW 功率時,將產生 3 kW 的廢熱 。而當效率提升至 99.2% 時,廢熱大幅驟降至區區 800 W。這一高達 73% 的熱耗散縮減,從根本上改變了儲能柜熱管理系統的設計邊界 。
5.2 液冷系統(Liquid Cooling)設計壓力的斷崖式下降
現代高功率密度 800V 儲能柜為了將鋰電池維持在最優的電化學溫度區間(通常為 15°C 至 35°C 之間)并冷卻功率電子器件,強制標配了復雜的液冷系統(包含冷水主機、循環水泵、液冷板、管路等) 。這些液冷組件是儲能系統的主要輔助功耗(Parasitic Load)來源 。
通過 DAB 變換器 99.2% 的滿載效率實現,DC-DC 模塊向液冷板排放的熱流密度急劇減少。
減小水泵與管路功耗:由于需要帶走的總熱量銳減 73%,液冷系統的冷卻液循環流量(L/min)可以按照比例下調。流體力學表明,泵的功耗與流量的三次方成正比,流量的減少將極大地降低水泵的運行能耗,從而提升整個儲能電站的系統級充放電綜合效率(RTE) 。
縮減壓縮機與制冷機組尺寸:冷卻需求的降低允許設計人員選用制冷量更小的壓縮機和換熱器,減少了儲能柜的輔助部件體積,使得系統能量密度(Power Density,kW/L 或 MW/m3)得到直接提升 。
無源散熱(Passive Cooling)的探索:部分最新研究甚至指出,憑借超低的損耗(如 15 kW 系統損耗僅 21 W),在特定工況下甚至可以完全摒棄主動水冷或風冷,轉而采用純自然冷卻機制,這對于極端環境(如高海拔、沙塵暴地區)的儲能電站可靠性具有劃時代的意義 。
5.3 熱均勻性(Thermal Homogenization)對電池循環壽命的延長
鋰離子電池的衰減機理(Capacity Fade)對其運行環境溫度具有極高的敏感性。阿倫尼烏斯定律(Arrhenius equation)指出,溫度每升高 10°C,電池內部的副反應速率大約增加一倍。在擁擠的 800V 儲能柜中,功率變換器通常與電池模組物理距離極近。如果 DC-DC 變換器效率低下,其散發的巨大熱量(如 97% 效率下的 3kW 熱源)將對周圍相鄰的電池電芯形成嚴重的局部熱輻射,造成儲能簇內部嚴重的溫度梯度(Thermal Gradients) 。
木桶效應決定了,一個電池串的整體壽命由老化最快(溫度最高)的電芯決定 。當 SiC DAB 變換器以 99.2% 的效率運行時,它實際上從系統中“摘除”了一個大型的局部熱源。這極大地減輕了液冷系統的局部均溫負擔,使得冷凍水能夠將所有制冷量集中于均勻冷卻每一個電池模組 。實現了高度的熱均勻性后,整個 800V 電池簇的電化學衰減速率將趨于一致,有效抑制了早期單體電芯的熱失控和嚴重掉電現象。因此,雖然前端的 SiC 模塊看似僅增加了電力電子硬件的初期投入,但其帶來的系統級熱管理優化,將實打實地延長儲能電芯的整體日歷壽命與循環壽命,大幅降低整個電站的平準化儲能成本(LCOS) 。
6. 結論與未來展望
綜上所述,伴隨能源結構向高電壓、大容量的穩步演進,800V 架構下的雙向 DAB 拓撲已經成為電能轉換技術的核心高地 。依托于碳化硅(SiC)MOSFET——尤其是基本半導體最新迭代的低熱阻、低電容、高閾值工業級模塊(如 BMF540 系列)——工程師們成功跨越了硅基時代的物理藩籬 。通過優化或集成肖特基二極管實現極低乃至“零反向恢復”,徹底消滅了寄生諧振帶來的危險電壓尖峰,極大地提升了系統級 EMI 與可靠性 。同時,借助 SiC 器件極小的輸出電容 Coss?,DAB 拓撲在輕載至滿載的全局范圍內完美保持了零電壓開關(ZVS) 。
這一系列從底層晶體物理學到變換器拓撲控制的突破,最終凝結成了在 800V 系統中高達 99.2% 的全負載變換效率 。這一工程成就不僅是對功率半導體的勝利,更是對整個電池儲能熱管理系統的一次重塑,它史無前例地削減了液冷系統的冗余設計壓力,通過重構儲能柜內的熱力學平衡,切實延長了鋰電池模組的使用壽命 。展望未來,隨著 SiC 器件結殼熱阻與互連寄生參數的進一步逼近物理極限,基于 SiC 的 DAB 拓撲必將成為推動 TWh 時代全球新型儲能網絡構建的堅實基石 。
-
變換器
+關注
關注
17文章
2168瀏覽量
112573 -
DC-DC
+關注
關注
30文章
2464瀏覽量
87223
發布評論請先 登錄
800V DC-50V DC轉換方案,未來數據中心的剛需

固變SST固態變壓器DAB雙有源橋隔離DC-DC變換器熱設計,移相控制策略,EMC設計

ED3半橋SiC模塊構建固態變壓器(SST)的隔離級DAB DC-DC的設計方案

100kW的SST固態變壓器高頻 DAB 隔離直流變換器設計與驗證

AI算力機架電源架構、拓撲演進與碳化硅MOSFET的應用價值深度研究報告

B3M系列碳化硅MOSFET軟反向恢復技術特性及其在橋式拓撲中的應用價值研究報告

MCS兆瓦級充電系統拓撲架構演進與SiC碳化硅模塊升級替代IGBT模塊技術研究報告

不控整流后的隔離DC-DC變換必要性與碳化硅MOSFET的戰略價值

傾佳電子碳化硅SiC MOSFET驅動特性與保護機制深度研究報告

基于SiLM6880CB-DG DC-DC降壓變換器:寬壓輸入與高效轉換的優勢解析
戶儲雙向 DC-DC 變換器功率電感選型:電感值、飽和電流與損耗的權衡

基于62mm碳化硅(SiC)模塊的大功率雙向DC-DC隔離電源
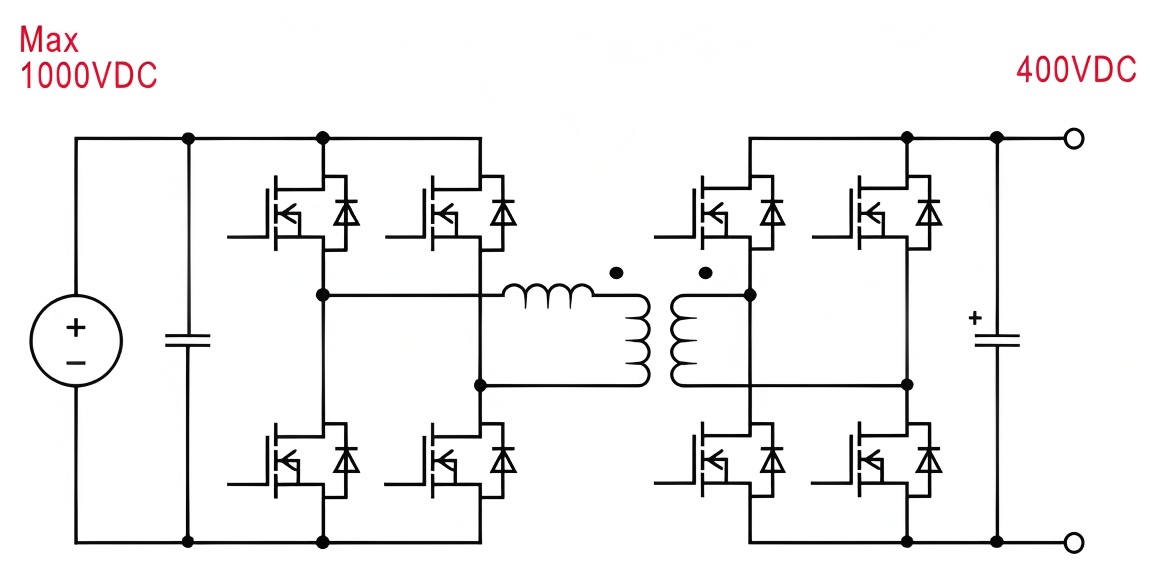



 電池雙向DC-DC變換器:800V架構下的DAB拓撲與碳化硅零反向恢復特性研究報告
電池雙向DC-DC變換器:800V架構下的DAB拓撲與碳化硅零反向恢復特性研究報告






評論