文章來源:半導體與物理
原文作者:jjfly686
本文主要講述芯片可靠性。
芯片可靠性是一門研究芯片如何在規定的時間和環境條件下保持正常功能的科學。它關注的核心不是芯片能否工作,而是能在高溫、高電壓、持續運行等壓力下穩定工作多久。隨著晶體管尺寸進入納米級別,芯片內部猶如一個承受著巨大電、熱、機械應力考驗的微觀世界,其可靠性面臨著原子尺度的根本性挑戰。

柵氧擊穿
在芯片的每個晶體管中,柵極與溝道之間隔著一層極薄的二氧化硅絕緣層,稱為柵氧。在先進制程中,這層材料的厚度僅相當于幾個原子的直徑。它的作用是隔絕柵極電壓,防止漏電。然而,當施加在它上面的電場強度過高時,問題就會出現。
柵氧擊穿的機理類似于堤壩在高水壓下出現管涌直至崩潰。強電場會使電子以極高的能量隧穿或注入到氧化層中。這些電子在氧化層中撞擊原子,逐漸造成微觀缺陷的積累。隨著時間推移,這些缺陷連接成一條導電路徑,導致柵極與溝道之間發生瞬間短路,晶體管永久失效。這一過程被稱為“時間依賴介電擊穿”。工藝波動導致氧化層局部變薄、芯片工作時電壓波動或靜電放電,都可能誘發或加速這一過程。

金屬電遷移
芯片內部密布著總長度可達數十公里的金屬互連線,負責在不同晶體管之間傳遞電流和信號。當電流密度非常高時,流動的電子會與金屬原子發生動量交換,形成一股持續的“電子風”。
這股力量會推動金屬原子沿著電子流動的方向緩慢遷移。經年累月,原子遷出的區域會形成微觀的“空洞”,導致導線電阻增大甚至完全斷開,造成開路失效。而在原子堆積的區域,則可能形成“小丘”,可能刺穿絕緣層與相鄰導線短路,或導致層間連接失效。電遷移的速率與電流密度的平方成正比,并隨溫度升高呈指數增長。因此,高性能芯片在計算密集型任務時,局部過熱和高電流會顯著加劇這一風險。

界面態不穩定
在硅襯底與柵氧層之間的交界處,存在著一個原子尺度上的模糊界面。這里可能存在未完美結合的化學鍵(懸掛鍵)或其他晶格缺陷,形成所謂的“界面態”。
這些界面態如同能量陷阱,可以捕獲或釋放電荷載流子(電子或空穴)。在外加電場(特別是柵壓)和溫度應力的共同作用下,界面處的電荷分布會發生變化。例如,正偏置溫度不穩定性會導致閾值電壓漂移,使晶體管開關變得遲緩或提前;熱載流子注入則可能造成性能的永久性退化。這種不穩定性的直接后果是晶體管的關鍵電學參數(如閾值電壓、跨導)隨時間發生漂移,導致電路時序出錯、功耗增加、信號噪聲變大,最終使芯片性能偏離設計指標。

-
芯片
+關注
關注
463文章
54163瀏覽量
467750 -
晶體管
+關注
關注
78文章
10415瀏覽量
148159 -
可靠性
+關注
關注
4文章
281瀏覽量
27620
原文標題:芯片可靠性
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄

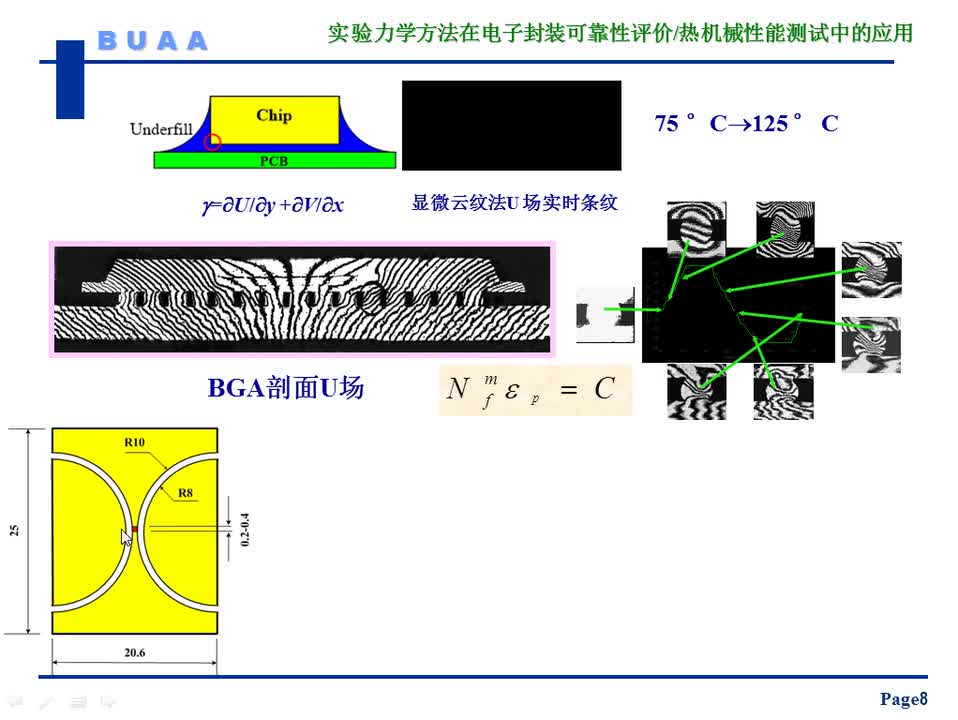
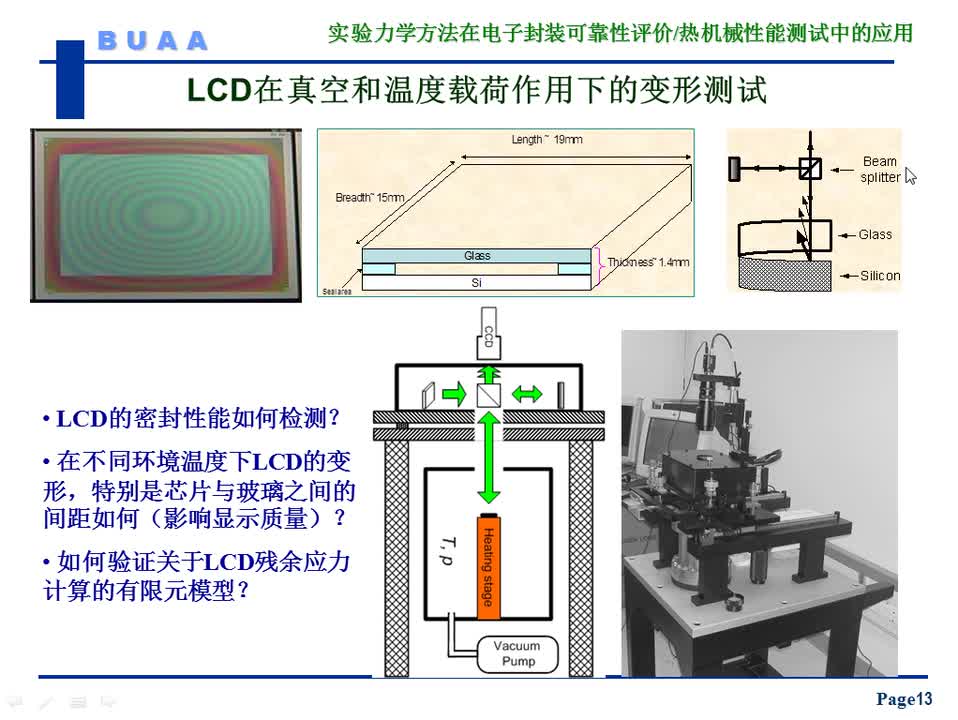


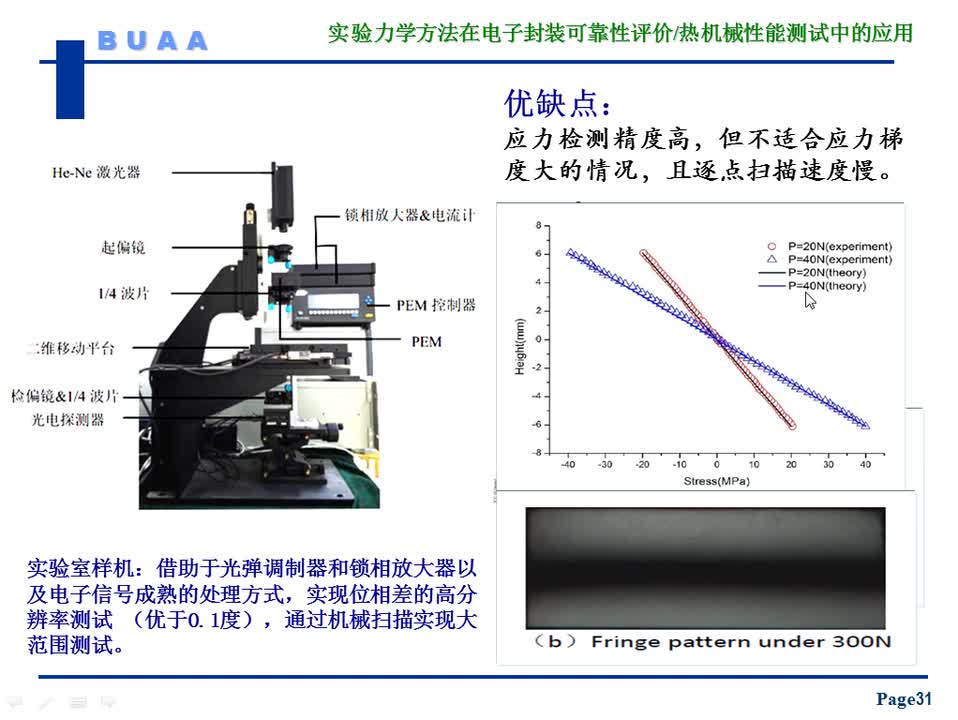
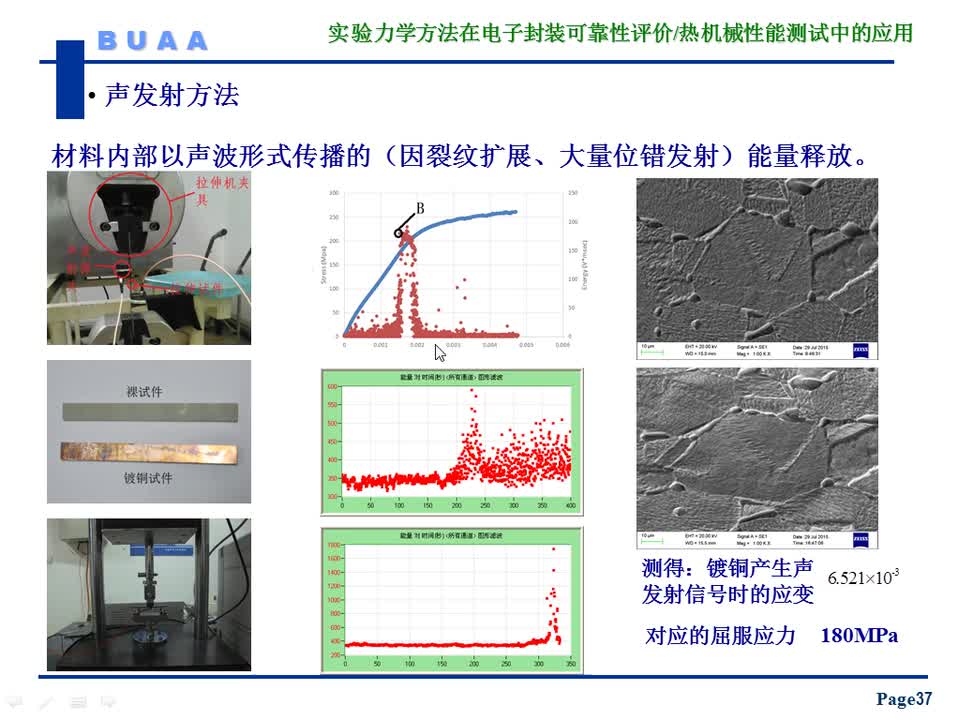
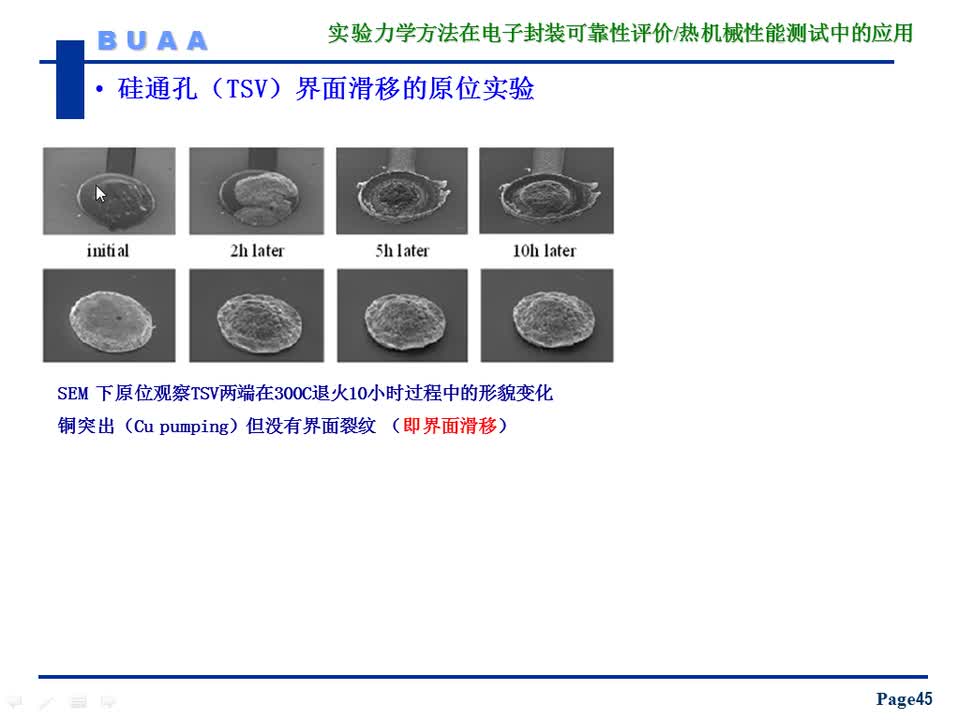
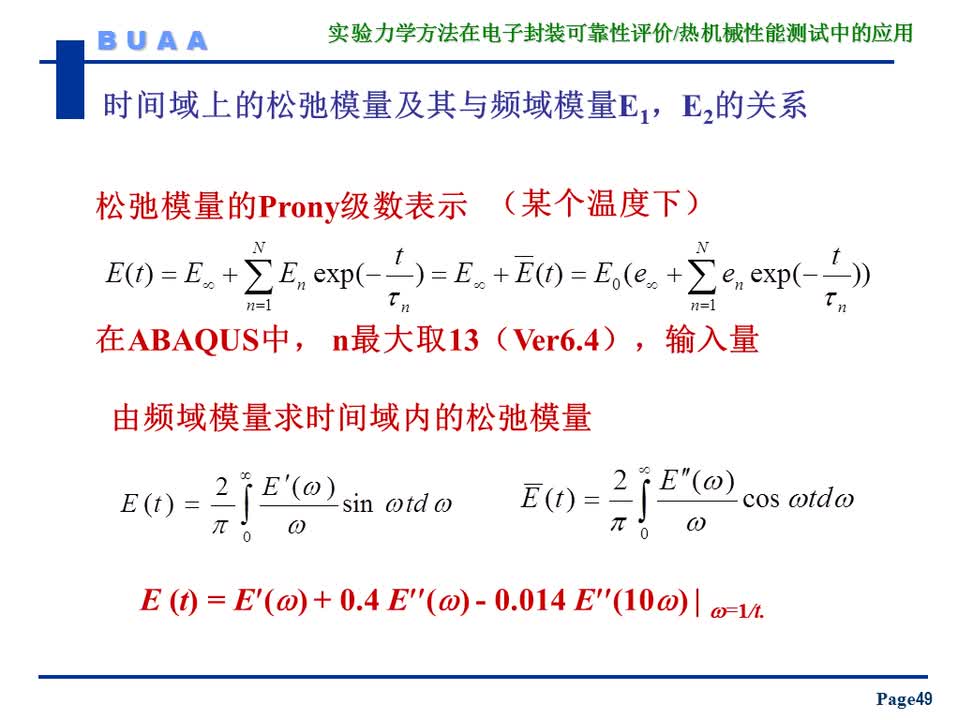
單片機應用系統的可靠性與可靠性設計
硬件工程師在可靠性設計中所面臨的挑戰及解決之道

半導體封裝技術的可靠性挑戰與解決方案




 芯片可靠性面臨哪些挑戰
芯片可靠性面臨哪些挑戰




評論