當集成電路進入深亞微米尺度時,可靠性問題日益突出。隨著器件使用時間的延長,這些可靠性問題將導致器件閾值電壓和驅動電流漂移,使器件性能退化,影響器件壽命。
可靠性認證通常在生產線試流片后進行。版圖設計者根據工藝要求設計出一整套可靠性測試結構,采用相應的工藝流片后進行測試,對測試結果的分析可套用業界通用的可靠性經驗模型,推算相應壽命。可靠性測試是一項很耗時的工作,例如金屬線的電遷移測試至少需要 500 小時,而產品的高溫運行壽命測試(HTOL)則需要 1 000 小時。如果出現失效,需要重復優化工藝,則耗費的時間將無法計算,這無疑增加了研發成本,延緩了產品的問世時間(Time-To-Market)。如果可以在初始電路設計階段就將可靠性問題考慮進去,則可使之處于可控之中,避免出現反復改進甚至迷失方向的困境。越來越多的研發人員提出可靠性設計(Design-For-Reliability)的理念,即設計高可靠性電路。然而,在設計時考慮電路的可靠性,需要對可靠性失效過程進行建模,并采用該模型進行器件或電路模擬,再以實際測試的數據進行修正,最終得到一個能模擬器件或電路實際劣化(Degradation)的精確模型。
本文就集成電路制造中關注的幾個可靠性問題,重點介紹其物理失效機理。
可靠性問題及其模型
目前關注的可靠性問題可分為以下幾類:柵介質膜中的可靠性問題,主要有經時擊穿特性 TDDB(Time-Dependent Dielectric Breakdown);前道工藝晶體管的可靠性問題,主要有熱載流子注入 HCI(hot Carrier Injection)、負偏壓溫度失穩性 NBTI(Negative Bias Temperature Instability);以及后道工藝的可靠性問題,主要有電遷移 EM(Electro-Migration)和應力遷移SM(Stress-Migration)。
1 TDDB物理機理
柵氧可靠性問題在集成電路行業初期就已經是個重要的問題,隨著器件尺寸的減小,柵介質層隨之減薄。在過去幾年中,氧化膜厚度已經接近幾個納米,因此氧化膜中的任何缺陷、雜質或界面態對柵氧來說都有重大的影響。此外,柵氧的失效過程是個積累過程,氧化膜中的缺陷容易俘獲電子,隨著時間的延長,電子積累到一定程度將形成通路,致使氧化膜擊穿,導致器件失效。
隨著器件尺寸的進一步縮小,高介電常數介質(high k)作為柵氧的替代材料成為必然趨勢。然而 k 值越高,介質擊穿電場 Ebd 越低,根據Joe等人的解釋,由于 high k 材料中存在局部高電場,導致極化分子鍵的扭曲甚至斷裂,降低了介質層的擊穿強度。Joe 等人還發現,在同樣的厚度下,high k 材料比 SiO2 具有更小的 β 值,也就是說high k 材料具有更大的離散度,這是由于缺陷/陷阱的單位尺寸隨 k 值的升高而增大。Kenji等人研究了 high k 材料的漏電流逐步升高現象的原因,認為在介質層中的軟擊穿不同時間在多個位置發生,提出了多重軟擊穿機制,high k 材料的可靠性問題還需要進一步進行深入研究。
2 晶體管可靠性
晶體管可靠性中最受關注的問題是HCI 和 NBTI,其中 HCI 效應通常發生在短溝道 NMOSFET 器件中,尤其在溝道橫向電場較大的情況下較為嚴重。而 NBTI 效應是發生在 PMOSFET 器件中,但無論器件溝道長短均會產生,并且隨著柵介質膜減薄變得愈加嚴重。另外,除了隨時間延長器件性能退化,在芯片測試的高溫老化過程中也會發生 NBTI 效應,因此,NBTI 已不僅影響器件的壽命,同時還影響了成品率,直接關系到制造商的經濟效益。
物理機理
HCI 導致 MOSFET 性能隨時間退化是個重要的可靠性問題。所謂熱載流子即高能載流子,在溝道橫向電場作用下靠近漏極的載流子被加速,與晶格碰撞后產生電子-空穴對。一部分能量較低的電子經漏極流出,另一部分能量較高的電子則跨過 Si/SiO2 界面勢壘進入 SiO2 介質層,從而形成一個小的柵極電流Ig;而空穴則由襯底電極引出,形成一個襯底電流Isub。襯底電流的大小是 HCI 效應強弱的標志量。溝道熱載流子與 Si/SiO2 界面的晶格碰撞會產生界面態,同時注入 SiO2 介質層的電子會陷入其中形成陷阱電荷。陷阱電荷和界面態影響了溝道載流子遷移率和有效溝道電勢,使閾值電壓、驅動電流和跨導產生漂移,器件性能退化。對于 NMOSFET 的 HCI 效應的抗擊能力可用襯底電流的大小進行評判,而對于 PMOSFET 的 HCI 效應可用柵電流或襯底電流進行監測。
NBTI 通常產生于 PMOSFET 中,當柵極加上負電壓,或器件處于一定的溫度下,NBTI 效應就會產生。柵極加上負電壓后,空穴陷入Si/SiO2 界面陷阱中,形成一層界面態,并且成為氧化膜中的固定電荷,導致閾值電壓(Vt)和關態電流(Ioff)的上升,以及飽和電流(Idsat)和跨導(Gm)的下降。NBTI 效應與器件溝道長短無關,但與柵氧化層厚度成反比,尤其對于超薄柵氧情況下, NBTI 效應更加嚴重。
在短溝道器件中,情況更為復雜。T.Enda等人在研究 PMOS 的 HCI 過程中發現,在溝道中心位置發生的 HCI 物理機制與 NBTI 相似,可能由于熱空穴在溝道電場中被加速,產生了 NBTI 效應。另外,工藝產生的應力對短溝道器件的壽命有著重要的影響。J.R.Shih 等人和 Takaoki Sasaki 等人分別觀察到器件受側墻(spacer)和 SiN 薄膜應力后HCI 和 NBTI 退化更為嚴重。
3 電遷移(EM)
后道金屬互連工藝的可靠性問題主要有 EM 和 SM 兩種。SM 是由于金屬材料與絕緣介質的熱膨脹系數存在較大差異導致接觸面產生較強機械應力,該應力會致使金屬原子發生遷移從而在連線上產生裂紋或空洞,結果引起器件或電路性能退化甚至失效。 SM 是一種與環境溫度變化相關的退化行為,而并非電流/電壓加速退化所致,所以難以進行可靠性建模與仿真,因此在此只討論 EM 問題。
物理機理
后道工藝集成中主要的可靠性問題是金屬的電遷移。在互連的系統中,金屬線和通孔受到電流中電子的碰撞,產生能量交換,使晶格離子獲得能量離開原來的位置,并在沿著電子運動方向漂移。由于金屬結構中存在著缺陷或晶界交叉點,金屬原子空位容易在這些地方聚集,隨著時間的推移,空位容易成長為空洞,宏觀上可以看見金屬線條或通孔變得不連續,甚至斷裂,造成電流的阻斷。發生電遷移的地方電阻升高,在器件工作過程時造成局部過熱,從而使器件失效。隨著器件的等比例縮小,互連線的尺寸也相應減小,因此增加了電流密度和功率密度,EM效應更為嚴重。
當傳統的 Al/SiO2 逐步被 Cu/low k 材料所代替時,芯片性能有了較大幅度提升,然而 Cu/low k 的 EM/SM 壽命卻下降,并且引發了新的可靠性失效機制:low k 材料具有很小的彈性模量和熱機械約束。因此相比于 SiO2,銅原子在 low k 材料中的反向擴散(back-diffusion)能力更小,導致遷移的銅原子總量增加,使器件壽命下降。為改善銅互連中的 EM 問題,阻擋層起著重要的作用,S. Matsumoto 等人驗證了選擇合適的阻擋層厚度對防止 EM 有著顯著的作用。
-
集成電路
+關注
關注
5452文章
12572瀏覽量
374574 -
失效機理
+關注
關注
2文章
31瀏覽量
11968
發布評論請先 登錄

集成電路可靠性介紹

電機驅動與控制專用集成電路及應用
電機控制專用集成電路PDF版
中國集成電路大全 接口集成電路
聚焦塑封集成電路:焊錫污染如何成為可靠性“絆腳石”?




 集成電路有哪些可靠性問題 集成電路物理失效機理原因分析
集成電路有哪些可靠性問題 集成電路物理失效機理原因分析







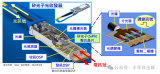



評論