這兩年,功率電子圈子里有一個很明顯的變化:越來越多的高功率應用,開始從分立器件轉向 SiC 模塊化方案。不管是新能源、工業電源,還是高端驅動與變流系統,工程師討論的重點,已經不只是“能不能做”,而是:
· 能效還能不能再高一點?
· 體積還能不能再小一點?
· 系統成本有沒有優化空間?
在這樣的背景下,SiC MODULE 模塊,正在成為很多中高功率系統的新選擇。

為什么 SiC MODULE 會成為趨勢?
如果只從器件層面看,SiC MOSFET 的優勢大家已經很熟悉了:高耐壓、低損耗、高開關頻率、高溫工作能力強。
但在實際工程中,真正決定系統性能的,往往不是單顆器件,而是整體封裝與拓撲實現方式。相比分立方案,模塊化 SiC 帶來的變化主要體現在三個方面:
1.寄生參數更可控
模塊內部布局經過優化,回路電感更低,有利于發揮 SiC 高速開關的優勢。
2.功率密度明顯提升
在同等體積下,模塊可以承載更高電流,系統結構更緊湊。
3.系統設計門檻降低
尤其是在 100A 以上電流等級,模塊方案在一致性、可靠性上更友好。
至信微 SiC MODULE 的設計思路
從我們與至信微電子的技術交流來看,他們在 SiC MODULE 上的思路比較明確:不是單純堆參數,而是圍繞“系統級效率與成本”去做平衡。
1.多種成熟拓撲,直接面向應用
至信微 SiC MODULE 系列,采用了多種成熟的功率拓撲方案,包括:
· 半橋拓撲
· 全橋拓撲
· 三電平拓撲
這些拓撲在新能源逆變、電機驅動、工業電源中已經被廣泛驗證,工程師在系統設計階段,可以更快進入調試和優化,而不是從零開始“踩坑”。
2.搭載高性能 SiC MOSFET 芯片
模塊內部采用 SiC MOSFET 高性能芯片方案,在實際應用中,優勢主要體現在:
· 開關損耗低,有利于提升整機效率
· 支持高開關頻率,磁性器件和濾波器體積可進一步縮小
· 高溫性能穩定,適合高功率密度場景
在 100A~300A 電流密度范圍內,依然能保持良好的熱穩定性和一致性。
3.封裝形式覆蓋主流應用場景
在封裝選擇上,至信微并沒有“只推一種方案”,而是提供了多種工程上常用的規格:
· 62mm 模塊封裝:適合中高功率變流器、工業驅動等場景
· SOT-227 封裝:結構緊湊,便于系統集成和散熱設計
· Easy 1B 封裝:兼顧功率密度與裝配便利性,適合追求高集成度的設計
這對做平臺化設計的客戶來說,其實非常友好。

應用場景:不只是“能用”,而是“好用”
結合目前行業的實際需求,SiC MODULE 在以下場景中優勢尤為明顯:
· 新能源逆變器(光伏 / 儲能):高效率 + 高功率密度,直接影響系統度電成本
· 工業電機驅動與變頻系統:低損耗、低溫升,有利于長期穩定運行
· 高端電源與充電設備:高頻化趨勢下,模塊方案更容易做整體優化
· 軌交、電力電子設備:對可靠性、一致性要求高,模塊化優勢更明顯
作為至信微電子的合作代理商,浮思特科技在實際項目中接觸到的,并不僅僅是產品參數本身,而是從“器件供應”到“方案協同”,
· 客戶在不同應用中遇到的功率密度瓶頸
· 從分立 SiC 遷移到模塊方案時的設計取舍
· 拓撲、封裝、散熱之間的系統級權衡

也正是因為這種長期的技術溝通和項目配合,我們更傾向于把 SiC MODULE 當作一個系統級解決方案,而不是簡單的“賣模塊”。SiC MODULE 并不是“所有場景的唯一答案”,但在中高功率、高效率、高集成度這些需求越來越明確的今天,它確實正在成為一個更現實、也更成熟的選擇。
如果你正在評估:分立 SiC 方案是否已經接近性能天花板;系統效率、體積和可靠性是否還有優化空間那么,基于成熟拓撲與多封裝形式的至信微 SiC MODULE,值得認真了解一下。
-
SiC
+關注
關注
32文章
3833瀏覽量
69936 -
Module
+關注
關注
0文章
76瀏覽量
13577
發布評論請先 登錄
至信微發布1200V/7mΩ、750V/5mΩ SiC芯片
浮思特|SiC MOSFET與普通MOSFET的區別及應用分析

浮思特 | SiC MOSFET 如何重塑電動車熱泵空調,替代IGBT的核心優勢

浮思特 | 高效能與低損耗,至信微SMD1000HB120DPA1 SiC模塊的應用與優勢

浮思特 | 至信微SMC40N065T4BS碳化硅MOSFET,高效能電源設計新選擇

浮思特 | 車載 OBC 功率升級背后,至信微 SiC SBD 發揮什么作用

浮思特 | 8英寸碳化硅晶圓為什么重要?至信微量產背后的技術邏輯

浮思特 | 從8位到32位,浮思特科技專注ABOV單片機,賦能全鏈創新

浮思特 | 面向1500V系統,至信微2000V SiC二極管帶來哪些改變

浮思特 | SiC功率模塊新標桿:至信微SMC300HB120E2A1如何重塑高壓功率設計




 浮思特 | 從拓撲到封裝,至信微SiC MODULE 真正改變了哪些設計細節
浮思特 | 從拓撲到封裝,至信微SiC MODULE 真正改變了哪些設計細節

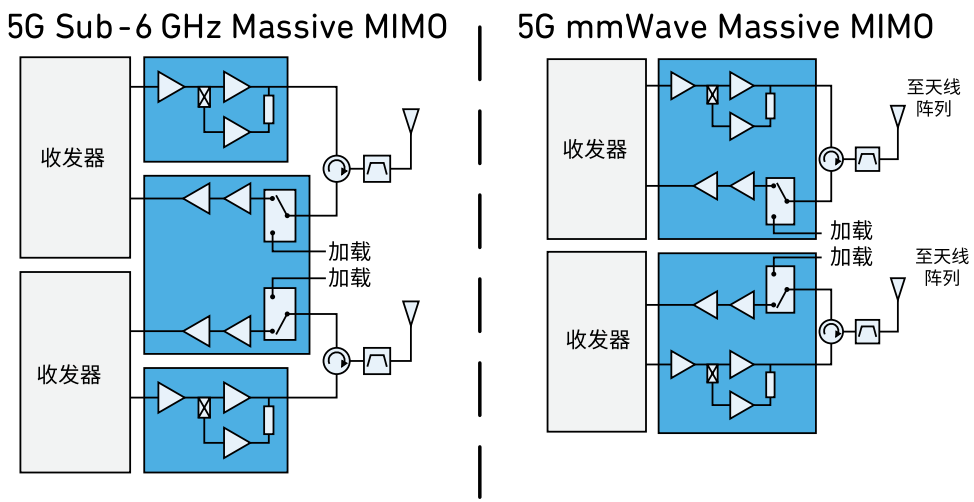






評論