在電子元件可靠性管控中,“分層”是非密封封裝產(chǎn)品的核心隱患——它可能導(dǎo)致元件散熱失效、信號傳輸異常,甚至引發(fā)整體故障。
IPC/JEDEC聯(lián)合發(fā)布的《J-STD-035A非密封封裝電子元件的聲學(xué)顯微鏡》標(biāo)準(zhǔn),不僅規(guī)范了聲學(xué)顯微鏡(SAT)的檢測流程,更明確了分層的判斷標(biāo)準(zhǔn),成為行業(yè)排查該類缺陷的“黃金準(zhǔn)則”。
本文將聚焦標(biāo)準(zhǔn)中的分層檢測核心內(nèi)容,為電子制造、質(zhì)檢及采購環(huán)節(jié)提供專業(yè)指引。
一。標(biāo)準(zhǔn)定位
分層檢測的“統(tǒng)一標(biāo)尺”
《IPC/JEDEC J-STD-035A-非密封封裝電子元件的聲學(xué)顯微鏡》首次發(fā)布于1999年,2022年12月重新修訂,是針對非密封封裝電子元件的無損聲學(xué)檢測專用標(biāo)準(zhǔn)。其核心目標(biāo)之一,就是通過標(biāo)準(zhǔn)化的聲學(xué)掃描方法,精準(zhǔn)識別元件內(nèi)部“分層”缺陷,并建立統(tǒng)一的判斷與記錄體系,解決不同企業(yè)檢測標(biāo)準(zhǔn)不統(tǒng)一、結(jié)果不可比的痛點。
標(biāo)準(zhǔn)明確:分層檢測需通過聲學(xué)顯微鏡的A/B/C/T掃描模式,覆蓋元件內(nèi)部關(guān)鍵接口,且所有判斷需基于“可復(fù)現(xiàn)的檢測流程”與“明確的缺陷界定指標(biāo)”,確保檢測結(jié)果的權(quán)威性與一致性。
二、先懂“檢測基礎(chǔ)”
分層觀測的核心維度
要準(zhǔn)確判斷分層,需先明確標(biāo)準(zhǔn)定義的“檢測對象”與“觀測工具”——這是分層判斷的前提。
1分層觀測的4種核心模式
標(biāo)準(zhǔn)規(guī)定,分層檢測需依賴以下4種聲學(xué)掃描模式,不同模式對應(yīng)分層判斷的不同維度:
A-mode(A-Scan)
聚焦“單點驗證”——通過單點的振幅、相位與飛行時間數(shù)據(jù),確認(rèn)疑似分層位置的信號異常是否為真實缺陷(而非成像干擾)。

B-mode(B-Scan)
聚焦“深度分析”——沿X-Z/Y-Z平面生成截面圖,直觀顯示分層在元件內(nèi)部的深度、延伸范圍(如從芯片表面延伸至基板)。
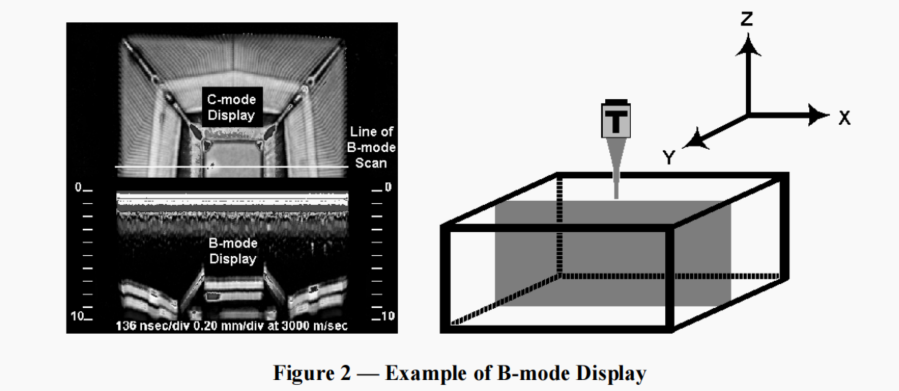
C-mode(C-Scan)
聚焦“平面定位”——在特定深度的X-Y平面生成圖像,精準(zhǔn)標(biāo)注分層的平面位置、面積大小(如芯片角落的2mm2分層)。
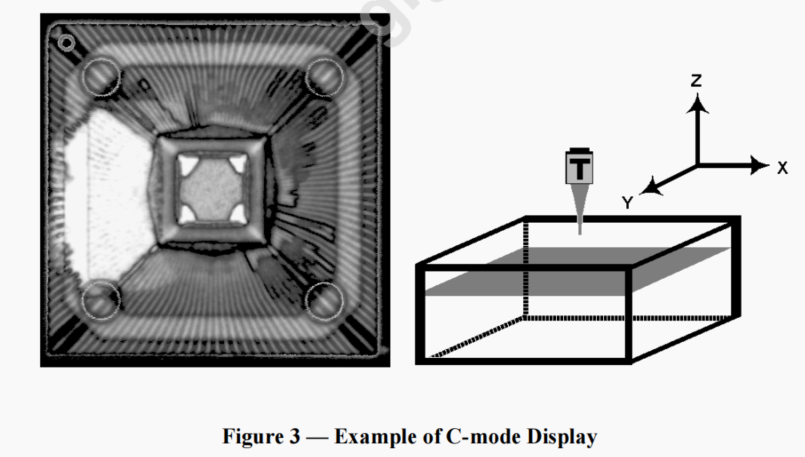
T-mode(T-Scan)
聚焦“初步篩查”——通過整體穿透掃描,快速判斷元件是否存在大面積分層(適用于批量檢測的初篩環(huán)節(jié))。
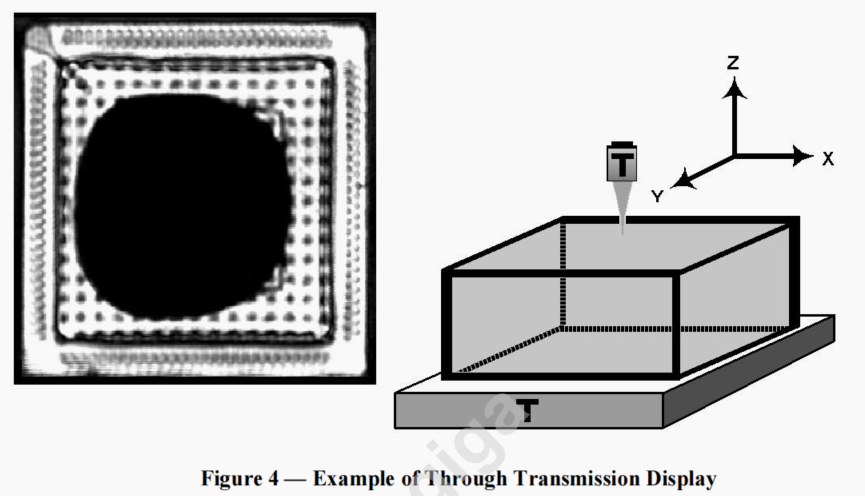
2分層易發(fā)生的7大關(guān)鍵區(qū)域
標(biāo)準(zhǔn)在聲學(xué)顯微鏡檢查表中,明確了分層檢測的“必查區(qū)域”——這些區(qū)域是元件內(nèi)部應(yīng)力集中、界面結(jié)合易失效的部位,也是分層的高發(fā)區(qū):

三、核心重點
分層判斷的“硬標(biāo)準(zhǔn)”
《IPC/JEDEC J-STD-035A非密封封裝電子元件的聲學(xué)顯微鏡》在聲學(xué)顯微鏡檢查表中,給出了分層判斷的“量化+定性”雙重指標(biāo)——這是行業(yè)唯一明確的分層判斷依據(jù),需逐點核對。
1通用判斷原則:先區(qū)分“缺陷vs干擾”
標(biāo)準(zhǔn)強調(diào),所有分層判斷需先排除“成像偽影(干擾信號)”,避免誤判。可通過以下2步驗證:
A-mode驗證
在疑似分層位置采集A掃描信號——若信號顯示“振幅突變”“相位反轉(zhuǎn)”(與正常bonded區(qū)域信號差異顯著),則初步判定為分層;
物理輔助驗證(必要時)
若A-mode無法確認(rèn),需結(jié)合元件結(jié)構(gòu)(如基板材質(zhì)、封裝厚度)或局部物理檢測,確認(rèn)是否為真實分層。
2分層判斷的“具體指標(biāo)”(按檢測側(cè)分類)
標(biāo)準(zhǔn)將分層檢測分為“電路側(cè)掃描”與“非電路側(cè)掃描”,兩類場景的判斷指標(biāo)各有側(cè)重,需嚴(yán)格按檢查表記錄:
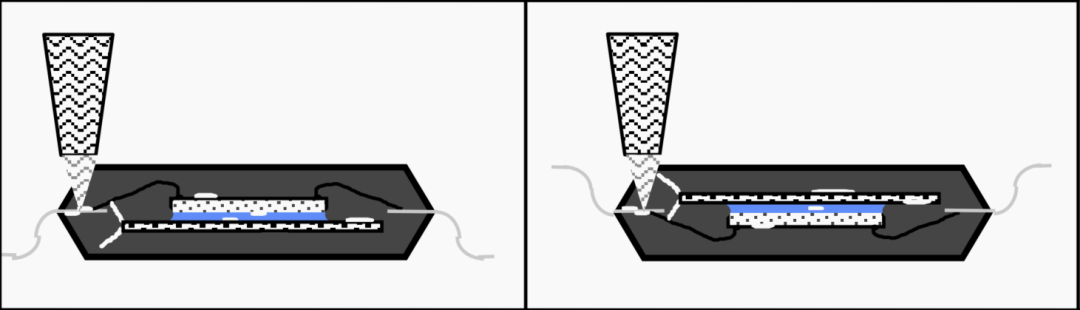
▲電路側(cè)掃描
▲非電路側(cè)掃描
01電路側(cè)掃描:
聚焦“芯片與信號傳輸相關(guān)區(qū)域”
電路側(cè)是元件核心功能區(qū),分層可能直接影響信號與散熱,判斷需更精細:
Type I(封裝材料/芯片表面分層)
需記錄:受影響的芯片數(shù)量、分層面積占芯片表面的“平均百分比”(如某芯片分層面積占比15%)、分層位置(角落/邊緣/中心);
關(guān)鍵要求:若分層覆蓋芯片活性區(qū)(如鍵合pad周圍),需額外標(biāo)注“是否靠近信號傳輸點”。
Type II(芯片貼裝區(qū)分層)
需記錄:受影響的貼裝區(qū)域數(shù)量、分層面積占粘貼區(qū)的“平均百分比”、分層是否導(dǎo)致“芯片與基板剝離”(通過B-mode確認(rèn)深度)。
Type III
(封裝材料/基板(芯片側(cè))分層)
需記錄:分層位置(基板邊緣/中心)、分層長度(如沿基板邊緣延伸3mm)、是否與TypeI/II分層連通(形成“貫通性缺陷”)。
Type V(封裝材料/引線框架分層)
需記錄:受影響的引線數(shù)量、分層占引線長度的“最大百分比”(如某引線分層占長度的40%)、是否覆蓋鍵合區(qū)(如楔形鍵合點周圍分層)。
02非電路側(cè)掃描
聚焦“基板與散熱相關(guān)區(qū)域”
非電路側(cè)分層雖不直接影響信號,但可能導(dǎo)致散熱失效,判斷需關(guān)注“大面積分層”與“結(jié)構(gòu)穩(wěn)定性”:
Type IV(封裝材料/基板背面分層)
需記錄:分層面積占基板背面的“平均百分比”、分層是否集中在“散熱片貼合區(qū)”(若有散熱片)、是否導(dǎo)致基板翹曲(通過C-mode平面度分析)。
Type VII(散熱片/基板分層)
需記錄:分層面積占散熱片貼合區(qū)的“平均百分比”、是否導(dǎo)致“散熱片局部脫離”(通過B-mode確認(rèn)散熱片與基板的間隙)。
03分層的“否決性指標(biāo)”
必須記錄的關(guān)鍵風(fēng)險
標(biāo)準(zhǔn)明確,若分層滿足以下任一條件,需判定為“高風(fēng)險缺陷”,需重點標(biāo)注并評估是否合格:
分層與“裂紋連通”
通過B-mode確認(rèn)分層延伸至裂紋,形成“缺陷通道”;
分層覆蓋“關(guān)鍵功能區(qū)”
如覆蓋引線鍵合點、芯片敏感電路區(qū);
分層面積超標(biāo)
若結(jié)合其他標(biāo)準(zhǔn)(如J-STD-020),分層面積超過規(guī)定閾值(如某類元件允許最大分層面積5%);
分層導(dǎo)致“結(jié)構(gòu)失效”
如芯片因分層脫離基板、散熱片因分層失去導(dǎo)熱功能。
四、分層檢測的“設(shè)備與流程保障”
要確保分層判斷準(zhǔn)確,標(biāo)準(zhǔn)對“檢測設(shè)備”與“操作流程”提出了嚴(yán)格要求——這是避免“判斷誤差”的基礎(chǔ)。
1分層檢測的設(shè)備配置要求
核心設(shè)備
需使用“反射式聲學(xué)顯微鏡”或“穿透式聲學(xué)顯微鏡”(額外配備獨立接收換能器);
校準(zhǔn)工具
必須配備“標(biāo)準(zhǔn)參考封裝件”(含“有分層”與“無分層”的標(biāo)準(zhǔn)樣品),用于校準(zhǔn)設(shè)備靈敏度(避免因增益不當(dāng)導(dǎo)致分層漏判/誤判);
輔助工具
樣品架需確保元件“平面度穩(wěn)定”(避免傾斜導(dǎo)致分層信號偏移),耦合介質(zhì)需用去離子水(避免氣泡干擾信號)。
2分層檢測的流程規(guī)范(關(guān)鍵4步)
設(shè)備校準(zhǔn)
用標(biāo)準(zhǔn)參考件驗證——無分層樣品應(yīng)無異常信號,有分層樣品需準(zhǔn)確顯示分層位置與面積,否則調(diào)整換能器頻率、增益;
樣品準(zhǔn)備
將元件固定于耦合介質(zhì)中,排除表面氣泡(氣泡會模擬分層信號,導(dǎo)致誤判);
多模式掃描
先通過穿透模式初篩,再用C-mode定位疑似分層,最后用A/B-mode驗證缺陷真實性;
記錄與判定
按檢查表填寫分層類型、位置、面積,結(jié)合標(biāo)準(zhǔn)指標(biāo)判定是否合格,并保存A/B/C/T模式圖像(用于追溯)。
五、避坑指南
分層判斷的“常見誤區(qū)”
標(biāo)準(zhǔn)在潛在圖像陷阱中,特別列出了分層判斷的“易誤判場景”,需重點規(guī)避:
1信號丟失≠分層
若增益設(shè)置過低、換能器頻率過高(導(dǎo)致信號衰減),可能誤判為分層——需通過調(diào)整設(shè)備參數(shù)重新掃描;
2表面干擾≠分層
元件表面的劃痕、指紋、Mark、pad扎痕,可能在C-mode中顯示“暗區(qū)”——需用A-mode驗證(表面干擾無相位突變,分層有明顯相位差異);
3聚焦錯誤≠分層
若換能器聚焦不在目標(biāo)界面(如聚焦在封裝材料表面而非芯片表面),可能顯示“虛假分層信號”——需通過B-mode調(diào)整聚焦深度,重新確認(rèn)。
六、標(biāo)準(zhǔn)的行業(yè)價值
分層管控的“定心丸”
對于電子行業(yè)而言,《IPC/JEDEC J-STD-035A非密封封裝電子元件的聲學(xué)顯微鏡》中的分層判斷標(biāo)準(zhǔn),不僅是“檢測指南”,更是“質(zhì)量共識”:
對制造商
可建立標(biāo)準(zhǔn)化的分層篩查流程,提前攔截缺陷品,避免因分層導(dǎo)致的客戶投訴;
對質(zhì)檢方
有明確的判斷依據(jù),無需依賴“經(jīng)驗主義”,檢測結(jié)果更具說服力;
對采購方
可將標(biāo)準(zhǔn)要求納入供應(yīng)商協(xié)議,確保接收的元件“分層管控達標(biāo)”,降低下游產(chǎn)品風(fēng)險。
總之,非密封封裝電子元件的分層檢測,需以《IPC/JEDEC J-STD-035A非密封封裝電子元件的聲學(xué)顯微鏡》為核心依據(jù)——從“模式選擇→區(qū)域覆蓋→指標(biāo)判斷→流程保障”全環(huán)節(jié)落地標(biāo)準(zhǔn)要求,才能真正實現(xiàn)“精準(zhǔn)識別、有效管控”。
季豐電子上海、嘉善、成都、深圳RA 實驗室均配有SAT設(shè)備和專業(yè)人員,對IPC/JEDEC J-STD-035A標(biāo)準(zhǔn)通過了 CNAS、ISO17025 資質(zhì)認(rèn)證,歡迎咨詢與委案!郵箱:sales@giga-force.com。
季豐電子
季豐電子成立于2008年,是一家聚焦半導(dǎo)體、先進材料、先進裝備、新型能源等領(lǐng)域的軟硬件研發(fā)及檢測類技術(shù)服務(wù)的賦能型平臺企業(yè)。公司主營分為四大板塊,分別為基礎(chǔ)實驗室、軟硬件開發(fā)、測試封裝和儀器設(shè)備,可為芯片設(shè)計、晶圓制造、封裝測試、材料裝備、新型能源等產(chǎn)業(yè)客戶提供一站式的軟硬件方案、檢測分析類技術(shù)服務(wù)及實驗室部署方案。
季豐電子通過國家級專精特新“重點小巨人”、國家高新技術(shù)企業(yè)、上海市“科技小巨人”、上海市企業(yè)技術(shù)中心、研發(fā)機構(gòu)、公共服務(wù)平臺等企業(yè)資質(zhì)認(rèn)定,通過了ISO9001、 ISO/IEC17025、CMA、CNAS、IATF16949、ISO/IEC27001、ISO14001、ISO45001、ANSI/ESD S20.20等認(rèn)證。公司員工超1100人,總部位于上海,在浙江、北京、深圳、成都等地設(shè)有子公司。
-
封裝
+關(guān)注
關(guān)注
128文章
9297瀏覽量
148880 -
電子元件
+關(guān)注
關(guān)注
95文章
1538瀏覽量
60357 -
顯微鏡
+關(guān)注
關(guān)注
0文章
762瀏覽量
25542
原文標(biāo)題:非密封封裝電子元件分層檢測權(quán)威指南 ——IPC/JEDEC J-STD-035A聲學(xué)顯微鏡標(biāo)準(zhǔn)核心解析
文章出處:【微信號:zzz9970814,微信公眾號:上海季豐電子】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
電子元件常用封裝
使用非車規(guī)的電子元件的風(fēng)險有多大
AD各類電子元件PCB封裝庫
電子元件缺陷檢測方法
密封封裝回流曲線、端接光潔度以及引腳修整和形狀

SOD972-S1塑料、超小型和無引腳全密封封裝




 非密封封裝電子元件分層檢測權(quán)威指南
非密封封裝電子元件分層檢測權(quán)威指南





評論