【博主簡介】本人“愛在七夕時(shí)”,系一名半導(dǎo)體行業(yè)質(zhì)量管理從業(yè)者,旨在業(yè)余時(shí)間不定期的分享半導(dǎo)體行業(yè)中的:產(chǎn)品質(zhì)量、失效分析、可靠性分析和產(chǎn)品基礎(chǔ)應(yīng)用等相關(guān)知識(shí)。常言:真知不問出處,所分享的內(nèi)容如有雷同或是不當(dāng)之處,還請(qǐng)大家海涵。當(dāng)前在各網(wǎng)絡(luò)平臺(tái)上均以此昵稱為ID跟大家一起交流學(xué)習(xí)!

在半導(dǎo)體制造中,晶圓廠制程的任何微小變動(dòng),都可能引起良率與可靠性的風(fēng)險(xiǎn)。其中,一個(gè)尤為典型的系統(tǒng)性失效模式,是源于光刻環(huán)節(jié)的Reticle(光罩)。當(dāng)Reticle本身存在污染、劃傷或設(shè)計(jì)瑕疵時(shí),或當(dāng)光刻機(jī)在步進(jìn)重復(fù)曝光過程中出現(xiàn)參數(shù)漂移(如焦距不準(zhǔn)、曝光能量不均)時(shí)。這些因Reticle問題而產(chǎn)生的特定區(qū)域內(nèi)的芯片,實(shí)質(zhì)上構(gòu)成了一個(gè)高風(fēng)險(xiǎn)的"潛伏失效群體"。若不能在測(cè)試階段被情確識(shí)別并剔除,將直接流向客戶端,對(duì)產(chǎn)品的長期可靠性與品牌聲譽(yù)構(gòu)成嚴(yán)重威脅。識(shí)別并處理這類與Reticle強(qiáng)相關(guān)的潛在缺陷,是現(xiàn)代高可靠性質(zhì)量管理中一項(xiàng)較具挑戰(zhàn)性的關(guān)鍵任務(wù)。所以,相較于消費(fèi)級(jí)、工業(yè)級(jí)芯片,車規(guī)級(jí)芯片在使用過程中,面臨著冷熱溫度范圍大、濕度變化大等挑戰(zhàn),對(duì)可靠性的要求更高。想要判斷芯片是否能夠應(yīng)用于車輛中,拿到汽車市場的“入場券”,那就少不了“零件平均測(cè)試(PAT)”系統(tǒng)來進(jìn)行檢驗(yàn)。
同時(shí),業(yè)界對(duì)于半導(dǎo)體器件零缺陷需求的呼聲日益高漲,為此半導(dǎo)體制造商開始加大投資應(yīng)對(duì)挑戰(zhàn),以滿足汽車用戶的需求。隨著汽車中電子元器件數(shù)量的不斷增加,必須嚴(yán)格控制現(xiàn)代汽車中半導(dǎo)體器件的質(zhì)量以降低每百萬零件的缺陷率(DPM),將與電子元件相關(guān)的使用現(xiàn)場退回及擔(dān)保等問題化,并減小因電子元件失效導(dǎo)致的責(zé)任問題。
美國汽車電子委員會(huì)AEC-Q001規(guī)范推薦了一種通用方法,該方法采用零件平均測(cè)試(PAT)方法將異常零件從總零件中剔除,從而在供應(yīng)商這就改進(jìn)部件的質(zhì)量和可靠性。對(duì)給定晶圓、批號(hào)或被測(cè)零件組,零件平均測(cè)試(PAT)方法可以指示總平均值落在6σ之外的測(cè)試結(jié)果,任何超出給定器件的6σ門限值的測(cè)試結(jié)果均被視為不合格,并從零件總數(shù)中剔除,那些未達(dá)到零件平均測(cè)試(PAT)門限值的零件不能付運(yùn)給客戶,這樣一來就改進(jìn)了器件的質(zhì)量和可靠性。所以,從其編號(hào)AEC-Q001就可以看出其在汽車電子行業(yè)的奠基者般的地位。隨著汽車行業(yè)的發(fā)展以及PAT應(yīng)用的推廣,人們?cè)絹碓蕉嗟匕l(fā)現(xiàn)零件平均測(cè)試(PAT)的好處,并漸漸地將其引入到JEDEC(電子器件工程聯(lián)合委員會(huì))標(biāo)準(zhǔn)里,大家可以在JESD50C里面找到它。
由于“零件平均測(cè)試(PAT)”涉及到芯片、測(cè)試項(xiàng)維度的計(jì)算,長期以往存在巨大數(shù)據(jù)量,對(duì)模型的可擴(kuò)展性以及運(yùn)算的效率、準(zhǔn)確性有著較高的要求。此外,不同上游廠商對(duì)于“零件平均測(cè)試(PAT)”的理解不同,又會(huì)在靜態(tài)零件平均測(cè)試(SPAT)、動(dòng)態(tài)零件平均測(cè)試(DPAT)的基礎(chǔ)上延伸出GDBN、Cluster、NNR等算法,即使是同一種“零件平均測(cè)試(PAT)”類型,也會(huì)在參數(shù)設(shè)置、算法模型上有著較大的差異。對(duì)于IC設(shè)計(jì)公司、測(cè)試廠來說,要自行構(gòu)建一套高效、準(zhǔn)確的“零件平均測(cè)試(PAT)”系統(tǒng),應(yīng)對(duì)龐大數(shù)據(jù)量場景下的“零件平均測(cè)試(PAT)”運(yùn)算,無疑是一件費(fèi)時(shí)又費(fèi)力的事情。但本章節(jié)主要跟大家分享“零件平均測(cè)試(PAT)”這一方法的相關(guān)內(nèi)容。

一、零件平均測(cè)試(PAT)方法的介紹
零件平均測(cè)試,英文全稱:Part Average Testing,簡稱:PAT,也可被稱作:部件平均測(cè)試。它是一種通過統(tǒng)計(jì)篩選方法識(shí)別并剔除異常器件的技術(shù)方法,從而提高整體產(chǎn)品的可靠性。當(dāng)前主要應(yīng)用于提高半導(dǎo)體產(chǎn)品的可靠性,尤其在汽車電子領(lǐng)域(AEC-Q001標(biāo)準(zhǔn)推薦)應(yīng)用最為廣泛。

二、零件平均測(cè)試(PAT)方法的基本原理
零件平均測(cè)試法(PAT)通過動(dòng)態(tài)計(jì)算每個(gè)測(cè)試參數(shù)的均值和標(biāo)準(zhǔn)差,并基于統(tǒng)計(jì)分布設(shè)置更嚴(yán)格的限制,以此識(shí)別出偏離群體行為的異常器件。它利用統(tǒng)計(jì)學(xué)原理,對(duì)特定晶圓、批號(hào)或待測(cè)零件組的測(cè)試數(shù)據(jù)進(jìn)行統(tǒng)計(jì)分析,通過計(jì)算總平均值、穩(wěn)健平均值、穩(wěn)健標(biāo)準(zhǔn)差等統(tǒng)計(jì)量,來確定測(cè)試參數(shù)的合理范圍,將超出該范圍的異常零件剔除。
細(xì)分來講,零件平均測(cè)試法(PAT)的核心原理主要體現(xiàn)在以下兩個(gè)方面:
1、統(tǒng)計(jì)篩選機(jī)制
零件平均測(cè)試法(PAT)通過動(dòng)態(tài)計(jì)算測(cè)試參數(shù)的均值(μ)和標(biāo)準(zhǔn)差(σ),并設(shè)置用戶定義的乘數(shù)(通常為6),識(shí)別偏離群體行為的異常器件1。例如,若測(cè)試結(jié)果超出μ±6σ范圍,則判定為不合格3。
2、統(tǒng)計(jì)優(yōu)勢(shì)
a. 動(dòng)態(tài)適應(yīng)性 :相比傳統(tǒng)測(cè)試,零件平均測(cè)試法(PAT)能更精準(zhǔn)地反映當(dāng)前批次質(zhì)量,尤其適用于晶圓測(cè)試(lDPAT)和最終測(cè)試環(huán)節(jié)(liPAT)。
b. 減少冗余測(cè)試 :通過統(tǒng)計(jì)分析剔除不合格品,避免重復(fù)測(cè)試,提升效率。

三、零件平均測(cè)試(PAT)方法的實(shí)施步驟及計(jì)算方法
1、數(shù)據(jù)收集與預(yù)處理
選擇與器件特性高度相關(guān)的測(cè)試參數(shù)(如電流測(cè)試、電阻測(cè)量等),并進(jìn)行中心化、白化等預(yù)處理以提高統(tǒng)計(jì)可靠性,具體如:電流測(cè)試(IDDQ)、泄漏電流、電阻測(cè)量等。數(shù)據(jù)需經(jīng)過預(yù)處理(如中心化、白化)以提高統(tǒng)計(jì)可靠性。
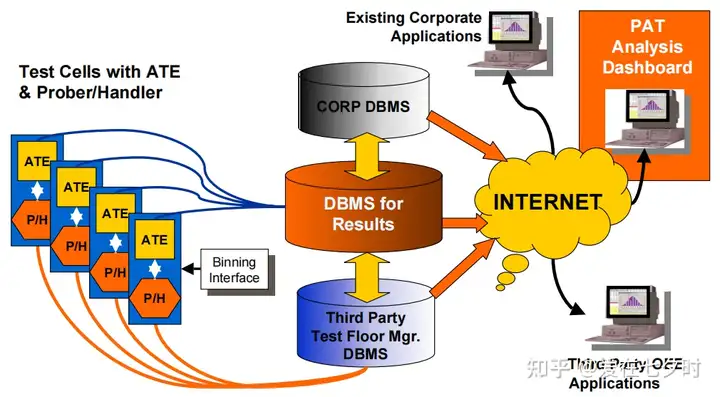
2、統(tǒng)計(jì)計(jì)算與限制設(shè)置
通常零件平均測(cè)試法(PAT)限制的計(jì)算公式為以下,詳細(xì)情況也會(huì)在下文中有講到:

其中:
lμ為穩(wěn)健均值(中位數(shù)),
N為穩(wěn)健標(biāo)準(zhǔn)差(基于四分位距計(jì)算),
σ為用戶定義的乘數(shù)(汽車行業(yè)通常為±6)。

A. 靜態(tài)零件平均測(cè)試法(SPAT)
靜態(tài)零件平均測(cè)試,英文全稱:Static Part Average Testing,簡稱:SPAT,它程序的概述是從26個(gè)批次中抽取30個(gè)隨機(jī)零件(與晶圓批次有5個(gè)區(qū)域不同的管芯)。在早期包括表征批次為每個(gè)測(cè)試設(shè)置建立一個(gè)“穩(wěn)健平均值”(μ),μ=統(tǒng)計(jì)中值,并根據(jù)四分位數(shù)(Q3和Q1)測(cè)量值計(jì)算出一個(gè)“穩(wěn)健sigma”,即σ=(Q3-Q1) /1.35,從而定義靜態(tài)零件平均測(cè)試法(SPAT)限值為:μ±6σ。
特殊情況處理:如果分布不是高斯分布(正態(tài)分布),則使用“可防御”技術(shù)來標(biāo)記表現(xiàn)出相同概率的離群值(約5.068億中的1)。
更新周期:基于歷史批次數(shù)據(jù)計(jì)算μ和σ,設(shè)置μ±6σ限制,每6-8個(gè)月更新一次,以先到者為準(zhǔn)。

另外,在靜態(tài)零件平均測(cè)試法(SPAT)中,測(cè)試限值基于設(shè)定的批次數(shù)。通常,在動(dòng)態(tài)零件平均測(cè)試法(DPAT)中,會(huì)針對(duì)每個(gè)晶圓測(cè)試計(jì)算限值。在靜態(tài)零件平均測(cè)試法(SPAT)和動(dòng)態(tài)零件平均測(cè)試法(DPAT)中,都會(huì)執(zhí)行一種算法。該設(shè)備只是通過或失敗。
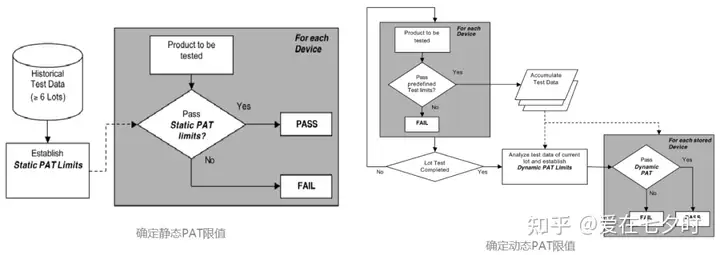
至于在某些情況下,這些算法可能達(dá)不到要求的情況,就會(huì)涉及到有多種類型的復(fù)雜異常值檢測(cè)算法,基于地理、多變量和其他方案。甚至可以將許多算法與DPAT和SPAT相結(jié)合等情況,這就是另一個(gè)后續(xù)要跟大家分享的內(nèi)容了,在此就不過多贅述。

還有以下這些方法都可以結(jié)合起來的哦:

B. 動(dòng)態(tài)零件平均測(cè)試法(DPAT)
動(dòng)態(tài)零件平均測(cè)試,英文全稱:Dynamic Part Average Testing,簡稱:DPAT,它的限值的計(jì)算方法與靜態(tài)零件平均測(cè)試法(SPAT)限值相同,但使用“滾動(dòng)”樣品從當(dāng)前批次中"合格”的零件確定平均值和標(biāo)準(zhǔn)偏差(或適當(dāng)?shù)姆歉咚瓜拗?。
在這種情況下,在批次完成之后,將重新分析“合格”零件的結(jié)果,以確定是否使用更緊密的批次分布來確定它們是否超出了動(dòng)態(tài)PAT限制= H±60。使用當(dāng)前批次合格零件數(shù)據(jù)實(shí)時(shí)計(jì)算μ和σ,動(dòng)態(tài)調(diào)整限制(如H±6σ)。
特殊情況處理:如果它們是“異常值”,則盡管通過了最初的USL, LSL測(cè)試,但仍被拒絕。對(duì)于測(cè)量結(jié)果不是參數(shù)化(通過/失敗)或無法索引(例如,使用序列號(hào)進(jìn)行跟蹤)的設(shè)備, 動(dòng)態(tài)零件平均測(cè)試法(DPAT)需要重新測(cè)試部件以檢查異常 值。AEC確實(shí)可以使用500或1000個(gè)單位的靜態(tài)限值,如果通過,則構(gòu)成用于計(jì)算后續(xù)設(shè)備更嚴(yán)格的動(dòng)態(tài)零件平均測(cè)試法(DPAT)限值的示例。這樣避免了重新測(cè)試零件。
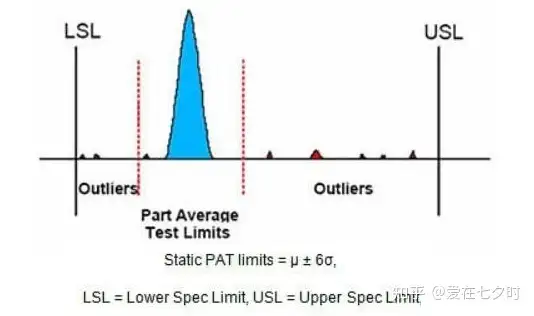
當(dāng)然,動(dòng)態(tài)零件平均測(cè)試法(DPAT)的管控標(biāo)準(zhǔn)并不都是±6sigma ,雖然±6sigma是常見的一種管控方式,但實(shí)際上它存在多種管控形式:
a. 常見的±6sigma管控
在許多實(shí)際應(yīng)用場景中,會(huì)采用±6sigma作為動(dòng)態(tài)零件平均測(cè)試法(DPAT)的管控標(biāo)準(zhǔn)。以汽車電子行業(yè)為例,依據(jù)AEC - Q001 Rev - D指南,動(dòng)態(tài)零件平均測(cè)試法(DPAT)利用統(tǒng)計(jì)學(xué)原理,通過計(jì)算測(cè)試結(jié)果的平均值(mean)和標(biāo)準(zhǔn)偏差(stddev),再根據(jù)特定的系數(shù)(k)來確定測(cè)試的上限和下限。當(dāng)采用±6sigma時(shí),意味著以均值為中心,向兩側(cè)各延伸6倍標(biāo)準(zhǔn)差的區(qū)間作為正常范圍,超出這個(gè)范圍的芯片就可能被判定為存在潛在故障風(fēng)險(xiǎn),從而被篩選出來。這種方式能夠在一定程度上保證產(chǎn)品的質(zhì)量和可靠性,將可能出現(xiàn)問題的芯片提前剔除。
b. 其他管控標(biāo)準(zhǔn)
DPAT管控標(biāo)準(zhǔn)并非固定為±6sigma,其系數(shù)(k)可以根據(jù)不同的應(yīng)用場景、產(chǎn)品要求以及質(zhì)量目標(biāo)等因素進(jìn)行調(diào)整。不同的k值對(duì)應(yīng)著不同的管控嚴(yán)格程度和范圍:
(a)更嚴(yán)格的管控
當(dāng)對(duì)產(chǎn)品質(zhì)量要求極高,需要最大程度降低潛在故障風(fēng)險(xiǎn)時(shí),可能會(huì)采用比±6sigma更嚴(yán)格的管控標(biāo)準(zhǔn),例如±7sigma、±8sigma等。這意味著允許的測(cè)試結(jié)果波動(dòng)范圍更小,只有那些性能非常穩(wěn)定、接近理想狀態(tài)的芯片才能通過測(cè)試,雖然可能會(huì)增加篩選出的“可疑芯片”數(shù)量,但能進(jìn)一步提高產(chǎn)品的整體質(zhì)量和可靠性,適用于對(duì)安全性、穩(wěn)定性要求極高的關(guān)鍵應(yīng)用領(lǐng)域,如航空航天、高端醫(yī)療設(shè)備等。
(b)相對(duì)寬松的管控
在某些對(duì)成本較為敏感、產(chǎn)品性能要求相對(duì)不是特別苛刻的場景下,可能會(huì)采用比±6sigma更寬松的管控標(biāo)準(zhǔn),如±5sigma等。這樣可以在保證一定產(chǎn)品質(zhì)量的前提下,減少因過度嚴(yán)格篩選而導(dǎo)致的芯片浪費(fèi),降低生產(chǎn)成本,提高生產(chǎn)效率,適用于一些對(duì)成本控制要求較高、對(duì)偶爾出現(xiàn)的輕微性能波動(dòng)有一定容忍度的應(yīng)用場景。
C. 在線零件平均測(cè)試法(iPAT )
在測(cè)試過程中實(shí)時(shí)計(jì)算限制,無需重測(cè)器件,適合最終測(cè)試環(huán)節(jié)。
3、滾動(dòng)窗口與動(dòng)態(tài)更新
在線零件平均測(cè)試法(iPAT )使用滾動(dòng)窗口(通常大小為100)動(dòng)態(tài)更新統(tǒng)計(jì)量。窗口中的數(shù)據(jù)包括通過和部分失敗結(jié)果(在擴(kuò)展限制范圍內(nèi)),以確保分布估計(jì)的完整性。
4、異常檢測(cè)與分類
將測(cè)試結(jié)果與設(shè)定的統(tǒng)計(jì)限制對(duì)比,超出者視為不合格品并剔除。零件平均測(cè)試法(PAT)生成以下附加測(cè)試結(jié)果:
A. PATUL/PATLL:記錄動(dòng)態(tài)上下限;
B. PAT:以Sigma單位衡量器件偏離均值的程度;
C. PATEF:針對(duì)窗口數(shù)據(jù)不足時(shí)的早期失敗檢測(cè)。

四、零件平均測(cè)試(PAT)方法的目的
我們知道,半導(dǎo)體的制造過程非常復(fù)雜,以芯片為例,過程流程圖有成百上千個(gè)步驟,每一個(gè)步驟又可以分解為人、機(jī)、料、法、環(huán)、測(cè)(俗稱5M1E)等各種因素。這些復(fù)雜的因素不可避免地會(huì)導(dǎo)致產(chǎn)品參數(shù)的波動(dòng),于是我們看到的參數(shù)是一個(gè)分布。通常,為了驗(yàn)證制程能力,我們會(huì)去算Cpk,如果Cpk大到一定值,例如1.67,我們會(huì)認(rèn)為制程能力足夠。但Cpk考察的是制程的整體,Cpk滿足要求,并不能保證落在測(cè)試規(guī)格限內(nèi)的產(chǎn)品都沒有風(fēng)險(xiǎn)。
首先,測(cè)試規(guī)格是在研發(fā)階段用軟件模擬出來的,或者依據(jù)少量的工程樣品確定的,某些規(guī)格本身的合理性有待商榷,相信很多SQE都遇到過供應(yīng)商在出現(xiàn)問題后收緊測(cè)試規(guī)格限的做法。
其次,從統(tǒng)計(jì)的觀點(diǎn)來看,脫離分布的少量離散點(diǎn)是小概率事件,如6sigma之外的數(shù)據(jù)出現(xiàn)的概率為0.002ppm(這里我們考察的是任一參數(shù)的實(shí)際分布,沒有必要考慮1.5sigma偏移),我們完全有足夠大的信心(95%以上)認(rèn)為:一個(gè)發(fā)生概率僅0.002ppm的事件發(fā)生了,一定是制程出現(xiàn)了異常。這些異常制程做出來的產(chǎn)品,哪怕依然在測(cè)試規(guī)格限之內(nèi),但是由于有異常原因不確定性,我們何不把它當(dāng)作異常品來處理呢?這也是SPC的原理之一。
所以,零件平均測(cè)試法(PAT)的做法就是根據(jù)參數(shù)的實(shí)際分布,用其均值±6sigma來代替原來寬松的測(cè)試規(guī)格限,達(dá)到過濾掉某些outlier的目的。限于篇幅,詳細(xì)的零件平均測(cè)試法(PAT)執(zhí)行方法這里不再贅述,讀者可以參考AEC-Q001或JESD50C。
綜合歸納,零件平均測(cè)試法(PAT)的作用和意義主要有以下三點(diǎn):
A. 提高產(chǎn)品質(zhì)量和可靠性
通過剔除異常零件,減少了產(chǎn)品在使用過程中出現(xiàn)故障的概率,提高了產(chǎn)品的整體質(zhì)量和可靠性,特別是對(duì)于汽車電子等對(duì)可靠性要求極高的領(lǐng)域。
B. 改進(jìn)制造工藝
通過對(duì)測(cè)試數(shù)據(jù)的分析,可以發(fā)現(xiàn)制造過程中可能存在的問題,為制造工藝的改進(jìn)提供反饋,從而提高生產(chǎn)效率和產(chǎn)品質(zhì)量。
C. 優(yōu)化測(cè)試流程
在一些測(cè)試方法中,如半導(dǎo)體器件測(cè)試,動(dòng)態(tài)零件平均測(cè)試法(DPAT)不僅能實(shí)現(xiàn)動(dòng)態(tài)零件平均測(cè)試,還能同時(shí)完成持續(xù)可靠性測(cè)試,優(yōu)化了測(cè)試流程,提高了測(cè)試效率,還使得測(cè)試條件更加嚴(yán)格,最終篩選出的半導(dǎo)體器件品質(zhì)更高、可靠性更強(qiáng)。
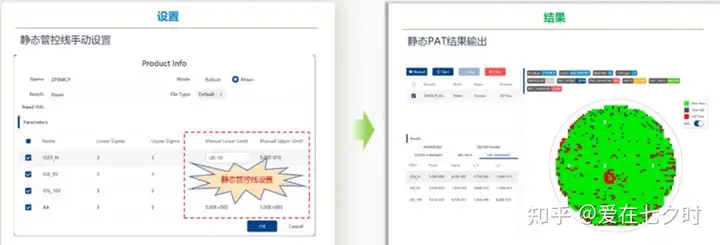
五、零件平均測(cè)試(PAT)方法在晶圓測(cè)試(CP)端的應(yīng)用
零件平均測(cè)試法(PAT)的應(yīng)用就大范圍來講,主要有以下兩個(gè)方面:
1、在供應(yīng)商端的應(yīng)用
從上文的解釋顯而易見,PAT可以用在量產(chǎn)品測(cè)試階段,通過對(duì)測(cè)試規(guī)格的收緊,達(dá)到對(duì)具有潛在風(fēng)險(xiǎn)的產(chǎn)品(part)進(jìn)行篩選的目的。既然是篩選,自然就會(huì)對(duì)良率有所影響,但是,原理上來講,對(duì)良率的影響不應(yīng)該太大(想想前面提到的0.002ppm),如果太大就是方法有問題,需要調(diào)整。我們?cè)?0家半導(dǎo)體分立元器件供應(yīng)商推行PAT的經(jīng)驗(yàn)告訴我們,良率大概損失0.2-0.3%,但是由于電性不良造成的客戶投訴幾乎降到0,這筆質(zhì)量成本的賬大家應(yīng)該都會(huì)算吧?
2、在客戶端的應(yīng)用
在客戶端,尤其是整機(jī)或系統(tǒng)提供商,PAT也能發(fā)揮作用。首先,通過對(duì)元器件供應(yīng)商的PAT要求,可以提高整機(jī)或系統(tǒng)的可靠性;另外,在新產(chǎn)品開發(fā)階段,如果能明確知道某顆元件的某個(gè)參數(shù)對(duì)系統(tǒng)的性能起決定性作用 ,為了避免量產(chǎn)后出現(xiàn)少量比例的搭配性問題,在驗(yàn)證時(shí)就要考慮到產(chǎn)品參數(shù)的實(shí)際分布,而不是只拿幾顆樣品驗(yàn)證。這個(gè)類似于半導(dǎo)體工藝開發(fā)中常見的corner check。
但就半導(dǎo)體行業(yè)來講,由于動(dòng)態(tài)零件平均測(cè)試法(DPAT)是汽車電子委員會(huì)AEC–Q001 Rev-D指南中對(duì)汽車電子產(chǎn)品的要求。具有異常特性(或異常值)的部件會(huì)嚴(yán)重影響質(zhì)量和可靠性問題。查找異常值對(duì)于汽車電子產(chǎn)品的可靠性至關(guān)重要。量產(chǎn)測(cè)試作為最后的卡控,為了保證質(zhì)量,防止離群芯片的逃逸,動(dòng)態(tài)零件平均測(cè)試法(DPAT)作為一個(gè)重要手段被越來越多的半導(dǎo)體設(shè)計(jì)公司應(yīng)用到生產(chǎn)中。
通常來說,大家會(huì)選擇在晶圓測(cè)試(CP)之后做DPAT, 原因也簡單,因?yàn)榫A測(cè)試(CP)之后可以通過離線的方式來產(chǎn)生Inkless map, 利用數(shù)據(jù)系統(tǒng)自動(dòng)Ink功能就可以了。在實(shí)施手段上,有設(shè)計(jì)公司選擇讓工廠來完成,有些設(shè)計(jì)公司因?yàn)橛懈鼜?fù)雜的算法就會(huì)自己來用系統(tǒng)完成。在晶圓測(cè)試(CP)階段的常見的Ink算法包括重要參數(shù)的零件平均測(cè)試法(PAT) (DPAT或ZPAT),也有wafer上地理位置上一些篩選算法(GDBN等)。孤波的OneData系統(tǒng)將這些算法都標(biāo)準(zhǔn)化在系統(tǒng)中了。同時(shí)我們也看到越來越多基于大數(shù)據(jù)挖掘得到的更加復(fù)雜的算法被設(shè)計(jì)公司使用。Gubo OneData系統(tǒng)因?yàn)镻B級(jí)大數(shù)據(jù)系統(tǒng)、以及可以靈活定制算法,被不少頭部設(shè)計(jì)公司采用來實(shí)現(xiàn)數(shù)據(jù)挖掘+自動(dòng)Ink。這些算法最后都成為設(shè)計(jì)公司積累的核心資產(chǎn)。在一些公開的海外文獻(xiàn)資料,探討了一些復(fù)雜的Limit計(jì)算方法,大家可以參考。
具體操作方法是通過提供的Shot Mapping Ink方案,將整個(gè)Mapping技Reticdle大小或是自定義大小的方格,根據(jù)設(shè)定的算法將整個(gè)Shot進(jìn)行l(wèi)Ink,從而去除掉因光刻環(huán)節(jié)的Reticles起的潛在性失效芯片。通過ShotMapping Ink方案,就能夠?qū)①|(zhì)量管控的關(guān)口從 "篩查單個(gè)失效芯片"前移至"攔截整個(gè)失效風(fēng)險(xiǎn)區(qū)域"。
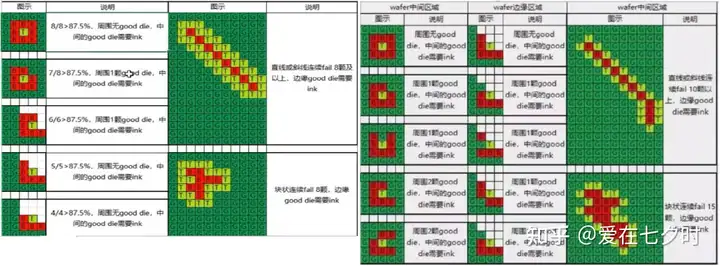
這尤其適用于對(duì)可靠性要求較嚴(yán)苛的車規(guī)、工規(guī)等產(chǎn)品,它能較大程度地降低因光刻制程偶發(fā)問題導(dǎo)致的批次性可靠性風(fēng)險(xiǎn),為晶圓測(cè)試(CP)構(gòu)建起一道應(yīng)對(duì)系統(tǒng)性缺陷的堅(jiān)固防線,最后通過動(dòng)態(tài)零件平均測(cè)試法(DPAT)的功能,結(jié)合測(cè)試數(shù)據(jù)去除超出規(guī)范的芯片并生成新的MaPping。

當(dāng)晶圓測(cè)試(CP)良率驟降而HT失敗模式復(fù)雜時(shí),只靠單一測(cè)試階段數(shù)據(jù)難以歸因。YMS系統(tǒng)將WAT、CP與印T參數(shù)統(tǒng)一納入分析框架,建立跨階段關(guān)聯(lián)模型。例如,若某批次WAT中犧氧擊穿電壓偏移,同時(shí)晶圓測(cè)試(CP)漏電流異常升高,YMS可自動(dòng)關(guān)聯(lián)兩者趨勢(shì),提示前道氧化工藝可能存在波動(dòng)。圖形化界面支持并排查看參數(shù)曲線與良率變化,快速鎖定關(guān)鍵影響因子,避免在封裝或測(cè)試環(huán)節(jié)言日排查。這種端到端的根因分析能力,將問題診斷周期從數(shù)天縮短至數(shù)小時(shí),減少試產(chǎn)浪費(fèi)。通過深度整合多源測(cè)試數(shù)據(jù),使YMS成為良率攻關(guān)的關(guān)鍵工具。最后結(jié)合GDBC服務(wù)Cluster方法有效定位區(qū)域性異常Die,通過相鄰關(guān)聯(lián)性分析識(shí)別連續(xù)性失效。

如果選擇最終測(cè)試(FT)來做零件平均測(cè)試法(PAT)的話, 主要還是攔截封裝過程中帶來的問題,通常是多Die 封裝或者其他的先進(jìn)封裝形式。最終測(cè)試(FT)做動(dòng)態(tài)零件平均測(cè)試法(DPAT)的實(shí)施上會(huì)有一些復(fù)雜性:
最終測(cè)試(FT)的分bin是實(shí)時(shí)的,單顆芯片測(cè)試后需要立即做出Binning的決定,所以動(dòng)態(tài)零件平均測(cè)試法(DPAT)也要做成和ATE聯(lián)動(dòng),在執(zhí)行過程中根據(jù)實(shí)時(shí)的結(jié)果完成Binning
在確定Limit的時(shí)候,因?yàn)橐话阆纫≈辽?00顆來設(shè)初始的limit, 這些用于初始的Limit計(jì)算的芯片的Binning問題需要專門處理
但是實(shí)際上這些問題都已經(jīng)得到了很好的解決。大芯片和小芯片會(huì)用不同的路徑來實(shí)現(xiàn)。
對(duì)于大芯片,因?yàn)橥ǔ?huì)有ECID,又會(huì)做SLT,DPAT的工作也可以通過SLT這個(gè)insertion來實(shí)現(xiàn)。這時(shí)候大數(shù)據(jù)系統(tǒng)的能力又發(fā)揮作用了,根據(jù)芯片的ECID, 可以發(fā)現(xiàn)離群的芯片,完成Binning。

對(duì)于小一些的芯片,因?yàn)橐话悴蛔鯯LT,所以還需要在FT這個(gè)步驟完成。行業(yè)內(nèi)大家也都研究并且實(shí)踐不同的算法改善動(dòng)態(tài)零件平均測(cè)試法(DPAT)的算法,以達(dá)到不用重新測(cè)試前200顆的目的。在孤波的軟件中也有類似算法支持,客戶一般也會(huì)按照自己的需求做各種優(yōu)化,非常方便。
另一個(gè)問題就是如何和ATE互動(dòng)設(shè)置新的Limit。這個(gè)問題的解決方式也有兩種,一種是直接寫程序的時(shí)候在程序里支持,這樣不需要ATE公司的特殊支持也能完成,不方便的就是如果算法調(diào)優(yōu)修改,都要做程序的變更。如果公司的變更流程復(fù)雜,或者芯片種類很多,那么這個(gè)過程還是很費(fèi)些功夫的。還有一種方式就是把算法和Limit修改做到外面的一個(gè)軟件里,那么程序和算法之間就解耦了,算法可以更方便地進(jìn)行調(diào)優(yōu),測(cè)試程序不需要做任何變更。后一種方式已經(jīng)逐漸演化成為行業(yè)趨勢(shì)。目前SEMI在推進(jìn)的RITdb(Rich Interactive Test Database)天生就可以支持這一應(yīng)用方式。下圖是RITdb的架構(gòu):
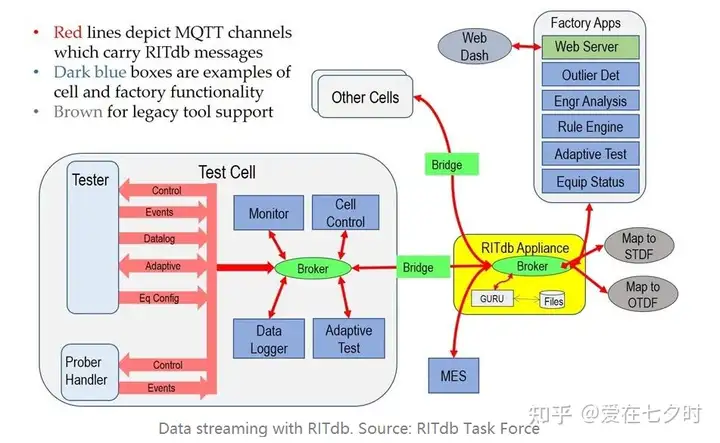
主流的ATE公司推出的Edge computing的方式也和這一應(yīng)用場景類似,Edge computing的計(jì)算能力很強(qiáng),又不占用ATE CPU的時(shí)間。但是在大多數(shù)情況下,尤其對(duì)于規(guī)模小的芯片來說,這一架構(gòu)就顯得太重了。由于DPAT的實(shí)時(shí)性需求并沒有達(dá)到需要在一個(gè)insertion內(nèi)完成的程度,因此許多情況下可以直接使用ATE的CPU來執(zhí)行這一應(yīng)用。孤波科技采用這一領(lǐng)先的軟件架構(gòu),實(shí)施起來非常方便,沒有增加任何的硬件和軟件開銷,就可以直接實(shí)現(xiàn)FT的動(dòng)態(tài)零件平均測(cè)試法(DPAT)。目前這一方案已經(jīng)在Chroma系列機(jī)臺(tái)上實(shí)施,因此,無論是CP還是FT或者SLT都可以完成動(dòng)態(tài)零件平均測(cè)試法(DPAT), 實(shí)現(xiàn)的技術(shù)手段已經(jīng)不是問題了。
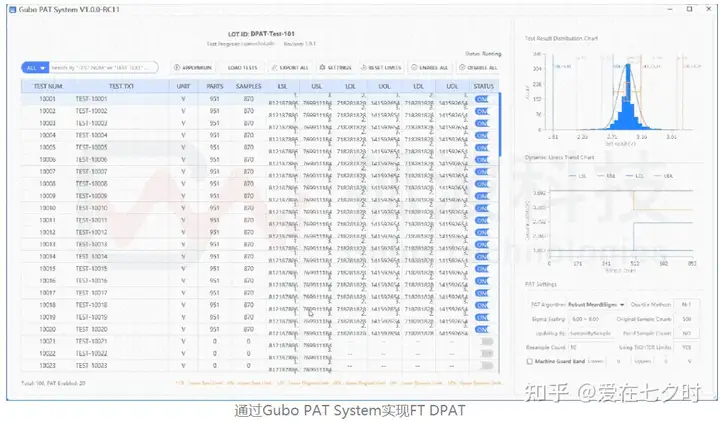
零件平均測(cè)試(PAT)系統(tǒng)的核心亮點(diǎn)在于,支持并行Lot/Run數(shù)據(jù)同時(shí)進(jìn)行校驗(yàn)與卡控;結(jié)合業(yè)務(wù)Know-How設(shè)計(jì)了常見的零件平均測(cè)試法(PAT)卡控規(guī)則,包括DPAT、GDBN、ZPAT等,支持通過配置的方式進(jìn)行設(shè)定,滿足不同的管控需求;支持生成Inkless Map文件。

同時(shí),零件平均測(cè)試(PAT)系統(tǒng)還支持與MES系統(tǒng)、CIM系統(tǒng)做集成:MES 系統(tǒng)發(fā)起零件平均測(cè)試(PAT)要求,零件平均測(cè)試(PAT)系統(tǒng)根據(jù)設(shè)定項(xiàng)計(jì)算,然后輸出結(jié)果并同步給CIM系統(tǒng)。

當(dāng)前,市面上已知的零件平均測(cè)試(PAT)系統(tǒng)可設(shè)定類型包括:
A. SPAT(Static Part Average Testing):通過設(shè)定靜態(tài)的測(cè)試項(xiàng)上下限范圍,找出有風(fēng)險(xiǎn)的芯片。
B. DPAT(Dynamic Part Average Testing):通過設(shè)定動(dòng)態(tài)的測(cè)試項(xiàng)上下限范圍,找出有風(fēng)險(xiǎn)的芯片。
C. GDBN(Good Die in Bad Neighborhood):通過良品坐標(biāo)周圍的不良品數(shù)量,找出有風(fēng)險(xiǎn)的芯片。
D. ZPAT(Z-axis Part Average Testing):通過同一坐標(biāo)縱向良率大小,找出有風(fēng)險(xiǎn)的芯片。
E. Cluster:通過查看不良品坐標(biāo)聚集情況,找出有風(fēng)險(xiǎn)的芯片。
F. NNR (Nearest Neighbor Residual):通過最鄰近殘差算法,找出有風(fēng)險(xiǎn)的芯片。

六、零件平均測(cè)試(PAT)方法必要性
1、可靠性背景與早期失效問題
半導(dǎo)體器件的生命周期可用“浴盆曲線”描述,其早期失效階段主要由制造過程中的缺陷引起。這些缺陷可能導(dǎo)致器件在客戶使用初期發(fā)生故障,帶來安全風(fēng)險(xiǎn)和高額保修成本。

2、傳統(tǒng)測(cè)試方法的局限性
傳統(tǒng)測(cè)試方法(如功能測(cè)試和規(guī)格限測(cè)試)無法有效識(shí)別那些在靜態(tài)測(cè)試中通過但存在潛在缺陷的器件。例如,某些器件可能在電流或電阻測(cè)試中處于分布尾部,雖未超出現(xiàn)有測(cè)試限,卻存在早期失效風(fēng)險(xiǎn)。
3、零件平均測(cè)試法(PAT)的統(tǒng)計(jì)優(yōu)勢(shì)
零件平均測(cè)試法(PAT)通過動(dòng)態(tài)計(jì)算每個(gè)測(cè)試參數(shù)的均值和標(biāo)準(zhǔn)差,并基于統(tǒng)計(jì)分布設(shè)置 tighter 的限制,從而識(shí)別出偏離群體行為的異常器件。這種方法彌補(bǔ)了傳統(tǒng)測(cè)試的不足,特別是在高可靠性要求的汽車電子領(lǐng)域(AEC-Q001標(biāo)準(zhǔn)推薦使用零件平均測(cè)試(PAT))。

七、零件平均測(cè)試(PAT)方法的效應(yīng)與效益
1、提高可靠性與降低風(fēng)險(xiǎn)
通過剔除異常器件,零件平均測(cè)試法(PAT)顯著減少了早期失效風(fēng)險(xiǎn)。例如,在案例研究中(Zernig et al., 2014),結(jié)合ICA與NNR的方法成功識(shí)別出8個(gè)異常器件,其中7個(gè)在后續(xù)Burn-In測(cè)試中失敗。

2、成本節(jié)約與效率提升
零件平均測(cè)試法(PAT)減少了對(duì)Burn-In測(cè)試的依賴,從而降低了測(cè)試時(shí)間和成本。以Infineon Technologies的實(shí)踐為例,通過零件平均測(cè)試法(PAT)篩選,Burn-In測(cè)試量減少的同時(shí)保持了高可靠性標(biāo)準(zhǔn)。

3、支持多變量與空間分析
進(jìn)階零件平均測(cè)試法(PAT)方法(如多變量零件平均測(cè)試法(PAT)和GDBN)考慮了參數(shù)間的相關(guān)性及空間分布(如晶圓上的簇狀缺陷),進(jìn)一步提高了檢測(cè)精度。

八、零件平均測(cè)試(PAT)方法行業(yè)標(biāo)準(zhǔn)與最佳實(shí)踐
1、AEC-Q001指南
汽車電子委員會(huì)(AEC)發(fā)布的AEC-Q001明確推薦使用零件平均測(cè)試法(PAT)進(jìn)行異常器件篩查。該指南強(qiáng)調(diào)了統(tǒng)計(jì)穩(wěn)健性和動(dòng)態(tài)計(jì)算的重要性。
2、實(shí)施建議
A. 測(cè)試選擇:優(yōu)先選擇分布接近高斯、Cpk值高的參數(shù);
B. 窗口大小:根據(jù)批次大小和穩(wěn)定性調(diào)整(通常為100);
C. 早期處理:使用“從零開始”或“從規(guī)格限開始”模式處理早期數(shù)據(jù)不足問題;
D. 持續(xù)監(jiān)控:結(jié)合實(shí)時(shí)數(shù)據(jù)監(jiān)控和反饋優(yōu)化零件平均測(cè)試法(PAT)參數(shù)。
3、案例研究:ICA與NNR的結(jié)合
在Sub-micron工藝中,傳統(tǒng)零件平均測(cè)試法(PAT)效果下降。獨(dú)立成分分析(ICA)能夠從高維數(shù)據(jù)中提取潛在特征,再通過最近鄰殘差(NNR)分析空間依賴性,顯著提高異常檢測(cè)率(見Section 6.3-6.4)。

九、零件平均測(cè)試(PAT)方法的總結(jié)與展望
當(dāng)前,用戶對(duì)這些規(guī)范的要求促使供應(yīng)商之間的競爭更加激烈。在改進(jìn)可靠性并降低缺陷率方面面臨很大的壓力,尤其對(duì)于目前由半導(dǎo)體控制的許多相當(dāng)重要的安全功能,諸如剎車、牽引控制、動(dòng)力及主動(dòng)穩(wěn)定控制系統(tǒng)。供應(yīng)商既要改進(jìn)已付運(yùn)零件的質(zhì)量,又要讓這些規(guī)范對(duì)其成品率的影響。由于制造成本持續(xù)走低,測(cè)試成本卻維持在相對(duì)不變的水平,因此測(cè)試成本在制造成本中的比重日益增大,元器件的利潤空間持續(xù)縮水。由于絕大部分的成品率都不能夠滿足要求,所以供應(yīng)商必須徹底評(píng)估他們的測(cè)試程序以便找到替代測(cè)試方法,并且從備選方法中反復(fù)試驗(yàn)直至找到方法。
不借助的分析和仿真工具,供應(yīng)商就會(huì)在沒有充分了解這些規(guī)范對(duì)供應(yīng)鏈影響的情況下應(yīng)用它們。更糟糕的是,如果盲目應(yīng)用并遺漏了重要的測(cè)試,那么結(jié)果即使保證采用零件平均測(cè)試法(PAT)之類的規(guī)范對(duì)器件進(jìn)行了測(cè)試并以相同的DPM率付運(yùn),在這種情況下保證也是毫無疑義的,而且可靠性也會(huì)降低。
一些供應(yīng)商似乎認(rèn)為,在晶圓探測(cè)中進(jìn)行零件平均測(cè)試法(PAT)測(cè)試就足夠了,但研究表明采用這種方法存在許多問題。在晶圓探測(cè)中采用PAT是道質(zhì)量關(guān),但在剩余的下游制造過程中,由于無數(shù)可變因素造成的變數(shù)增加,因此會(huì)在封裝測(cè)試時(shí)導(dǎo)致更多的零件平均測(cè)試法(PAT)異常值。如果供應(yīng)商希望付運(yùn)高質(zhì)量的零件,他們就需在晶圓探測(cè)和終測(cè)試兩個(gè)階段都進(jìn)行零件平均測(cè)試法(PAT)測(cè)試,而且他們的客戶也應(yīng)推動(dòng)該方法的應(yīng)用。
所以,零件平均測(cè)試(PAT)方法作為一種基于統(tǒng)計(jì)的先進(jìn)篩選方法,在提高半導(dǎo)體器件可靠性方面發(fā)揮了關(guān)鍵作用。其動(dòng)態(tài)計(jì)算、滾動(dòng)窗口和多變量擴(kuò)展使其適用于多種測(cè)試場景。未來,隨著機(jī)器學(xué)習(xí)與統(tǒng)計(jì)方法的進(jìn)一步融合,零件平均測(cè)試法(PAT)將更加精準(zhǔn)和自適應(yīng),為高可靠性應(yīng)用提供更強(qiáng)保障。
參考文獻(xiàn)
1. T. Honda, T. Haarhuis, J. D. David, H. Hannink, G. Prewitt and V. Rajan, "ML-assisted IC Test Binning with Real-Time Prediction at the Edge," 2023 7th IEEE Electron Devices Technology & Manufacturing Conference (EDTM), Seoul, Korea, Republic of, 2023, pp. 1-4, doi:10.1109/EDTM55494.2023.10102972. keywords: {Semiconductor device modeling;Process monitoring;Statisticalanalysis;Machinelearning;Semiconductordevicemanufacture;Predictivemodels;Realtimesystems;ICTest;Tester;DynamicTestController;MachineLearning;Edge;Inference Engine},
2. K. K. S. Lim, M. E. B. Francisco and G. L. R. F. Abug, "Moving Limits: A More Effective Approach in Outlier Screening at Final Test," 2022 IEEE 24th Electronics Packaging Technology Conference (EPTC), Singapore, Singapore, 2022, pp. 806-810, doi: 10.1109/EPTC56328.2022.10013211. keywords: {Production facilities;Manufacturing;Reliability;Testing;Electronics packaging}
3. https://semiengineering.com/part-average-tests-for-auto-ics-not-good-enough/
4. https://www.semi.org/en/blogs/technology-trends/ritdb-the-interplanetary-database-for-manufacturing
5. http://aecouncil.com/Documents
6. AEC-Q001 Guidelines, Automotive Electronics Council.
7. Zernig, A., et al. (2014). Device Level Maverick Screening - Application of Independent Component Analysis in Semiconductor Industry. ICPRAM.
8. ROOS INSTRUMENTS. (2017). PAT Implementation & Operation Product Specifications.
9. Turakhia, R. P., et al. (2005). Defect Screening Using Independent Component Analysis on IDDQ. IEEE VLSI Test Symposium.
10. https://mp.weixin.qq.com/s/cBSLkh63sEprzXjBIhMFrQ

免責(zé)聲明
【我們尊重原創(chuàng),也注重分享。文中的文字、圖片版權(quán)歸原作者所有,轉(zhuǎn)載目的在于分享更多信息,不代表本號(hào)立場,如有侵犯您的權(quán)益請(qǐng)及時(shí)私信聯(lián)系,我們將第一時(shí)間跟蹤核實(shí)并作處理,謝謝!】
審核編輯 黃宇
-
半導(dǎo)體
+關(guān)注
關(guān)注
339文章
30725瀏覽量
264040 -
PAT
+關(guān)注
關(guān)注
0文章
13瀏覽量
9794
發(fā)布評(píng)論請(qǐng)先 登錄
車輛零部件測(cè)試:為汽車“骨骼與神經(jīng)”注入可靠基因的精密工程

通訊零部件CNC加工:您的零部件加工真的確定夠“快”嗎
PCBA加工零件封裝技術(shù)解析:從傳統(tǒng)到前沿的全面指南
半導(dǎo)體行業(yè)零部件表面痕量金屬檢測(cè)技術(shù)的核心優(yōu)勢(shì)
特瑞仕榮獲2025年超制造零件大賞電氣電子零件獎(jiǎng)
高精度通訊零件加工 CNC技術(shù)解決方案詳解
關(guān)于零部件清洗機(jī)工藝流程的詳細(xì)介紹

一文讀懂:汽車發(fā)動(dòng)機(jī)零件氣密性檢測(cè)儀怎么選-岳信儀器

微電機(jī)關(guān)鍵零部件制造誤差對(duì)其質(zhì)量的影響權(quán)重分析
如何給汽車零部件進(jìn)行疲勞耐久測(cè)試?

汽車零部件可靠性測(cè)試項(xiàng)目

只需在COLLABORATION 3Dfindit中篩選過濾所需的零部件即可
如何在COLLABORATION 3Dfindit中定義首選零件并管理零件編號(hào)
如何利用超聲波真空清洗機(jī)清洗復(fù)雜形狀的零件?
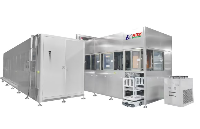



 半導(dǎo)體“零件(部件)平均測(cè)試(PAT)”方法的詳解
半導(dǎo)體“零件(部件)平均測(cè)試(PAT)”方法的詳解




評(píng)論