在我們?nèi)粘J褂玫?a target="_blank">智能手機(jī)、智能手表、無(wú)線耳機(jī)和健康穿戴設(shè)備中,藏著一顆顆微小的芯片,負(fù)責(zé)感知我們的動(dòng)作、姿態(tài)與周?chē)h(huán)境。
從橫豎屏切換、跌落檢測(cè),到計(jì)步與運(yùn)動(dòng)姿態(tài)識(shí)別,這些芯片在默默發(fā)揮著關(guān)鍵作用。
而在出廠前,這些芯片都要經(jīng)歷一套“穿衣打扮”的過(guò)程——也就是封裝(Packaging)。只有經(jīng)過(guò)封裝,它們才能以堅(jiān)固小巧的形態(tài),穩(wěn)定地服務(wù)于各種智能設(shè)備。
今天,就讓我們通過(guò) Bosch Sensortec 的明星產(chǎn)品——BMA530 & BMA580 全球最小三軸加速度計(jì),一起揭開(kāi)芯片封裝背后的技術(shù)秘密,重點(diǎn)了解其中的先進(jìn)工藝:
WLCSP(Wafer-Level Chip Scale Package,晶圓級(jí)芯片尺寸封裝)。
本文為【MEMS 芯知課堂】系列首期內(nèi)容,我們將持續(xù)帶你探索MEMS傳感器的結(jié)構(gòu)與封裝奧秘,敬請(qǐng)期待更多芯片微世界的精彩分享。
01芯片“穿衣”的兩種方式
LGA與WLCSP封裝工藝對(duì)比
1.1 LGA封裝:量身定制的多層“外衣”
傳統(tǒng)的LGA(Land Grid Array,柵格陣列)封裝,就像為芯片量身定制的一件多層外套。
芯片在晶圓制造完成后,需要經(jīng)過(guò)切割、搬運(yùn)等步驟,再依次完成基板貼裝、引線鍵合(Wire Bonding)和塑料封裝(Molding),最終形成標(biāo)準(zhǔn)尺寸的封裝芯片。
這種工藝成熟、可靠,適用于多種應(yīng)用場(chǎng)景,但封裝層數(shù)較多,尺寸相對(duì)更大,材料與制造成本也較高。
示例:Bosch Sensortec 的BMA456 三軸加速度計(jì)尺寸約為2.0×2.0×0.95 mm3,底部排列有12個(gè)金屬觸點(diǎn),用于信號(hào)傳輸和電源連接。

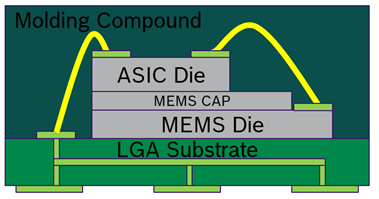
(示意圖源自Bosch Sensortec工程師團(tuán)隊(duì))
BMA456 采用傳統(tǒng) LGA 封裝,體積相對(duì)較大,底部帶有金屬觸點(diǎn)陣列。
1.2 WLCSP封裝:在晶圓階段完成的極簡(jiǎn)“制服”
WLCSP(晶圓級(jí)芯片尺寸封裝)則是一種“極簡(jiǎn)主義”風(fēng)格。這種技術(shù)在晶圓制造階段就完成封裝,無(wú)需再進(jìn)行基板安裝、金線鍵合或外殼塑封。
當(dāng)晶圓上的封裝工藝全部完成后,再統(tǒng)一切割成獨(dú)立芯片。
示例:Bosch Sensortec 的BMA530 & BMA580 加速度計(jì)采用的正是這一封裝方式,尺寸僅1.2×0.8×0.55 mm3,實(shí)現(xiàn)了極致小型化。

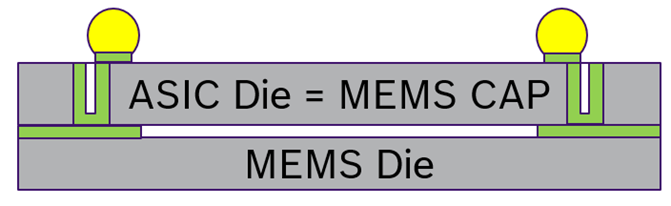
(示意圖源自Bosch Sensortec工程師團(tuán)隊(duì))
BMA530 & BMA580 采用 WLCSP 封裝,體積極小,適用于空間受限的終端設(shè)備。
1.3 LGA 與 WLCSP 封裝流程對(duì)比

(點(diǎn)擊圖片可放大查看)
1.4LGA與WLCSP封裝各自?xún)?yōu)勢(shì)對(duì)比

(點(diǎn)擊圖片可放大查看)
02BMA530 & BMAA580
芝麻粒大小的黑科技
把一粒白芝麻切成2等份,它們的占板面積僅為 0.96 mm2,比紙上的一個(gè)印刷逗號(hào)還小。——這就是 BMA530 & BMA580 在電路板上的真實(shí)存在感。
BMA530 & BMA580 采用 Bosch Sensortec 自主開(kāi)發(fā)的 WLCSP 封裝技術(shù),實(shí)現(xiàn)了極致小型化,為可穿戴設(shè)備、無(wú)線耳機(jī)等產(chǎn)品提供了更大的設(shè)計(jì)自由度。
BMA530 & BMA580 擁有以下核心技術(shù)亮點(diǎn)。
晶圓級(jí)貼裝(Wafer-Level Assembly):
MEMS 與 ASIC 芯片在晶圓階段直接精密貼合,無(wú)需分步劃片與裝配,厚度接近裸芯片極限。
TSV(Through Silicon Via,硅通孔)技術(shù):
相當(dāng)于在芯片內(nèi)開(kāi)“電梯井”,打通上下層,實(shí)現(xiàn)內(nèi)部信號(hào)直接互連,減少金線、銅線與封裝材料,提升信號(hào)速度并降低延遲。
高良率與高效率:簡(jiǎn)化封裝與搬運(yùn)流程,提高產(chǎn)能與良品率,同時(shí)降低制造成本。
優(yōu)異散熱性能:無(wú)封裝殼體設(shè)計(jì),使芯片工作熱量更快散出,提升系統(tǒng)穩(wěn)定性。
03WLCSP技術(shù)為何門(mén)檻高?
盡管 WLCSP 具備明顯優(yōu)勢(shì),但并非所有廠商都能輕易實(shí)現(xiàn)。這項(xiàng)工藝需要高精度設(shè)備與長(zhǎng)期技術(shù)積累。
以 Bosch Sensortec 為例,
BMA530 & BMA580 的成功依托于:
博世自有晶圓廠:實(shí)現(xiàn)晶圓制造與封裝工藝全流程掌控;
MEMS與ASIC 協(xié)同設(shè)計(jì)能力:確保兩者結(jié)構(gòu)、熱應(yīng)力、電氣性能完美匹配;
核心工藝整合能力:掌握TSV、晶圓鍵合等關(guān)鍵技術(shù),確保高良率與規(guī)模化量產(chǎn)。
這些技術(shù)積累,使 Bosch Sensortec 能夠在高性能、高穩(wěn)定性、極小尺寸與成本控制之間取得平衡,真正將“微米級(jí)精密制造”帶入消費(fèi)電子世界。
04科技創(chuàng)新,成就更智能的生活
對(duì)于 Bosch Sensortec 而言,WLCSP 只是眾多創(chuàng)新制造技術(shù)中的一個(gè)縮影。隨著消費(fèi)電子設(shè)備對(duì)性能、尺寸與功耗要求的不斷提升,MEMS 傳感器將持續(xù)向更高集成度、更小封裝、更強(qiáng)感知力方向演進(jìn)。
希望這篇小課堂,能讓你對(duì)那些“看不見(jiàn)的微小傳感器”多一份理解與敬意。歡迎關(guān)注 Bosch Sensortec 公眾號(hào),探索更多 MEMS 黑科技的奧秘!
-
傳感器
+關(guān)注
關(guān)注
2576文章
55028瀏覽量
791246 -
mems
+關(guān)注
關(guān)注
129文章
4475瀏覽量
198785 -
封裝
+關(guān)注
關(guān)注
128文章
9248瀏覽量
148614 -
BOSCH
+關(guān)注
關(guān)注
14文章
65瀏覽量
55421
原文標(biāo)題:芯片也要“穿衣打扮”?揭秘全球最小加速度計(jì)的晶圓級(jí)封裝黑科技
文章出處:【微信號(hào):Bosch Sensortec,微信公眾號(hào):Bosch Sensortec】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
TDK InvenSense IAM - 20381HT:高性能汽車(chē)級(jí)三軸加速度計(jì)的卓越之選
TDK InvenSense ICM - 42370 - P:高性能三軸加速度計(jì)的深度剖析
探索NXP FXLS8964AF 3軸低g加速度計(jì):特性、應(yīng)用與設(shè)計(jì)要點(diǎn)
深入解析FXLS8971CF:3軸低g加速度計(jì)的卓越性能與應(yīng)用
深入解析FXLS8961AF:汽車(chē)應(yīng)用中的3軸低g加速度計(jì)
883M數(shù)字三軸MEMS加速度計(jì)和溫度傳感器技術(shù)解析

加速度計(jì)都有哪些分類(lèi)?

加速度計(jì)伺服電路模塊原理與應(yīng)用
精準(zhǔn)捕捉三維運(yùn)動(dòng):三軸MEMS加速度計(jì)的高精度之道

如何為你的項(xiàng)目選擇合適的加速度計(jì)?

基于STEVAL-MKI226KA加速度計(jì)套件的數(shù)據(jù)手冊(cè)技術(shù)解析與應(yīng)用指南

MEMS加速度計(jì)與石英加速度計(jì)的發(fā)展現(xiàn)狀與水平對(duì)比

洞察萬(wàn)物運(yùn)動(dòng):詳解加速度計(jì)的分類(lèi)與廣泛應(yīng)用

為什么在振動(dòng)分析中加速度計(jì)最常用?

貿(mào)澤開(kāi)售提供精確工業(yè)狀態(tài)監(jiān)測(cè)維護(hù)的 Amphenol Wilcoxon 883M數(shù)字三軸MEMS加速度計(jì)




 博世全球最小三軸加速度計(jì)的封裝工藝對(duì)比
博世全球最小三軸加速度計(jì)的封裝工藝對(duì)比




評(píng)論