“本系列將從電壓需求與隔離、電流需求與分配、功率需求與熱管理三個章節來介紹大功率 PCB 設計。”

大功率 PCB 設計不僅僅是管理電壓和電流,更是管理它們的乘積:功率,而功率最終絕大多數會轉化為熱量。同時,高功率開關電路還會產生強烈的電磁場。本文將探討功率設計中的場效應、熱生成和材料選擇。
1. 高功率場效應
高功率路徑(特別是高di/dt,即電流變化率高的路徑)會產生強大的電磁場。這些場會耦合到附近的敏感電路上,如控制電路、門極驅動(Gate Drive)信號和溫度檢測電路。在理想情況下,高功率路徑應與其返回路徑緊密耦合(例如在相鄰層上反向布線),以使其產生的場相互抵消。
大功率 PCB 設計需要考慮的一些通用問題,包括:
-
大功率路徑附近是否有敏感電路?
-
在您的設計中,大功率路徑是否與其回流路徑緊密耦合?
-
某些系統可能存在機械結構限制,導致無法(使路徑)緊密耦合。
-
電池的端子(或:接線柱)通常相距很遠,且兩者之間幾乎沒有空間允許緊密耦合。在這種情況下,請確保您有策略來保護信號免受大功率能量的干擾。
-
在大功率路徑下方走信號線或電源線,會使它們面臨極大的風險,容易受到來自大功率路徑瞬態能量的干擾。對于柵極驅動信號或溫度測量電路而言,這種情況是不可避免的。在這種情況下,應保持信號(與其回流路徑)緊密耦合,并在層疊設計中使其盡可能遠離大功率(路徑)。
-
信號完整性 (SI) 和電源完整性 (PI) 的設計準則同樣適用于大功率設計
-
隨著功率/能量等級的增加,(不良)設計所導致后果的嚴重程度也會隨之增加。
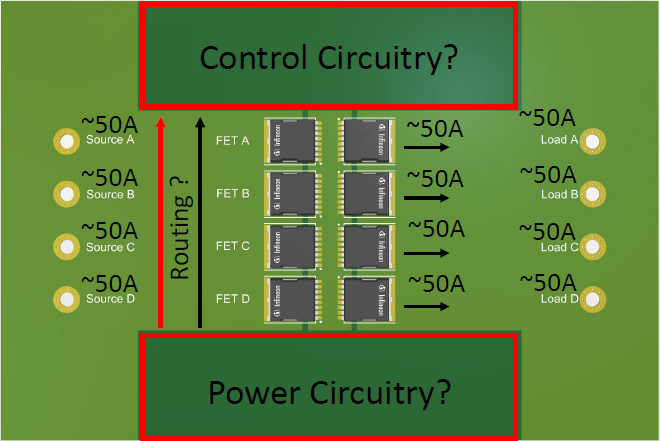
2. 熱量生成與管理
設計中最大的敵人是熱量。您必須準確識別熱源:
您必須了解設計的熱限制:
-
材料玻璃化轉變溫度 (Tg)
-
元件最高溫度:所有元件(包括無源元件)的最高工作溫度。
-
冷卻方式:設計是依賴自然對流(被動冷卻)還是風扇(主動冷卻)?
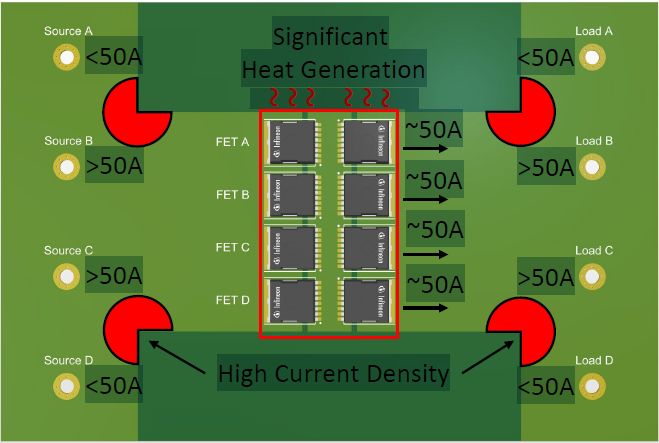
還需要注意的一些事項:
-
局部的發熱區域會給 PCB層疊結構帶來應力。
-
X/Y 軸(平面)的膨脹會受到玻璃纖維布(Glass Weave)的約束。
-
Z 軸(垂直方向)將承受更大的熱膨脹。
-
在熱循環過程中,電鍍通孔(Plated Through Holes, PTH) 會產生疲勞,如果 Z 軸膨脹不受控制,(這些通孔)可能會失效。

3. 熱機械應力與材料 (Tg)
當 PCB 受熱時,它會膨脹。這對可靠性有著致命的影響。
-
Z 軸膨脹 (Z-Axis Expansion):PCB在X-Y平面(水平方向)由于有玻璃纖維布的束縛,膨脹系數(CTE)較低。但在Z軸(垂直方向),CTE要高得多。
-
過孔疲勞:當 Z 軸在熱循環中反復膨脹和收縮時,會對鍍通孔(PTH)的桶壁施加巨大的應力。這會導致桶壁裂紋 (Barrel Cracks)或拐角裂紋 (Corner Cracks),最終導致過孔開路。
解決方案:選擇正確的材料
玻璃化轉變溫度 (Tg)是 PCB 基材從堅硬的玻璃態轉變為柔軟的橡膠態的溫度。
-
設計規則:必須選擇Tg 高于設計最高工作溫度的材料。當 PCB 接近其 Tg 時,它會軟化,Z 軸膨脹會急劇增加,極易導致分層和過孔失效。
材料對比 :
-
不良選擇 (如標準FR-4):
-
Tg: 135°C
-
Z軸CTE (Tg前): 70 ppm/°C
-
總膨脹 (50-260°C):4.2%
-

-
更優選擇 (如高Tg材料):
-
Tg:200°C
-
Z軸CTE (Tg前):38 ppm/°C
-
總膨脹 (50-260°C):2.2%
-

選擇低Z軸膨脹和高Tg的材料,是確保高功率PCB在熱循環下保持長期可靠性的關鍵。
4. 層疊(Stack-up) 的挑戰
在高功率設計中,我們希望使用厚銅(如多層2oz)來承載電流。然而,這給需要控制阻抗的信號(如差分對)帶來了巨大挑戰。
阻抗由走線寬度、介電常數(Dk)和介質厚度(走線到參考平面的距離)決定。
-
問題1:如果使用厚銅(2oz)和薄介質(例如5mil)
-
假設在內層為了實現差分對 75Ω 或 100Ω 阻抗,計算出的走線寬度會非常細。分別為 3.237 mil 及 0.656mil。單端的更是無法實現。
-
這種寬度在 2oz 銅上是無法制造的。
-


-
-
如果需要在外層(頂層或底層)實現 50Ω 阻抗,線寬需要 7.832 mil。這對于那些 pitch 比較下的器件而言又太寬了!
-

-
問題2:如果為了解決可制造性問題(線寬太小),可以加厚介質(例如 8 mil)或者增加差分對的間隙。
-
比如,對于 100Ω 阻抗的差分對而言,將間隙調整為 15mil,走線寬度則可調整為 4.413 mil。但 15mil 的差分對間隙對信號完整性而言并不是一個合理的值
-
增加介質厚度是一個方案。但是,這會顯著增加PCB的總厚度(例如從0.089"增加到0.110")。
-
-
連鎖反應:板厚的增加會惡化鉆孔的縱橫比(Aspect Ratio)。
-
8mil 成孔(最終孔徑),縱橫比 0.110” / 0.008” =13.75
-
10mil 成孔(最終孔徑),縱橫比 0.110” / 0.010” =11
-
12mil 成孔(最終孔徑),縱橫比 0.110” / 0.012” =9.17
-
高縱橫比的孔非常難以電鍍均勻,增加了過孔失效的風險。
-
結論:大功率PCB的疊層設計充滿了權衡。您必須在載流能力(厚銅)、信號完整性(阻抗控制)、可制造性(走線寬度)和可靠性(鉆孔縱橫比)之間找到一個可接受的平衡點。
-
pcb
+關注
關注
4387文章
23711瀏覽量
420049 -
PCB設計
+關注
關注
396文章
4901瀏覽量
93917
發布評論請先 登錄
Tips:大功率電源PCB繪制注意事項
大功率發光二極管的熱管理及其散熱設計
微波射頻設計的熱管理有什么影響?
PCB材料對熱管理有什么影響?
大功率LED照明系統的熱管理設計
大功率LED照明系統的熱管理設計解析
大功率應用的PCB設計的要求及要點
大功率晶閘管模塊的熱管理與散熱解決方案
找到精通大功率PCB設計的工程師真的很難嗎
Tips:大功率電源PCB繪制注意事項

大功率PCB設計思路與技巧






 大功率PCB設計 (三):功率需求與熱管理
大功率PCB設計 (三):功率需求與熱管理



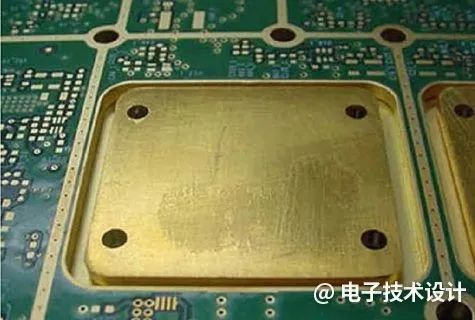










評論