隨著電子器件尺寸持續縮小,熱管理問題日益突出。熱電材料的三項關鍵參數——電導率(σ)、熱導率(κ)和塞貝克系數(α),共同決定了器件的熱電優值(ZT),進而影響其能效與可靠性。四探針技術因其高空間分辨率、無損接觸和快速測量等優勢常應用于電導率測量,Xfilm 埃利四探針方阻儀是電導率測量的重要設備。本文將解析基于諧波電壓分析的微四探針方法,旨在通過單一測量同時獲取σ與α/κ,為全面評估材料熱電性能提供了新手段。
數值模擬與理論驗證
/Xfilm
本研究首先通過多物理場仿真軟件COMSOL Multiphysics構建了熱電耦合數值模型,對測量理論進行了驗證。模擬結果與解析預測高度一致,在電壓幅值與相位上的平均誤差小于1%,為實驗方法的可靠性奠定了堅實基礎。
樣品制備與表征
/Xfilm
實驗樣品包括5組校準樣品(均勻摻雜的p型與n型硅片)和5組測試樣品(Ge、Si:As及多晶BiTe塊體)。校準樣品的κref和αref分別通過瞬態平面源法(TPS)和斜率法測得,其標準誤差控制在2.5%以內,為微四探針測量結果提供了可靠的基準。
微四探針測量流程
/Xfilm

本研究中使用的七電極探針的掃描電子顯微鏡圖像
測量使用四探針設備,配備七電極探針,電極間距為10 μm。采用頻率為12.06 Hz的交流電流,在0.5–5 mA范圍內調節電流強度,并利用鎖相放大器精確記錄各諧波下的電壓與相位。通過多達158種四探針構型的組合測量,系統性地提取基波電阻(R?ω)與二次諧波電壓(V?ω),并采用三步擬合流程依次得到電阻率、接觸半徑及最終的α/κ比值。
理論模型的實驗驗證
/Xfilm

樣品4790 在4.08 mA 電流下測得的微四探針數據

樣品4790 的擬合結果匯總,以電流平方為橫坐標繪制
以樣品4790(p型Si:B)為例,在4.08 mA電流下,其基波與二次諧波測量數據與模型擬合優度(R2)均超過0.95,證明了理論模型的準確性。通過將不同電流下的α/κ比值外推至零電流,有效消除了電阻溫度系數的影響,獲得α/κ比值為5.18 ± 0.03 μm A?1,與宏觀參考值4.93 ± 0.25 μm A?1高度吻合。
塞貝克系數的微區測量結果
/Xfilm
在所有5組校準樣品中,微四探針測得的塞貝克系數(αM4PP)與參考值(αref)的誤差均在不確定度范圍內。對于測試樣品,除Ge:Sb因費米能級釘扎效應無法有效測量外,其余如Si:As(αM4PP = -432 μV K?1 vs αref = -435 μV K?1)與Ge:Ga(αM4PP = 560 μV K?1 vs αref = 540 μV K?1)均表現良好。BiTe樣品因多晶各向異性及電流路徑復雜性,測量值偏離文獻參考約20–30%,這反映了微區測量對局部微觀結構的敏感性。
本實驗成功開發并驗證了一種基于微四探針的諧波電壓分析方法,能夠在微米尺度下同時測量材料的電導率與塞貝克系數/熱導率比值。該方法在多種半導體材料中表現出高精度與重復性,為微納器件熱電性能的原位表征提供了有力工具。
Xfilm埃利四探針方阻儀
/Xfilm
Xfilm埃利四探針方阻儀用于測量薄層電阻(方阻)或電導,可以對樣品進行快速、自動的掃描,獲得樣品不同位置的方阻/電阻率分布信息。

超高測量范圍,測量1mΩ~100MΩ
高精密測量,動態重復性可達0.2%
全自動多點掃描,多種預設方案亦可自定義調節
快速材料表征,可自動執行校正因子計算
基于四探針法的Xfilm埃利四探針方阻儀,憑借智能化與高精度的電阻測量優勢,助力評估電子器件材料的熱電性能,推動多領域的材料檢測技術升級。
#四探針#薄層電導測量#方阻測量#表面電阻測量#電導率測量#熱導率測量
原文參考:《Determination of thermoelectric properties frommicro four-point probe measurements》
*特別聲明:本公眾號所發布的原創及轉載文章,僅用于學術分享和傳遞行業相關信息。未經授權,不得抄襲、篡改、引用、轉載等侵犯本公眾號相關權益的行為。內容僅供參考,如涉及版權問題,敬請聯系,我們將在第一時間核實并處理。
-
電壓
+關注
關注
45文章
5779瀏覽量
122141 -
測量
+關注
關注
10文章
5660瀏覽量
116813 -
電導率
+關注
關注
1文章
308瀏覽量
15617
發布評論請先 登錄
吉時利四探針法測試系統實現材料電阻率的測量

測量薄層電阻的四探針法

基于四點探針和擴展電阻模型的接觸電阻率快速表征方法

基于四探針測量的 BiFeO?疇壁歐姆響應研究

二探針與四探針電阻測量法的區別

四探針方阻:超薄ITO薄膜多方法電學表征與精準測量新范式




 基于微四探針測量的熱電性能表征
基于微四探針測量的熱電性能表征





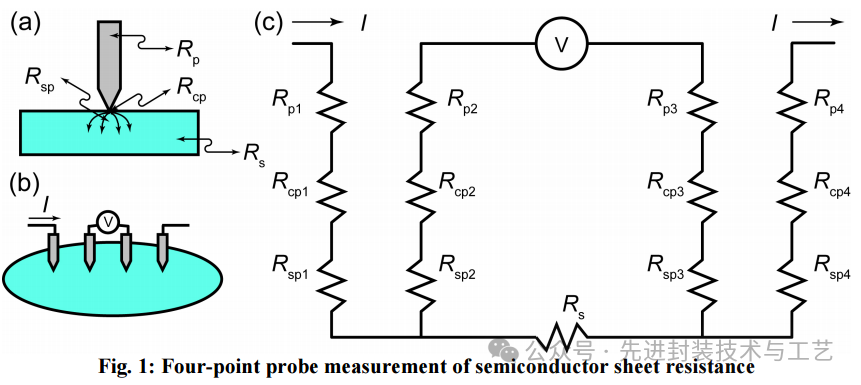



評論