在 5G/6G 通信、電動汽車(EV)功率器件、新能源裝備等戰略領域,化合物半導體(SiC、GaN、GaAs 等)已成為突破硅基材料性能瓶頸的核心載體。然而,其制造流程中 —— 晶體生長與外延階段的隱性缺陷,往往要到最終測試 / 封裝環節才暴露 —— 此時晶圓已附加高價值工藝成本,良率損失已成定局。如何將良率管控 “前置” 到缺陷源頭,成為化合物半導體制造商規模化降本的關鍵卡點。
三大技術痛點,制約化合物半導體良率突破
化合物半導體已在硅基材料無法覆蓋的高性能應用場景中占據核心地位:其高電子遷移率為 5G/6G 射頻芯片、高速電子器件提供了關鍵性能支撐,保障現代通信的高效運行;直接帶隙特性使其具備高效光轉換能力,既是 LED、激光二極管實現高亮度發光的核心,也為紅外傳感器的精準探測提供了技術基礎;此外,高擊穿電壓與優異熱導率的結合,讓它能在電動汽車(EV)功率器件、快速充電器及可再生能源系統的極端工況下穩定工作,突破硅基器件的環境適應性瓶頸。
但這些性能優勢的實現,依賴極高復雜度的制造流程,也帶來了三大關鍵技術痛點:
1. 缺陷追溯難:源頭問題 “遲滯暴露”
晶體生長與外延既是高成本工序,也是缺陷產生的主要源頭 —— 但這些缺陷往往要等到后續測試、封裝環節才會暴露。而此時晶圓已歷經多道工序、附加了大量價值,最終卻可能因這些早期缺陷被報廢,或導致整體良率大幅下降。若沒有集成數據系統支撐,要將這些失效問題追溯到襯底或外延層的源頭缺陷,難度極大。
2. 數據孤島:多系統協同失效
制造數據分散于不同場景:晶體生長設備的溫度 / 壓力數據、外延機的氣體流量數據、電測設備的 IV/CV 曲線、封裝環節的封裝追溯數據……若無法建立能將襯底缺陷、在線工藝數據與最終電性能測試結果串聯起來的集中化數據視圖,工程師開展根本原因分析時,就只能進行耗時的手動排查工作,而非遵循規范的系統化工程流程。
3. 信號干擾:致命缺陷被 “掩蓋”
晶圓缺陷圖中布滿了不影響良率的非關鍵 “干擾性缺陷”,這些缺陷掩蓋了真正重要的 “致命缺陷”。再加上諸如返工和批次拆分導致的襯底 ID 變更等數據質量問題,信噪比會變得過低,難以開展有效分析。
端到端數據集成
Exensio 構建良率預測 “數據底座”
要應對這些挑戰,需構建一個能整合全制造流程數據的平臺—— 覆蓋從晶體生長、外延、晶圓前段工藝(FEOL),到最終封裝與成品測試的全環節。Exensio 大數據智能分析平臺可將在線缺陷數據、計量數據、設備傳感器數據、電學測試結果(WAT/CP)及封裝追溯信息,整合為統一連貫的數據體系。
借助這一統一數據結構,制造商可將失效芯片完整追溯至原材料批次、所用的特定設備與工藝配方,甚至是該芯片生產時的具體工藝參數。對于化合物半導體制造商而言,這種全流程追溯數據,正是預測性機器學習得以落地應用的核心基礎。
目前,該平臺已在全球100 余家半導體企業完成部署應用;其中 10 余家化合物半導體制造商將其用于企業級良率管理,覆蓋 IDMs、Foundries 及 Fabless 企業,解決了實際產線問題。

機器學習核心技術:從襯底缺陷到良率預測
核心創新點在于,將襯底缺陷(即制造流程最起始階段產生的缺陷)與最終電學測試的合格 / 失效結果相關聯。這一關聯可實現三大價值:明確哪些缺陷類型真正影響良率、在工藝早期預測良率,甚至在襯底進入下游工序前對其進行分級。
技術流程圍繞半導體技術人員的實際需求設計,具體步驟如下:
1. 數據采集與映射
采集襯底缺陷數據(或后續工藝步驟的在線缺陷數據)及電性能測試分箱圖(binmap)數據。通過 Python 腳本,將絕對缺陷坐標映射至 binmap 配置所定義的芯片坐標系,從而實現缺陷數量與電性能測試結果的逐芯片直接對比。
2. 智能缺陷篩選
并非所有缺陷的影響都相同,模型會識別并篩選兩類特殊缺陷:一是強致命缺陷,即致命率(kill ratio)>0.9 的缺陷,幾乎必然導致芯片失效,含此類缺陷的芯片會被自動標記為 “不合格”;二是負相關缺陷,即在合格芯片中出現頻率反而高于不合格芯片的缺陷,表明這類缺陷不限制良率。這兩類缺陷均從訓練數據集中移除,確保模型僅聚焦具有預測價值的有效信號。
3. 特征降維
對缺陷特征進行標準化處理后,采用 PCA 算法保留 95% 數據方差。這種降維方式既能捕捉關鍵信息,又可避免模型被冗余或低價值特征過載。
4. 模型訓練
基于篩選后、降維后的特征集,采用 10 折交叉驗證(類別平衡處理,避免對單一結果的偏向)訓練 XGBoost 分類器。模型通過學習缺陷特征,預測芯片級合格 / 失效概率。
5. 預測與評估
訓練完成的模型預測每顆芯片的電學測試合格 / 失效結果。設置覆蓋規則:含強致命缺陷的芯片,無論模型輸出的概率如何,均自動判定為失效。評估結果包括混淆矩陣、分類指標(精確率、召回率、F1 分數),且最關鍵的是預測與實際晶圓良率對比。
注意
如何平衡【漏判】與【誤判】?
可調節的概率閾值是其核心功能,支持用戶根據業務優先級調校模型判定行為:較低閾值:會增加漏判風險(將不良芯片誤判為良品),但可能減少誤判(將良品誤判為不良品);較高閾值則相反。這種靈活性使工程師能根據具體的經濟約束,平衡良率損失與制造成本。
交互式操作:工程師 “即學即用”
分析工具的價值,僅在于工程師能將其切實應用于日常工作中。為此,該平臺配套設計了交互式用戶界面,支持直觀操作,具體包括:
登錄頁
提供概覽信息及側邊導航;
介紹頁
列出輸入要求與數據導入流程;
使用頁
引導用戶完成輸入設置,并說明如何用定制化 Python 腳本替換默認模型;
預測頁
為核心操作區,包含輸入字段,支持選擇分組列、運行缺陷坐標映射、設置合格 / 失效閾值及執行預測;
結果區
展示特殊缺陷類別、分類性能指標、晶圓圖三方對比(實際圖、預測圖及差異圖-差異圖顯示假陰性與假陽性),以及按晶圓和批次劃分的實際與預測良率對照表 / 散點圖;
附錄頁
匯總支持該模板的背景知識。

部分交互式頁面展示
關鍵在于,用戶可在模板內直接打開并修改 Python 腳本,從而根據自身工藝知識與需求調整模型。
實際應用:碳化硅案例研究
該平臺已在碳化硅(一種對電動汽車和高功率應用至關重要的寬帶隙材料)制造中得到驗證。在本案例中,研究團隊將襯底缺陷與電性能測試結果關聯,對缺陷進行篩選和分類,并訓練 XGBoost 模型預測芯片級良率,成效如下:
在附加大量價值前,基于襯底缺陷實現早期良率預測;
區分真正影響良率的致命缺陷與無害的干擾缺陷;
在晶圓進入高成本下游工序前,實現襯底分級;
通過binmap 對比提供可視化依據,輔助工程師決策;
提供模型性能與良率預測準確性的量化指標。
行業價值:化合物半導體規模化的 “良率基石”
隨著化合物半導體進入 “規模化量產” 階段,良率已成為企業競爭的核心壁壘。Exensio 大數據智能分析平臺通過 “數據集成 + 機器學習” 的組合方案,從根本上解決了化合物半導體制造的三大痛點:
缺陷遲滯暴露→早期預測:將良率管控從 “最終測試”前移至 “襯底階段”。
數據孤島→全流程追溯:打通多系統數據,實現根因分析高效化。
干擾缺陷→智能缺陷篩選:精準鎖定關鍵缺陷,避免盲目工藝調整。

未來展望:技術驅動下的良率突破新路徑
隨著 5G/6G 通信、電動汽車到可再生能源等市場對化合物半導體的需求爆發,制造復雜度與規模化需求的矛盾將愈發突出。制造商需要能應對其日益增長的復雜性的工具。制造商通過統一數據、智能篩選與機器學習預測相結合,可實現更早干預、更明智決策,并最終提升良率。
對于半導體技術人員而言,“從源頭預測良率” 已不再是技術構想,Exensio 大數據智能分析平臺已在 10 多家企業的實踐中得到驗證,是可落地、可優化、可復制的解決方案。隨著行業持續擴大規模,預測并預防源頭缺陷導致的良率損失,將不再只是一項優勢,而是企業具備制造競爭力的必備要求。
-
電動汽車
+關注
關注
156文章
12645瀏覽量
237171 -
機器學習
+關注
關注
67文章
8560瀏覽量
137152 -
半導體制造
+關注
關注
8文章
521瀏覽量
26288
發布評論請先 登錄
半導體 AI 轉型利器!Exensio StudioAI:讓良率、效率雙翻倍的企業級 ModelOps 平臺

半導體缺陷檢測升級:機器學習(ML)攻克類別不平衡難題,小數據也能精準判,降本又提效!

【2025九峰山論壇】從材料革命到制造工藝破局,揭秘化合物半導體產業重構密碼

普迪飛:以安全性與可擴展性賦能半導體制造測試,AI 驅動與數據前饋技術破局行業挑戰

核芯聚變·鏈動未來 | 2026中國光谷國際化合物半導體產業博覽會 再次啟航!開啟化合物半導體新紀元

普迪飛Exensio電池制造全流程智能分析平臺,驅動產業效能升級

Exensio 應用篇:數據驅動 OSAT 智能化,破解半導體封測效率與品控雙難題

一文讀懂 | 關于半導體制造數據的那些事兒

EFEM晶圓傳輸系統:半導體制造的關鍵樞紐與科技的賦能
半導體制造良率低?RFID技術如何破解晶圓追溯難題?

化合物半導體器件的定義和制造工藝
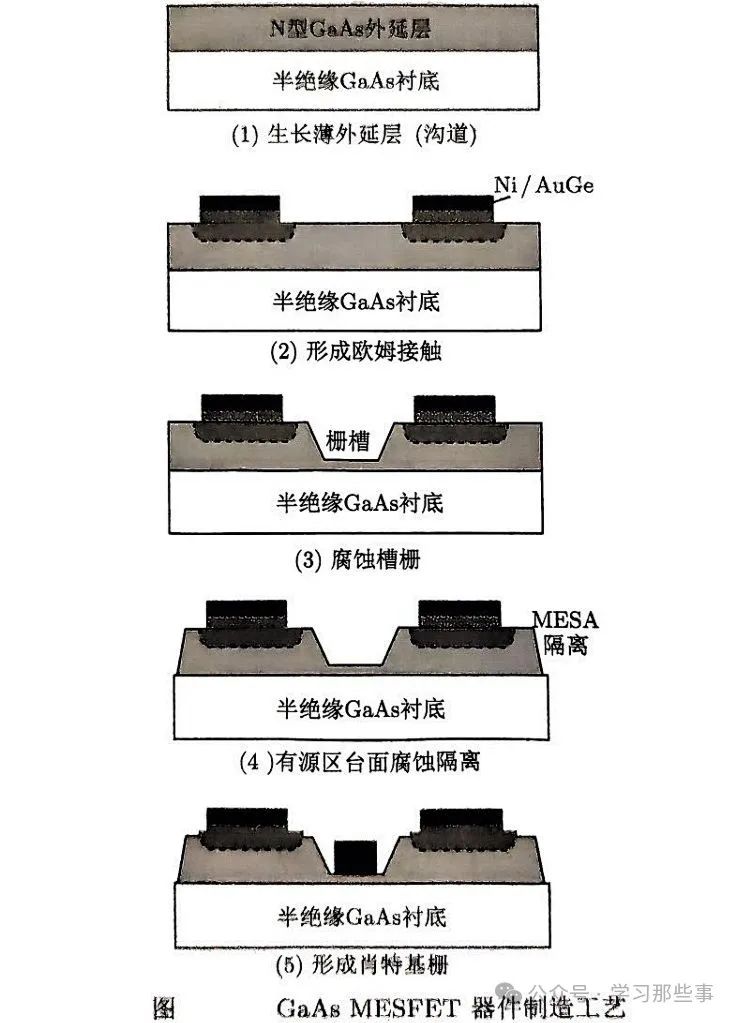



 機器學習(ML)賦能化合物半導體制造:從源頭破局良率難題,Exensio平臺實現全流程精準預測
機器學習(ML)賦能化合物半導體制造:從源頭破局良率難題,Exensio平臺實現全流程精準預測




評論