在集成電路分析領域,芯片開封(Decapsulation,簡稱Decap)是一項至關重要的技術環節。無論是進行失效分析還是反向工程研究,芯片開封都是打開微觀世界大門的第一把鑰匙。這項技術旨在精確移除包裹芯片的外部封裝材料,完整暴露內部的晶粒、邦定線和焊盤,同時確保內部結構不受損傷,為后續分析工作奠定基礎。
芯片開封方式通常有化學(Chemical)開封、機械(Mechanical)開封、激光(Laser)開封。
機械開封適用于陶瓷、金屬等堅硬封裝材料,通過物理手段進行移除;激光開蓋則是一種借助高能量密度激光蝕刻掉芯片外部封裝殼體的開蓋方式。
而化學開封則主要針對占市場主流的環氧樹脂塑料封裝,利用化學試劑的選擇性溶解特性實現精準開封。
在現代集成電路分析中,化學開封因其高精度和可控性成為最主流的開封方法,本文將重點探討這一技術的詳細流程與操作要點。
化學開封的前期準備工作
1. 安全防護
化學開封操作涉及發煙硝酸、發煙硫酸等強腐蝕性試劑,因此安全措施必須放在首位。操作人員必須在專業通風櫥內進行作業,配備完善的個人防護裝備和應急處理設施。金鑒實驗室在進行試驗時,嚴格遵循相關標準操作,確保每一個測試環節都精準無誤地符合標準要求。
2. 樣品評估與預處理在開始開封前,需充分了解待處理芯片的基本信息。
通過X-Ray透視技術預先檢查芯片內部結構,可以初步判斷晶粒位置、邦定線布局以及是否存在空腔等特征,為確定最佳開封位置提供依據。
-
芯片
+關注
關注
463文章
54181瀏覽量
467804 -
集成電路
+關注
關注
5459文章
12617瀏覽量
375213 -
decap
+關注
關注
0文章
5瀏覽量
8668
發布評論請先 登錄
芯片開蓋去除封膠Decap
Decap開蓋大概怎么做?
第三方實驗室芯片開封科普介紹
芯片化學開封了解一下!
芯片在失效分析中的開封方法及注意事項
封裝開封技術介紹
淺談封裝開封技術
芯片開封decap簡介及芯片開封在失效分析中應用案例分析
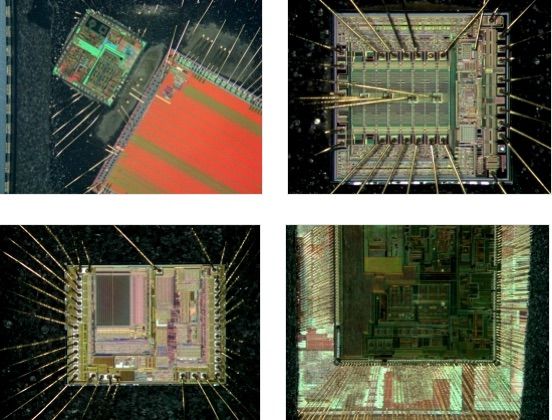



 芯片開封(Decap)的流程
芯片開封(Decap)的流程



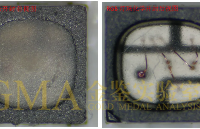



評論