一、輻射環境與威脅來源
輻射環境是導致電子器件性能退化甚至失效的關鍵外部因素,其空間分布與粒子類型具有顯著差異性,對不同應用場景下的芯片可靠性構成差異化威脅。深入解析輻射環境的構成與威脅來源,是開展抗輻照設計與防護的前提。
(一)空間輻射環境
空間輻射主要由銀河宇宙射線(GCR)、太陽高能粒子(SEP)及二者與大氣作用產生的次級粒子構成,覆蓋從低地球軌道到深空的廣闊區域,對航天器電子系統構成持續性、突發性雙重威脅。
銀河宇宙射線作為太陽系外起源的高能帶電粒子流,成分以輕核為主:質子占比約 84%,α 粒子(氦核)占比約 14%,剩余 2% 為碳、氧、鐵等重核(原子序數 Z≥6)。這些粒子經超新星爆發、星際激波等極端天體物理過程加速,能量可達 102? eV 以上,具備穿透航天器艙體的能力。盡管其通量較低(約 1-10 粒子 /(cm2?s)),但高能量特性使其能直接作用于芯片內部,既會引發瞬時單粒子效應,也會通過長期能量沉積導致總劑量累積損傷。例如,鐵重核在硅材料中可形成高密度電離軌跡,極易觸發單粒子閂鎖(SEL)等致命故障。
太陽高能粒子是太陽活動(太陽耀斑、日冕物質拋射)釋放的高能帶電粒子,成分以質子為主(占比 > 90%),其次為 α 粒子與少量重核,能量范圍集中在 1 MeV-10 GeV。其顯著特征是通量的強時間依賴性:太陽活動峰年(每 11 年一個周期)時,粒子通量較谷年可提升 1-3 個數量級,形成短時間強輻射脈沖。這種突發性輻射會對航天器電子器件造成 “沖擊式” 損傷,例如 2003 年太陽風暴期間,多顆衛星因太陽高能粒子引發的單粒子效應出現數據丟失、設備宕機。
當銀河宇宙射線與太陽高能粒子穿透地球大氣層時,會與大氣中的氮、氧原子核發生核反應(彈性散射、核裂變等),產生次級粒子場,包括中子、質子、電子及輕核碎片。其中,次級中子能量覆蓋熱中子(<0.025 eV)至快中子(>1 MeV),雖 LET 值較低,但可通過與硅原子核碰撞產生高 LET 反沖硅核,進而誘發單粒子效應。同時,海拔高度直接影響次級粒子通量:高空(如 10km 海拔)的次級中子通量是地面的 100 倍以上,這也是高空航空器電子系統需強化抗輻照設計的核心原因。

圖1大氣輻射環境示意圖
(二)地面輻射環境
地面輻射環境強度雖低于空間,但特定場景下的輻射仍會對長壽命、高可靠電子系統(如核電站控制單元、高能物理實驗裝置)構成威脅,其主要來源包括核設施泄漏、封裝材料放射性雜質及大氣次級中子。
核設施(核電站反應堆、核廢料處理廠)在運行或退役過程中,會釋放中子、γ 射線、β 射線等輻射。反應堆核心區域中子通量可達 101?中子 /(cm2?s),即便經混凝土屏蔽層衰減,泄漏的快中子仍可能對周邊電子設備產生影響;γ 射線的強穿透性則會導致芯片氧化層電荷累積,引發總劑量效應。例如,核電站安全級控制器若長期處于 γ 射線輻射下,可能因氧化層正電荷積累導致閾值電壓漂移,進而出現控制邏輯延遲。
電子器件封裝材料(陶瓷外殼、粘接劑、焊料)中,可能含微量鈾(U-238)、釷(Th-232)及其衰變子體(鐳 - 226、氡 - 222)。這些雜質通過 α 衰變釋放 α 粒子(能量 4-8 MeV),LET 值可達 10-100 MeV?cm2/mg,可在芯片敏感區域沉積大量電荷。研究表明,若陶瓷封裝中鈾、釷含量超過 10?12 g/g,存儲芯片的單粒子翻轉(SEU)錯誤率會上升一個數量級,對需要長期穩定存儲數據的設備(如核電站數據記錄儀)構成隱患。
大氣次級中子是地面環境誘發單粒子效應的主要因素,其通量約為 10?2-10?中子 /(cm2?s),能量峰值集中在 1-100 MeV。對于深亞微米工藝芯片(如 CMOS 節點 < 45 nm),敏感區域體積縮小(<10?1? cm3)、臨界電荷降低(<10?1? C),即便低通量快中子也可能引發單粒子瞬態(SET)—— 錯誤脈沖若超過電路時序容限,會導致邏輯錯誤。例如,商用微控制器在地面長期運行時,約 30% 的未知邏輯錯誤與大氣中子誘發的 SET 相關。
二、損傷核心物理量
輻射對電子器件的損傷本質是粒子在材料中沉積能量并引發物理化學變化,線性能量轉移(LET)與吸收劑量是定量描述損傷強度的核心物理量,分別對應 “瞬時局部損傷” 與“長期累積損傷”,二者共同決定器件的輻射響應特性。
線性能量轉移(Linear Energy Transfer, LET)定義為帶電粒子在單位路徑長度上向介質轉移的能量,單位為 MeV?cm2/mg,其值直接反映粒子電離損傷的強度:質子LET隨能量上升而下降,低能質子損傷更強。
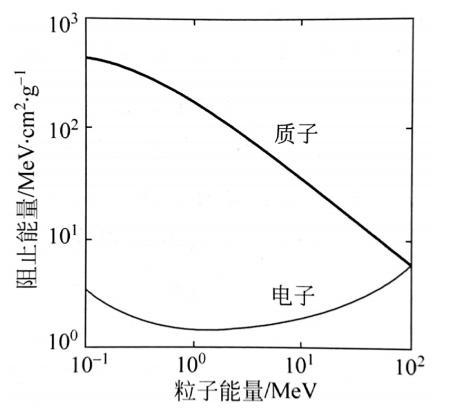
圖2質子和電子 LET 值隨粒子能量變化示
吸收劑量(Absorbed Dose)定義為單位質量介質吸收的輻射能量,單位為拉德(rad)或戈瑞(Gy)(1 Gy=100 rad),是表征總劑量效應的核心參數,直接反映器件累積的能量損傷,其大小與輻射類型、照射時間、介質特性相關。硅材料中1 Mrad ≈ 101?陷阱/cm3
三、總劑量效應:累積性退化
總劑量效應是高能粒子長期照射導致器件材料(核心為 SiO?層)發生累積性物理化學變化,進而引發電性能退化的現象,其本質是氧化層電荷陷阱與界面態的形成,對 MOS 器件、功率器件等的性能與壽命構成嚴重威脅。
損傷過程:高能粒子電離SiO?→產生電子-空穴對→空穴被深能級陷阱俘獲。

圖3電離總劑量損傷的主要過程
退化表現:正電荷積累→閾值電壓負漂、泄漏電流上升。
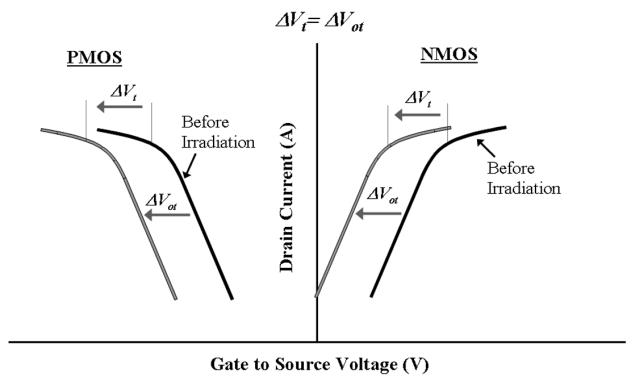
圖4固定氧化物俘獲電荷對晶體管轉移特
四、單粒子效應:瞬時災難
單粒子效應(Single Event Effect, SEE)是高能粒子(重離子、快中子)在器件敏感區域瞬時沉積大量能量,形成高密度電荷團,引發的突發性電路故障。與總劑量效應的累積性不同,SEE 具有瞬時性、隨機性,可能導致邏輯翻轉、電流閂鎖甚至器件燒毀,是高輻射環境電子系統的重大安全隱患。
中子作用機制:大氣中子轟擊硅原子→核反應產生高LET碎片→局部電荷沉積。
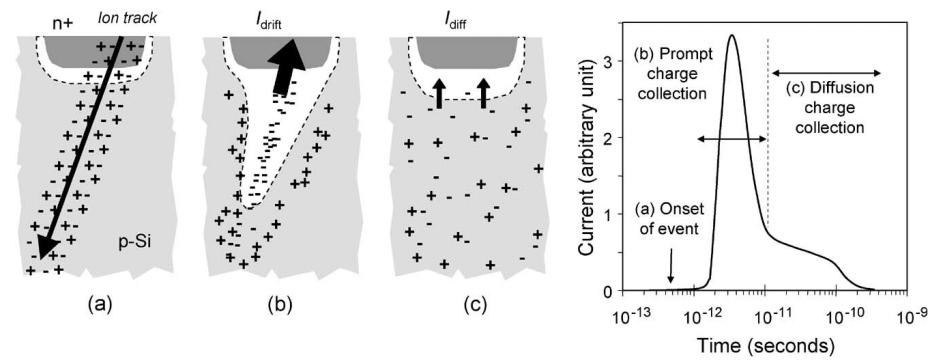
圖5單粒子效應機制示意圖
單粒子閂鎖(SEL):瞬態電流激活CMOS寄生PNPN結構→正反饋大電流→器件燒毀。
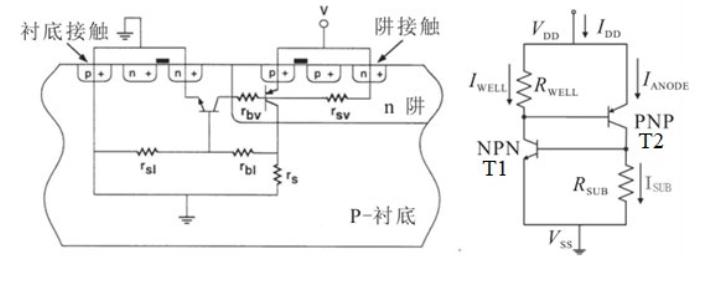
圖6 CMOS 器件可控硅結構
五、解決方案:低成本抗輻照芯片
針對商業航天、核電站等高輻射場景的 “高可靠 + 低成本” 需求,抗輻照加固的芯片可以抵御單粒子和總劑量效應問題,國內芯片公司國科安芯推出一系列抗輻照MCU、DCDC電源、CANFD接口等低成本芯片,解決商業航天、核電站等既有抗輻照高可靠要求又對成本限制苛刻的矛盾,該系列芯片已經通過質子試驗、總劑量試驗、重離子試驗等,部分型號已經上天在軌運行。

圖7 ASM1042總劑量效應試驗報告
試驗結論:ASM1042S 在受到 150Krad(si)的總劑量照射后,其關鍵電參數,包括但不限于閾值電壓、漏電流、電容等,未顯示出超出預期范圍的變化。此外,在試驗過程中,器件的關鍵性能指標保持穩定,無明顯性能退化跡象。

圖8 ASM1042重離子試驗報告
試驗結論:ASM1042S在LET值為 37MeV·cm2mg-1時,未出現單粒子效應。該芯片表現出優異的抗單粒子效應能力,適用于高輻射環境。

圖9 ASM1042在軌應用證明
審核編輯 黃宇
-
芯片
+關注
關注
463文章
54007瀏覽量
465928
發布評論請先 登錄



 單粒子與總劑量輻射損傷機制與芯片抗輻照設計
單粒子與總劑量輻射損傷機制與芯片抗輻照設計






評論