南京屹立芯創半導體科技有限公司
在半導體先進封裝向更高密度、更薄厚度、異質集成演進的浪潮中,Die Attach Film (DAF膠膜) 憑借其優異的工藝精度、超薄特性(可低至<10μm)和簡化流程的優勢,已成為芯片貼裝不可或缺的核心材料。然而,其精密結構也帶來了一個核心痛點——微米級氣泡(Void)問題。尤其在追求極致集成的3D堆疊、超薄芯片(<50μm)、2.5D/3D封裝等前沿領域,任何微小氣泡都可能成為封裝可靠性失效的“導火索”。
面對這一行業共性難題,屹立芯創憑借對先進封裝工藝的深刻理解,聚焦于真空環境下的熱流精準控制與智能氣壓調節核心技術,推出了一系列創新解決方案,直擊氣泡痛點,為高可靠性封裝保駕護航。
一、氣泡:高密度封裝的隱形殺手
DAF膠膜在貼裝過程中,受熱軟化后被壓合于芯片與基板的微米級界面中。界面微觀不平整、殘留氣體或排氣不暢等因素,都極易將氣體“鎖”在膠體內,形成致命空洞。
?機械完整性崩塌:氣泡直接侵蝕有效粘接面積,顯著削弱結合強度,大幅提升界面分層(Delamination)風險。
?熱管理失效:氣泡是熱的絕佳絕緣體。它會阻塞芯片向基板的導熱路徑,形成局部熱點(Hot Spot),加速器件性能衰減。
?長期可靠性隱患:在后續回流焊或溫度循環中,氣泡內氣體受熱膨脹會產生巨大應力,極易誘發芯片微裂紋或界面剝離。
超薄芯片與高密度堆疊更放大了這一風險:
芯片與DAF膜同步減薄,使得氣體逃逸路徑被極度壓縮,除泡難度呈指數級上升。多層芯片堆疊中,下層的一個微小氣泡都可能成為引發整個結構力學失穩的“多米諾骨牌”。
二、破局之道:真空除泡技術的精妙協同
傳統方法難以應對微米級間隙中的氣泡挑戰。屹立芯創通過真空、熱流與壓力的精妙協同,實現了對氣泡的“精準殲滅”。
1. 真空壓力除泡系統:深入“敵后”,動態剿滅氣泡
核心技術:真空-壓力循環“呼吸法”
針對貼裝后已存在的界面氣泡,該系統通過精心設計的多段式真空-壓力循環程序,實現動態、深度除泡。
在高真空環境下,強力抽吸并擴大溶解及游離的微米氣泡,使其脫離界面束縛。
隨后施加均勻的靜高壓,促進膠體二次流動與滲透,強力擠壓并溶解微小氣泡,同時確保界面緊密接觸。
通過多次循環,徹底清除包括邊緣氣阱(Air Trap)在內的各類氣泡,實現完美界面填充。
應用場景:
貼膜除泡:攻克貼合界面氣泡難題,為芯片堆疊/micro LED/OCA提供無缺陷貼合保障。
底填除泡:守護微米互連可靠性,確保倒裝芯片封裝長期穩定運行。
灌封除泡:實現模塊級結構保護,提升車規與功率器件在惡劣環境下的耐久性。
銦TIM除泡:突破散熱界面導熱瓶頸,為CPU/GPU/AI芯片釋放極致性能潛能。
 真空壓力除泡系統
真空壓力除泡系統 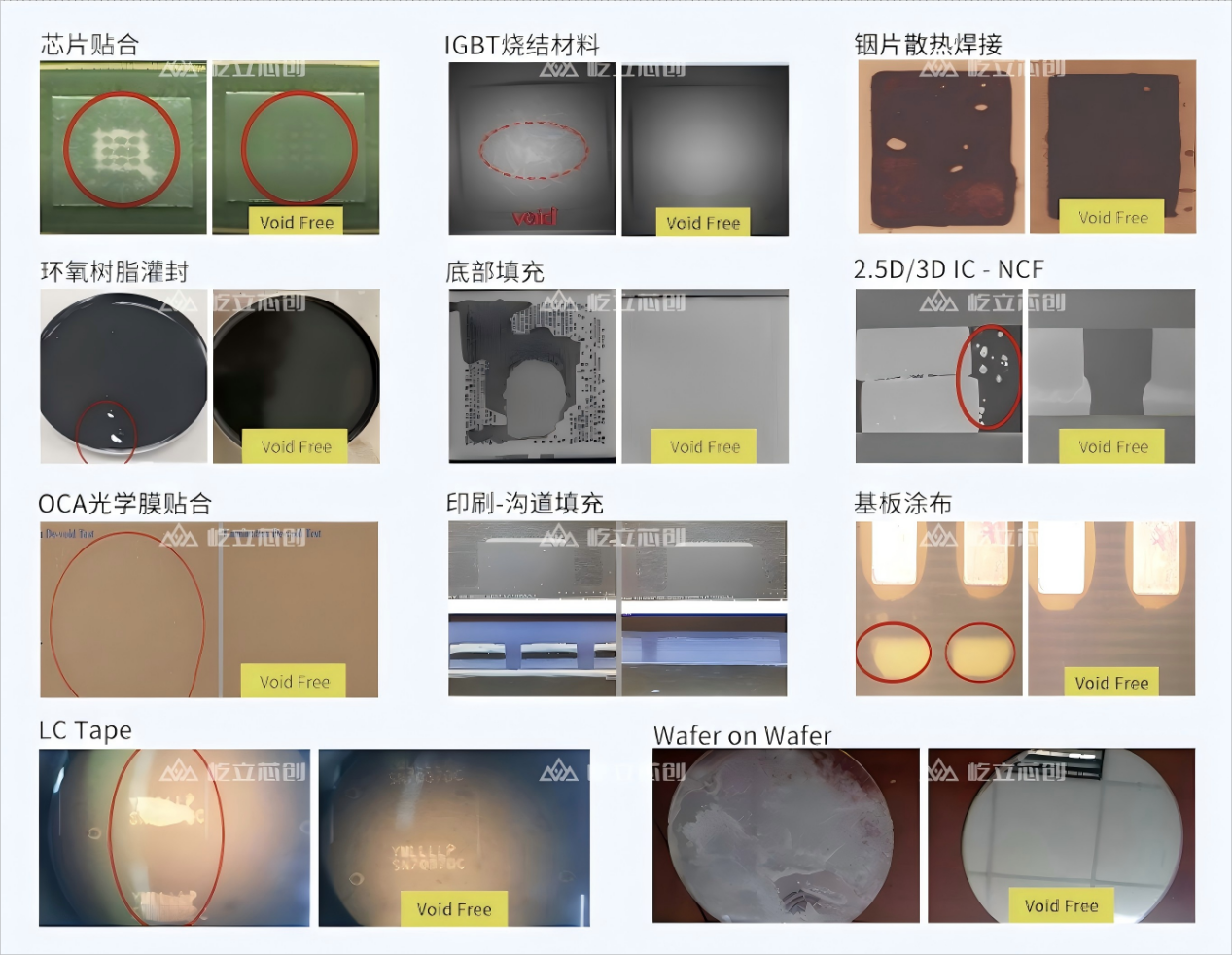
三、微米世界的勝負手,為先進封裝提供“零氣泡”基底
當DBG/SDBG工藝將芯片帶入“超薄時代”,當異質集成成為提升算力的核心路徑,界面氣泡已成為制約其可靠性的最大瓶頸之一。
屹立芯創依托熱流與氣壓兩大核心技術,打造以真空除泡系統和晶圓級真空貼壓膜系統為核心的先進封裝氣泡整體解決方案,致力于為全球客戶提供從材料、工藝到設備的全鏈條“零氣泡”保障,正躋身成為全球熱流與氣壓技術的領導者與除泡品類專家,為半導體封裝的下一次革新奠定堅實的可靠性基石。
審核編輯 黃宇
-
半導體
+關注
關注
339文章
31062瀏覽量
265681 -
先進封裝
+關注
關注
2文章
553瀏覽量
1051
發布評論請先 登錄
徹底告別真空泵:免脫泡自排泡灌封膠如何提升精密電子生產效率? |鉻銳特實業

灌封膠氣泡消除技巧:攪拌+抽真空+固化全流程排氣消泡方法 | 鉻銳特實業

康麗達導電泡棉全系列解析:從SMT工藝到AIR LOOP的結構創新與選型指南

真空造粒機PLC數據采集解決方案

芯片印刷除鎢漿料的改進
告別虛焊移位!康麗達SMT導電泡棉

DAF膠膜(Die Attach Film)詳解
里程碑!屹立芯創除泡系統落地馬來檳城,深耕 IoT 與先進封裝

虹科分享 功夫機器人來了!CMG擂臺之上的技術決勝點是什么?

PVC6800真空變送器:冷凍干燥機真空測量的革新之選

真空度與流量的平衡之道,無刷吸塵器方案常見問題--其利天下技術

真空計的分類及原理優缺點

咖啡機應用方案-“智”控溫度、打造完美咖啡奶泡

光纖怎么接真空饋通
瓶蓋檢測方案:從微米級測量到360° 無死角




 決勝微米之間:DAF膠膜真空除泡方案
決勝微米之間:DAF膠膜真空除泡方案




評論