文章來源:學(xué)習(xí)那些事
原文作者:前路漫漫
本文介紹了MEMS封裝的需求與封裝方案。
MEMS 封裝的特殊性
當(dāng)前,盡管針對(duì) MEMS 器件的制備工藝與相關(guān)設(shè)備已開展了大量研究,但仍有不少 MEMS 傳感器未能實(shí)現(xiàn)廣泛的商業(yè)化落地,其中一個(gè)重要原因便是 MEMS 器件的封裝問題尚未得到妥善解決。MEMS 封裝技術(shù)雖源于微電子封裝技術(shù),兩者存在一定共性,但 MEMS 器件因包含微機(jī)械結(jié)構(gòu),且對(duì)力隔離、真空環(huán)境、氣密性等方面有特殊要求,使其封裝與微電子封裝存在顯著差異。
多數(shù) MEMS 器件在完成全部制造流程后,其機(jī)械結(jié)構(gòu)才會(huì)暴露在外,因此 MEMS 封裝首先要實(shí)現(xiàn)對(duì)器件的物理防護(hù)。MEMS 器件的性能易受水汽、摩擦作用、化學(xué)腐蝕等因素影響而下降,這就需要進(jìn)行微型化的保護(hù)與密封處理。例如,微機(jī)械開關(guān)在濕度較高的環(huán)境中,性能會(huì)明顯變差甚至完全失效。從長(zhǎng)期可靠使用的角度來看,MEMS 封裝需具備良好的密封性,通過密封形成的空氣環(huán)境或真空狀態(tài),可減少器件內(nèi)部的摩擦、振動(dòng)及腐蝕等問題。特別是對(duì)于植入式醫(yī)療領(lǐng)域應(yīng)用的 MEMS 器件,密封更是必不可少的條件。
MEMS 封裝技術(shù)具有自身的特殊性與復(fù)雜性,通常需滿足以下要求:
(1)低應(yīng)力特性。由于 MEMS 器件尺寸微小、精度極高且結(jié)構(gòu)脆弱,因此要求封裝過程對(duì)器件產(chǎn)生的應(yīng)力盡可能最小化。
(2)高真空環(huán)境。將 MEMS 器件中的可動(dòng)結(jié)構(gòu)置于真空環(huán)境中,能夠減小摩擦作用,提升器件的可靠性并延長(zhǎng)其使用壽命。
(3)高氣密性保障。部分 MEMS 器件如微陀螺儀,在氣密性不足的情況下,無法實(shí)現(xiàn)長(zhǎng)期穩(wěn)定的可靠工作。
(4)高隔離度設(shè)計(jì)。為避免其他信號(hào)對(duì)器件造成干擾,需要對(duì) MEMS 器件的特定部位進(jìn)行封裝,以達(dá)到隔離干擾的目的。
(5)其他特殊需求。部分 MEMS 傳感器(如光學(xué)傳感器、微流體傳感器、化學(xué)傳感器等)需要設(shè)計(jì)與外界環(huán)境交互的接口。
鑒于 MEMS 封裝的特殊性與復(fù)雜性,其封裝成本占 MEMS 整體成本的比例可達(dá) 50% 至 95%,遠(yuǎn)高于微電子封裝的成本占比。一方面,MEMS 產(chǎn)品的高度多樣性導(dǎo)致不同產(chǎn)品對(duì)可靠封裝的要求存在本質(zhì)差異。例如,壓力傳感器的封裝要求與汽車安全氣囊系統(tǒng)中常用的慣性傳感器截然不同,后者需要在多塵、溫度劇烈波動(dòng)、存在腐蝕性介質(zhì)的苛刻環(huán)境中,以及汽車行駛時(shí)的強(qiáng)烈振動(dòng)下保持正常工作。這些由系統(tǒng)使用環(huán)境決定的封裝要求,使得生產(chǎn)廠家必須為每一款新產(chǎn)品重新調(diào)整所有封裝設(shè)備,因此,每款新 MEMS 產(chǎn)品往往需要大量的資金投入,以及對(duì)新方法和新工藝設(shè)備的研發(fā)投入。
另一方面,MEMS 產(chǎn)品中結(jié)構(gòu)元件的微小尺寸給封裝帶來了諸多特殊問題。許多封裝工序涉及的工藝本質(zhì)上屬于物理 - 化學(xué)過程,這些過程常會(huì)產(chǎn)生各種附加效應(yīng)。例如,鍵合過程中及完成后必然會(huì)產(chǎn)生熱應(yīng)力與應(yīng)變,較大的殘余熱應(yīng)力可能導(dǎo)致鍵合表面出現(xiàn)裂痕,過大的殘余應(yīng)變則可能因膨脹系數(shù)的差異使鍵合表面發(fā)生變形凸起。這些問題都會(huì)引發(fā)一系列可靠性測(cè)試相關(guān)的難題,進(jìn)而增加MEMS 產(chǎn)品的封裝成本。
晶圓級(jí) MEMS 封裝
MEMS 封裝可分為芯片級(jí)封裝與晶圓級(jí)封裝兩種類型。芯片級(jí)封裝工藝借鑒現(xiàn)有集成電路的封裝流程與設(shè)備,待晶圓切割成獨(dú)立裸片后,再對(duì) MEMS 器件進(jìn)行結(jié)構(gòu)釋放與密封。以德州儀器公司的數(shù)字微鏡器件(digital micromirror device,DMD)為例,其芯片貼合在封裝基座上,通過鍵合引線與陶瓷基底連接,密封光學(xué)窗口與陶瓷基底則借助密封圈實(shí)現(xiàn)密封。由于陶瓷的熱膨脹系數(shù)處于 5×10??~9×10??/℃之間,與硅的熱膨脹系數(shù)(約 2.6×10??/℃)接近,因此可實(shí)現(xiàn)陶瓷與硅的鍵合。熱膨脹系數(shù)的匹配能減輕熱脹冷縮產(chǎn)生的應(yīng)力,尤其在器件面積較大時(shí),這種應(yīng)力緩解作用更為關(guān)鍵。
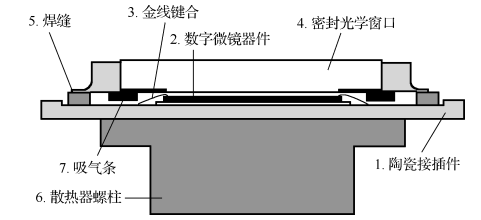
芯片級(jí)封裝的主要缺陷在于,在完成 MEMS 器件整體封裝前,需對(duì)每個(gè)裸片單獨(dú)執(zhí)行結(jié)構(gòu)釋放、密封等操作,導(dǎo)致成本偏高且效率低下。作為替代方案,晶圓級(jí)封裝技術(shù)選擇在晶圓切割前完成結(jié)構(gòu)釋放與密封等工序,之后再進(jìn)行劃片處理。
三維晶圓級(jí)封裝已成為 MEMS 封裝的重要發(fā)展方向,當(dāng)前先進(jìn)的技術(shù)方案通常涉及三個(gè)晶圓,分別是 MEMS 器件晶圓、接口 ASIC 晶圓和蓋帽晶圓(cap-wafer)。以下介紹幾種以低成本、高性能、少引腳為目標(biāo)的三維 MEMS 封裝設(shè)計(jì)及工藝流程。這三類晶圓的封裝形式各有不同,例如 MEMS 器件晶圓可采用引線鍵合、倒裝、硅通孔等封裝形式,而 ASIC 晶圓與蓋帽晶圓則可選擇帶硅通孔或無硅通孔的封裝方案。
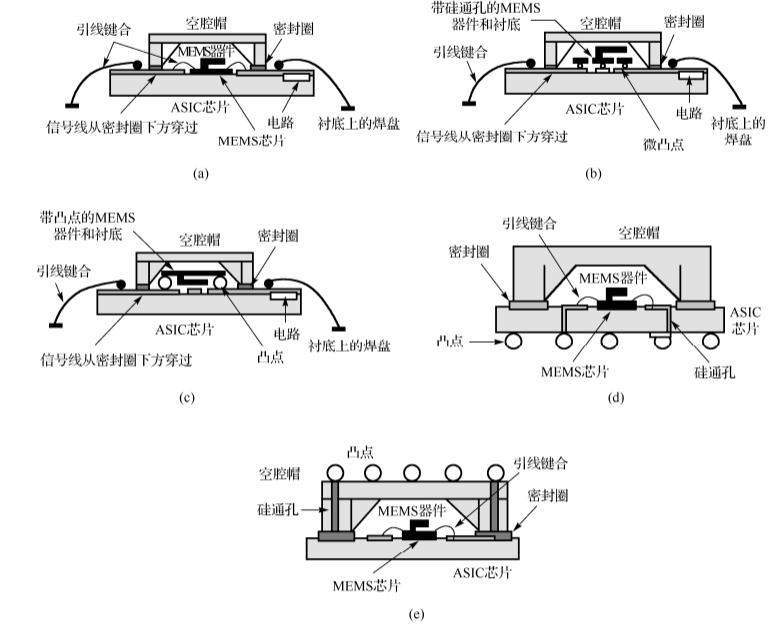
晶圓級(jí) MEMS 封裝存在多種結(jié)構(gòu)形式,其中部分方案的共性在于將蓋帽芯片與 ASIC 芯片通過密封圈粘合,信號(hào)線從密封圈下方穿過后,再通過鍵合引線與封裝外部的其他器件或系統(tǒng)襯底連接(如直接接入系統(tǒng)級(jí)封裝內(nèi)的其他芯片襯底或印刷電路板)。它們的差異主要體現(xiàn)在 MEMS 器件與 ASIC 芯片的連接方式上:有的通過引線鍵合實(shí)現(xiàn)連接,有的采用硅通孔與微凸點(diǎn)鍵合,還有的借助倒裝鍵合方式連接。
另一種封裝形式中,ASIC 芯片通過硅通孔與凸點(diǎn)直接與襯底或印刷電路板相連,引線無需經(jīng)過密封圈下方布線,而 MEMS 器件與 ASIC 芯片的連接方式可與上述方案保持一致。還有一種結(jié)構(gòu)是 ASIC 芯片利用貫穿蓋帽芯片的硅通孔及凸點(diǎn)鍵合實(shí)現(xiàn)與外界的連接,當(dāng)需要與封裝襯底或印刷電路板對(duì)接時(shí),需將整個(gè)封裝倒置,其 MEMS 器件與 ASIC 芯片的連接方式同樣可采用上述各類鍵合形式。
晶圓級(jí) MEMS 封裝的簡(jiǎn)化流程可概括如下:若 MEMS 器件與 ASIC 芯片采用直接引線鍵合,那么 MEMS 器件在自身晶圓完成釋放后,可直接劃片轉(zhuǎn)移至 ASIC 芯片晶圓;若采用硅通孔或倒裝鍵合方式,則需先完成通孔成型或微凸點(diǎn)制備,再轉(zhuǎn)移至 ASIC 芯片晶圓。隨后,將 MEMS 器件與 ASIC 晶圓進(jìn)行芯片到晶圓(chip-to-wafer,C2W)鍵合,接著把已鍵合 MEMS 器件的 ASIC 芯片晶圓與蓋帽晶圓進(jìn)行鍵合密封,最終劃片形成單個(gè)封裝器件。其他封裝形式的實(shí)現(xiàn)步驟與此類似。
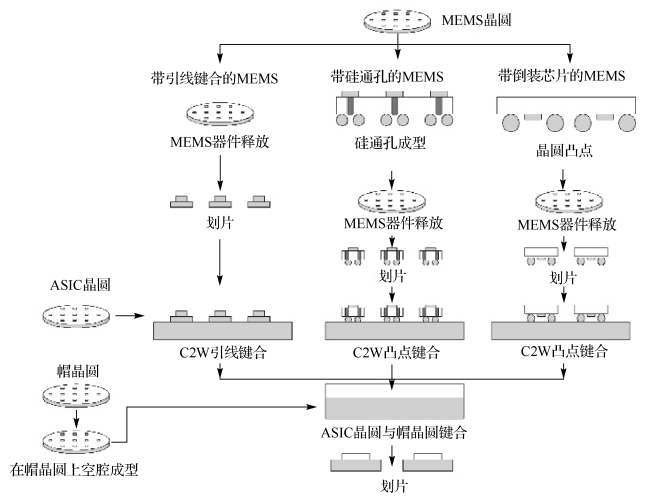
從上述實(shí)例可見,MEMS 晶圓級(jí)封裝與普通微電子三維封裝的核心差異在于蓋帽結(jié)構(gòu)。蓋帽除了發(fā)揮保護(hù)、隔離作用或作為被檢測(cè)量的窗口外,還可作為布線通道。蓋帽封裝可采用多種技術(shù),包括各類鍵合技術(shù)、薄膜密封技術(shù)及聚合物密封技術(shù),其中鍵合技術(shù)目前應(yīng)用最為廣泛。
-
mems
+關(guān)注
關(guān)注
129文章
4507瀏覽量
199248 -
晶圓
+關(guān)注
關(guān)注
53文章
5434瀏覽量
132561 -
封裝
+關(guān)注
關(guān)注
128文章
9302瀏覽量
148937 -
工藝
+關(guān)注
關(guān)注
4文章
716瀏覽量
30376
原文標(biāo)題:MEMS封裝
文章出處:【微信號(hào):bdtdsj,微信公眾號(hào):中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
MEMS器件的封裝級(jí)設(shè)計(jì)
MEMS元器件的組成部分
開創(chuàng)性的5 kV ESD MEMS開關(guān)技術(shù)
RF-MEMS系統(tǒng)元件封裝問題
高通MEMS封裝技術(shù)解析
MEMS封裝技術(shù)
MEMS器件的封裝級(jí)設(shè)計(jì)考慮
移動(dòng)裝置需求大MEMS封裝邁向標(biāo)準(zhǔn)化

MEMS封裝的四大條件 關(guān)于MEMS后端封裝問題
MEMS產(chǎn)品的封裝選擇和設(shè)計(jì)
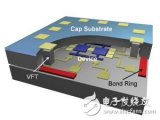
高通MEMS封裝技術(shù)解析
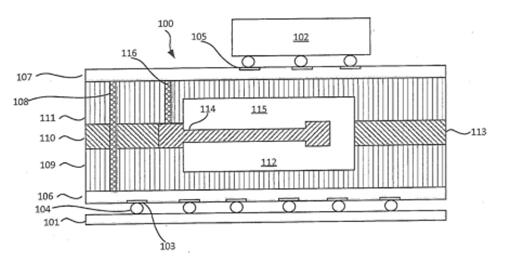
MEMS封裝的新趨勢(shì)
用于MEMS器件的先進(jìn)晶圓級(jí)封裝解決方案
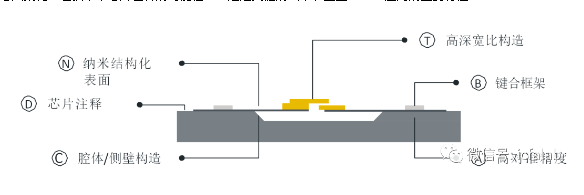



 MEMS封裝的需求與優(yōu)化方案
MEMS封裝的需求與優(yōu)化方案




評(píng)論