在存儲芯片(DRAM/NAND)制造中,晶圓劃片是將整片晶圓分割成單個芯片(Die)的關(guān)鍵后道工序。隨著芯片尺寸不斷縮小、密度持續(xù)增加、晶圓日益變薄(尤其對于高容量3D NAND),傳統(tǒng)劃片工藝帶來的崩邊、裂紋、應(yīng)力損傷成為制約良率和產(chǎn)能提升的核心瓶頸之一。現(xiàn)代高精度晶圓切割機通過一系列技術(shù)創(chuàng)新,有效應(yīng)對這些挑戰(zhàn),成為推動存儲芯片產(chǎn)能躍升的關(guān)鍵力量。

核心瓶頸:晶圓劃片面臨的嚴(yán)峻挑戰(zhàn))
1. 微型化與高密度:DRAM單元和3D NAND堆疊結(jié)構(gòu)導(dǎo)致芯片尺寸微小,切割道寬度被壓縮至極窄(如30-50微米)。要求劃片位置精度極高,避免切傷芯片電路。
2. 超薄晶圓的脆弱性: 為容納更多堆疊層,3D NAND晶圓在劃片前需減薄至100微米以下(甚至<50微米)。超薄晶圓剛性極低,對切割應(yīng)力異常敏感,極易產(chǎn)生裂紋、崩邊、分層甚至碎裂。
3. 材料與結(jié)構(gòu)復(fù)雜性: 存儲芯片可能包含多層薄膜、金屬互連、低k介質(zhì)等,其機械性能和粘附強度各異,增加了切割過程中產(chǎn)生分層或損傷的風(fēng)險。
4. 產(chǎn)能壓力:12英寸晶圓包含數(shù)千至上萬顆芯片。劃片速度、設(shè)備穩(wěn)定性和稼動率(OEE)直接影響整體生產(chǎn)效率和產(chǎn)能。
5. 良率殺手:劃片產(chǎn)生的微裂紋、崩邊、污染是導(dǎo)致后續(xù)封裝失效或早期產(chǎn)品失效的主要原因之一,直接拉低最終良率。
高精度切割機如何突破瓶頸?(聚焦刀片切割技術(shù)創(chuàng)新)
現(xiàn)代高精度切割機通過以下關(guān)鍵技術(shù),顯著提升了對超薄、高密度DRAM/NAND晶圓的切割能力和效率:
1. 亞微米級超高精度運動與對準(zhǔn):
納米級運動平臺:采用高性能直線電機、空氣軸承和精密反饋系統(tǒng),實現(xiàn)切割路徑的亞微米級定位精度和重復(fù)定位精度。
先進(jìn)視覺系統(tǒng):配備高分辨率光學(xué)系統(tǒng)和智能圖像處理算法,即使在極窄切割道上也能精準(zhǔn)識別對準(zhǔn)標(biāo)記,確保刀片精確切入預(yù)定位置,避免切傷芯片。
實時動態(tài)補償:對晶圓翹曲、切割熱變形等進(jìn)行實時測量與補償,保證全程切割精度。
2. 超薄金剛石刀片與精密主軸技術(shù):
極薄刀片:使用厚度僅為15-25微米(甚至更薄)的高品質(zhì)金剛石刀片。更薄的刀片意味著更小的切口寬度(Kerf Loss),允許設(shè)計更窄的切割道,顯著提高單晶圓有效芯片產(chǎn)出數(shù)量(直接提升產(chǎn)能)。
刀片優(yōu)化: 針對不同材料(硅、化合物、低k介質(zhì)等)和晶圓厚度,優(yōu)化刀片金剛石顆粒度、結(jié)合劑和刃口形狀,平衡切割效率、壽命和邊緣質(zhì)量。
超高轉(zhuǎn)速精密主軸:采用空氣軸承或混合軸承主軸,轉(zhuǎn)速可達(dá)60, 000 RPM 甚至更高。具備極高的剛性和旋轉(zhuǎn)精度,最大限度減少徑向跳動和振動,這是獲得光滑切割面和減少崩邊的關(guān)鍵。
主動溫控主軸:精密控制主軸溫度,防止熱膨脹影響切割精度。
3. 切割工藝優(yōu)化與智能控制:
DBG:這是高精度切割機處理超薄晶圓的核心工藝!
步驟1(劃片):在晶圓正面、減薄前(此時晶圓較厚,強度高),使用切割機進(jìn)行精確的、部分深度的切割(通常切割深度為最終芯片厚度的1/3到1/2),形成預(yù)設(shè)的溝槽。
步驟2(背面減薄):將晶圓翻轉(zhuǎn),進(jìn)行背面研磨減薄,直至溝槽深度暴露出來,芯片自然分離。
核心優(yōu)勢:
避免超薄狀態(tài)切割:最脆弱的超薄狀態(tài)是在背面研磨后,此時芯片已通過正面預(yù)切溝槽實現(xiàn)分離,無需在超薄狀態(tài)下進(jìn)行機械切割,從根本上規(guī)避了超薄晶圓易碎的問題。
大幅減少崩邊和應(yīng)力:切割發(fā)生在較厚的晶圓上,應(yīng)力更易控制,崩邊主要產(chǎn)生在強度較高的正面,且被限制在溝槽內(nèi),不會影響芯片有效區(qū)域。
提升良率:是提升超薄存儲芯片劃片良率的主流技術(shù)。
自適應(yīng)切割參數(shù):根據(jù)晶圓厚度、材料特性、切割位置(邊緣更易崩邊)實時動態(tài)調(diào)整切割速度、進(jìn)刀速度、切割深度、冷卻液流量等參數(shù),優(yōu)化切割質(zhì)量。
高級振動控制:采用主動/被動減振系統(tǒng)、高剛性機臺設(shè)計,有效隔離外部和內(nèi)部振動,確保切割過程穩(wěn)定,提升邊緣質(zhì)量和精度。
4. 高產(chǎn)能與自動化集成:
高速切割:優(yōu)化的運動控制、高剛性主軸和先進(jìn)刀片技術(shù)允許更高的切割速度。
多主軸系統(tǒng): 一臺切割機可配備多個獨立控制的切割主軸,同時進(jìn)行多條切割道的作業(yè),成倍提升單位時間產(chǎn)能,尤其適合大尺寸(12英寸)、高芯片數(shù)量的DRAM/NAND晶圓。
集成自動化:無縫對接研磨機、清洗機、晶圓環(huán)貼膜/解膜設(shè)備、檢測設(shè)備及物料搬運系統(tǒng),實現(xiàn)全自動化的晶圓后道處理線,減少人工操作和晶圓等待時間,最大化設(shè)備利用率和整體生產(chǎn)效率。
對DRAM/NAND產(chǎn)能躍升的直接貢獻(xiàn)
1. 顯著提升劃片良率:通過DBG工藝、超高精度控制、超薄刀片和振動抑制,有效消除或大幅減少切割崩邊、裂紋和分層,直接降低因劃片環(huán)節(jié)導(dǎo)致的芯片失效,提升最終封裝良品率。良率提升是最直接的產(chǎn)能增益。
2. 增加單晶圓有效芯片產(chǎn)出:
更窄切割道:超薄金剛石刀片實現(xiàn)的極小切口寬度,允許設(shè)計更窄的切割道,在同樣面積的晶圓上布局更多芯片。
更小崩邊:高精度控制減少的崩邊尺寸,意味著芯片有效面積的損失更小,合格芯片數(shù)量增加。
3. 提高切割效率與設(shè)備產(chǎn)能:
高速切割與多主軸并行:大幅縮短單張晶圓的切割時間。
高自動化與高OEE: 減少換刀、校準(zhǔn)、上下料等非生產(chǎn)時間,提升設(shè)備綜合利用率,實現(xiàn)單位時間內(nèi)處理更多晶圓。
4. 賦能超薄高密度存儲芯片量產(chǎn):DBG工藝與高精度設(shè)備的結(jié)合,是當(dāng)前實現(xiàn)超薄(<100um)3D NAND晶圓穩(wěn)定、高良率量產(chǎn)的關(guān)鍵技術(shù)保障。
5. 降低綜合制造成本:良率提升、單晶圓產(chǎn)出芯片增加、生產(chǎn)效率提高,共同攤薄了單顆存儲芯片的制造成本。
結(jié)論
高精度晶圓切割機,特別是結(jié)合了DBG(先劃后磨)工藝、超薄金剛石刀片、納米級運動控制、高剛性低振動主軸以及多主軸并行切割/高自動化等技術(shù)的先進(jìn)設(shè)備,是突破當(dāng)前DRAM和NAND閃存制造中晶圓分割瓶頸的核心利器。它通過在較厚晶圓上進(jìn)行精密預(yù)切(DBG)規(guī)避超薄切割風(fēng)險、利用極窄切口提升晶圓利用率、以高精度高穩(wěn)定性保證切割質(zhì)量、并通過高速高效提升生產(chǎn)節(jié)拍,直接且顯著地提升了存儲芯片的良率、單晶圓產(chǎn)出和整體產(chǎn)能,為滿足全球不斷增長的存儲需求提供了堅實的后道制造基礎(chǔ)。隨著存儲芯片持續(xù)向更小尺寸、更高堆疊演進(jìn),高精度切割機的技術(shù)創(chuàng)新將繼續(xù)扮演至關(guān)重要的角色。
-
晶圓
+關(guān)注
關(guān)注
53文章
5432瀏覽量
132502 -
劃片機
+關(guān)注
關(guān)注
0文章
200瀏覽量
11828 -
存儲芯片
+關(guān)注
關(guān)注
11文章
1046瀏覽量
44852 -
博捷芯
+關(guān)注
關(guān)注
0文章
56瀏覽量
327
發(fā)布評論請先 登錄
劃片機和切割機有什么區(qū)別?看完這篇不再選錯

博特精密 紫外皮秒激光切割機|FPC / 超薄玻璃 / 陶瓷精密切割設(shè)備

皮秒激光切割機——博特精密高精度精密冷加工設(shè)備

晶圓切割機技術(shù)升級 破解碳化硅/氮化鎵低損傷切割難題

什么是DRAM存儲芯片
聚焦博捷芯劃片機:晶圓切割機選購指南

CO?激光切割機:制造業(yè)的“隱形冠軍”

基于鋇錸BL370的智能激光切割機一體化控制與AI工藝優(yōu)化解決方案
您的激光切割機正被連接器所“連累”么?那就快“開盒”這款連接器吧!

切割液性能智能調(diào)控系統(tǒng)與晶圓 TTV 預(yù)測模型的協(xié)同構(gòu)建




 攻克存儲芯片制造瓶頸:高精度晶圓切割機助力DRAM/NAND產(chǎn)能躍升
攻克存儲芯片制造瓶頸:高精度晶圓切割機助力DRAM/NAND產(chǎn)能躍升



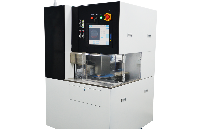



評論