在電子元器件領域,芯片失效問題一直是工程師們最為棘手的挑戰之一。科準測控小編發現,芯片失效往往在量產階段甚至產品出貨后才被發現,此時可能僅有少量失效樣品,但足以引發嚴重的質量關注。面對這種情況,研發工程師需要系統性地排查各種可能原因,從外圍電路到生產工藝,甚至需要原廠支持進行剖片分析。
本文科準測控小編將詳細介紹芯片失效分析的原理、標準、常用設備(如Beta S100推拉力測試機)以及標準流程,幫助工程師更好地理解和應對芯片失效問題,同時提高對分析報告質量的判斷能力。
一、芯片失效分析原理
芯片失效分析是基于材料科學、電子學和物理學原理,通過一系列檢測手段確定芯片失效模式和根本原因的系統性方法。其核心原理包括:
- 失效模式識別 :通過電性測試、顯微觀察等手段確定失效表現特征
- 失效機理分析 :研究導致失效的物理、化學或電學過程
- 根本原因追溯 :從設計、制造、應用等環節找出導致失效的原始因素
失效分析遵循"從非破壞性到破壞性"、"從外部到內部"的漸進原則,確保在分析過程中不遺漏關鍵證據。
二、芯片失效分析標準
國際通用的芯片失效分析標準主要包括:
- JEDEC標準 :
o JESD22-A104:溫度循環測試
o JESD22-A105:功率溫度循環測試
o JESD22-B104:機械沖擊測試
- MIL-STD-883 :美國軍用標準中關于微電子器件測試方法
- IPC標準 :
o IPC-9701:表面貼裝焊點性能測試方法
o IPC-TM-650:測試方法手冊
- AEC-Q100 :汽車電子委員會制定的汽車級IC應力測試標準
這些標準規定了不同應用場景下芯片可靠性測試和失效分析的基本要求和方法。
三、常用失效分析設備
1. Beta S100推拉力測試機

設備介紹 :
Beta S100推拉力測試機是一款專為微電子封裝行業設計的高精度測試設備。它能夠滿足多種封裝形式的測試需求,包括QFN、BGA、CSP、TSOP等,并支持靜態和動態的拉力、推力及剪切力測試。其廣泛的應用范圍覆蓋了半導體封裝、LED封裝、光電子器件、PCBA電子組裝、汽車電子以及航空航天等多個領域。
應用場景 :
· 焊球剪切/拉力測試
· 金線拉力測試

· 芯片粘結強度測試

· 材料界面結合力測試
優勢特點 :
· 高精度力值測量
· 多種測試模式可選
· 可編程自動化測試
· 數據采集分析系統完善
四、芯片失效分析標準流程
1. 失效信息收集
· 失效現象記錄
· 失效環境條件
· 失效比例統計
· 歷史失效數據
2. 非破壞性分析
· 外觀檢查(光學顯微鏡)
· X-ray檢測
· 電性參數測試
· 紅外熱成像
3. 破壞性分析
· 開封去層(化學或機械方法)
· 截面制備(FIB或拋光)
· SEM/EDS分析
· 聚焦離子束電路修改
4. 推拉力測試(以Beta S100為例)
測試步驟 :
- 樣品固定:將芯片樣品固定在測試平臺上
- 測試針選擇:根據測試部位選擇合適形狀和尺寸的測試針
- 參數設置:設置測試速度、行程、采樣頻率等參數
- 測試執行:自動/手動進行推拉力測試
- 數據采集:實時記錄力-位移曲線
- 結果分析:確定失效模式和強度參數
5. 數據分析與報告
· 失效模式歸類
· 根本原因分析
· 改進建議提出
· 報告編制與評審
五、芯片失效常見難題分析
- 間歇性失效 :
o 特點:時好時壞,難以復現
o 解決方法:環境應力加速、長時間監測
- 系統性失效 :
o 特點:特定條件下必然出現
o 解決方法:設計缺陷分析、應用條件驗證
- 多因素耦合失效 :
o 特點:多種應力共同作用導致
o 解決方法:DOE實驗設計、因素分離
- 界面失效 :
o 特點:材料界面處的分層、開裂
o 解決方法:界面形貌分析、材料兼容性研究
- 靜電放電(ESD)損傷 :
o 特點:瞬時高能量造成的隱性損傷
o 解決方法:ESD防護設計評估、敏感部位檢查
以上就是小編介紹的有關于芯片失效分析方法相關內容了,希望可以給大家帶來幫助!如果您還想了解更多關于推拉力測試機怎么使用視頻和圖解,使用步驟及注意事項、作業指導書,原理、怎么校準和使用方法視頻,推拉力測試儀操作規范、使用方法和測試視頻,焊接強度測試儀使用方法和鍵合拉力測試儀等問題,歡迎您關注我們,也可以給我們私信和留言,【科準測控】小編將持續為大家分享推拉力測試機在鋰電池電阻、晶圓、硅晶片、IC半導體、BGA元件焊點、ALMP封裝、微電子封裝、LED封裝、TO封裝等領域應用中可能遇到的問題及解決方案。
審核編輯 黃宇
-
芯片
+關注
關注
463文章
54200瀏覽量
468002 -
鍵合
+關注
關注
0文章
103瀏覽量
8297 -
推拉力測試機
+關注
關注
0文章
181瀏覽量
674
發布評論請先 登錄
電子元器件剪切強度測試怎么做?推拉力測試機方法詳解
FPCB焊點強度總不合格?推拉力測試機推力測試方法與判定標準

基于推拉力測試機的PCBA電路板元器件焊點可靠性評估與失效機理探討

你不知道的COB封裝測試方法,快來看看推拉力測試機的應用!
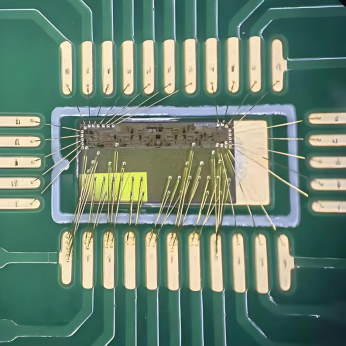



 芯片鍵合強度如何評估?推拉力測試機測試方法與標準解讀
芯片鍵合強度如何評估?推拉力測試機測試方法與標準解讀




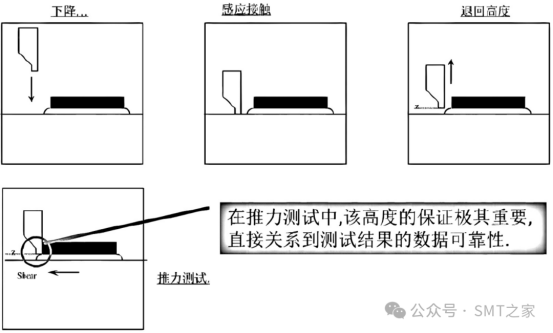







評論