聚焦離子束技術(shù)
聚焦離子束(Focused Ion Beam,簡(jiǎn)稱 FIB)技術(shù)是一種先進(jìn)的微觀加工與分析手段,廣泛應(yīng)用于材料科學(xué)、納米技術(shù)以及半導(dǎo)體研究等領(lǐng)域。FIB核心原理是利用離子源產(chǎn)生高能離子束,通常以鎵(Ga)離子為主,部分設(shè)備還配備氦(He)或氖(Ne)離子源。離子束在轟擊樣品時(shí),會(huì)產(chǎn)生濺射現(xiàn)象,從而實(shí)現(xiàn)材料的精準(zhǔn)去除,同時(shí)通過二次電子信號(hào)獲取樣品的形貌圖像,為制樣過程提供直觀的輔助。這種技術(shù)能夠在納米尺度上對(duì)樣品進(jìn)行微加工,為透射電子顯微鏡(TEM)樣品的制備提供了高效、精準(zhǔn)的解決方案。
FIB 在 TEM 制樣的操作流程
1.樣品定位與標(biāo)記
在制樣初期,需要從樣品中精準(zhǔn)定位出感興趣的區(qū)域。由于樣品的微觀結(jié)構(gòu)復(fù)雜,直接對(duì)其進(jìn)行加工可能存在定位偏差。因此,采用離子束沉積技術(shù)在樣品周圍或特定位置進(jìn)行標(biāo)記是至關(guān)重要的一步。通過離子束的作用,將一些容易識(shí)別的材料(如金屬鉑等)沉積在樣品表面,形成清晰可見的標(biāo)記點(diǎn)。這些標(biāo)記點(diǎn)不僅為后續(xù)的加工操作提供了明確的參考,還能在制樣過程中實(shí)時(shí)監(jiān)控樣品的位置變化,確保加工精度。
2.保護(hù)層沉積
離子束的濺射作用雖然能夠高效去除材料,但同時(shí)也可能對(duì)樣品表面造成損傷,尤其是對(duì)于一些對(duì)表面敏感的樣品,如半導(dǎo)體材料、生物樣品等。為了避免樣品在加工過程中受到不必要的破壞,需要在正式開展切割等加工操作前,在樣品表面沉積一層保護(hù)性材料。常用的保護(hù)材料包括碳、鉑、鎢等。這層保護(hù)膜能夠在一定程度上緩沖離子束的沖擊,降低對(duì)樣品原始結(jié)構(gòu)和成分的破壞風(fēng)險(xiǎn),從而保障樣品在后續(xù)加工過程中的完整性以及最終的 TEM 觀察效果。
3.粗加工與切割
完成樣品定位、標(biāo)記和保護(hù)層沉積后,便進(jìn)入粗加工階段。此時(shí),使用相對(duì)較高能量和較大束流的離子束對(duì)樣品進(jìn)行初步加工。根據(jù) TEM 樣品所需的大致形狀和尺寸要求,將塊狀或較大尺寸的原始樣品逐步切割成接近目標(biāo)形態(tài)的薄片。既要保證切割效率,又要避免因過度加工而導(dǎo)致樣品出現(xiàn)裂紋、分層等損傷情況。這一步驟是整個(gè)制樣流程的基礎(chǔ),其加工質(zhì)量直接影響后續(xù)精加工的效果。
4.精加工與減薄
粗加工完成后,樣品的形狀和尺寸已基本接近目標(biāo)要求,但此時(shí)樣品的厚度和表面質(zhì)量仍需進(jìn)一步優(yōu)化。因此,需要切換為較低能量和較小束流的離子束,對(duì)樣品進(jìn)行更為精細(xì)的加工和進(jìn)一步減薄處理。通過改變離子束的參數(shù)以及補(bǔ)償角度,對(duì)樣品進(jìn)行均勻減薄,使其達(dá)到 TEM 觀察所需的厚度范圍(通常為幾十納米)。在減薄過程中,還需特別注意避免引入新的損傷和污染。最后,切換到低電壓進(jìn)行最終的清掃,清除樣品表面在切割過程中可能產(chǎn)生的非晶污染,確保樣品在 TEM 下能夠呈現(xiàn)出清晰、準(zhǔn)確的微觀結(jié)構(gòu)圖像。
FIB 技術(shù)的優(yōu)勢(shì)與局限性
1.優(yōu)勢(shì)
FIB 技術(shù)在透射電子顯微鏡樣品制備領(lǐng)域具有不可替代的重要地位。例如,它能夠在納米尺度上對(duì)樣品進(jìn)行精準(zhǔn)加工,避免了傳統(tǒng)方法可能引入的樣品損傷和污染;同時(shí),F(xiàn)IB 技術(shù)的靈活性高,能夠適應(yīng)各種復(fù)雜樣品和特殊需求,為材料微觀結(jié)構(gòu)研究提供了更廣闊的應(yīng)用空間。
2.局限性
設(shè)備成本較高,操作復(fù)雜,需要專業(yè)的技術(shù)人員進(jìn)行操作和維護(hù)。
總結(jié)
聚焦離子束技術(shù)作為一種先進(jìn)的微觀加工與分析手段,在透射電子顯微鏡樣品制備中發(fā)揮著至關(guān)重要的作用。它不僅為科研人員提供了高質(zhì)量的樣品制備支持,還推動(dòng)了材料科學(xué)、納米技術(shù)等相關(guān)領(lǐng)域的研究進(jìn)展。金鑒作為國(guó)內(nèi)領(lǐng)先的光電半導(dǎo)體檢測(cè)實(shí)驗(yàn)室,致力于為科研人員提供全面的技術(shù)支持和測(cè)試服務(wù),推動(dòng)材料科學(xué)的進(jìn)步。
-
fib
+關(guān)注
關(guān)注
1文章
129瀏覽量
11783 -
電子顯微鏡
+關(guān)注
關(guān)注
1文章
126瀏覽量
10682 -
離子束
+關(guān)注
關(guān)注
0文章
114瀏覽量
8128
發(fā)布評(píng)論請(qǐng)先 登錄
穿透式電子顯微鏡TEM
掃描式電子顯微鏡 (SEM)
聚焦離子束顯微鏡(FIB-SEM)
聚焦離子束應(yīng)用介紹
透射電子顯微鏡的結(jié)構(gòu)與成像原理

【應(yīng)用案例】透射電子顯微鏡TEM

透射電子顯微鏡的用途和特點(diǎn)
透射電子顯微鏡(TEM)的優(yōu)勢(shì)及應(yīng)用
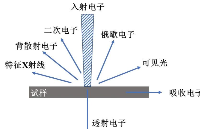
什么是透射電子顯微鏡(TEM)?

透射電子顯微鏡(TEM)與聚焦離子束技術(shù)(FIB)在材料分析中的應(yīng)用




 聚焦離子束技術(shù)在透射電子顯微鏡樣品制備中的應(yīng)用
聚焦離子束技術(shù)在透射電子顯微鏡樣品制備中的應(yīng)用









評(píng)論