等離子體(Plasma)是一種電離氣體,通過向氣體提供足夠的能量,使電子從原子或分子中掙脫束縛、釋放出來,成為自由電子而獲得,通常含有自由和隨機(jī)移動(dòng)的帶電粒子(如電子、離子)和未電離的中性粒子。由于帶正電荷的離子和帶負(fù)電荷的電子是在電離過程中由中性粒子成對(duì)產(chǎn)生的,因此整個(gè)等離子體呈電中性。?
等離子體按照溫度可分為高溫等離子體和低溫等離子體。高溫等離子體是一種完全電離的氣體,各粒子均具有一致的溫度,只有在溫度足夠高(通常可達(dá)106K)時(shí)才能夠獲得,通常存在于宇宙天體及核聚變中。

低溫等離子體又分為熱等離子體(103~105K)和冷等離子體(102~105K)。熱等離子體重粒子(分子、原子、正離子)溫度接近于電子溫度,處于熱力學(xué)平衡態(tài)或近熱力學(xué)平衡。冷等離子體中的重粒子溫度接近室溫,而電子溫度仍然很高,處于非熱力學(xué)平衡態(tài)。
在實(shí)驗(yàn)室和工業(yè)應(yīng)用中,冷等離子體通常由低壓下的輝光放電產(chǎn)生,所使用交變電場(chǎng)的頻率包括音頻(10~50 kHz)、射頻(約 13.56MHz)和微波頻率(約 2.45 GHz),有時(shí)也會(huì)使用直流放電。
等離子體因具有電離態(tài)的離子和電子而展現(xiàn)出更高的化學(xué)活性,使材料更易發(fā)生化學(xué)反應(yīng)。實(shí)際上,等離子體技術(shù)用于材料的合成和表面改性大多是基于自由基。通常情況下,自由基處于基態(tài),但總有部分自由基會(huì)以電子激發(fā)態(tài)的形式存在,比基態(tài)自由基具有更高的能量,可打破多種化學(xué)鍵。當(dāng)高能自由基與基底材料表面接觸時(shí),即在能量交換的過程中,會(huì)發(fā)生一系列物理、化學(xué)反應(yīng),從而改變材料表面的物理、化學(xué)性質(zhì),實(shí)現(xiàn)對(duì)材料的加工和改性。
一、離子化
等離子體的離子化率?是指等離子體中離子占總粒子數(shù)的比例。太陽(yáng)是一個(gè)充滿等離子體的大球。在太陽(yáng)的邊緣,由于溫度相對(duì)較低(約6000℃),離化率也就低。但在太陽(yáng)中心,由于溫度相當(dāng)高(10,000,000℃),因此幾乎所有氣體分子都被離子化,離化率幾乎為 100% 。
半導(dǎo)體制造使用的冷等離子體的離化率通常很低,比如等離子體增強(qiáng)化學(xué)氣相沉積反應(yīng)室(PECVD)內(nèi)電容耦合等離子體(CCP)產(chǎn)生的離化率大約為百萬分之一到千萬分之一,或小于 0.0001% 。電容耦合等離子體刻蝕反應(yīng)室內(nèi)離化率稍高一些,為 0.01% 左右。對(duì)于電感耦合等離子體(ICP)和電子回旋共振(ECR)這兩種最普遍的高密度等離子體源,離化率仍很低,約為1%~5% 。半導(dǎo)體用等離子體的離化率與等離子體功率直接相關(guān),同時(shí)也與壓力、電極間距、氣體種類及反應(yīng)室設(shè)計(jì)有關(guān)。
二、腔室壓力
粒子的平均自由程(Mean Free Path, MFP)的定義是粒子和粒子碰撞前能夠移動(dòng)的平均距離。平均自由程主要取決于腔室壓力,因?yàn)閴毫Q定粒子的密度。由于不同氣體分子有不同尺寸或橫截面,因此反應(yīng)室中的氣體也會(huì)影響平均自由程。當(dāng)壓力減小時(shí),平均自由程就會(huì)增加,粒子密度就會(huì)下降,因此碰撞的頻率就降低。平均自由程是等離子體的重要參數(shù),能通過控制腔室壓力改變平均自由程,最終影響等離子體工藝結(jié)果。PECVD 腔室壓力通常在0.1~10Torr ,其電子的平均自由程為 0.001~0.1cm。等離子體刻蝕室壓力較低,為 3~300mTorr,其電子的平均自由程范圍在 0.33~33cm 之間。
在等離子體刻蝕工藝中,當(dāng)腔室壓力改變時(shí), 平均自由程也發(fā)生變化,同時(shí)離子轟擊能量和離子運(yùn)動(dòng)方向也受壓力的影響,這樣會(huì)改變刻蝕中的刻蝕速率和刻蝕輪廓。等離子體的聚集態(tài)也會(huì)因電子平均自由程改變而不同。當(dāng)壓力較高時(shí),等離子體比較集中在電極附近,但是當(dāng)壓力較低時(shí),等離子體則分布在反應(yīng)室的各處。壓力會(huì)影響等離子體的均勻性并改變整個(gè)晶圓的刻蝕速率。
氮化硅膜都存在一個(gè)機(jī)械應(yīng)力較大的問題,尤其是低壓化學(xué)氣相沉積(LPCVD)氮化硅膜,最厚只能淀積 300nm 左右,超過就會(huì)開裂甚至脫落。PECVD制備氮化硅薄膜的應(yīng)力情況雖然比LPCVD要好一點(diǎn),但它受工藝條件的影響非常明顯。工藝條件適當(dāng),可得到無應(yīng)力的氮化硅薄膜,工藝條件掌握不好 300nm 氮化硅薄膜照樣會(huì)出現(xiàn)開裂、脫落等現(xiàn)象。

上圖為使用 PECVD 沉積氮化硅薄膜。可以看出,腔室壓力從低到高,壓應(yīng)力(Compressive)由大變小。這是因?yàn)樵诘蛪毫ο码x子對(duì)襯底表面的轟擊作用變強(qiáng),離子能量到達(dá)一定程度就能打破膜生成過程中的原子鍵,造成膜膨脹而引發(fā)壓應(yīng)力。這跟后文會(huì)提到在低頻下產(chǎn)生壓應(yīng)力的根本原因是一樣的。在低頻電源作用下,等離子體中的離子容易被交變電場(chǎng)加速,到達(dá)襯底的速率要比高頻交變電場(chǎng)中的大,對(duì)襯底表面的轟擊作用也就更明顯,從而造成壓應(yīng)力。
三、離子轟擊
當(dāng)?shù)入x子體產(chǎn)生后,任何接近等離子體的物體(包括反應(yīng)室壁和電極)都會(huì)帶負(fù)電,因?yàn)殡娮拥囊苿?dòng)速度比離子快得多。帶負(fù)電的電極吸引正離子,因此電極附近的離子比電子多。
因此等離子體與電極附近因電荷差異會(huì)形成電場(chǎng),被稱為鞘層。鞘層電位差會(huì)將離子加速向電極移動(dòng),會(huì)造成離子轟擊。將一片晶圓放在電極上方,就可利用鞘層電位形成的離子加速使晶圓表面受到轟擊。而且鞘層區(qū)域內(nèi)電子較少,發(fā)光不如等離子體那樣強(qiáng)烈。可以在電極附近觀察到一個(gè)黑暗區(qū)域(暗區(qū))。
離子轟擊是等離子體的一個(gè)重要特征。任何接近等離子體的材料都會(huì)受到離子轟擊,這將影響刻蝕的速率、選擇性和輪廓,也會(huì)影響沉積速率和沉積薄膜應(yīng)力。
離子轟擊有兩個(gè)重要參數(shù):離子能量和離子流量。離子能量與等離子體功率、反應(yīng)室壓力、電極間距及工藝氣體等條件有關(guān)。在射頻等離子體系統(tǒng)中,射頻頻率會(huì)影響離子能量。例如在高頻(13.56MHz)下,電子將吸收多數(shù)能量而離子保持“冷凍靜止”。頻率較低(350kHz)時(shí),雖然大多數(shù)能量仍由電子吸收,但在變化緩慢的交流電場(chǎng)中,離子卻有機(jī)會(huì)從射頻功率中獲得能量。離子流量與等離子體的密度有關(guān),因此也與等離子體功率、反應(yīng)室壓力、電極間距及工藝氣體等條件有關(guān)。
四、直流偏壓
前面提到,等離子體電位高于電極電位。在射頻等離子體系統(tǒng)中,等離子體電位在整個(gè)循環(huán)周期內(nèi)一直維持比接地電位高的狀態(tài)。這樣腔體內(nèi)等離子體與接地電極之間將保持一個(gè)直流電位差值,這種差值稱為直流偏壓。離子轟擊的能量取決于直流偏壓,對(duì)于兩個(gè)電極面積相同且對(duì)稱的 PECVD 反應(yīng)室內(nèi)電極間的直流偏壓約為 10~20V。
射頻功率增加,直流偏壓也會(huì)增加,同時(shí)會(huì)影響等離子體密度。因此早期 CCP 只有一個(gè)射頻電源,射頻功率的變化會(huì)同時(shí)影響到離子轟擊能量和等離子體密度,所以單頻 CCP 的可控性較差。多頻 CCP 可以單獨(dú)對(duì)等離子體密度以及離子轟擊能量進(jìn)行控制,高頻電場(chǎng)主要控制等離子體密度,低頻電場(chǎng)主要控制離子轟擊能量,多頻 CCP 也是當(dāng)前主流 CCP 刻蝕設(shè)備。
-
等離子體
+關(guān)注
關(guān)注
0文章
144瀏覽量
15153
原文標(biāo)題:【推薦】等離子體的一些基礎(chǔ)知識(shí)
文章出處:【微信號(hào):深圳市賽姆烯金科技有限公司,微信公眾號(hào):深圳市賽姆烯金科技有限公司】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
射頻功率放大器在等離子體激勵(lì)及發(fā)射光譜診斷系統(tǒng)中的應(yīng)用
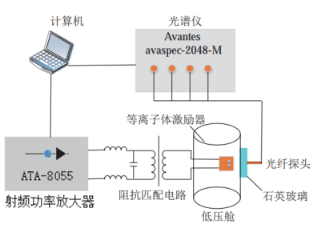
中達(dá)瑞和定制內(nèi)推式高光譜相機(jī)助力等離子體運(yùn)動(dòng)軌跡監(jiān)測(cè)
TDK PiezoBrush PZ3 - c評(píng)估套件:探索冷等離子體解決方案的利器
SPS-5T-2000℃型智能型放電等離子體燒結(jié)爐

使用簡(jiǎn)儀科技產(chǎn)品的等離子體診斷高速采集系統(tǒng)解決方案

光譜橢偏術(shù)在等離子體光柵傳感中的應(yīng)用:參數(shù)優(yōu)化與亞皮米級(jí)測(cè)量精度

探索微觀世界的“神奇火焰”:射頻等離子體技術(shù)淺談
高端芯片制造裝備的“中國(guó)方案”:等離子體相似定律與尺度網(wǎng)絡(luò)突破

遠(yuǎn)程等離子體刻蝕技術(shù)介紹

安泰高壓放大器在等離子體發(fā)生裝置研究中的應(yīng)用

上海光機(jī)所在多等離子體通道中實(shí)現(xiàn)可控Betatron輻射
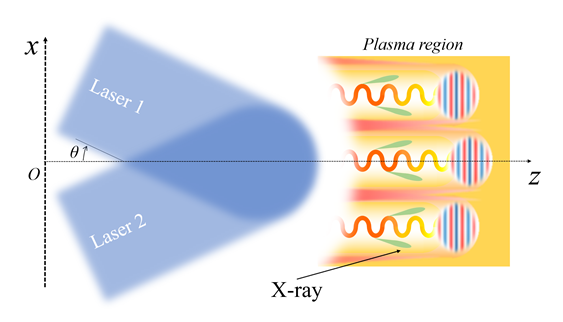
通快霍廷格電子攜前沿等離子體電源解決方案亮相SEMICON China 2025

等離子體光譜儀(ICP-OES):原理與多領(lǐng)域應(yīng)用剖析
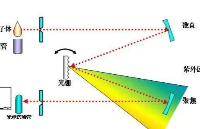
利用等離子體將鉛筆芯重新用作光學(xué)材料
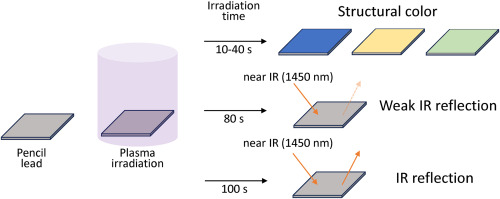
等離子體蝕刻工藝對(duì)集成電路可靠性的影響




 等離子體的一些基礎(chǔ)知識(shí)
等離子體的一些基礎(chǔ)知識(shí)




評(píng)論