引線鍵合檢測
引線鍵合完成后的檢測是確保產(chǎn)品可靠性和后續(xù)功能測試順利進(jìn)行的關(guān)鍵環(huán)節(jié)。檢測項(xiàng)目全面且細(xì)致,涵蓋了從外觀到內(nèi)部結(jié)構(gòu)的多個(gè)方面。
以下是對各項(xiàng)檢測項(xiàng)目的詳細(xì)分述:
目檢
球的推力測試
拉線測試
鍵合的失效可靠性
1
目檢
目檢是在顯微鏡下對完成品進(jìn)行的檢查,主要關(guān)注以下幾個(gè)方面:
焊球短路:確保金球與相鄰的金球或金屬引線之間無短路觸碰,避免電流異常流通。

焊點(diǎn)的位置偏移:檢查金球是否在焊墊有效面積的75%以內(nèi),且金球與相鄰金球或金屬引線之間無觸碰,確保鍵合位置準(zhǔn)確。
焊球大小:最小球徑不得小于2倍線徑,最大球徑不得大于5倍線徑,避免過大或過小影響鍵合強(qiáng)度。
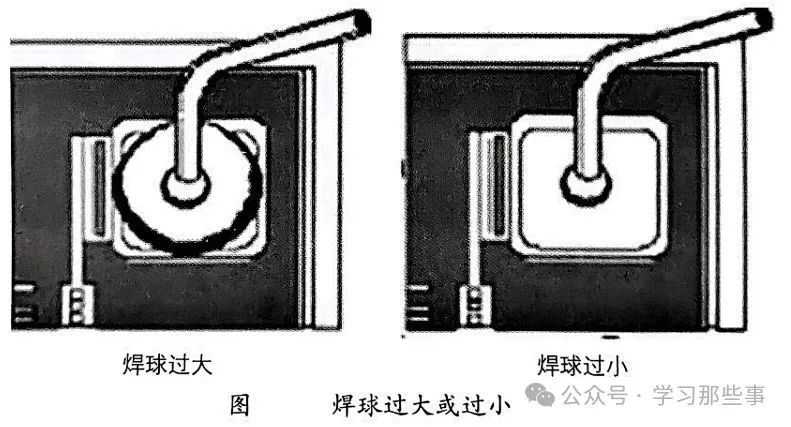
第二焊點(diǎn)的魚尾大小:第二焊點(diǎn)(魚尾)的寬度和長度需符合規(guī)定范圍,寬度不得小于1.2倍線徑或大于5倍線徑,長度不得小于0.5倍線徑或大于3倍線徑,確保焊點(diǎn)形狀符合標(biāo)準(zhǔn)。
錯(cuò)焊:核對實(shí)際焊線位置與鍵合裝配圖的要求是否一致,避免誤焊導(dǎo)致功能異常。
線尾殘留:檢查線尾是否殘留并黏著在鋁墊上或手指區(qū)、銅板區(qū)、連接帶上,殘留長度需符合規(guī)定范圍,避免影響后續(xù)工藝。
引線受損:檢查金屬引線本身和球頸部分是否存在受損、刮傷等,受損程度不得超過25%線徑,確保引線完整性。

碰線、線距不足、塌線:檢查金屬引線之間或金屬引線與芯片之間是否存在短路,線弧與線弧、線弧與芯片邊緣、線弧與其他引腳之間的間距需符合規(guī)定,避免短路和塌線現(xiàn)象。

鍵合線的弧度不良:檢查線弧的弧度是否在規(guī)格范圍內(nèi),避免弧度過大或過小影響鍵合效果和美觀。
漏焊線:核對鍵合裝配圖,確保規(guī)定應(yīng)該焊線的位置已正確焊線,避免漏焊導(dǎo)致功能缺失。
鍵合造成晶粒崩角、隱裂:檢查作業(yè)中是否因外力傷及晶粒實(shí)體,導(dǎo)致部分晶粒缺失損壞,影響芯片性能和可靠性。
第二焊點(diǎn)頸部斷裂:檢查第二焊點(diǎn)的頸部是否存在拉折、撕裂、裂痕等現(xiàn)象,確保焊點(diǎn)強(qiáng)度符合要求。
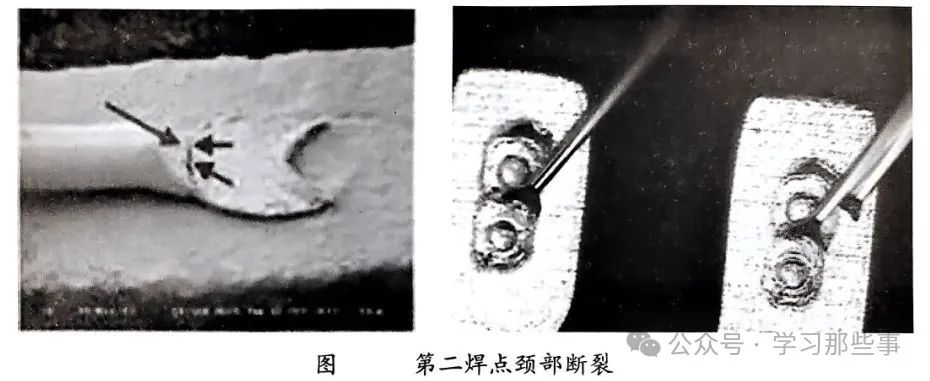
通過目檢,可以及時(shí)發(fā)現(xiàn)并排除潛在的缺陷和問題,確保引線鍵合的質(zhì)量和可靠性。同時(shí),目檢也是后續(xù)檢測項(xiàng)目的基礎(chǔ)和前提,為后續(xù)檢測提供了重要的參考和依據(jù)。
2
球的推力測試
球的推力測試,也被稱作鍵合點(diǎn)強(qiáng)度測試,是評估引線鍵合質(zhì)量的重要手段。該測試旨在通過精確的推刀夾具和測試平臺,模擬實(shí)際使用中可能遇到的剪切力,從而檢測焊球與芯片或基板之間的結(jié)合強(qiáng)度。
測試準(zhǔn)備與設(shè)備
推刀夾具:選用剛硬且精密的推刀夾具,確保測試的準(zhǔn)確性和可靠性。
三軸測試平臺:通過三軸測試平臺,可以精確控制測試頭的移動(dòng),確保測試位置準(zhǔn)確無誤。
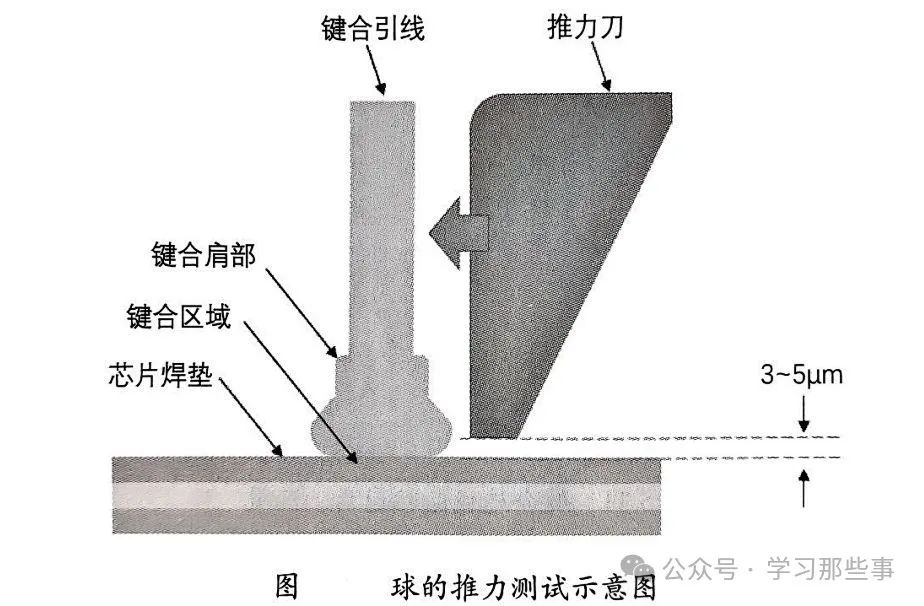
測試角度:剪切工具與芯片表面應(yīng)呈90°±5°的夾角,以確保測試力的均勻分布。
傳感器:定期校準(zhǔn)的傳感器用于測量推力大小,其負(fù)載能力應(yīng)超過焊球最大剪切力的1.1倍,以確保測試的準(zhǔn)確性。
光學(xué)芯片與顯微鏡:高功率光學(xué)芯片和穩(wěn)定的雙臂顯微鏡用于輔助觀察測試過程,確保測試操作的精確性。
攝像系統(tǒng):配置攝像系統(tǒng)進(jìn)行加載工具與焊接對準(zhǔn)、測試后檢查、故障分析和視頻捕獲,便于后續(xù)分析和記錄。
失效模式與判定
焊球在推力作用下的失效模式多種多樣,主要包括以下幾種:
球脫模式:焊球整體脫離,可能包含或不包含形成的金屬間化合物(如銅鋁材料的殘留)

焊接面殘留:經(jīng)推力作用后,焊球的焊接面會殘留銅鋁材料或僅殘留引線本身材料(如銅材料)

焊墊金屬脫離:焊墊金屬從焊墊上脫離,嚴(yán)重時(shí)甚至?xí)⑿酒幕撞牧蠋С?/p>

推刀位置錯(cuò)誤:推刀位置設(shè)置過高可能推斷引線頸部,設(shè)置過低則可能將整個(gè)焊墊層推走

通過球的推力測試,可以及時(shí)發(fā)現(xiàn)并評估引線鍵合的強(qiáng)度和質(zhì)量問題,為產(chǎn)品的可靠性和后續(xù)功能測試提供有力保障。同時(shí),該測試也是質(zhì)量控制和工藝改進(jìn)的重要依據(jù)。
3
拉線測試
拉線測試(Wire Pull)是一種用于監(jiān)控鍵合線弧質(zhì)量和工藝可靠性的重要測試方法。該測試通過施加拉力來評估鍵合線的強(qiáng)度,并確定其最弱位置。
測試位置與設(shè)備
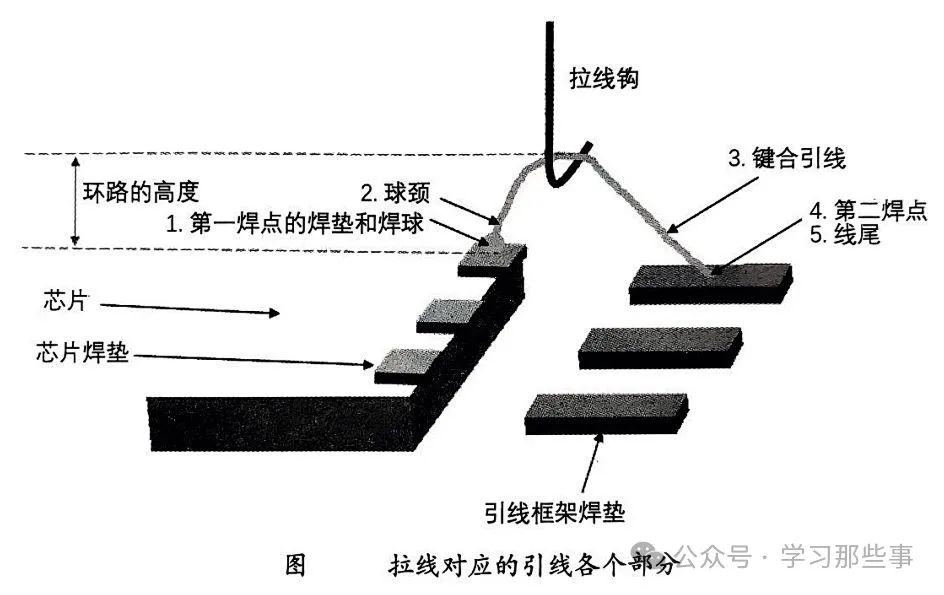
測試位置:拉線測試通常選擇在距離第一焊點(diǎn)或第二焊點(diǎn)1/3的位置進(jìn)行,以模擬實(shí)際使用中可能受到的拉力。測試位置的選擇應(yīng)確保能夠準(zhǔn)確反映鍵合線的強(qiáng)度。
測試設(shè)備:拉線測試需要使用專門的拉線鉤和測試設(shè)備,如拉力計(jì)或拉力測試機(jī)。這些設(shè)備能夠精確控制拉力的施加,并記錄測試過程中的數(shù)據(jù)。
測試方法
將拉線鉤移動(dòng)到焊線下方,并沿Z軸方向(即垂直于芯片表面的方向)向上拉扯。測試可以是破壞性的,即直到焊接被破壞;也可以是非破壞性的,即達(dá)到預(yù)先定義的力度后停止。
拉力范圍與評判標(biāo)準(zhǔn)
拉力范圍:拉力的測試范圍通常根據(jù)具體需求而定,常見的范圍包括0~100g、0~1kg和0~10kg等。
質(zhì)量評判:拉線測試后,需要對鍵合引線的各個(gè)部分進(jìn)行質(zhì)量評判。評判內(nèi)容包括第一焊點(diǎn)的焊墊和焊球、球頸、鍵合引線、焊接位置以及第二焊點(diǎn)的線尾等。根據(jù)評判結(jié)果,可以確定鍵合線的強(qiáng)度和質(zhì)量是否符合要求。
第二焊點(diǎn)拉線力測試
測試目的:第二焊點(diǎn)拉線力測試是評估第二焊點(diǎn)鍵合強(qiáng)度的一種方法。它通過觀察拉線后殘留金屬的狀況,為工藝分析提供重要信息。
測試方法:進(jìn)行第二焊點(diǎn)拉線力測試時(shí),拉線鉤應(yīng)盡量靠近第二焊點(diǎn),以確保線弧在第二焊點(diǎn)處斷裂。該測試是破壞性的,通常不作為標(biāo)準(zhǔn)測試項(xiàng),但在特定情況下可用于分析工藝問題。
4
鍵合的失效可靠性
在超聲波焊鍵合過程中,焊盤產(chǎn)生彈坑是一種常見的缺陷現(xiàn)象,它指的是焊盤金屬層下方的二氧化硅層或其他層次受到破壞。彈坑通常肉眼難以察覺,但其對電性能的影響卻不容忽視。
彈坑產(chǎn)生的原因
彈坑的產(chǎn)生源于多種因素,主要包括以下幾個(gè)方面:
超聲波能量過高:當(dāng)超聲波能量超過一定閾值時(shí),會導(dǎo)致硅晶格點(diǎn)陣的破壞,進(jìn)而形成彈坑。過高的能量輸入使得焊盤下方的材料無法承受,從而產(chǎn)生損傷。
鍵合壓力過大:在楔焊鍵合過程中,如果鍵合力過高,同樣會對焊盤下方的材料造成壓迫,導(dǎo)致彈坑的產(chǎn)生。
焊球尺寸不合適:如果焊球太小,堅(jiān)硬的鍵合工具在鍵合過程中可能會直接接觸到焊盤金屬層,而非通過焊球進(jìn)行緩沖,從而增加焊盤受損的風(fēng)險(xiǎn)。
焊盤厚度不足:焊盤的厚度是影響其抗損傷能力的重要因素。當(dāng)焊盤厚度小于一定值時(shí)(如0.6微米以下),其抵抗外力破壞的能力會顯著降低,更容易產(chǎn)生彈坑。
材料硬度不匹配:焊盤金屬和金屬引線的硬度如果匹配不當(dāng),也可能導(dǎo)致彈坑的產(chǎn)生。硬度差異過大時(shí),較軟的材料更容易受到損傷。
鋁絲超聲波焊鍵合的特殊性:在鋁絲超聲波焊鍵合中,由于鋁絲的硬度相對較高,如果工藝參數(shù)控制不當(dāng),也容易導(dǎo)致晶圓焊盤產(chǎn)生彈坑。
芯片本身的問題:芯片本身的質(zhì)量問題,如材料缺陷、加工精度不足等,也可能導(dǎo)致彈坑的產(chǎn)生。
晶圓測試時(shí)的損傷:在晶圓測試過程中,如果探針操作不當(dāng),也可能刺傷焊墊,進(jìn)而引發(fā)彈坑問題。
彈坑對可靠性的影響
彈坑的存在會嚴(yán)重影響鍵合的可靠性。首先,彈坑會破壞焊盤與金屬引線之間的電氣連接,導(dǎo)致電路性能下降或失效。其次,彈坑還可能成為潛在的裂紋源,隨著時(shí)間和環(huán)境的變化,裂紋可能逐漸擴(kuò)展,最終導(dǎo)致整個(gè)鍵合結(jié)構(gòu)的失效。
因此,在超聲波焊鍵合過程中,必須嚴(yán)格控制工藝參數(shù),確保焊盤、焊球、金屬引線等材料的匹配性,以及芯片本身的質(zhì)量。同時(shí),在晶圓測試和后續(xù)處理過程中,也需要采取適當(dāng)?shù)拇胧苊鈱笁|造成損傷。通過這些措施,可以有效降低彈坑產(chǎn)生的風(fēng)險(xiǎn),提高鍵合的可靠性和穩(wěn)定性。
彈坑缺陷與化學(xué)腐蝕分析
彈坑是超聲波焊鍵合中常見的一種缺陷,它指的是焊盤金屬層下方的二氧化硅層或其他層次受到破壞。為了深入分析彈坑缺陷,通常需要進(jìn)行化學(xué)腐蝕分析。
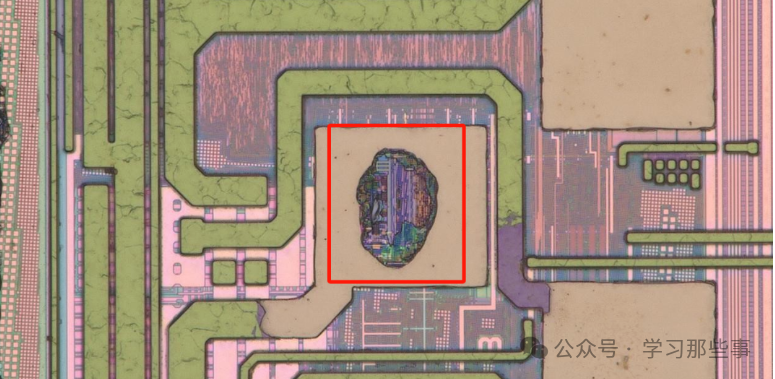
這一分析過程涉及將焊區(qū)的金屬鋁腐蝕掉,以觀察金屬間化合物的覆蓋率和焊區(qū)金屬層下方電路是否有損傷。
鍵合點(diǎn)的質(zhì)量與可靠性問題
在實(shí)際生產(chǎn)過程中,鍵合點(diǎn)可能會遇到多種問題,如開裂、翹起、尾部不一致以及剝離等。這些問題可能由多種因素導(dǎo)致,包括引線通道不干凈、進(jìn)料角度不對、劈刀堵塞、引線夾污染、夾力或距離不正確、張力不正確等。此外,金屬間化合物的形成、引線彎曲疲勞、腐蝕、金屬遷移以及振動(dòng)疲勞等也是影響鍵合可靠性的主要原因。
影響鍵合可靠性的主要因素
焊接面絕緣層未去除干凈:如芯片鍵合區(qū)的光刻膠或窗口鈍化膜殘留,會導(dǎo)致金屬間鍵合不良,形成絕緣夾層,增加接觸電阻,降低鍵合可靠性。
金屬層缺陷:如芯片金屬層過薄、有合金點(diǎn)或黏附不牢固,會導(dǎo)致鍵合時(shí)無緩沖作用,形成缺陷,或壓焊點(diǎn)容易脫落。
表面沾污:各部件在各個(gè)環(huán)節(jié)均可能產(chǎn)生沾污,如灰塵、有機(jī)物、鈉等,會導(dǎo)致原子不能互相擴(kuò)散,影響鍵合質(zhì)量。
材料間接觸應(yīng)力不當(dāng):鍵合應(yīng)力過小會導(dǎo)致鍵合不牢,過大則會影響鍵合點(diǎn)的機(jī)械性能,甚至損傷芯片材料。
引線框架腐蝕:鍍層污染過多及較高的殘余應(yīng)力會導(dǎo)致引線框架腐蝕,影響鍵合可靠性。
-
檢測
+關(guān)注
關(guān)注
5文章
4904瀏覽量
94262 -
引線鍵合
+關(guān)注
關(guān)注
2文章
38瀏覽量
8627
原文標(biāo)題:一文了解引線鍵合檢測
文章出處:【微信號:芯長征科技,微信公眾號:芯長征科技】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
有償求助本科畢業(yè)設(shè)計(jì)指導(dǎo)|引線鍵合|封裝工藝
半導(dǎo)體引線鍵合清洗工藝方案
大功率IGBT模塊封裝中的超聲引線鍵合技術(shù)
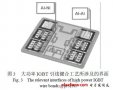
集成電路封裝中的引線鍵合技術(shù)

LED引線鍵合的檢測內(nèi)容與工藝評價(jià)
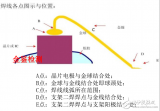
LED引線鍵合工藝評價(jià)
什么是引線鍵合?引線鍵合的演變

3D 結(jié)構(gòu)和引線鍵合檢測對比

金絲引線鍵合的影響因素探究

引線鍵合之DOE試驗(yàn)
帶你一文了解什么是引線鍵合(WireBonding)技術(shù)?

引線鍵合的基礎(chǔ)知識

引線鍵合替代技術(shù)有哪些

什么是引線鍵合?芯片引線鍵合保護(hù)膠用什么比較好?




 引線鍵合檢測的基礎(chǔ)知識
引線鍵合檢測的基礎(chǔ)知識

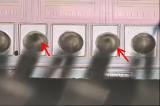



評論