二氧化硅薄膜實(shí)現(xiàn)增透的原因主要涉及以下幾個方面:
1. 折射率匹配
- 折射率特性 :二氧化硅(SiO?)的折射率相對較低,這使得它能夠作為一層有效的增透膜(或稱為減反射膜)。當(dāng)光線從一種介質(zhì)進(jìn)入另一種介質(zhì)時,會在界面上發(fā)生反射和折射。如果增透膜的折射率介于基底(如玻璃)和空氣之間,它可以有效地減少光線在界面上的反射,使更多的光線進(jìn)入基底并被吸收或透射。
- 能量守恒 :根據(jù)能量守恒定律,反射光與透射光的能量之和為入射光的能量。因此,當(dāng)光學(xué)薄膜的反射減少時,光的透射就會增加。
2. 薄膜厚度控制
- 納米級厚度 :納米級厚度的二氧化硅薄膜由于其極小的厚度,材料吸收造成的損耗極少,因此可以更有效地減少光的反射。
- 均勻性 :薄膜厚度的均勻性對于實(shí)現(xiàn)增透效果至關(guān)重要。如果薄膜厚度不均勻,會導(dǎo)致光的反射和透射特性在不同區(qū)域出現(xiàn)差異,從而影響整體的增透效果。
3. 孔隙結(jié)構(gòu)
- 多孔結(jié)構(gòu) :部分二氧化硅薄膜具有多孔結(jié)構(gòu),這些孔隙可以降低薄膜的折射率,進(jìn)一步減少光的反射。同時,孔隙結(jié)構(gòu)還可以提高薄膜的表面積,有助于吸附和固定其他功能材料。
- 環(huán)境穩(wěn)定性 :為了提高多孔膜的環(huán)境穩(wěn)定性,有時會采用氟硅烷等改性劑對薄膜進(jìn)行改性處理,以防止其吸附環(huán)境中的污染物而導(dǎo)致透過率下降。
4. 鍍膜工藝
- 制備方法 :二氧化硅薄膜的制備方法多種多樣,包括物理氣相沉積、化學(xué)氣相沉積、溶膠凝膠法等。不同的制備方法會影響薄膜的結(jié)構(gòu)和性能,進(jìn)而影響其增透效果。
- 工藝優(yōu)化 :通過優(yōu)化鍍膜工藝參數(shù)(如蒸發(fā)速度、蒸發(fā)溫度、裝量控制等),可以控制薄膜的厚度、均勻性和折射率等特性,從而實(shí)現(xiàn)更好的增透效果。
5. 應(yīng)用領(lǐng)域
- 二氧化硅薄膜由于其優(yōu)異的增透性能,被廣泛應(yīng)用于太陽能電池、光學(xué)儀器、顯示器等領(lǐng)域。在這些應(yīng)用中,增透膜能夠有效地提高光能利用效率、改善視覺效果等。
綜上所述,二氧化硅薄膜實(shí)現(xiàn)增透的原因主要包括折射率匹配、薄膜厚度控制、孔隙結(jié)構(gòu)、鍍膜工藝以及應(yīng)用領(lǐng)域的需求等多個方面。這些因素共同作用,使得二氧化硅薄膜成為一種重要的光學(xué)薄膜材料。
聲明:本文內(nèi)容及配圖由入駐作者撰寫或者入駐合作網(wǎng)站授權(quán)轉(zhuǎn)載。文章觀點(diǎn)僅代表作者本人,不代表電子發(fā)燒友網(wǎng)立場。文章及其配圖僅供工程師學(xué)習(xí)之用,如有內(nèi)容侵權(quán)或者其他違規(guī)問題,請聯(lián)系本站處理。
舉報(bào)投訴
-
參數(shù)
+關(guān)注
關(guān)注
11文章
1870瀏覽量
33999 -
能量守恒定律
+關(guān)注
關(guān)注
0文章
11瀏覽量
6128
發(fā)布評論請先 登錄
相關(guān)推薦
熱點(diǎn)推薦
PECVD工藝參數(shù)對二氧化硅薄膜致密性的影響
背景二氧化硅薄膜具有硬度大、防腐蝕性、耐潮濕性和介電性能強(qiáng)等優(yōu)點(diǎn),因此二氧化硅薄膜在半導(dǎo)體行業(yè)中可以用作器件的保護(hù)層、鈍化層、隔離層等。 PECVD即等離子體增強(qiáng)化學(xué)的氣相沉積法是借助
VirtualLab Fusion應(yīng)用:氧化硅膜層的可變角橢圓偏振光譜(VASE)分析
VirtualLab Fusion中的橢圓偏振分析器在二氧化硅(SiO2)涂層上的使用。對于系統(tǒng)的參數(shù),我們參考Woollam等人的工作 \"可變角度橢圓偏振光譜儀(VASE)概述。I.
發(fā)表于 02-05 09:35
VirtualLab Fusion應(yīng)用:氧化硅膜層的可變角橢圓偏振光譜(VASE)分析
VirtualLab Fusion中的橢圓偏振分析器在二氧化硅(SiO2)涂層上的使用。對于系統(tǒng)的參數(shù),我們參考Woollam等人的工作 \"可變角度橢圓偏振光譜儀(VASE)概述。I.
發(fā)表于 06-05 08:46
二氧化碳傳感器
二氧化碳傳感器通常是利用紅外輻射的方式進(jìn)行測量。由于二氧化碳對2.7、4.35和14.5波段處紅外線有強(qiáng)烈的吸收,并且考慮到2.7和14.5兩個吸收帶都易受到水汽吸收的影響,因此通常選擇4.35處
發(fā)表于 09-14 22:32
二氧化鈦白色和黑色的區(qū)別
易蒸發(fā),但是需要充氧,因?yàn)?b class='flag-5'>二氧化鈦在真空中加熱蒸發(fā)時會分解失氧,形成高吸收的鈦的亞氧化物薄膜。因此,在鍍制過程中需要給其充加氧氣。TiO2用于防反膜,分光膜,冷光膜,濾光片,高反膜,眼鏡膜,熱反射鏡等
發(fā)表于 11-20 10:03
石灰石二氧化硅化驗(yàn)儀器設(shè)備系列
`石灰石二氧化硅化驗(yàn)儀器設(shè)備系列 石灰石二氧化硅化驗(yàn)儀器設(shè)備系列 英特儀器測試石灰石硅含量儀器,檢測石英砂二氧化硅的設(shè)備,化驗(yàn)石灰石二氧化硅的設(shè)備,石英砂硅鐵檢測儀,化驗(yàn)石灰石硅設(shè)備英
發(fā)表于 03-11 11:24
用磷酸揭示氮化硅對二氧化硅的選擇性蝕刻機(jī)理
關(guān)鍵詞:氮化硅,二氧化硅,磷酸,選擇性蝕刻,密度泛函理論,焦磷酸 介紹 信息技術(shù)給我們的現(xiàn)代社會帶來了巨大的轉(zhuǎn)變。為了提高信息技術(shù)器件的存儲密度,我們?nèi)A林科納使用淺溝槽隔離技術(shù)將半導(dǎo)體制造成無漏
發(fā)表于 12-28 16:38
?8778次閱讀

碳化硅和二氧化硅之間穩(wěn)定性的刻蝕選擇性
磷酸(H3PO4) -水(H2O)混合物在高溫下已被使用多年來蝕刻對二氧化硅(二氧化硅)層有選擇性的氮化硅(Si3N4)。生產(chǎn)需要完全去除Si3N4,同時保持二氧化硅損失最小。批量晶片

二氧化硅蝕刻標(biāo)準(zhǔn)操作程序研究報(bào)告
緩沖氧化物蝕刻(BOE)或僅僅氫氟酸用于蝕刻二氧化硅在硅上晶片。 緩沖氧化蝕刻是氫氟酸和氟化銨的混合物。含氟化銨的蝕刻使硅表面具有原子平滑的表面高頻。 由于這一過程中所涉及的酸具有很高的健康風(fēng)險(xiǎn),建議用戶使用在執(zhí)行工藝之前,請仔
發(fā)表于 03-10 16:43
?2363次閱讀

在超臨界二氧化碳中蝕刻氧化硅薄膜
介紹 硅或二氧化硅已被用作犧牲層來制造獨(dú)立式結(jié)構(gòu),例如微機(jī)電系統(tǒng)(MEMS)中的梁、懸臂和隔膜。傳統(tǒng)的含水HF已經(jīng)廣泛用于蝕刻二氧化硅犧牲層,因?yàn)樗杀镜土H欢?dāng)具有高縱橫比的結(jié)構(gòu)在含水
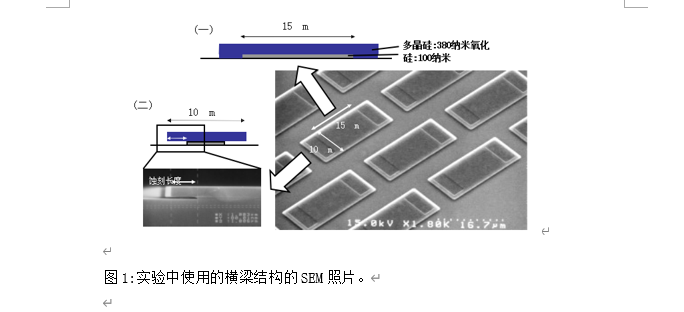
鍍膜使用二氧化硅的作用
1. 引言 鍍膜技術(shù)是一種在基材表面形成薄膜的技術(shù),廣泛應(yīng)用于光學(xué)、電子、機(jī)械、建筑等領(lǐng)域。二氧化硅作為一種常見的無機(jī)材料,因其良好的光學(xué)性能、化學(xué)穩(wěn)定性和機(jī)械強(qiáng)度,在鍍膜技術(shù)中得到了廣泛應(yīng)用
芯片制造中的二氧化硅介紹
二氧化硅是芯片制造中最基礎(chǔ)且關(guān)鍵的絕緣材料。本文介紹其常見沉積方法與應(yīng)用場景,解析SiO?在柵極氧化、側(cè)墻注入、STI隔離等核心工藝中的重要作用。

晶圓背面二氧化硅邊緣腐蝕的原因
在集成電路生產(chǎn)過程中,晶圓背面二氧化硅邊緣腐蝕現(xiàn)象是一個常見但復(fù)雜的問題。每個環(huán)節(jié)都有可能成為晶圓背面二氧化硅邊緣腐蝕的誘因,因此需要在生產(chǎn)中嚴(yán)格控制每個工藝參數(shù),尤其是對邊緣區(qū)域的處理,以減少這種現(xiàn)象的發(fā)生。
為什么LED芯片正電極要插入二氧化硅電流阻擋層,而負(fù)極沒有?
為什么LED正電極需要二氧化硅阻擋層?回答:LED芯片正極如果沒有二氧化硅阻擋層,芯片會出現(xiàn)電流分布不均,電流擁擠效應(yīng),電極燒毀等現(xiàn)象。由于藍(lán)寶石的絕緣性,傳統(tǒng)LED的N和P電極都做在芯片出光面
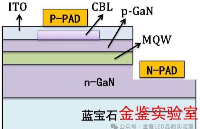



 二氧化硅薄膜實(shí)現(xiàn)增透的原因
二氧化硅薄膜實(shí)現(xiàn)增透的原因




評論