盡管傳統(tǒng)高壓平面 MOSFET 取得了進(jìn)步,但由于阻斷或漏源擊穿電壓因厚度、摻雜和幾何形狀而變化,因此局限性仍然存在。本文將講解超級(jí)結(jié) MOSFET(例如意法半導(dǎo)體的 MDmesh 技術(shù))通過(guò)晶圓上又深又窄的溝槽來(lái)應(yīng)對(duì)這些挑戰(zhàn)。
01
該技術(shù)非常適合開關(guān)模式電源,采用超級(jí)結(jié)多漏極結(jié)構(gòu)來(lái)降低漏源壓降。高漏電或軟擊穿電壓等問(wèn)題可能是由塊狀形成中的污染物或缺陷引??起的。因此,多尺度和多模態(tài)關(guān)聯(lián)顯微鏡工作流程對(duì)于缺陷定位和分析至關(guān)重要,需要先進(jìn)的硬件和軟件解決方案來(lái)進(jìn)行有效的樣品研究。
功率半導(dǎo)體器件在感應(yīng)加熱、電動(dòng)汽車和可再生能源等應(yīng)用中因其效率和多功能性而受到重視,它們依賴于碳化硅和氮化鎵等材料。與硅相比,這些材料具有較寬的禁帶寬度和優(yōu)異的性能,實(shí)現(xiàn)更高的擊穿電壓。
由高溫、過(guò)流和過(guò)壓等因素引起的運(yùn)行故障需要徹底了解結(jié)效應(yīng)和結(jié)構(gòu),這對(duì)于 SiC 在線監(jiān)測(cè)、缺陷定位和可靠性分析至關(guān)重要。對(duì)于 GaN,可通過(guò)電子束感應(yīng)電流 (EBIC) 等技術(shù)檢測(cè)的位錯(cuò)帶來(lái)了挑戰(zhàn),突出表明需要采用整體方法來(lái)表征功率半導(dǎo)體,以確保各種應(yīng)用中的可靠性。
02
蔡司和 Kleindiek Nanotechnik 的開創(chuàng)性聯(lián)合解決方案
在半導(dǎo)體的制造過(guò)程中,各種雜質(zhì)往往會(huì)在晶格中引入缺陷,導(dǎo)致局部區(qū)域出現(xiàn)高電阻或高導(dǎo)電率。為了進(jìn)行有效的故障分析,訪問(wèn)地下斷層點(diǎn)并了解構(gòu)造和連接剖面至關(guān)重要。在這些情況下,銑削對(duì)于器件制造中精確蝕刻半導(dǎo)體晶圓至關(guān)重要,這有助于以高度受控的方式去除層。
Zeiss 和 Kleindiek Nanotechnik 提出的技術(shù)由多個(gè)要素組成,其中 Zeiss Crossbeam 聚焦離子束掃描電子顯微鏡 (FIB-SEM) 用于銑削和成像。然后使用 Object Research Systems Inc. 的 Zeiss Atlas 5 和 Dragonfly Pro 軟件來(lái)處理和可視化斷層掃描數(shù)據(jù)。此外,Zeiss GeminiSEM 300 與 Kleindiek Nanotechnik PS8 Prober Shuttle 和 Keithley 4200-SCS 參數(shù)分析儀配對(duì),可用于 EBIC 測(cè)量。
03
該解決方案如何幫助芯片制造商并提供進(jìn)一步的見解
通過(guò)將被動(dòng)電壓對(duì)比 (PVC) SEM 成像與連續(xù) FIB 材料去除相結(jié)合,F(xiàn)IB-SEM 斷層掃描不僅可以可視化設(shè)備架構(gòu),還可以以 3D 形式可視化植入物形狀。這用于連接點(diǎn)健康狀況的 2D EBIC 調(diào)查,以進(jìn)行故障分析、流程開發(fā)和監(jiān)控。
根據(jù) Zeiss 的說(shuō)法,“EBIC 測(cè)量是在設(shè)備表面的 FIB 斜切處進(jìn)行的。這種切割使器件保持功能,從而實(shí)現(xiàn)電接觸,從而通過(guò)改變柵極電壓來(lái)研究器件中幾乎任何位置的結(jié)行為成為可能。”
FIB-SEM 斷層掃描是分析硅或 SiC 功率器件電氣故障的有用工具。它提供種植體形狀的精確 3D 成像并表征有問(wèn)題的區(qū)域。此外,它還通過(guò)提供有關(guān)各種植入?yún)^(qū)域的尺寸、均勻性和對(duì)準(zhǔn)的信息來(lái)幫助工藝開發(fā)和監(jiān)控。該數(shù)據(jù)對(duì)于解釋單個(gè)橫截面中可訪問(wèn)連接點(diǎn)的 2D EBIC 結(jié)果非常有價(jià)值。值得注意的是,這項(xiàng)研究并未包括對(duì) GaN 器件的評(píng)估。
據(jù)觀察,高能 Ga-FIB 銑削對(duì)硅基和 SiC 功率器件中的 SEM 摻雜劑對(duì)比成像和 EBIC 測(cè)量的影響可以忽略不計(jì)。這一發(fā)現(xiàn)使芯片制造商能夠繼續(xù)采用現(xiàn)有的 Ga-FIB 銑削工具和技術(shù),而無(wú)需采用成本更高且維護(hù)密集的等離子 FIB 工具。
“這兩種技術(shù)結(jié)合起來(lái)不僅可以告訴我們 pn 結(jié)的制造和植入物的去向,還可以告訴我們它的原位性能,”Kleindiek Nanotech 的發(fā)言人說(shuō)。“這樣的結(jié)果可以提供制造反饋以及功率器件實(shí)時(shí)運(yùn)行的信息。這些對(duì)于 TCAD 仿真、器件性能和可靠性分析的總體驗(yàn)證非常有用。”
04
使用的顯微鏡??技術(shù)
使用了多種顯微鏡技術(shù),將它們結(jié)合起來(lái)可以產(chǎn)生理想的結(jié)果。SEM、FIB 和 SEM 原位電探測(cè)技術(shù)是使用的一些主要技術(shù),其中使用 FIB-SEM 斷層掃描的成熟技術(shù)完成摻雜劑區(qū)域的 3D 可視化,以補(bǔ)充 EBIC 的 2D 結(jié)檢查。在摻雜成像中,研究人員最大限度地利用了 PVC,這是一種 3D 成像技術(shù)。
FIB-SEM 斷層掃描利用二次電子成像以 3D 方式可視化電活性注入?yún)^(qū)域,而 EBIC 捕獲 pn 結(jié)處的耗盡區(qū)狀態(tài),這些技術(shù)相互補(bǔ)充。
“PVC 是結(jié)點(diǎn)內(nèi)置電勢(shì)的函數(shù);有些人可能將其稱為結(jié)兩側(cè)不同電子親和力的特性,”研究人員說(shuō)。“結(jié)的負(fù)電[p側(cè)]能夠比正電[n側(cè)]發(fā)射更多的二次電子。當(dāng)您用電子束掃描結(jié)的兩側(cè)時(shí),您會(huì)得到一張圖像,其中黑色區(qū)域表示 n 型區(qū)域。該摻雜劑分析提供了植入物去向的圖片以及 SEM 的分辨率。
“我們的斷層掃描技術(shù)可以以 3D 方式觀察這些植入物的分布,這是任何其他方法都無(wú)法實(shí)現(xiàn)的——整個(gè)設(shè)備可以被重建,”他們補(bǔ)充道。
05
銑削工藝按其技術(shù)規(guī)范進(jìn)行
使用 30 kV 30 nA Ga-FIB 探針以與芯片表面成 36° 的角度切割硅基 IGBT 和 SiC 基 MOSFET 器件的橫截面。硅 IGBT 的最終尺寸為 330 × 100 μm 2 , SiC MOSFET 的尺寸為100 × 20 μm 2 。使用氣態(tài) Pt 和 C 前驅(qū)體在橫截面上沉積鉑 (Pt) 和碳 (C) 保護(hù)層。在 FIB-SEM 斷層掃描期間切割基準(zhǔn)線以實(shí)現(xiàn)精確的切片厚度控制。
在感興趣的體積前面銑削出一個(gè)大溝槽,并在自動(dòng)化過(guò)程中去除厚度為 50 nm(硅 IGBT)或 30 nm(SiC MOSFET)的切片。每個(gè)切片后記錄 SEM 圖像,形成硅 IGBT 的 1,120 個(gè)切片的數(shù)據(jù)集 (38.5 × 13.4 × 56.0 μm 3)和 320 個(gè) SiC MOSFET 切片(16.3 × 4.6 × 9.6 μm 3)。
當(dāng)談到 2D 摻雜劑成像和 2D EBIC 時(shí),研究人員指出,“FIB 銑削方法的 EBIC 替代方案是機(jī)械切片,然后進(jìn)行廣泛的氬離子束拋光。” 另一方面,對(duì)于 3D 摻雜劑成像,“沒(méi)有任何銑削方法可以替代使用 Ga 或其他離子種類的 FIB 銑削。”
06
束損傷和 Ga+ 擴(kuò)散對(duì)模型的影響
研究表明,在功率器件中,Ga-FIB引起的表面非晶化和Ga注入并不是影響摻雜劑對(duì)比成像和EBIC的重要因素。
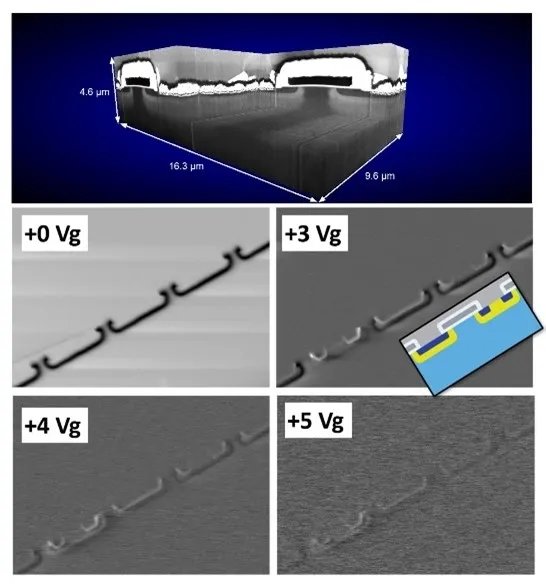 采用 EBIC 成像的 FIB-SEM 斷層掃描
采用 EBIC 成像的 FIB-SEM 斷層掃描上圖中的頂部描繪了從 SiC MOSFET 捕獲的FIB-SEM 斷層掃描數(shù)據(jù)集。為了揭示器件內(nèi)復(fù)雜的結(jié)構(gòu)和摻雜劑分布,大約三分之一的體積被選擇性地去除。
圖中的 SiC 樣品經(jīng)過(guò)原位 EBIC 成像,以觀察與柵極電壓相關(guān)的耗盡區(qū)。+4-Vg 圖像覆蓋了各個(gè)注入?yún)^(qū)域,顯示出隨著柵極電壓的增加,P 阱和 N CSL 外延層之間的耗盡區(qū)逐漸減弱。值得注意的是,N+源極/P阱層在此過(guò)程中變得越來(lái)越明顯。
Zeiss 和 Kleindiek Nanotechnik 聯(lián)合解決方案提供了一種分析 SiC 和 GaN 器件中功率半導(dǎo)體結(jié)的創(chuàng)新方法。通過(guò)將 FIB-SEM 斷層掃描與先進(jìn)的軟件工具相結(jié)合,該技術(shù)可以對(duì)植入物形狀進(jìn)行精確的 3D 成像,從而為設(shè)備架構(gòu)和連接健康狀況提供有價(jià)值的見解。
在傾斜 FIB 切割處包含 EBIC 測(cè)量可以增強(qiáng)對(duì)電氣行為的理解。這種綜合方法可幫助芯片制造商進(jìn)行缺陷定位、工藝開發(fā)和監(jiān)控,從而提高功率半導(dǎo)體器件在各種應(yīng)用中的可靠性。
以上就是關(guān)于如何利用 Ga-FIB 洞察 SiC 和 GaN 功率半導(dǎo)體結(jié)的全部?jī)?nèi)容分享。浮思特科技專注在新能源汽車、電力新能源、家用電器、觸控顯示,4大領(lǐng)域,主要供應(yīng)功率半導(dǎo)體元器件:IGBT/IGBT模塊、單片機(jī)、AC-DC芯片、IPM等。
-
SiC
+關(guān)注
關(guān)注
32文章
3726瀏覽量
69443 -
GaN
+關(guān)注
關(guān)注
21文章
2367瀏覽量
82514 -
功率半導(dǎo)體
+關(guān)注
關(guān)注
23文章
1467瀏覽量
45202
發(fā)布評(píng)論請(qǐng)先 登錄
SiC MOSFET功率半導(dǎo)體及配套驅(qū)動(dòng)對(duì)五萬(wàn)億電網(wǎng)投資的賦能作用

“三個(gè)必然”戰(zhàn)略論斷下的SiC碳化硅功率半導(dǎo)體產(chǎn)業(yè)演進(jìn)與自主可控之路
面向能源互聯(lián)網(wǎng)的功率半導(dǎo)體變革:基本半導(dǎo)體ED3系列SiC MOSFET功率模塊

SiC碳化硅MOSFET功率半導(dǎo)體銷售培訓(xùn)手冊(cè):電源拓?fù)渑c解析

SiC碳化硅功率半導(dǎo)體市場(chǎng)推廣與銷售賦能綜合報(bào)告
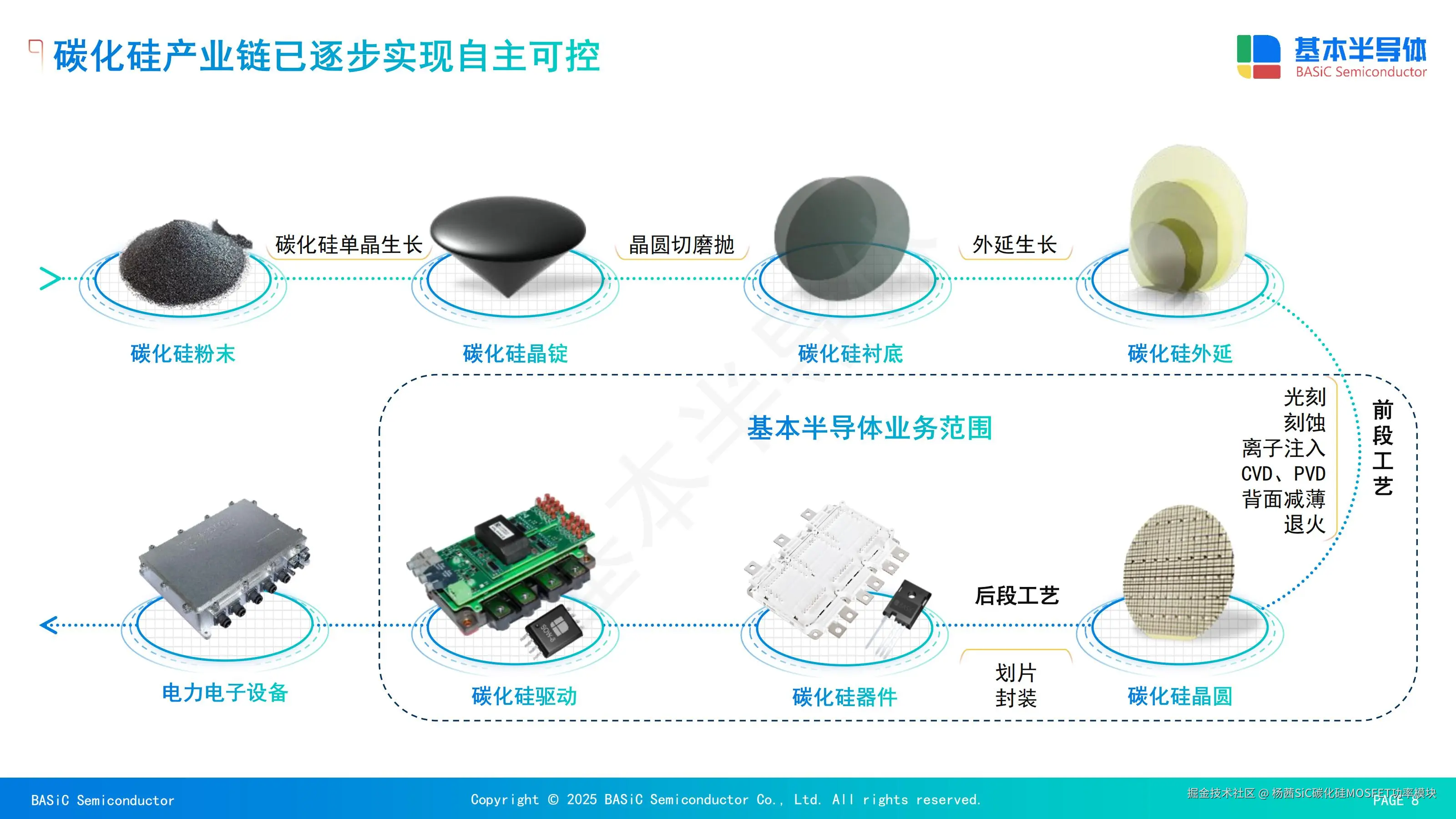
新型功率半導(dǎo)體決勝關(guān)鍵:智威科技憑超高散熱封裝GaN氮化鎵脫穎而出

BW-4022A半導(dǎo)體分立器件綜合測(cè)試平臺(tái)---精準(zhǔn)洞察,卓越測(cè)量
傾佳電子行業(yè)洞察:中國(guó)SiC碳化硅功率半導(dǎo)體發(fā)展趨勢(shì)與企業(yè)采購(gòu)策略深度解析

傾佳電子代理的BASiC基本半導(dǎo)體SiC功率器件產(chǎn)品線選型指南
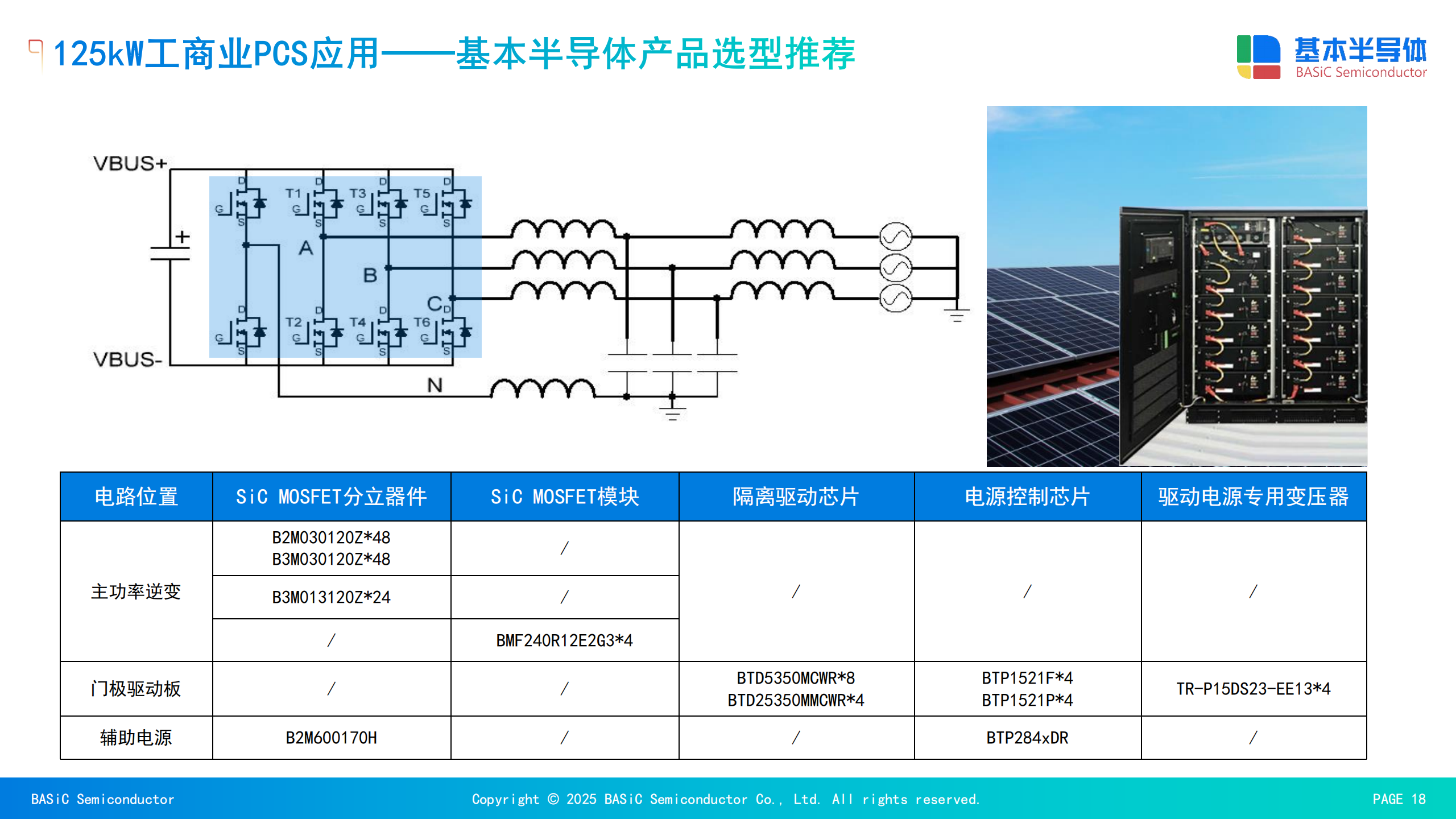
SiC碳化硅MOSFET功率半導(dǎo)體熱設(shè)計(jì)深度分析報(bào)告

傾佳電子行業(yè)洞察工業(yè)機(jī)器人伺服電控技術(shù)深度解析:SiC功率模塊的變革與未來(lái)

FIB在半導(dǎo)體分析測(cè)試中的應(yīng)用

深愛半導(dǎo)體 代理 SIC213XBER / SIC214XBER 高性能單相IPM模塊
國(guó)產(chǎn)SiC碳化硅功率半導(dǎo)體企業(yè)引領(lǐng)全球市場(chǎng)格局重構(gòu)
GaN與SiC功率器件深度解析




 利用 Ga-FIB 洞察 SiC 和 GaN 功率半導(dǎo)體結(jié)
利用 Ga-FIB 洞察 SiC 和 GaN 功率半導(dǎo)體結(jié)




評(píng)論