1. 引言:功率半導體熱管理的重要性與SiC技術的崛起
1.1 功率器件熱管理在電力電子中的核心地位
在現代電力電子系統中,功率半導體器件的熱管理已超越單純的可靠性考量,成為決定系統性能、效率和小型化水平的核心設計要素。有效的熱管理能夠確保器件的結溫(TJ?)維持在安全工作范圍內,防止因過熱導致的性能下降甚至永久性損壞。同時,降低器件工作結溫能夠顯著提升其運行效率。例如,在碳化硅(SiC)技術中,由于其卓越的特性,能夠減少熱管理對散熱片的需求,甚至完全省去,從而直接降低了系統的尺寸、重量和成本,為實現更高的功率密度提供了可能 。因此,熱管理不僅是被動地保護器件,更是通過優化散熱來主動提升系統性能的關鍵設計環節。

1.2 硅(Si)基功率半導體的熱阻發展簡史
硅(Si)基功率半導體的熱管理發展史,是隨著器件結構不斷演進以應對更高功率密度挑戰的歷史。早期的功率MOSFET技術,如雙擴散MOSFET(DMOS),由日本的研究人員在20世紀70年代提出,并逐步應用于音頻功率放大器等領域 。隨后,器件制造商如日立(Hitachi)在1977年至1983年間成為LDMOS的獨家制造商,其產品被廣泛應用于各種放大器和通信系統中 。隨著對性能要求的提高,超結(Superjunction)MOSFET概念的提出,通過在P型和N型層之間交替堆疊,部分緩解了硅器件高擊穿電壓與導通電阻之間的矛盾,從而改善了功率損耗和熱性能 。然而,硅材料自身的熱導率較低,限制了其在極端高頻和高功率應用中的性能提升空間,最終成為行業發展的瓶頸。

1.3 寬禁帶半導體SiC的顛覆性影響
碳化硅(SiC)作為第三代寬禁帶半導體材料,以其優異的物理特性從根本上解決了硅器件的熱學和電學瓶頸,為功率半導體領域帶來了革命性的變革 。SiC的禁帶寬度是硅的3倍,熱導率是硅的3至5倍,擊穿電場強度是硅的8至10倍 。這些特性使得SiC器件不僅能承受更高的工作電壓,還能在更高的頻率和溫度下工作,同時顯著提高了散熱效率 。這種材料的根本性優勢,使得SiC功率器件在新能源汽車、光伏儲能、高頻變流器等大功率應用中表現出卓越的性能和效率 。

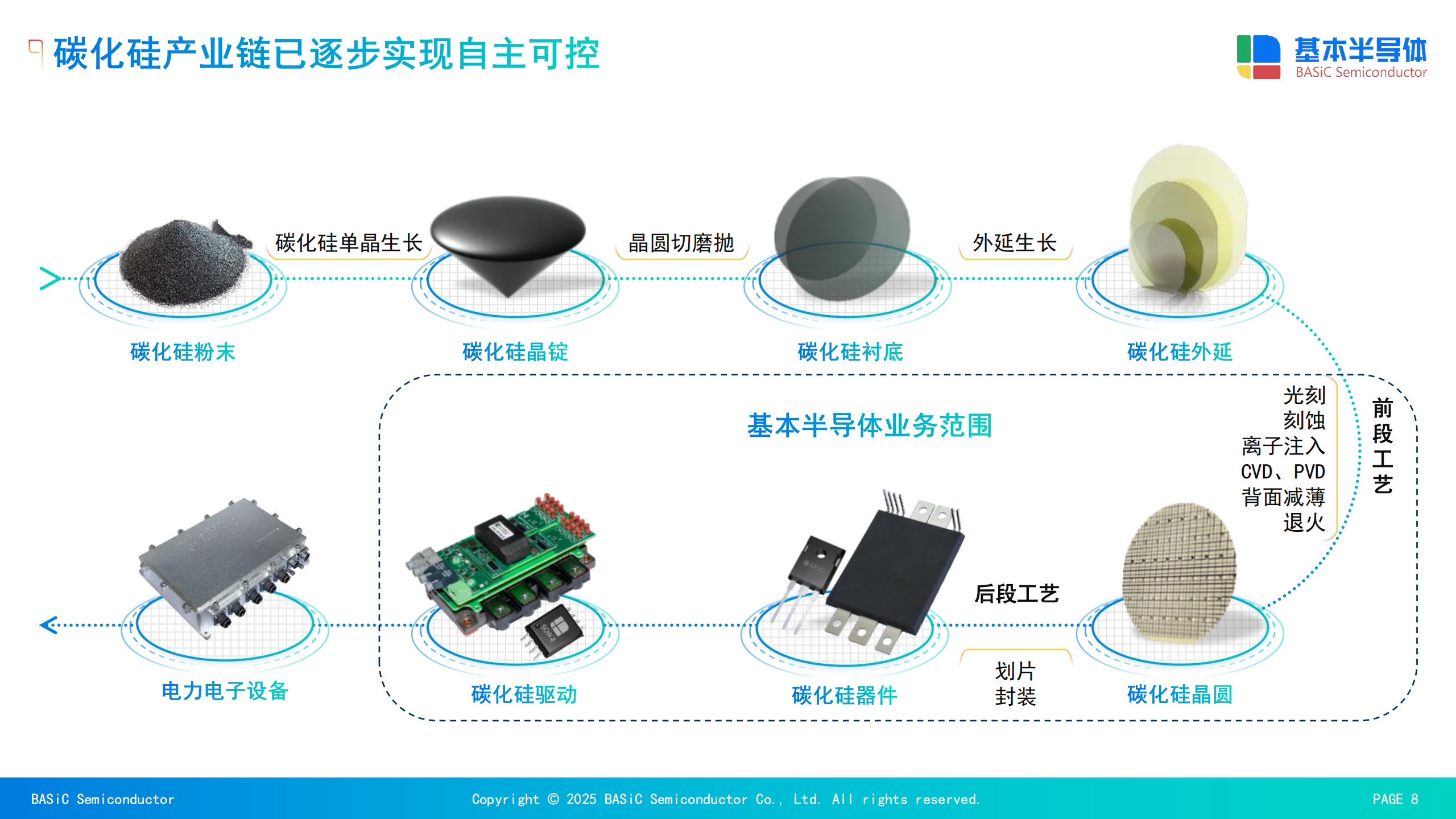
下表量化對比了硅與碳化硅在關鍵熱學和電學性能上的差異,清晰地展示了SiC材料為何能從根本上改變熱設計格局。
| 特性參數 | 硅 (Si) | 碳化硅 (SiC) | 相對優勢 |
|---|---|---|---|
| 禁帶寬度 (eV) | 1.12 | 3.26 | SiC是Si的3倍 |
| 熱導率 (W/mK) | ~1.5 | ~4.9 | SiC是Si的3-5倍 |
| 擊穿電場 (MV/cm) | 0.3 | >2.5 | SiC是Si的8-10倍 |
| 最高工作溫度 (°C) | <150 | >175 | SiC更高 |
2. SiC功率器件的熱設計基礎與熱阻分析
2.1 熱傳導基本原理與熱阻(Rth?)定義

熱阻(Thermal Resistance,Rth?)是量化熱量傳遞難易程度的物理量,是熱設計分析的基石。根據傅里葉熱傳導定律,熱流率(P)與溫度梯度(ΔT)和材料熱導率(λ)成正比。熱阻則被定義為穩態下溫度差(ΔT)與熱流率(P)的比值,其單位通常為K/W或°C/W。對于一個具有橫截面積(A)和長度(L)的物體,其熱阻可以通過以下公式計算:Rth?=L/(λ×A)。這個公式表明,熱阻與熱流路徑的長度成正比,與熱導率和橫截面積成反比 。因此,在熱設計中,目標是尋找高熱導率、大面積和短路徑的材料與結構,以實現低熱阻和高效散熱。
2.2 SiC功率器件中的熱阻串聯與并聯
熱阻的串聯

在功率模塊中,熱量從產生源(芯片結)到最終消散(環境)是一個多層、多界面的連續傳導過程。這個熱傳導路徑可以被建模為熱阻的串聯。例如,一個典型的功率模塊散熱通路包括:芯片結到芯片粘結層、芯片粘結層到陶瓷基板、陶瓷基板到銅基板、銅基板到導熱界面材料(TIM),再通過散熱器最終傳導到環境中 。在熱阻串聯關系中,總熱阻是各部分熱阻的簡單相加:
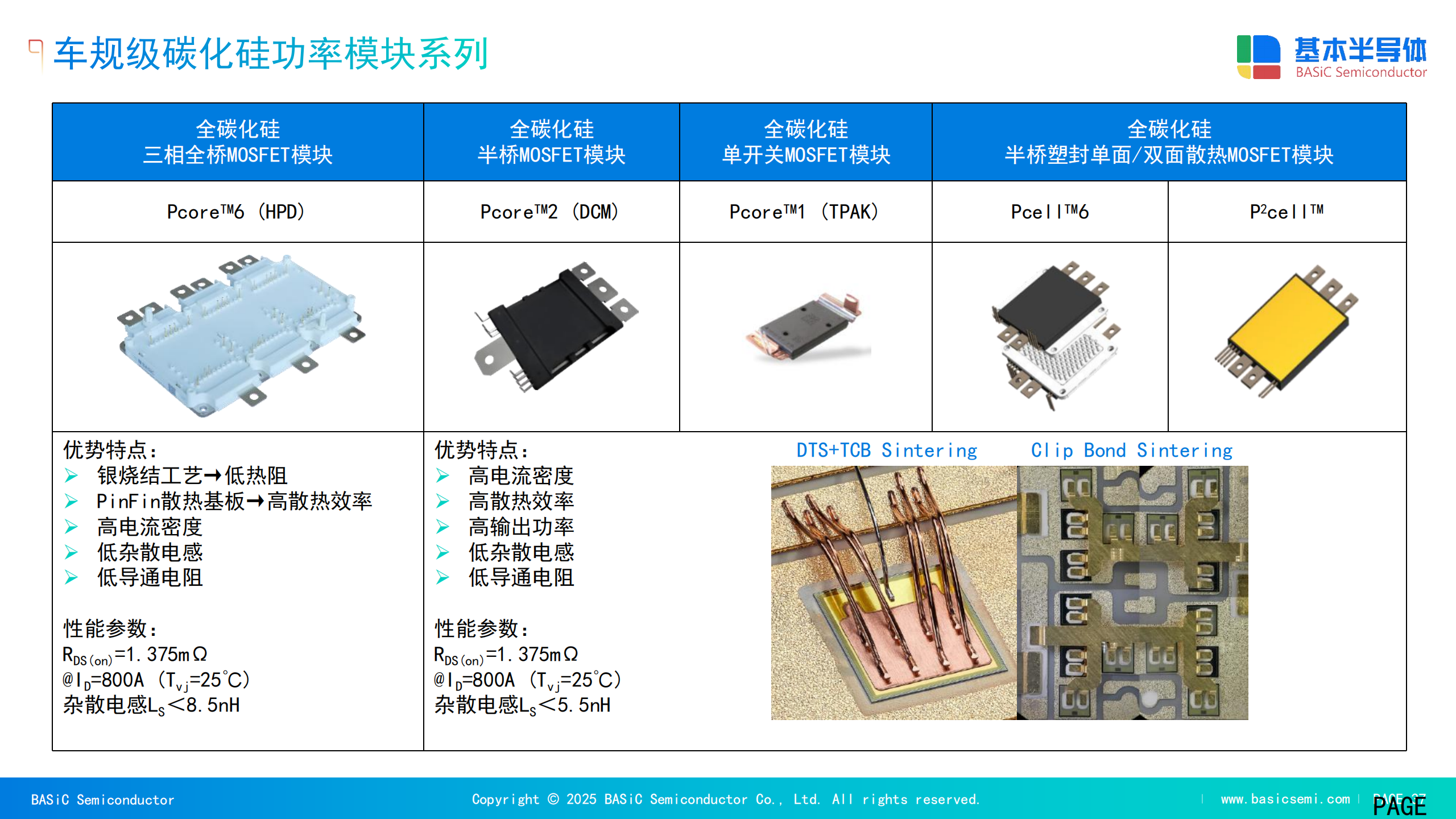
Rth(total)?=Rth1?+Rth2?+...+Rthn? 。這表明整個熱通路中熱阻最大的那一部分將成為散熱的瓶頸。對于SiC器件,由于芯片本身熱導率極高,熱量可以快速離開,但芯片粘結層(如銀燒結層)和導熱界面材料(TIM)如果設計不當,可能會成為熱量積聚的關鍵瓶頸,導致結溫與外殼溫度之間出現過大的溫差。因此,封裝材料和工藝的熱性能優化至關重要。

熱阻的并聯
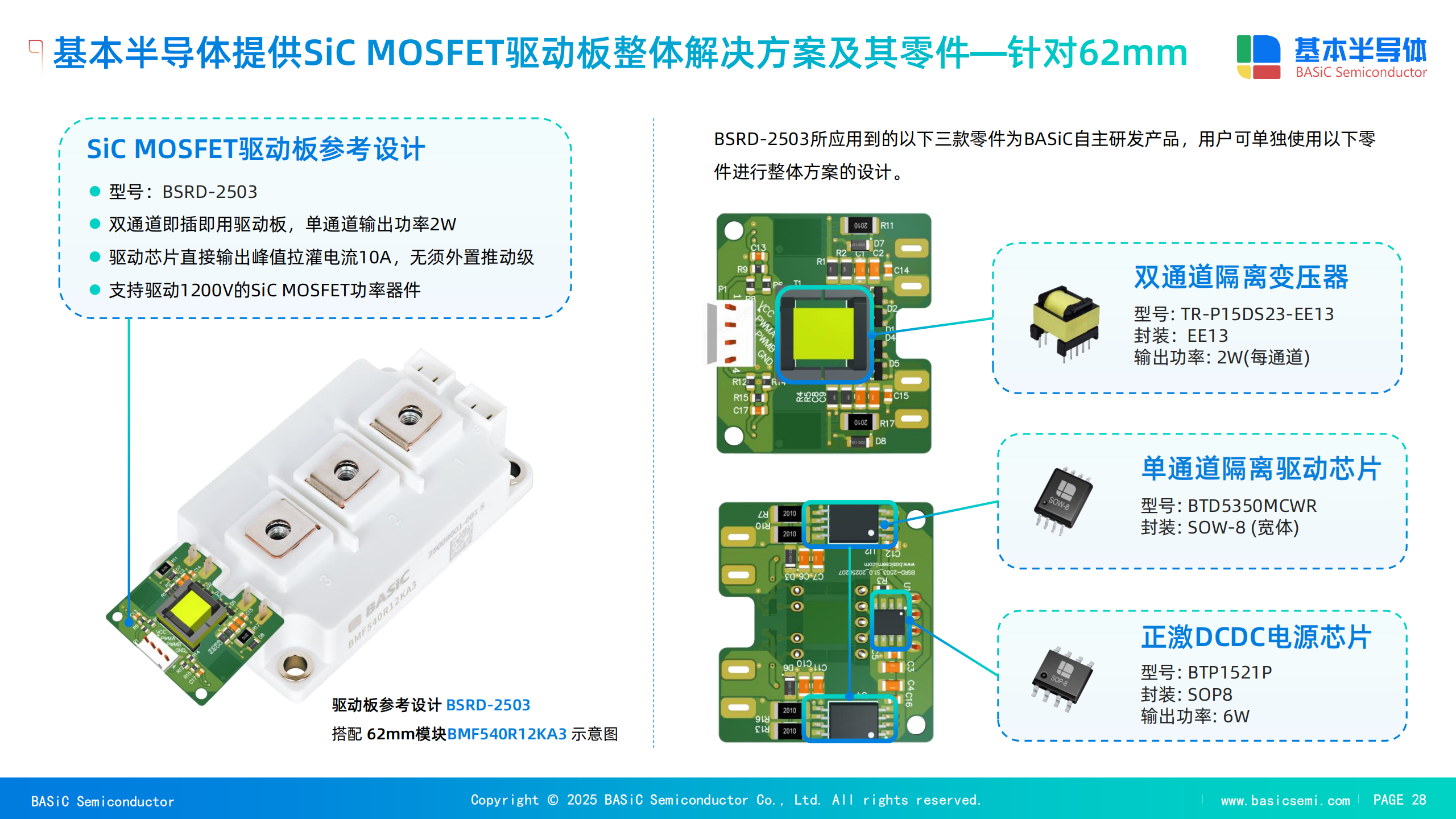
當多個熱傳導路徑同時存在時,熱阻之間呈現并聯關系。這在現代大功率模塊中尤為常見,其中多個功率芯片并聯以實現高電流容量。在多芯片并聯封裝中,每個芯片都提供了自己的散熱路徑,這些路徑在宏觀上可以視為并聯。并聯熱阻的計算方式與電阻并聯類似:總熱阻的倒數等于各個并阻的倒數之和,即1/Rth(total)?=1/Rth1?+1/Rth2?+...+1/Rthn? 。這意味著并聯散熱路徑可以顯著降低整體熱阻。例如,一份產品數據手冊顯示,一個由3片300A芯片并聯而成的900A IGBT模塊,其總熱阻約為單個芯片熱阻的三分之一 。這解釋了為何高電流功率模塊,如BMF540R12KA3,其每開關熱阻( Rth(j?c)?)為0.07 K/W,遠低于低電流模塊BMF60R12RB3的0.70 K/W 。
2.3 SiC功率器件的封裝與熱通路化
SiC器件熱性能的充分發揮,嚴重依賴于其封裝技術和材料的選擇。
封裝材料: 現代SiC功率模塊采用先進的材料來優化熱傳導。例如,銅基板被廣泛應用,因為它具有高熱導率,能夠將芯片產生的熱量均勻地擴散到更大的面積,從而降低熱流密度,實現更高效的散熱 。此外,氮化硅(Si3N4)陶瓷基板作為一種高性能的絕緣材料,因其優異的熱導率、高硬度和熱穩定性,已逐步取代傳統的氧化鋁(Al2O3)基板 。氮化硅基板能夠承受更大的熱機械應力,從而提高了模塊在高溫運行下的可靠性 。
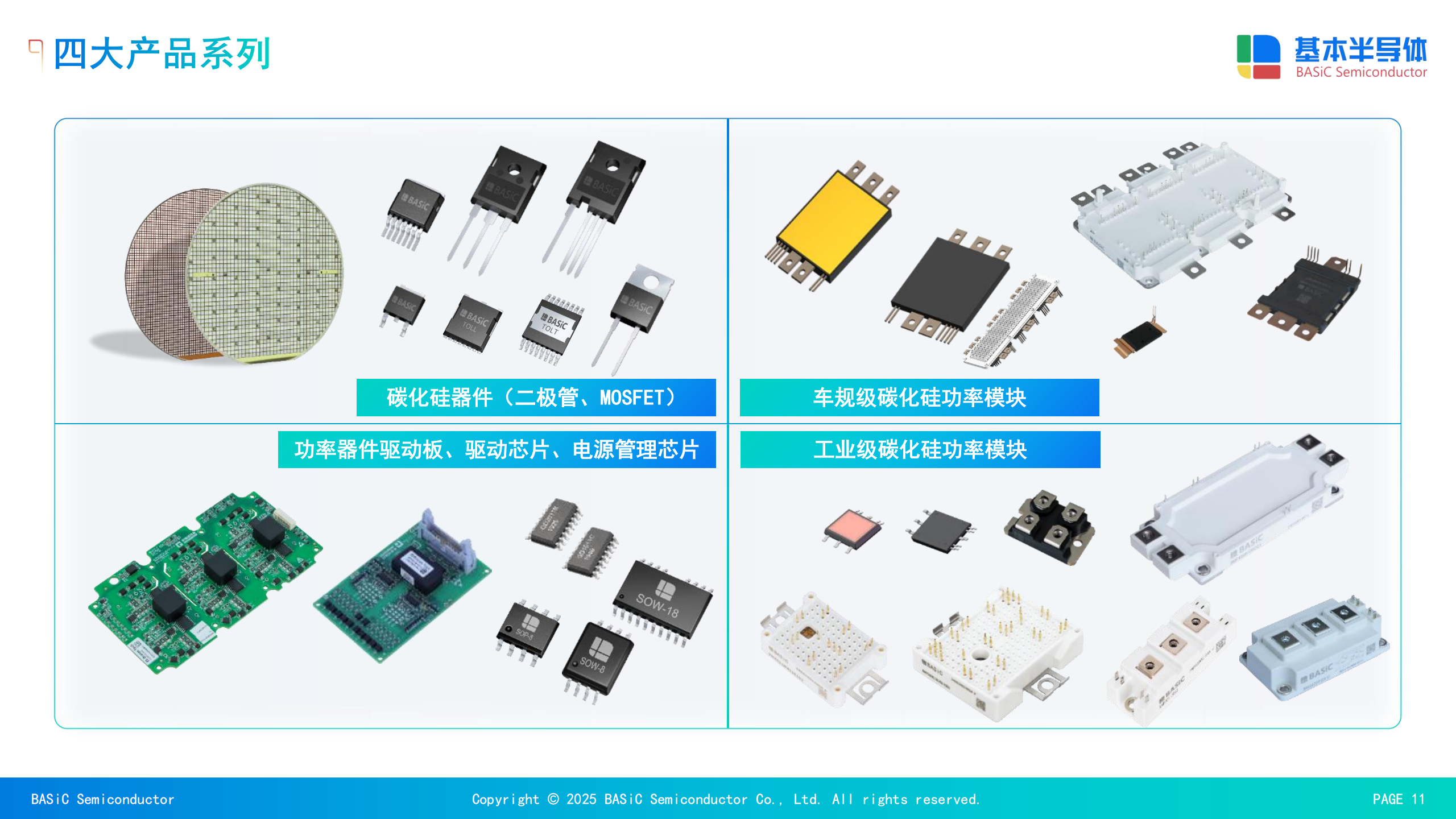
封裝工藝: 創新的封裝工藝也對熱性能的提升起到了關鍵作用。銀燒結(Silver Sintering)技術通過在低溫下將銀漿燒結成高密度、高導熱的鍵合層,顯著降低了芯片與基板之間的熱阻。這在某些SiC MOSFET產品(如B3M010C075Z和B3M013C120Z)的數據手冊中被明確提及,作為其熱阻(Rth(j?c)?)得以改善的關鍵特性 。

下表概括了BASiC半導體部分SiC功率器件的熱阻參數,并突出其封裝技術亮點,這些數據直觀地印證了上述熱設計原理在實際產品中的應用。
| 模塊型號 | 電壓 (VDSS?) | 額定電流 (ID?) | 封裝類型 | 熱阻 (Rth(j?c)?) (per switch) | 封裝技術亮點 | 來源 |
|---|---|---|---|---|---|---|
| BMF60R12RB3 | 1200V | 60A | 34mm Half Bridge | 0.70 K/W | 銅基板, Si3?N4?基板 | |
| BMF80R12RA3 | 1200V | 80A | 34mm Half Bridge | 0.54 K/W | 銅基板, Al2?O3?基板 | |
| BMF120R12RB3 | 1200V | 120A | 34mm Half Bridge | 0.37 K/W | 銅基板, Al2?O3?基板 | |
| BMF160R12RA3 | 1200V | 160A | 34mm Half Bridge | 0.29 K/W | 銅基板, Al2?O3?基板 | |
| BMF240R12E2G3 | 1200V | 240A | Pcore E2B | 0.09 K/W | Si3?N4?基板, Press-FIT, NTC | |
| BMF360R12KA3 | 1200V | 360A | 62mm Half Bridge | 0.11 K/W | 銅基板, Si3?N4?基板 | |
| BMF540R12KA3 | 1200V | 540A | 62mm Half Bridge | 0.07 K/W | 銅基板, Si3?N4?基板 |
3. 瞬態熱特性分析:從瞬態熱阻到結構函數
3.1 瞬態熱阻(Zth?)的物理意義與應用

瞬態熱阻(Zth?)是描述功率器件在短時脈沖功率下的熱響應,與穩態熱阻(Rth?)有著本質區別。穩態熱阻是一個恒定值,反映的是熱量在達到平衡狀態后,從結到環境的整體傳導能力 。而瞬態熱阻則是一個動態函數,是脈沖持續時間和占空比的函數 。在極短的脈沖時間內,熱量主要被芯片及其緊鄰的封裝層吸收,尚未擴散至整個封裝和散熱器,因此此時的瞬態熱阻遠小于穩態熱阻 。隨著脈沖時間延長,熱量逐漸向外擴散,瞬態熱阻曲線也隨之上升,并最終在足夠長的時間后趨近于穩態熱阻值 。
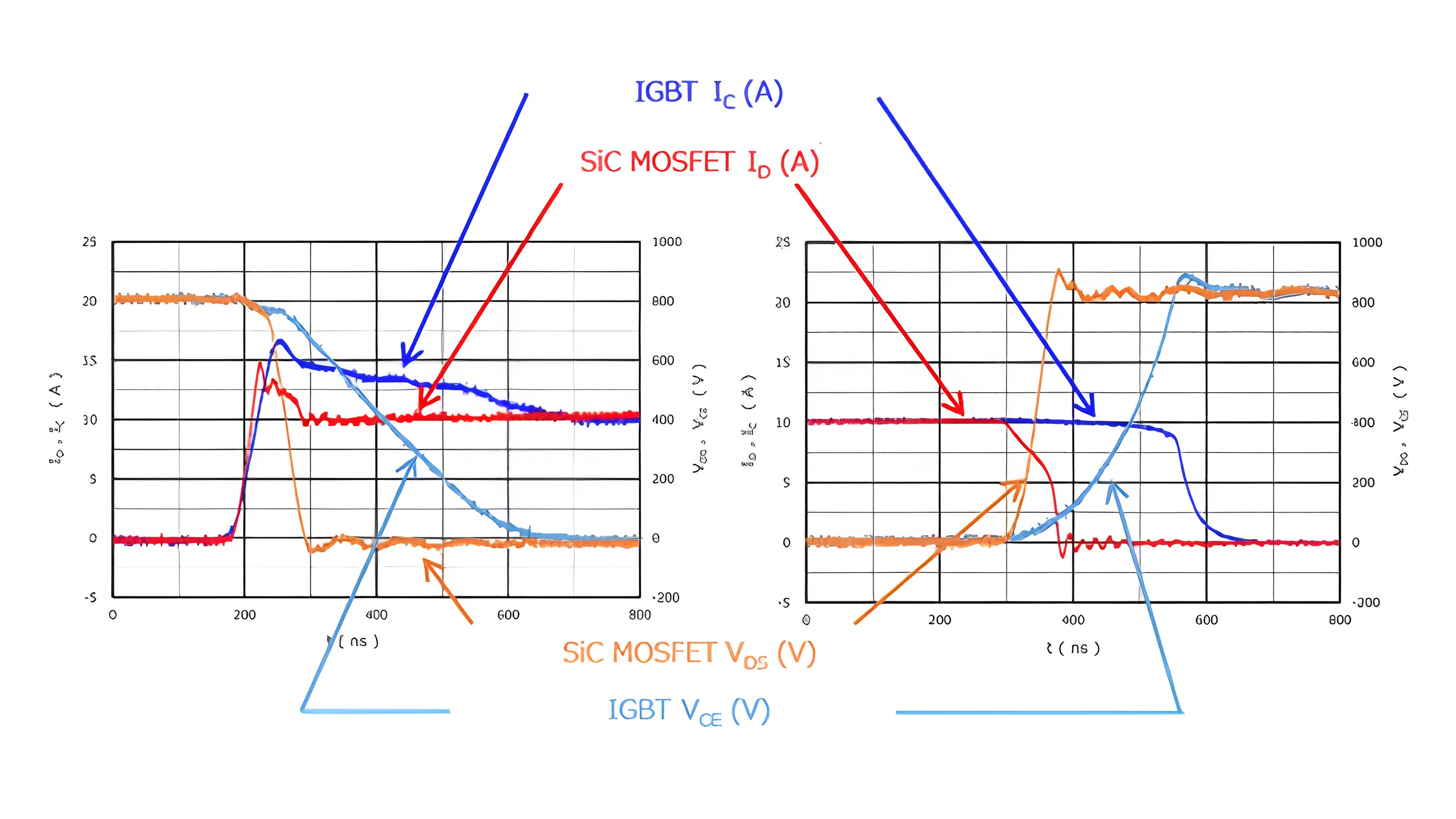
這種動態特性對于SiC器件的熱設計至關重要。SiC器件因其高速開關能力,常工作于高頻模式,其功率損耗是脈沖式的,而非連續的。在這種情況下,結溫會在每個開關周期內迅速升降,而無法達到穩態。因此,使用單一的穩態熱阻值來預測結溫會過于保守,且不準確。通過瞬態熱阻曲線,設計人員可以根據實際的脈沖寬度和占空比,精確地預測結溫的峰值,從而實現更高效、更精確的熱設計,避免不必要的過設計 。
3.2 利用瞬態熱阻計算二極管浪涌電流
瞬態熱阻曲線的一個重要應用是用于計算二極管在短時過載情況下的浪涌電流能力。例如,對于B3D80120H2 SiC肖特基二極管,其數據手冊提供了瞬態熱阻曲線圖 。結合這個曲線和器件的絕對最大額定值,可以計算其浪涌電流能力 。
計算步驟如下:
確定最大結溫: 從數據手冊中獲取器件的最高工作結溫(Tj(max)?),該二極管為175°C 。
讀取瞬態熱阻: 在瞬態熱阻曲線(如數據手冊Figure 8)中,找到特定脈沖寬度(例如10ms)下的熱阻值(Zth?)。
計算最大峰值功率: 假設器件外殼溫度為TC?,可使用公式$P_{peak} = (T_{j(max)} - T_C) / Z_{th}$計算出允許的最大峰值功率。
轉換浪涌電流: 將峰值功率轉換為浪涌電流(IFSM?)。對于半正弦波脈沖,I2t值可以根據公式I2×t=(IFSM?/2?)2×0.01來計算 。這與數據手冊中給出的 I2t值(2048 A2S)和非重復性正向浪涌電流(640A)相對應 。

3.3 SiC功率模塊的熱容

熱容(Thermal Capacitance)是理解瞬態熱行為的另一個核心物理量。它代表了材料在溫度每升高1°C時所能吸收和存儲的熱量。在熱等效電路模型中,熱容類似于電容,具有“儲能”的作用 。在瞬態加熱的初期,功率損耗產生的熱量首先被器件芯片及其緊鄰封裝層的熱容吸收,熱量尚未有效擴散到整個封裝和散熱器 。這解釋了為什么短脈沖不會導致結溫瞬間達到高穩態值。只有當脈沖持續時間足夠長,熱量才開始向外層(具有更大熱容和熱阻)擴散,此時熱阻的影響才變得更為顯著 。因此,瞬態熱阻曲線的形狀,本質上是對封裝內部各層熱阻和熱容網絡(RC網絡)動態響應的可視化 。
3.4 結構函數:熱通路的可視化工具

結構函數(Structure Function)是一種強大的熱分析工具,它通過對瞬態熱測量結果進行數學變換,將其轉化為熱阻與熱容的關系曲線,從而實現熱傳導路徑的“可視化” 。與單一的穩態熱阻值不同,結構函數能夠非破壞性地診斷封裝內部每一層的熱特性,類似于對熱通路進行CT掃描 。
物理意義: 結構函數曲線能夠清晰地描繪熱量從芯片結到環境的傳導路徑。曲線中斜率較小的區域表示該區域具有低熱導率或較小的橫截面積,這通常對應于芯片粘結層或鍵合線等熱阻較高的界面 。相反,斜率陡峭的區域則代表高熱導率或大截面積的材料,如SiC芯片本身或銅基板 。微分結構函數可以更清晰地界定不同材料層之間的界面,其峰值對應于高熱導率區域,而谷值對應于低熱導率區域 。
應用價值: 結構函數為功率器件的熱設計和可靠性評估提供了前所未有的細節信息。設計人員可以通過分析結構函數曲線,識別出封裝內部的熱瓶頸,例如芯片粘結層中的空洞,并據此優化封裝結構,從而提高器件的整體散熱能力和可靠性 。這是一種比傳統穩態熱阻分析更為先進和精確的診斷方法。
4. SiC功率模塊的溫度定義、測量方法與實際應用
4.1 功率模塊的溫度定義與測試方法

在SiC功率半導體熱設計中,有幾個關鍵的溫度參數需要精確定義和測量:
結溫(TJ?): 指的是芯片內部有源區的溫度。這是熱設計中最關鍵的參數,因為它直接關系到器件的性能、壽命和可靠性。結溫通常無法通過物理接觸直接測量,只能通過間接方法估算。
殼溫(TC?): 指的是功率模塊外殼上指定點的溫度,通常是與散熱器接觸的底板中心點。在數據手冊中,殼溫常作為參考溫度來定義器件的額定電流和功耗 。
散熱器溫度(TH?): 指的是散熱器上指定點的溫度。它通常用于計算熱量從模塊外殼到環境的熱阻。
4.2 結溫測量方法詳解:JEDEC JESD51-14 TDI標準

結溫的準確測量對于SiC器件的熱設計至關重要。目前最常用的方法是利用器件自身的電參數作為溫敏參數(Temperature Sensitive Parameter, TSP)來間接測量。這一方法通常遵循JEDEC JESD51-14 TDI(Transient Dual Interface Test Method)標準 。
測量原理: 測量基于一個經過校準的溫敏參數,例如MOSFET體二極管的正向壓降(VF?)。當流過體二極管的電流恒定時,其正向壓降會隨結溫的升高而線性下降。通過預先校準VF?與TJ?之間的關系(即K系數),就可以通過測量VF?的變化來反推出結溫的變化 。
測量流程: 該方法的核心是“瞬態冷卻曲線”的獲取。首先,對被測器件(DUT)施加一個高功率加熱電流,使其結溫達到穩態。然后,迅速關斷加熱電流,并切換到極小的測量電流模式。在此冷卻過程中,持續記錄溫敏參數(如VF?)隨時間的變化,從而得到瞬態冷卻曲線 。
加熱模式選擇: 對于SiC MOSFET的加熱,有兩種主要模式可供選擇:“體二極管模式”(Body-Diode Mode)和“MOS飽和模式”(MOS Saturation Mode) 。體二極管模式通過向體二極管施加加熱電流來產生熱量。然而,在多芯片并聯的SiC模塊中,由于各個芯片的體二極管特性可能存在微小差異,可能導致電流分配不均,從而影響測量準確性 。因此,對于并聯SiC MOSFET模塊,通常推薦使用MOS飽和模式。該模式通過向MOSFET通道施加加熱電流來產生熱量,這更接近器件的實際工作情況,能夠更好地避免電流不平衡問題 。
4.3 熱系數Ψth(j-top)的原理與應用
熱系數Ψth(j-top)是一個用于將結溫與封裝頂部溫度關聯起來的參數,它與傳統的熱阻(Rth)有所不同 。傳統的熱阻( Rth(j?c)?)假定所有熱量都從器件底部傳導到散熱器,而Ψth(j-top)則將結溫與封裝頂面的可測溫度聯系起來。這對于采用頂部散熱(Top-side cooled, TSC)封裝的器件尤其重要,因為頂部散熱在高功率密度和小型化應用中正變得越來越普遍 。
使用Ψth(j-top)的好處在于,它可以結合熱成像儀等非接觸式測量工具,通過測量封裝表面的溫度來估算結溫。其計算公式通常為:TJ?=P×Ψth(j?top)?+Ttop?,其中P是器件功耗,$T_{top}$是封裝頂部溫度。這種方法為設計人員提供了一種靈活且非侵入性的結溫估算手段,特別是在無法直接接觸器件底部的情況下。然而,這種估算需要謹慎,因為它忽略了熱量在封裝內部三維擴散的復雜性,且對封裝頂面溫度測量的準確性(如發射率校準)有較高要求。
4.4 熱成像儀測溫概述與校準
熱成像儀是一種強大的熱點可視化工具,它通過捕獲物體表面發出的紅外輻射來生成溫度分布圖像 。然而,熱成像儀測量的僅是物體表面的溫度,而不是芯片的結溫。在熱設計中,熱成像儀常用于識別封裝、PCB或散熱器上的熱點,但其讀數必須結合對封裝內部熱阻的理解進行解讀 。
為了確保熱成像儀測量的準確性,正確的校準至關重要。最關鍵的參數是材料的“發射率”(Emissivity) 。發射率是一個介于0和1之間的值,描述了物體發射熱輻射的能力。如果沒有正確設置發射率,熱成像儀的讀數將不準確。常用的校準方法包括:
使用已知發射率的材料(如電工膠帶,發射率接近0.95)作為參考,并通過調整發射率來使讀數與參考點溫度匹配 。
對被測物體表面涂覆一層發射率接近1.0的暗黑色油漆 。
在物體上鉆一個深孔,模擬黑體輻射,并以此作為校準的參考點 。
需要注意的是,即使經過校準,熱成像儀測量的也只是表面溫度(Ttop?),而熱設計中最關鍵的結溫(TJ?)通常要高得多。兩者之間的溫差取決于封裝內部的熱阻。因此,熱成像儀的讀數必須結合熱系數Ψth(j-top)或熱阻參數進行補償,才能用于估算結溫,否則可能會低估實際的結溫,帶來潛在的可靠性風險 。

5. SiC模塊熱設計的進階考量
5.1 功率端子的熱性能與優化

在SiC功率模塊中,鍵合線不僅僅是電流傳導路徑,也是熱傳導路徑的一部分。其熱學特性對模塊的整體性能和可靠性具有重要影響 。在多芯片并聯封裝中,鍵合線將芯片連接到封裝引腳,其等效電阻會產生焦耳熱 。如果鍵合線數量不足或電流分配不均,部分鍵合線可能會因過熱而形成熱點,甚至發生熔斷,從而導致功率回路斷開 。研究表明,相同功率等級和封裝下,SiC模塊的鍵合線溫度可能比硅模塊高出約40°C 。這表明鍵合線是SiC模塊中的一個熱薄弱點。為了解決這一問題,先進的封裝技術正在探索使用銀燒結或壓接連接等技術來取代傳統鍵合線,以消除這一熱瓶頸,提高模塊的長期可靠性 。
5.2 模塊內部的熱擴散路徑與材料選擇
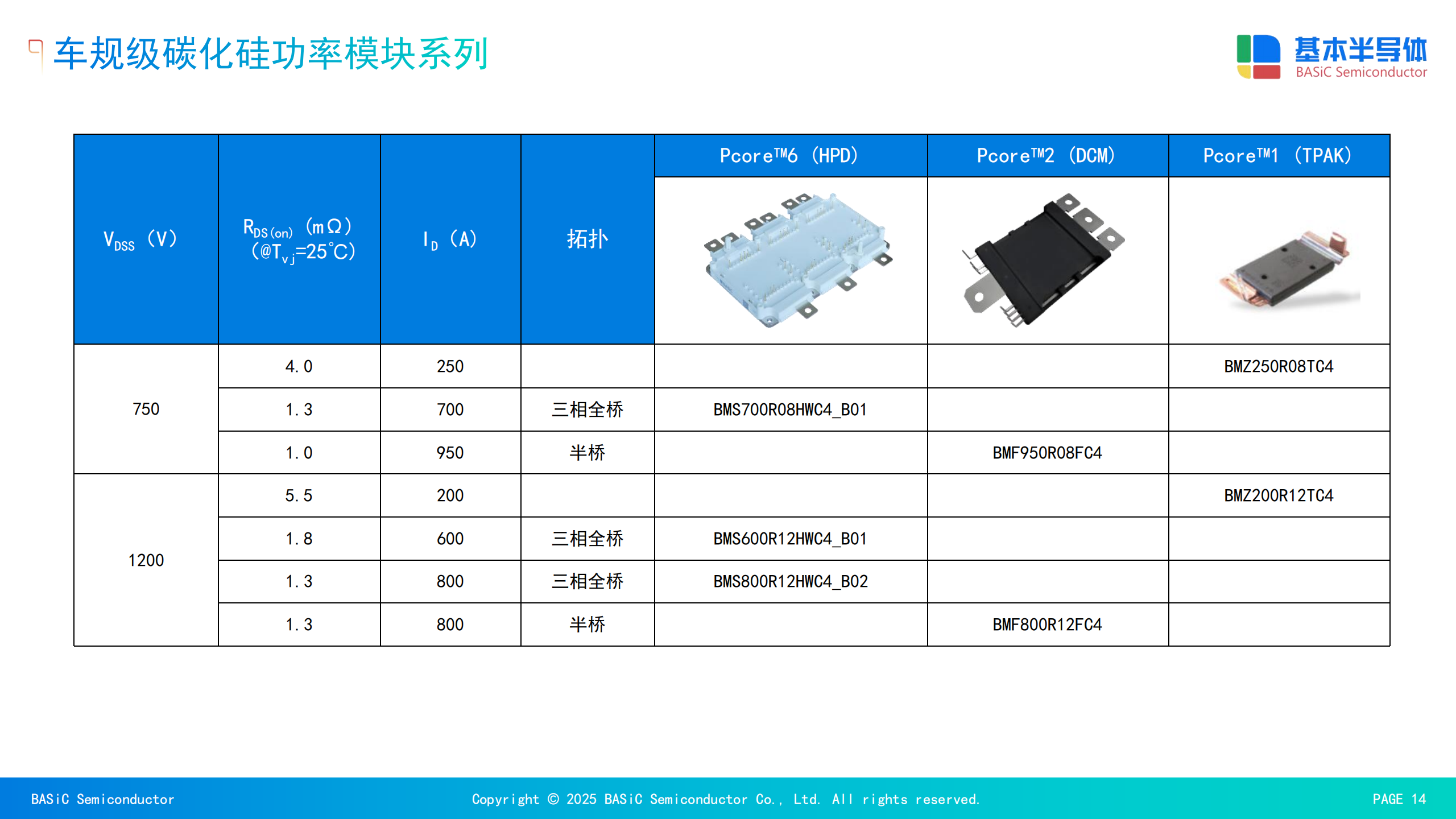
SiC功率模塊的內部熱擴散是一個復雜的三維熱傳導過程,其效率受到材料熱導率和幾何結構的影響。熱量從芯片結產生后,通過熱傳導的方式逐層擴散至封裝外殼 。這一過程遵循傅里葉導熱定律 。因此,優化熱擴散路徑和選擇高熱導率的材料至關重要。模塊中使用的氮化硅陶瓷基板和銅基板,正是為了在確保電氣絕緣的同時,提供高效的熱傳導路徑,以最大限度地將熱量從芯片內部傳導到外部散熱器 。這些材料和結構設計協同工作,共同構成了SiC功率模塊熱設計的基礎。
深圳市傾佳電子有限公司(簡稱“傾佳電子”)是聚焦新能源與電力電子變革的核心推動者:
傾佳電子成立于2018年,總部位于深圳福田區,定位于功率半導體與新能源汽車連接器的專業分銷商,業務聚焦三大方向:
新能源:覆蓋光伏、儲能、充電基礎設施;
交通電動化:服務新能源汽車三電系統(電控、電池、電機)及高壓平臺升級;
數字化轉型:支持AI算力電源、數據中心等新型電力電子應用。
公司以“推動國產SiC替代進口、加速能源低碳轉型”為使命,響應國家“雙碳”政策(碳達峰、碳中和),致力于降低電力電子系統能耗。
需求SiC碳化硅MOSFET單管及功率模塊,配套驅動板及驅動IC,請搜索傾佳電子楊茜
6. 結論與未來展望
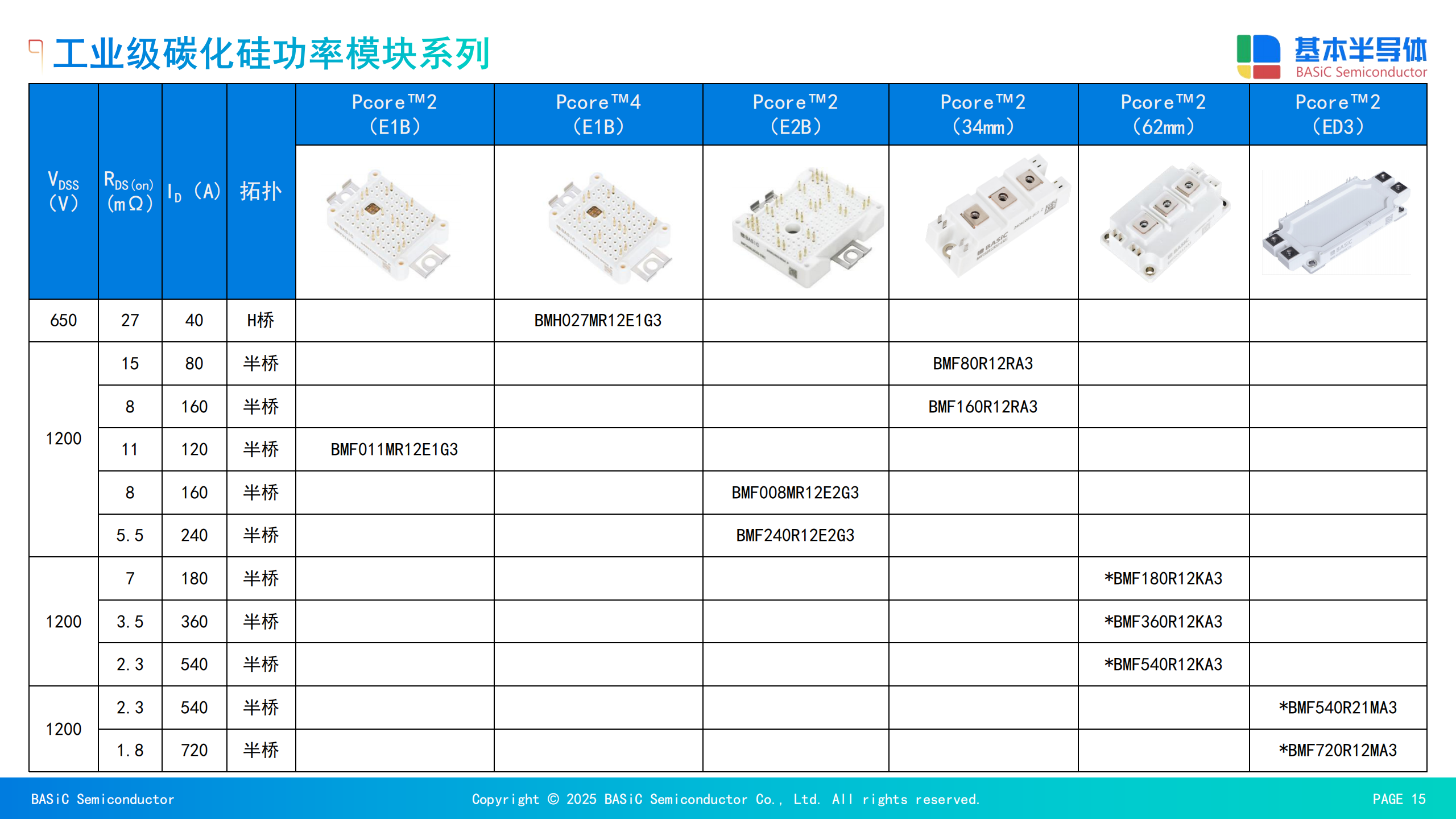
傾佳電子全面深入地分析了功率半導體熱管理的發展歷程和SiC技術背景下的熱設計基礎。從熱阻的串聯與并聯等基本概念,到瞬態熱阻、熱容和結構函數等高級分析工具,再到結溫測量和熱成像等實際應用方法,詳細闡述了SiC功率器件熱設計的核心理論與實踐。
SiC技術的崛起,以其優越的物理特性,為電力電子領域帶來了前所未有的性能提升。但與此同時,其高功率密度和高開關頻率也對封裝和熱管理提出了更嚴苛的挑戰。未來的熱設計將不再滿足于傳統的穩態熱阻分析,而必須轉向更全面的瞬態熱和結構函數分析,以實現對器件內部熱特性的精準掌控。通過采用銀燒結、氮化硅基板、頂部散熱等先進封裝技術,熱設計人員將能夠突破現有熱瓶頸,進一步釋放SiC器件的潛力,實現更小、更輕、更高效的電力電子系統。
審核編輯 黃宇
-
MOSFET
+關注
關注
151文章
9674瀏覽量
233554 -
熱阻
+關注
關注
1文章
121瀏覽量
17378 -
功率半導體
+關注
關注
23文章
1463瀏覽量
45195
發布評論請先 登錄
什么是MOSFET柵極氧化層?如何測試SiC碳化硅MOSFET的柵氧可靠性?
碳化硅半導體器件有哪些?
碳化硅陶瓷線路板,半導體功率器件的好幫手
傳統的硅組件、碳化硅(Sic)和氮化鎵(GaN)
被稱為第三代半導體材料的碳化硅有著哪些特點
功率模塊中的完整碳化硅性能怎么樣?
基本半導體碳化硅 (SiC) MOSFET 外特性深度研究報告:飽和區、線性區及動態行為的物理與工程分析

碳化硅 (SiC) MOSFET dv/dt 極限物理本質深度研究報告




 SiC碳化硅MOSFET功率半導體熱設計深度分析報告
SiC碳化硅MOSFET功率半導體熱設計深度分析報告







評論