掃描電子顯微鏡-電子通道對比成像(SEM-ECCI)是在掃描電子顯微鏡下直接表征晶體材料內部缺陷的技術。SEM-ECCI技術的發展已經取代了透射電子顯微鏡(TEM)在缺陷表征領域的部分功能。與TEM分析相比,它提供了更高的吞吐量、更快的效率分析解決方案,并且具有更強的統計意義。
于該技術成像效率高,制樣過程簡單、無損,近年來在金屬材料、化合物半導體等領域取得了很大的發展,也受到了越來越多的關注。
氮化鎵異質結中穿線和失配位錯的電子通道襯度成像分析。
異質外延生長的GaN/AlGaN薄膜材料廣泛應用于光子學、電力電子學和微波射頻器件中。隨著GaN器件的小型化,其薄膜材料中位錯缺陷的種類、面密度和分布已嚴重限制了器件的性能和可靠性。如何在不破壞薄膜材料的前提下精確表征GaN和GaN/AlGaN異質結中的位錯缺陷仍是一個很大的挑戰。
中國科學院蘇州納米研究所研究員范士釗,等基于蔡司場發射掃描電子顯微鏡溝道對比成像技術(ECCI)成功地分析了邊緣位錯、螺旋位錯和混合位錯的表面密度,并首次在GaN/AlGaN異質結中觀察到。脫臼半環和位錯滑移現象。
研究人員使用蔡司場發射掃描電子顯微鏡獲得了GaN薄膜材料的菊池圖案(圖1)。通過系統地分析菊池晶帶與垂直晶面和傾斜晶面的對應關系,準確地選擇布拉格衍射條件,并將其用于位錯通道襯度成像。

▲ (a)GaN薄膜的菊池花樣及由電子束衍射的運動學理論計算得出的(b)垂直晶面和(c)傾斜晶面的菊池晶帶分布圖
通過比較不同雙光束衍射條件下同一區域內位錯對比度演化規律,將消光判據和位錯對比度分布方向判據相結合,實現了位錯Burgers矢量的確定(圖2)。此外,通過分析基于電子通道襯度技術直接獲得的位錯類型比例和基于X射線衍射方法間接獲得的位錯類型比例,確定了電子通道襯度成像技術在分析混合位錯方面的獨特優勢。

▲ 圖2.同一區域GaN薄膜在不同雙束衍射條件下的通道襯度成像及位錯類型判定
最后,利用電子通道對比度成像技術對GaN/AlGaN異質結界面進行了直接測試,首次觀察到位錯半環,發現大量混合位錯在界面處彎曲形成錯位位錯(圖3)。通過分析位錯彎曲的晶體學方向,發現在界面處存在位錯滑移現象,為GaN器件的失效機理拓展了新的研究方向。
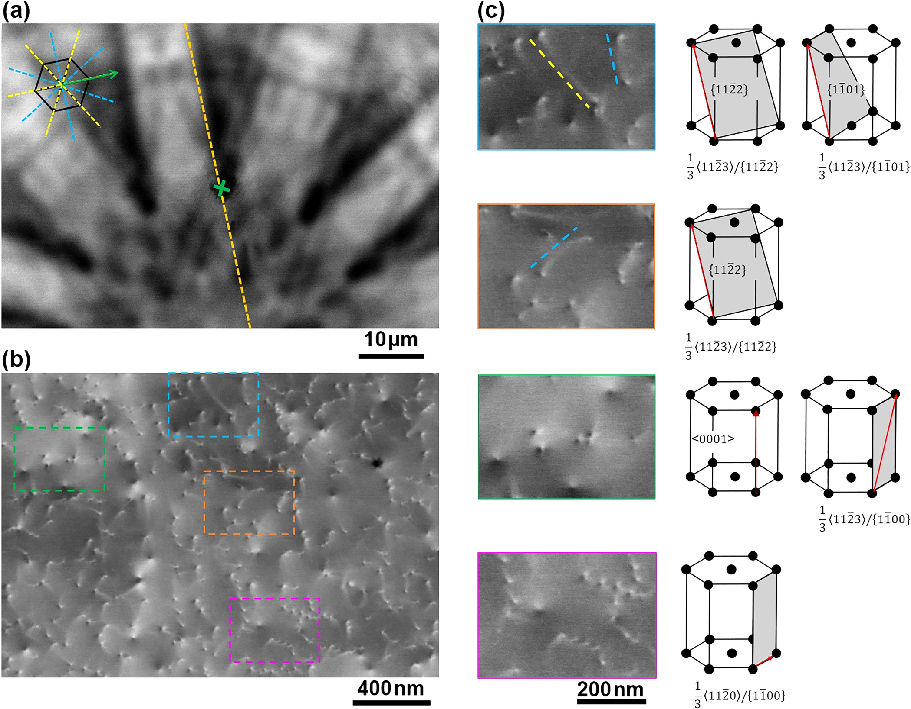
▲ 圖3. GaN/AlGaN異質結的通道襯度成像及位錯滑移體系的判定
審核編輯 黃宇
-
半導體
+關注
關注
339文章
30737瀏覽量
264138 -
GaN
+關注
關注
21文章
2366瀏覽量
82336 -
掃描電鏡
+關注
關注
0文章
120瀏覽量
9929 -
蔡司
+關注
關注
0文章
176瀏覽量
8222
發布評論請先 登錄
深圳市薩科微slkor半導體有限公司是宋仕強于2015年在深圳市華強北成立,當時掌握了行業領先的第三代半導體
高頻交直流探頭在第三代半導體測試中的應用
芯干線斬獲2025行家極光獎年度第三代半導體市場開拓領航獎

CINNO出席第三代半導體產業合作大會
材料與應用:第三代半導體引領產業升級
基本半導體B3M平臺深度解析:第三代SiC碳化硅MOSFET技術與應用
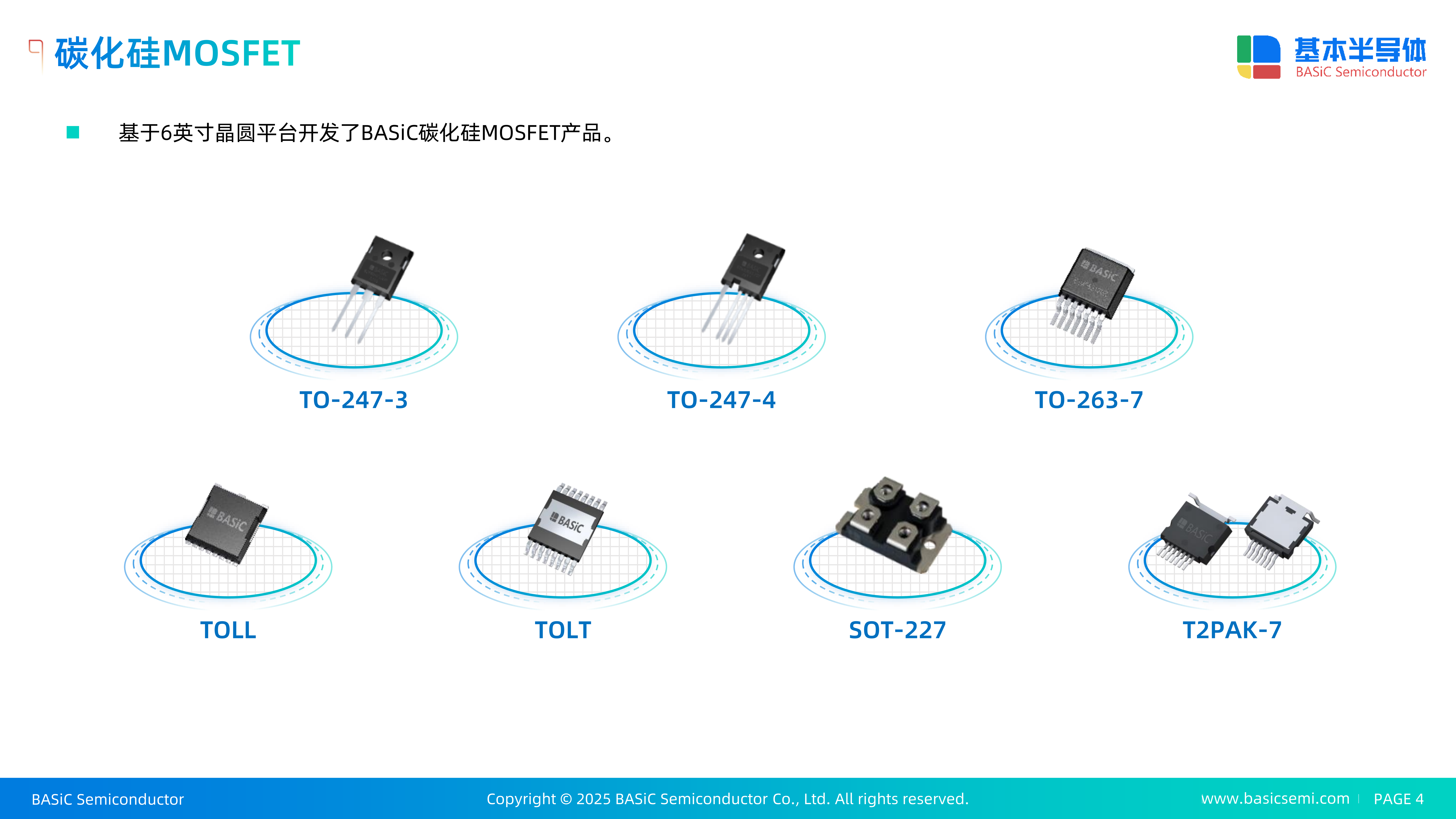
掃描電鏡(SEM)的工作原理和主要成像模式

第三代半導體的優勢和應用領域
瑞能半導體第三代超結MOSFET技術解析(1)
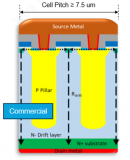
是德示波器如何精準測量第三代半導體SiC的動態特性




 蔡司掃描電鏡在第三代半導體領域的應用成果
蔡司掃描電鏡在第三代半導體領域的應用成果


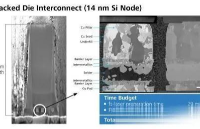





評論