在半導體行業中,Bump、RDL、TSV、Wafer合稱先進封裝的四要素,其中Bump起著界面互聯和應力緩沖的作用。
Bump從倒裝焊FlipChip出現就開始普遍應用,Bump的形狀有多種,最常見的為球狀和柱狀,也有塊狀等其他形狀,下圖所示為各種類型的Bump。
Bump起著界面之間的電氣互聯和應力緩沖的作用,從Bondwire工藝發展到FlipChip工藝的過程中,Bump起到了至關重要的作用。隨著工藝技術的發展,Bump的尺寸也變得越來越小,從最初 Standard FlipChip的100um發展到現在最小的5um。
伴隨著工藝技術的高速發展,對于Bump的量測要求也不斷提高,需要把控長寬尺寸,高度均勻性,亞納米級粗糙度、三維形貌等指標。
以粗糙度指標為例,電鍍工藝后的Cu 表面粗糙并存在一定的高度差,所以鍵合前需要對其表面進行平坦化處理,如化學機械拋光(CMP),使得鍵合時Cu 表面能夠充分接觸,實現原子擴散,由此可見把控Bump表面粗糙度是必不可缺的過程。
為了貼合工藝制程,積極響應客戶Bump 計量需求,中圖儀器以高精度、多功能合一等優勢將自研量測設備推向眾多優質半導體客戶。BOKI_1000系統支持鍵合、減薄、翹曲和切割后的基板,可以為包括切割后、預鍵合、銅焊盤圖案化、銅柱、凸塊(Bump)、硅通孔(TSV)和再分布層(RDL)在內的特征提供優異的量測能力。
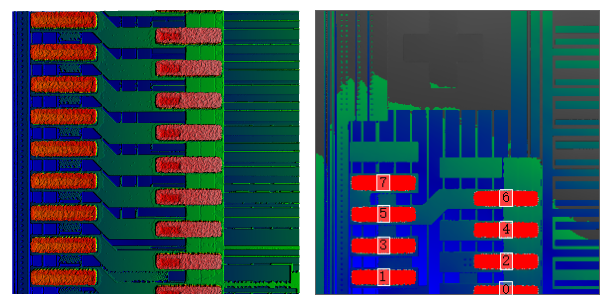 以上為量測Bump時的實時圖像
以上為量測Bump時的實時圖像
-
半導體
+關注
關注
339文章
30763瀏覽量
264375 -
電氣
+關注
關注
19文章
1266瀏覽量
56403 -
倒裝焊
+關注
關注
0文章
6瀏覽量
6492
發布評論請先 登錄
深入解析CDCLVP2106:高性能時鐘緩沖器的卓越之選
探索 CDCLVD1212:低抖動 LVDS 緩沖器的卓越性能與應用指南
LMK1D210xL:超低附加抖動LVDS緩沖器的卓越之選
從物理感知到量化數據:無應力計高精度測量原理與實現路徑

電子電器用膠中芯片封裝用膠有哪些?應用行業與核心作用

為何要測量混凝土的“自由變形”?——談談無應力計的關鍵作用

晶圓級封裝Bump制作中錫膏和助焊劑的應用解析

晶圓級封裝(WLP)中Bump凸點工藝:4大實現方式的技術細節與場景適配

AKEMOND應力應變測試儀選型
太誘MLCC電容的機械應力問題如何解決?

聊聊倒裝芯片凸點(Bump)制作的發展史

PCB分板應力測試方法和步驟

互聯世界中的人機界面 (HMI) 和網關
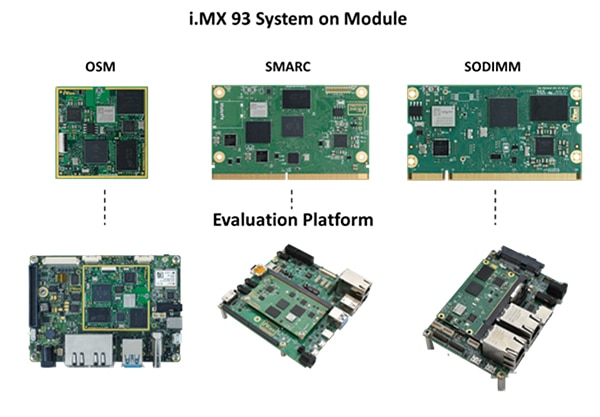



 Bump起著界面互聯和應力緩沖的作用
Bump起著界面互聯和應力緩沖的作用






評論