從國家知識產權局官網獲悉,華為技術有限公司日前公開了一項名為“具有改進的熱性能的倒裝芯片封裝”專利,申請公布號為CN116601748A。
據了解,該專利實施例提供了一種倒裝芯片封裝、一種裝備有應用封裝結構的電路的裝置以及一種組裝封裝的方法,更直觀來說,就是一種提供芯片與散熱器之間的接觸方式,能幫助改善散熱性能。
該專利可應用于CPU、GPU、FPGA(現場可編程門陣列)、ASIC(專用集成電路)等芯片類型,設備可以是智能手機、平板電腦、可穿戴移動設備、PC、工作站、服務器等。

專利提到,近來,半導體封裝在處理性能方面的進步對熱性能提出了更高的要求,以確保穩定操作。

就此而言,倒裝芯片封裝在熱性能方面具有優勢,因其結構特征是芯片通過其下方凸塊與基板連接,能夠將散熱器定位在芯片的頂表面上。
為提高冷卻性能,會將熱潤滑脂等熱界面材料(TIM)涂抹到芯片的頂表面,并夾在芯片和散熱器的至少一部分之間。從降低TIM中的熱阻以改善封裝的熱性能的角度來看,優選使TIM的厚度更小。

據了解,相較此前難以精細控制TIM厚度的散熱方案,華為這項專利中的熱界面材料的厚度由模制構件中的壁狀結構的高度限定。
由于能在模制過程中輕松控制由模具化合物組成的壁狀結構的高度,因此可以將熱界面材料的厚度調節到所需的小厚度,從而實現改進的熱性能。
華為“具有改進的熱性能的倒裝芯片封裝專利”摘要如下:
提供了一種倒裝芯片封裝(200),其中,所述倒裝芯片封裝包括:至少一個芯片(202),用于與基板(201)連接;形成在所述基板(201)上的模制構件(209),以包裹所述至少一個芯片(202)的側部分并使每個芯片(202)的頂表面裸露,其中,所述模制構件(209)的上表面具有與每個芯片(202)的頂表面連續的第一區域、涂抹粘合劑(210)的第二區域以及放置成包圍每個芯片(202)的頂表面的壁狀結構(209a),并且第一區域和第二區域由壁狀結構(209a)分隔;散熱器(206),放置在每個芯片(202)的頂表面上方,并通過填充在第二區域中的粘合劑(210)粘合到模制構件(209);熱界面材料(205),所述熱界面材料(205)填充在由所述第一區域、所述每個芯片(202)的頂表面、所述散熱器(206)的底表面的至少一部分和所述壁狀結構(209a)的第一側形成的空間區域中。
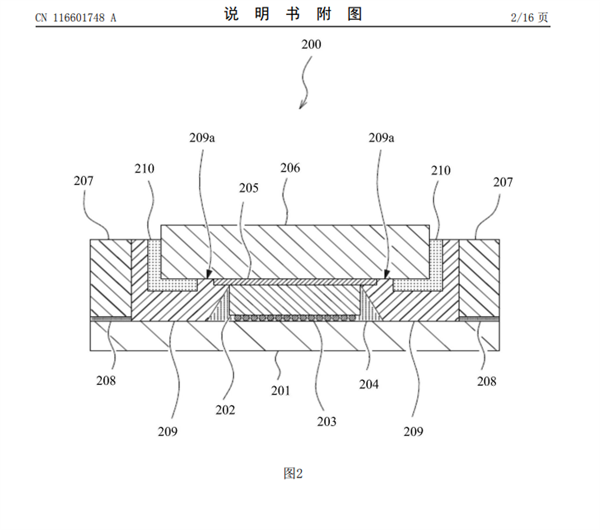
根據華為發明的實施例的倒裝芯片封裝示意性橫截面視圖
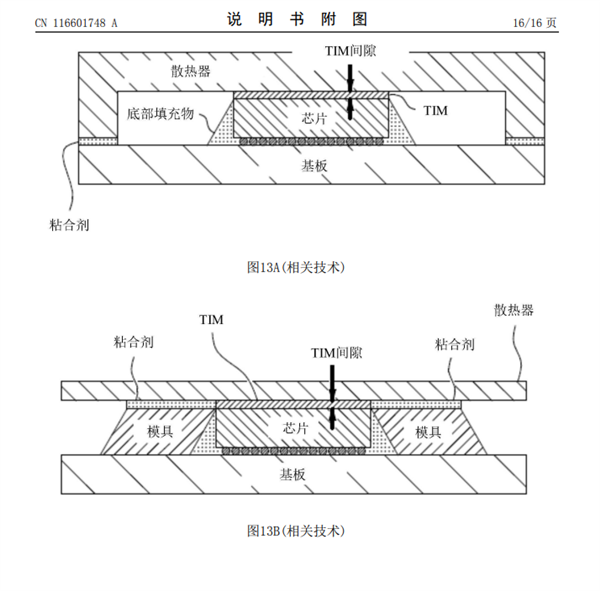
傳統倒裝芯片封裝示例
-
華為
+關注
關注
218文章
36005瀏覽量
262097 -
gpu
+關注
關注
28文章
5194瀏覽量
135445 -
芯片封裝
+關注
關注
13文章
614瀏覽量
32264
原文標題:華為公布倒裝芯片封裝最新專利:改善散熱 CPU、GPU等都能用
文章出處:【微信號:hdworld16,微信公眾號:硬件世界】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
CPU散熱器粘接用導熱膠怎么選?性能與應用全解析 |鉻銳特實業

英偉達Rubin GPU采用鉆石銅散熱,解決芯片散熱難題
QDPAK頂部散熱封裝簡介




 華為公布倒裝芯片封裝最新專利:改善散熱 CPU、GPU等都能用
華為公布倒裝芯片封裝最新專利:改善散熱 CPU、GPU等都能用











評論