華為技術(shù)有限公司8月15日在國家知識產(chǎn)權(quán)局官方網(wǎng)站公開了名為“cn116601748a”的涂裝芯片包裝專利。該專利被稱為“具具有改進的熱性能的倒裝芯片封裝”,提供芯片和散熱器之間的接觸方式,有助于提高散熱器的防熱性能。
綜上所述,倒置的芯片被密封在基板上,芯片的上端是暴露的,但周圍是環(huán)繞芯片側(cè)面的模塊化結(jié)構(gòu)。散熱器底部通過熱界面材料與芯片表面接觸。此外,芯片和結(jié)構(gòu)材料周圍和散熱器之間也涂上粘合劑。
華為在專利中表示,最近由于半導(dǎo)體封裝在處理性能方面的進步,對更高的熱性能提出了要求,保證了穩(wěn)定的操作。倒裝芯片膠囊在熱性能方面具有優(yōu)勢,其結(jié)構(gòu)特征是芯片可以通過其下方的凸起與基板連接,使散熱器位于芯片的頂層表面。為了提高冷卻性能,將熱界面材料(tim)涂抹在芯片頂部,并夾在芯片和散熱器的至少一部分之間。從減少tim的熱電阻,改善密封的熱性能的觀點來看,最好使tim的厚度更小。
以前的防熱方案使tim層的厚度難以控制,產(chǎn)生厚度不均勻等問題。華為的新專利介紹說,在鑄造模型的過程中,可以很容易地調(diào)整由鑄造模型化合物組成的墻壁結(jié)構(gòu)的高度,可以將熱界面材料的厚度調(diào)整為必要的小厚度,從而提高了熱性能。
該專利可應(yīng)用于cpu、fpga、asic、gpu等芯片,支持智能手機、平板電腦、可穿戴移動設(shè)備以及pc、工作站、服務(wù)器、相機等。
-
芯片
+關(guān)注
關(guān)注
463文章
54010瀏覽量
466169 -
散熱器
+關(guān)注
關(guān)注
2文章
1137瀏覽量
39654 -
模塊化
+關(guān)注
關(guān)注
0文章
356瀏覽量
22697
發(fā)布評論請先 登錄
浮思特 | NMB散熱風(fēng)扇靜音如何?卓越靜音效果提升散熱性能

華為衛(wèi)星通信專利公布
突破!華為先進封裝技術(shù)揭開神秘面紗
aQFN封裝芯片SMT工藝研究
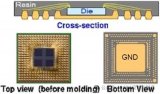
AI芯片封裝,選擇什么錫膏比較好?

新品 | 采用頂部散熱 Q-DPAK封裝的 CoolSiC? 1200V G2 SiC MOSFET

MUN12AD03-SEC的封裝設(shè)計對散熱有何影響?
MUN12AD03-SEC的熱性能如何影響其穩(wěn)定性?
氮化硼納米管在芯片熱界面領(lǐng)域?qū)?b class='flag-5'>熱性能可提升10-20%,成本僅增加1-2%
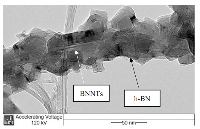
高散熱性能PCB:汽車電子高溫環(huán)境下的 “穩(wěn)定器”
全面剖析倒裝芯片封裝技術(shù)的內(nèi)在機制、特性優(yōu)勢、面臨的挑戰(zhàn)及未來走向
石墨膜和銅VC散熱性能和應(yīng)用方面的區(qū)別




 華為倒裝芯片封裝專利公布,可改善散熱性能
華為倒裝芯片封裝專利公布,可改善散熱性能







評論