晶圓級封裝技術(shù)是指直接在晶圓上進行大部分或全部的封裝、測試程序,然后進行安裝焊球并切割,從而產(chǎn)出一顆顆IC成品單元,可將封裝尺寸減小至IC芯片的尺寸,因此生產(chǎn)成本得以大幅下降。
隨著半導體應用市場對于芯片性能的不斷追求,芯片制造的成本也在持續(xù)增加,創(chuàng)新的先進封裝技術(shù)的出現(xiàn)也成為必然。
而硅晶圓切割工藝是在“后端”裝配工藝中的第一步,將晶圓分成單個的芯片,用于隨后的芯片接合、引線接合和測試工序。
在芯片制造領域,激光切割是最為常見主流的切割技術(shù),可將小功率的激光切割器聚焦到200nm的光斑上,形成巨大能量,從而將晶圓切割。
本期小明就來跟大家分享一下精密測量在晶圓切割中的“神助攻”。
項目難點
1、晶圓表面為“波浪形”
將晶圓表面放大后可看到,呈波浪形狀,非完全平滑,這就給激光切割帶來難題,無法實時判別其高度,激光不能精確落在晶圓改質(zhì)層,導致切割精度下降、損壞度提高。
2、激光難以均勻地作用在被加工物體上,從而導致圓弧處過度加工等現(xiàn)象。
3、運動機構(gòu)運行過程種存在的模擬量干擾、非線性、零飄等,導致了一定的精度誤差。
解決方案
1、切割晶圓時,可通過使用光譜共焦技術(shù)實時測量產(chǎn)品表面微小高度波動,實時補償?shù)郊す馄鞯腪軸,確保激光焦點精確落在晶圓改質(zhì)層。
2、采集數(shù)據(jù)時的編碼器控制測量,和激光器同步輸出信號進行相位同步,在運動軌跡的所有階段以恒定的空間(而非時間)間隔采集高度數(shù)據(jù),確保高度跟隨算法的精度保證。
3、由于設備采用光纖傳輸,避免了電磁干擾、非線性等的不穩(wěn)定因素,保證了輸出精度的穩(wěn)定性。
產(chǎn)品選型
1、該項目采用光譜共焦儀單通道控制器的方案,即ADV-12CKS+ACC-016L,搭配16mm測頭,線性精度可達正負0.35um(如有另外檢測距離要求可根據(jù)需要選擇8mm到55mm合適測頭,明治還可根據(jù)用戶特殊需求進行定制化開發(fā)。
2、通信方面,有豐富通訊接口,模擬量、232、網(wǎng)口通訊、編碼器控制等
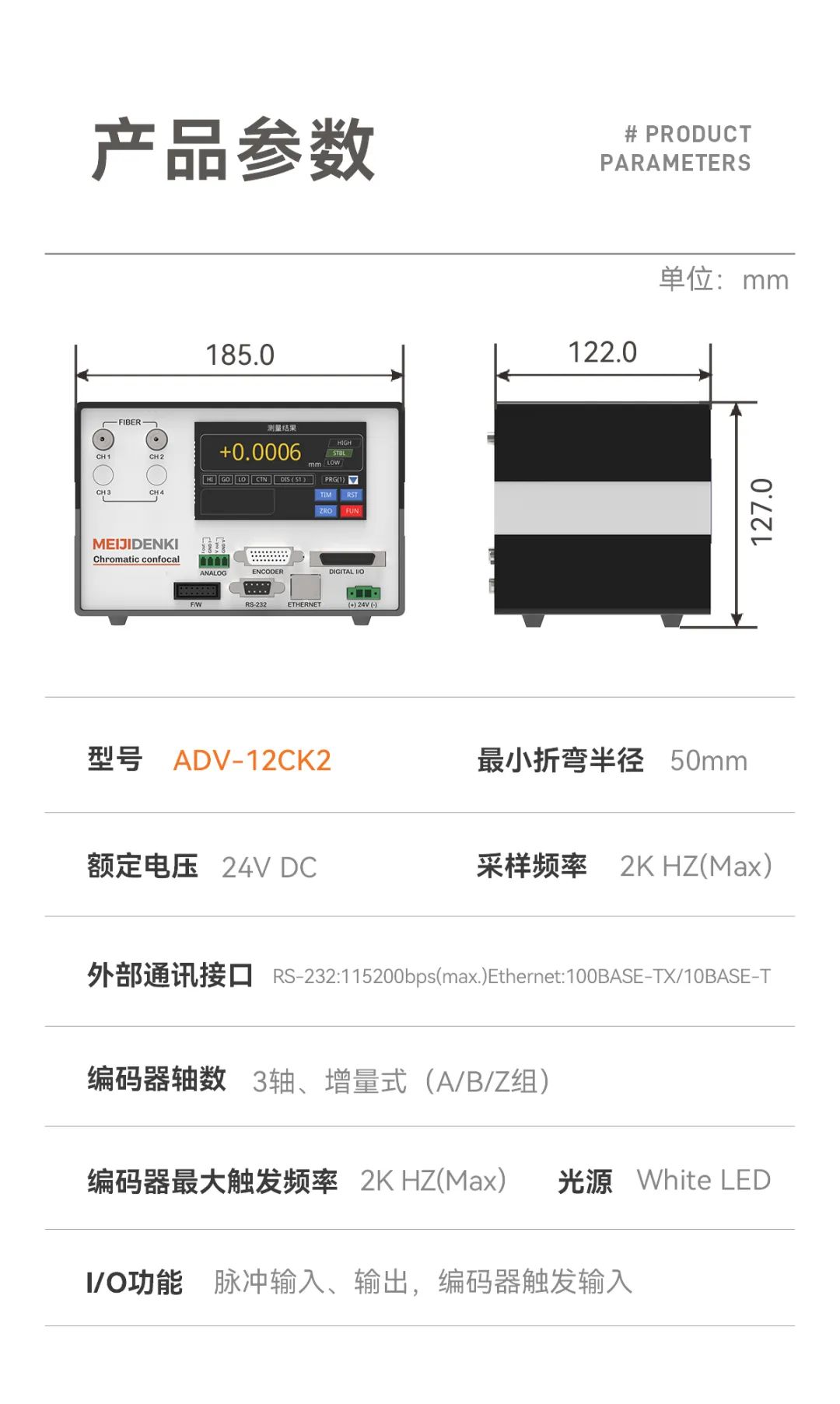

選型要點
一、精度、工作距離、量程(測量范圍或者被測物大小、厚度),這三個是最基本的要素
二、被檢測物的材質(zhì)
三、根據(jù)所需的接口選擇有無通訊方式,和什么樣的通訊方式
-
晶圓
+關注
關注
53文章
5410瀏覽量
132297 -
檢測
+關注
關注
5文章
4861瀏覽量
94156
發(fā)布評論請先 登錄
「直驅(qū)技術(shù)」破解晶圓測試精度瓶頸:雅科貝思超精密運動平臺如何實現(xiàn)±0.5um重復定位?

MEMS工廠核心技術(shù)解讀:微米級工藝與20余項特色工藝開發(fā)
博捷芯劃片機在射頻芯片高精度切割解決方案

50.6億!中國首條8英寸MEMS晶圓全自動生產(chǎn)線,正式投產(chǎn)
半導體行業(yè)案例:晶圓切割工藝后的質(zhì)量監(jiān)控

劃片機在生物晶圓芯片制造中的高精度切割解決方案

晶圓切割中淺切多道工藝與切削熱分布的耦合效應對 TTV 的影響

三坐標微米級測量精度,高精度檢測液壓支架導向套的幾何公差尺寸

光模塊芯片(COC/COB)切割采用國產(chǎn)精密劃片機的技術(shù)能力與產(chǎn)業(yè)應用




 應用案例 | 晶圓全自動切割工藝中,微米級精度檢測方案
應用案例 | 晶圓全自動切割工藝中,微米級精度檢測方案


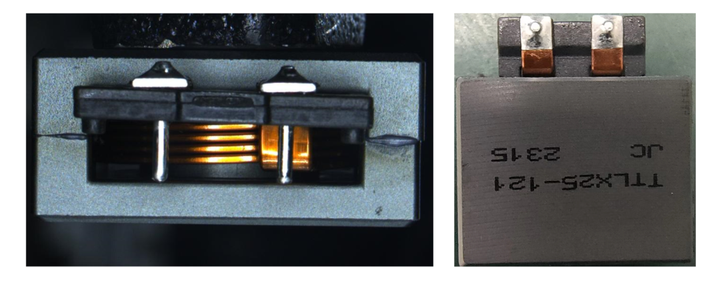
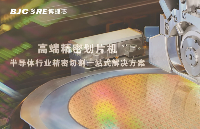





評論