貞光科技從車規(guī)微處理器MCU、功率器件、電源管理芯片、信號處理芯片、存儲芯片、二、三極管、光耦、晶振、阻容感等汽車電子元器件為客戶提供全產(chǎn)業(yè)鏈供應(yīng)解決方案。獲取更多方案或產(chǎn)品信息請聯(lián)系我們。
隨著新能源浪潮與全球節(jié)能減碳趨勢,汽車龍頭廠商將電動車(Electric Vehicle, EV)功能列入研發(fā)藍(lán)圖上。根據(jù)Yole的預(yù)測,從2021至2027年間,全球各類EV市場的平均年復(fù)合成長率(CAGR)可達(dá)21%,而在電動車的零件組成中,功率元件諸如DC-DC轉(zhuǎn)換器、車載充電器、逆變器等應(yīng)用水漲船高,盡管目前這些功率元件的產(chǎn)值仍與成熟IC元件相差許多,但CAGR預(yù)期至2027年皆有雙位數(shù)的成長。以SiC 模塊為例,到了2027年,其產(chǎn)值可達(dá)44億美元,CAGR為38%(圖1),因此功率元件是未來各半導(dǎo)體產(chǎn)業(yè)鏈的發(fā)展重心之一。

圖1 各類功率元件2021-2027年的營收與CAGR。
為滿足功率元件需求,廠商積極投入第三類半導(dǎo)體
第三類半導(dǎo)體是以碳化硅(SiC)、氮化鎵(GaN)等寬帶隙材料應(yīng)用的半導(dǎo)體,相較于傳統(tǒng)由硅制作的功率元件,第三類半導(dǎo)體擁有較高的頻率與功率的操作范圍,能應(yīng)用在許多高科技產(chǎn)業(yè)上,例如自駕車、5G/6G、太空、AI、量子高速運(yùn)算、發(fā)電設(shè)施等等。
許多傳統(tǒng)功率元件廠商紛紛宣布2022年下半年投入SiC元件的生產(chǎn),為整體第三類半導(dǎo)體市場帶入更多的動力。圖2說明了由各類材料制造出的功率元件的操作頻率與功率范圍,并說明可應(yīng)用的領(lǐng)域。
依照不同的應(yīng)用情境選擇適用的元件種類和電壓應(yīng)用范圍,圖3是針對不同電壓對元件所作的區(qū)分,現(xiàn)今車載功率元件的主流范圍在900V以下,此部份以傳統(tǒng)的Si和GaN MOSFET為主;而1200V以上的需求,則以鐵道或發(fā)電廠的應(yīng)用為主,此操作便需要IGBT或SiC的元件了。
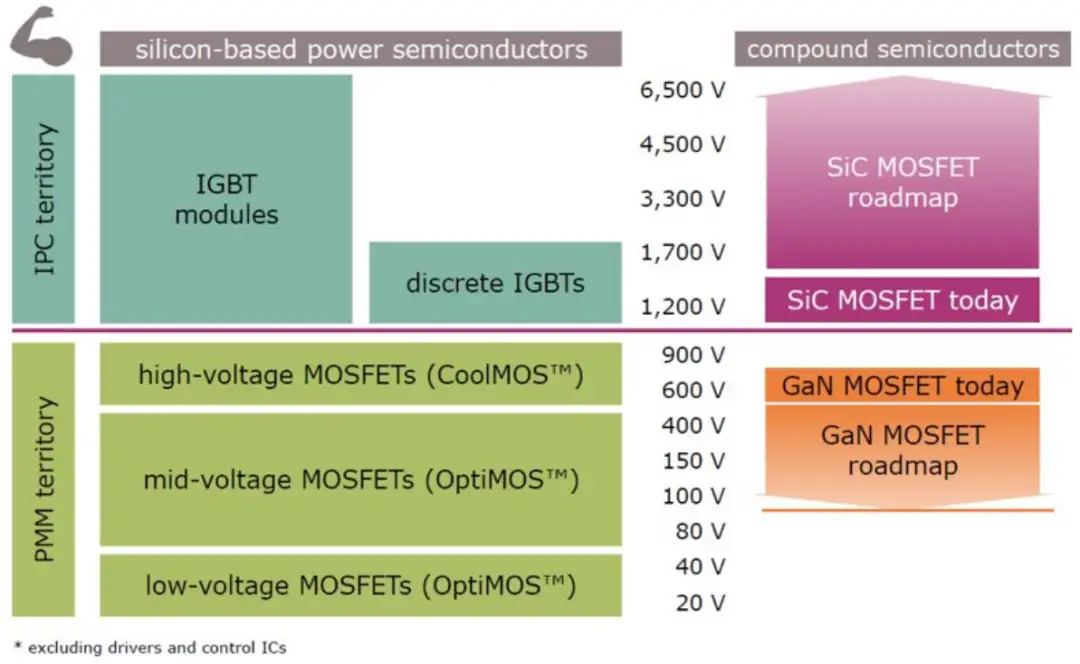
圖3 各類型材料之功率元件的操作電壓。
功率元件全方位檢測分析三大步驟
隨著功率元件產(chǎn)值的提升,自然也帶動了分析檢測的需求。在故障分析的領(lǐng)域上,對元件結(jié)構(gòu)的了解、電性量測是入門的基本功,盡管功率元件的結(jié)構(gòu)較IC簡單,不過材質(zhì)與金屬連接的布局,卻是影響樣品制備、缺陷觀察的重要影響因子;電性量測方面,由于功率元件的特殊規(guī)格,無法使用一般的參數(shù)分析儀確認(rèn)失效行為,因此需要高功率的量測儀器才能執(zhí)行。綜合以上考量,在全方案分析流程上,可簡易地歸納出以下三大步驟:
1.電性參數(shù)量測
IC的量測可以分為靜態(tài)測試與動態(tài)測試兩種,前者就是DC量測,open/short與leak Hi/Lo皆屬此類,在第三方分析實(shí)驗(yàn)室皆可靠參數(shù)分析儀進(jìn)行驗(yàn)證,而缺陷的定位也是以靜態(tài)測試為主;動態(tài)測試即是功能測試,需要ATE或臺架測試(bench test)才能夠達(dá)成,不同種類的IC有不同的測試程式,一般第三方分析實(shí)驗(yàn)室無此分析能量,故大多無法進(jìn)行功能失效的全方案流程。功率元件由于結(jié)構(gòu)簡單,電性參數(shù)項(xiàng)目固定,市場上已有單一儀器可進(jìn)行量測,電性參數(shù)在規(guī)格書定義得十分清楚,只要依照規(guī)格書的項(xiàng)目,便可逐一萃取各個項(xiàng)目值。首先電性參數(shù)需要量測,以600V的MOSFET為例,電性參數(shù)與說明如圖4;了解電性參數(shù)的定義后,即可在某參數(shù)異常時,推測是哪一結(jié)構(gòu)出現(xiàn)問題,擬定物性故障分析方案。

圖4 600V MOSFET電性參數(shù)與定義說明。
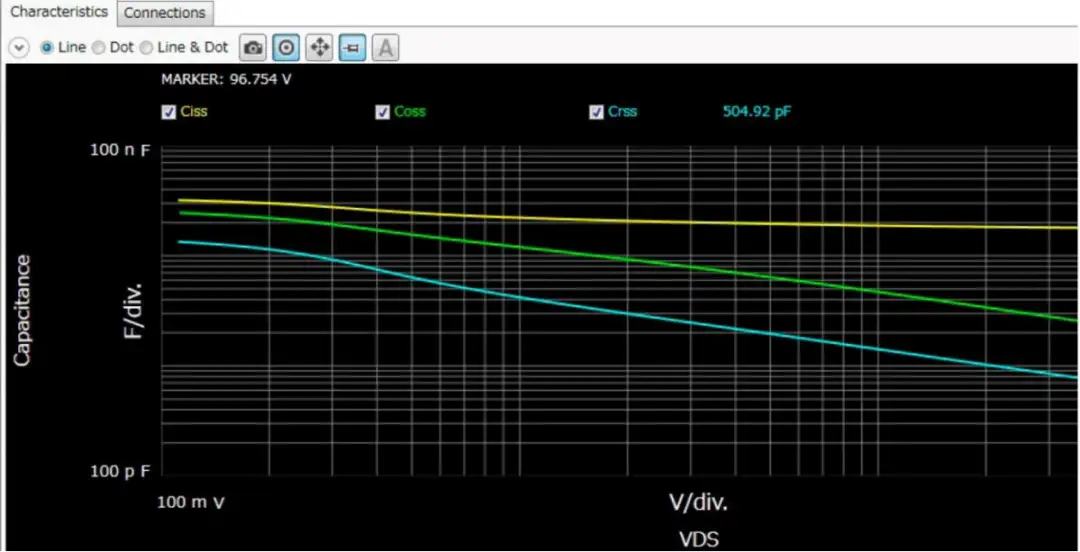
圖5 電容對電壓的關(guān)系圖。
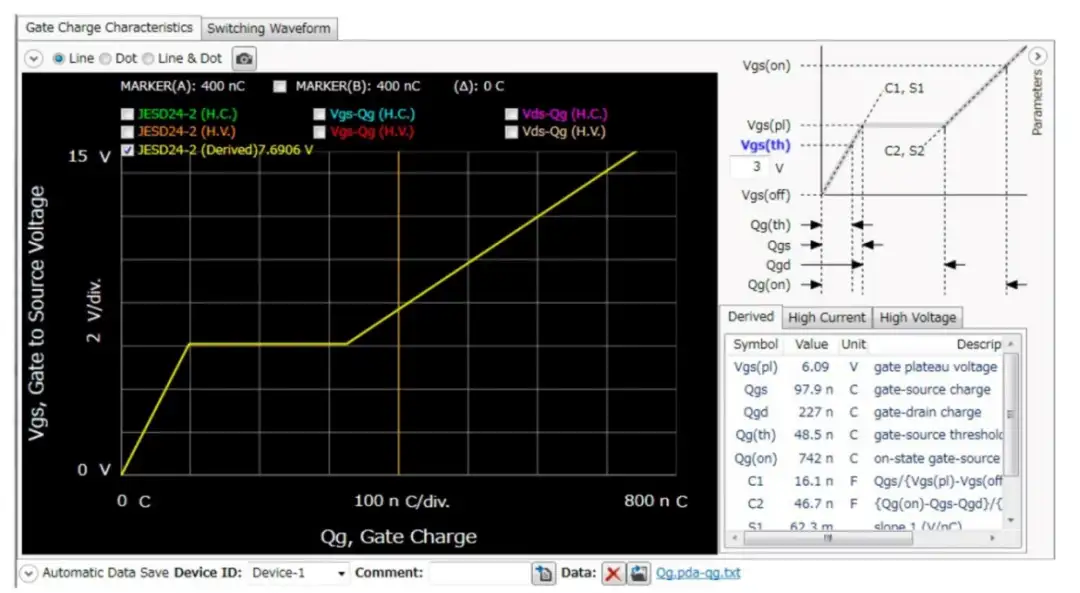
圖6 Vgs電壓對gate電荷的關(guān)系圖。
2.亮點(diǎn)定位
不論執(zhí)行何種半導(dǎo)體元件的亮點(diǎn)定位,主要以這三項(xiàng)工具:微光顯微鏡(PEM)、雷射致阻值變化偵測(OBIRCH)、熱影像分析儀(Thermal Emission Microscope, Thermal EMMI)。依電性故障行為與樣品結(jié)構(gòu)考量,選擇合適的定位儀器;從芯片的正面或背面?zhèn)蓽y亮點(diǎn),則視樣品制備難易度而定。功率元件的結(jié)構(gòu)雖然簡單,但樣品制備的難度卻高于IC制程,原因在于功率元件芯片表面有一層厚厚的鋁,遮擋了亮點(diǎn)的觀察,不過在初步的亮點(diǎn)定位上,可優(yōu)先選擇使用Thermal EMMI,利用其熱傳導(dǎo)的特性,先進(jìn)行第一次定位,待定位完成后,若需要更精細(xì)的范圍,再選擇其它的定位工具。
3.缺陷觀察
由于功率元件的結(jié)構(gòu)簡單,比如MOSFET或IGBT皆是許多cell以陣列的方式并聯(lián)排列,而單一明確的亮點(diǎn)即代表缺陷所在的位置,再加上由電性行為可以判斷漏電的路徑,對照結(jié)構(gòu)就可以推論出可能的物性故障現(xiàn)象,所以一般來說,亮點(diǎn)定位完成后直接進(jìn)行截面的觀察是標(biāo)準(zhǔn)作業(yè)流程。對于功率元件來說,要進(jìn)行截面的樣品制備并觀察缺陷的外貌,主要有兩種方式:一是聚焦離子束(Focused Ion Beam, FIB),另一種則是穿透式電子顯微鏡(Transmission Electron Microscopy, TEM),兩者的差別主要在于解析度差異,F(xiàn)IB可觀察燒熔、制程異常、外來物等較明顯可見的異狀,而TEM則可以觀察晶格缺陷。在第三類半導(dǎo)體的材料中,可能存在差排的晶格缺陷,若執(zhí)行FIB后未見明顯異常,可再轉(zhuǎn)做TEM觀察。
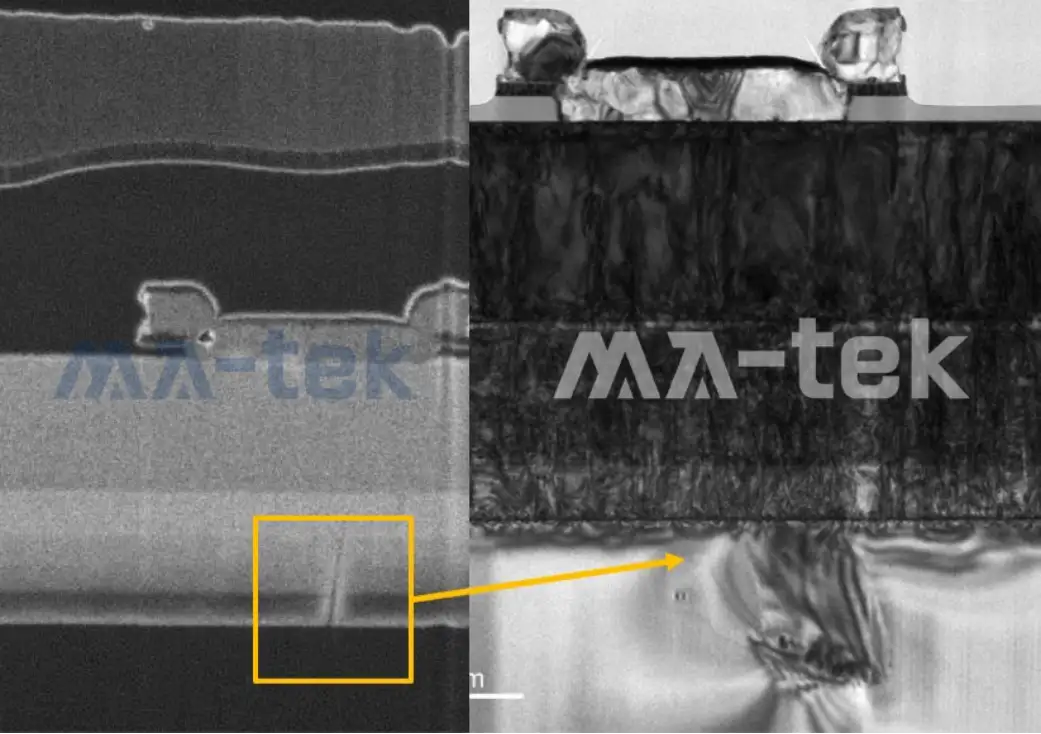
圖8 GaN MOSFET以FIB和TEM觀察到的裂痕和差排。

圖9 SiC MOSFET以TEM觀察到的差排。
若是因離子布植問題造成的漏電,上述兩種顯微鏡便無法派上用場,需要使用掃描式電容顯微鏡(Scanning Capacitance Microscopy, SCM)來觀察p-type與n-type攙雜的分布。濃度異常除了會造成電池泄漏,還會因?yàn)橛绊懥穗妶龇植迹鴮?dǎo)致?lián)舸┈F(xiàn)象所產(chǎn)生的大電流問題。綜觀以上,只要有適當(dāng)?shù)姆治龉ぞ撸M合成既定的分析步驟,再整合電性特征與物性結(jié)構(gòu),便能有效地挖掘出故障的真因。隨著功率元件的應(yīng)用愈發(fā)廣泛,相信此套分析流程,能夠協(xié)助功率元件廠商快速研發(fā)與提升量產(chǎn)良率。
*免責(zé)聲明:本文由作者原創(chuàng)。文章內(nèi)容系作者個人觀點(diǎn),貞光科技二次整理,不代表貞光科技對該觀點(diǎn)贊同或支持,僅為行業(yè)交流學(xué)習(xí)之用,如有異議,歡迎探討。
-
半導(dǎo)體
+關(guān)注
關(guān)注
339文章
30751瀏覽量
264348 -
測量
+關(guān)注
關(guān)注
10文章
5638瀏覽量
116744
發(fā)布評論請先 登錄
深圳市薩科微slkor半導(dǎo)體有限公司是宋仕強(qiáng)于2015年在深圳市華強(qiáng)北成立,當(dāng)時掌握了行業(yè)領(lǐng)先的第三代半導(dǎo)體
龍騰半導(dǎo)體推出全新第三代超結(jié)MOSFET技術(shù)平臺

行業(yè)快訊:第三代半導(dǎo)體駛?cè)肟燔嚨溃蓟杵骷杀居型?b class='flag-5'>三年內(nèi)接近硅基
高頻交直流探頭在第三代半導(dǎo)體測試中的應(yīng)用
上海永銘:第三代半導(dǎo)體落地關(guān)鍵,如何為GaN/SiC系統(tǒng)匹配高性能電容解決方案
第三代半導(dǎo)體碳化硅(Sic)功率器件可靠性的詳解;

第三代半導(dǎo)體碳化硅(Sic)加速上車原因的詳解;

CINNO出席第三代半導(dǎo)體產(chǎn)業(yè)合作大會
基本半導(dǎo)體B3M平臺深度解析:第三代SiC碳化硅MOSFET技術(shù)與應(yīng)用
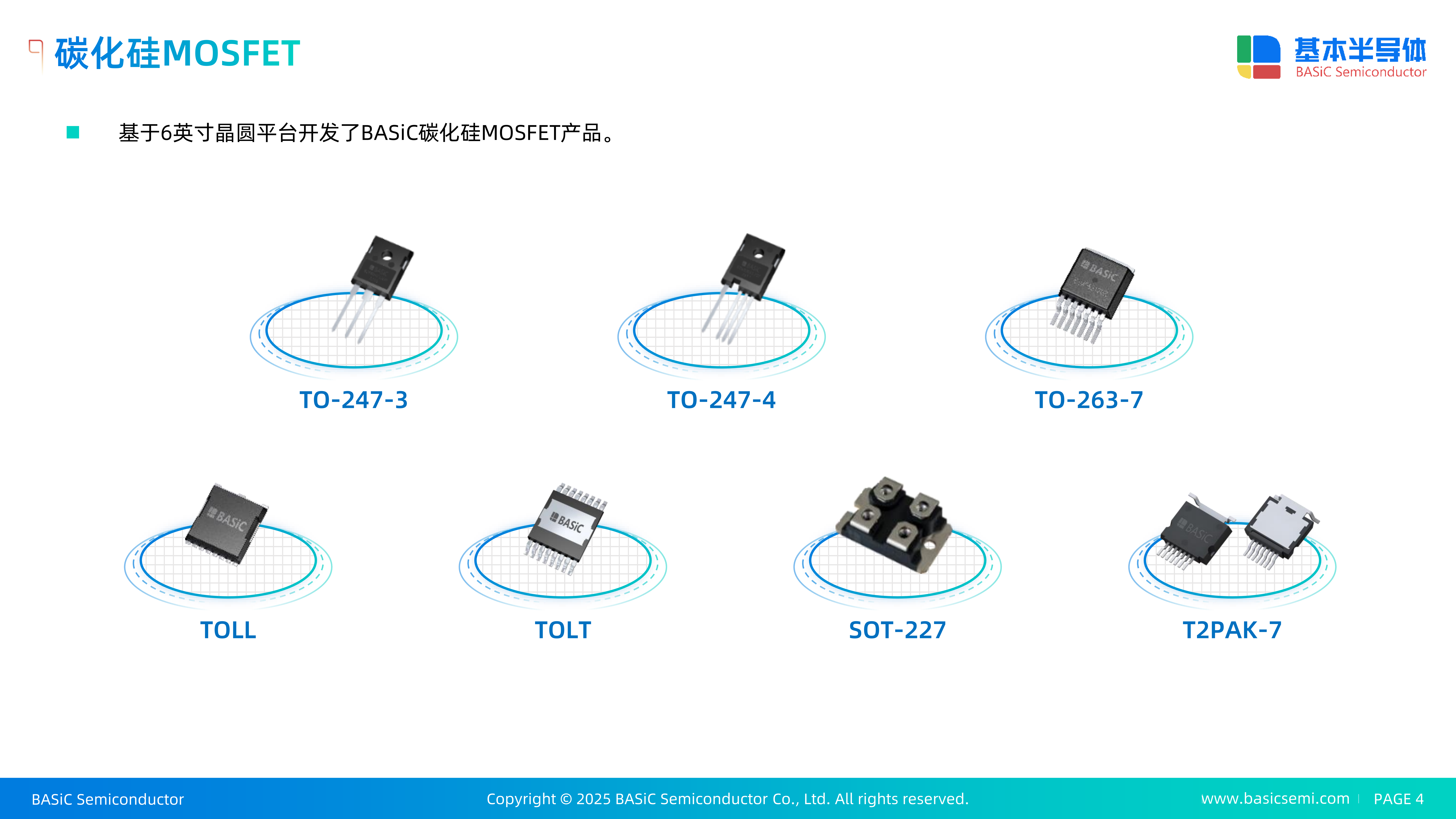
電鏡技術(shù)在第三代半導(dǎo)體中的關(guān)鍵應(yīng)用
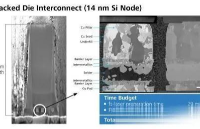
第三代半導(dǎo)體的優(yōu)勢和應(yīng)用領(lǐng)域
瑞能半導(dǎo)體第三代超結(jié)MOSFET技術(shù)解析(1)
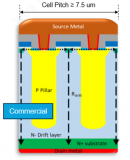
是德示波器如何精準(zhǔn)測量第三代半導(dǎo)體SiC的動態(tài)特性

UC3854 功率因數(shù)校正設(shè)計(jì)全攻略:從理論到實(shí)戰(zhàn)




 干貨!第三代半導(dǎo)體功率元件電性測量及故障分析全攻略
干貨!第三代半導(dǎo)體功率元件電性測量及故障分析全攻略




評論