光刻是半導體行業的核心技術。自仙童半導體公司的羅伯特諾伊斯在1960年發明單片集成電路以來,光刻技術一直是主要的光刻技術。
本質上,陰影掩模(shadow mask)用來協助一種稱為光刻膠的光敏材料進行圖案化,從而能夠進行圖案化沉積和蝕刻工藝。而光刻工藝的最終解決方案是由所用光源的波長決定的。
在開發更短波長的光刻源方面取得了進步。這使得以摩爾定律為特征的電路密度不斷增加。歷史上使用汞放電燈,例如 365 nm i-Line,但最近使用 248 nm 的 KrF 或 193 nm 的 ArF 準分子激光器成為首選光源。當使用液體浸沒技術時,ArF 激光器獲得的最終分辨率約為 50 nm,其中透鏡和半導體晶片浸入水中,水中的折射率高于空氣。
過去二十年見證了193 nm以下波長光刻技術的發展。在使用 F2 準分子激光器開發基于 157 納米的光刻技術方面付出了一些努力,但主要關注點是使用 13.5 納米軟 X 射線作為光源的極紫外 (EUV) 光刻技術。
荷蘭公司 ASML 在 EUV 技術的開發中發揮了主導作用,他們的工具集現在被包括英特爾、三星和臺積電在內的主要先進 CMOS 代工廠用于生產。
光刻方法的實踐
應用許多光刻方法來產生單芯片設計。TechInsights 最近對三星 5LPE 工藝進行了詳細分析。圖 1 顯示了器件 CPU 邏輯區域中柵極和鰭片布局的平面圖 TEM 圖像。
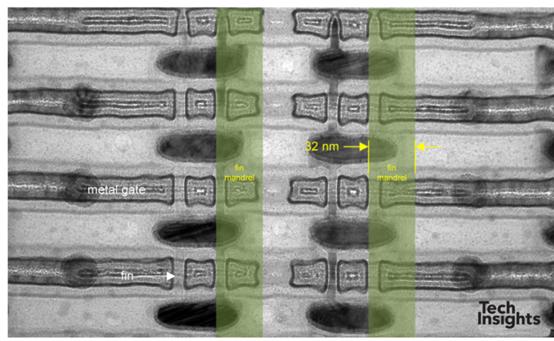
圖 1:Samsung 5LPE Gate and Fin Layout
自對準四重圖案化 (SAQP) 幾乎可以肯定用于對鰭進行圖案化。圖像注釋中顯示了 fin mandrels的大致位置,該位置將使用 ArF 193 nm 浸入式 (ArF 193i) 光刻進行圖案化。然后將通過在mandrel上創建 sidewall spacers來形成最終的 fin pattern。mandrel將具有 108 nm 的間距(pitch)。然后移除mandrel,然后使用第一個側壁間隔物( sidewall spacer)圖案來創建第二組側壁間隔物,最終的鰭間距為 27 nm。
兩組側壁間隔物的大致位置和尺寸如圖 2所示,這是一張橫截面 TEM 圖像,顯示邏輯區域中三星 5LPE 工藝的 27 nm 間距鰭結構.
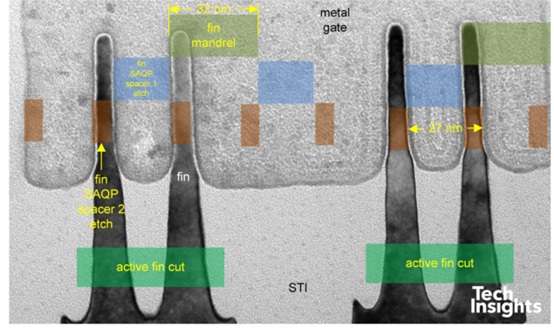
圖 2:Samsung 5LPE Fin Cross Section
然后將使用有源鰭(active fin)切割掩模去除不需要的鰭并用淺溝槽隔離 (STI:shallow trench isolation) 替換它們。圖 1中所示的金屬柵極很可能是使用自對準雙圖案化 (SADP) 技術形成的,其中mandrel上的側壁間隔物直接用于圖案化多晶硅柵極,后來被金屬柵極取代。
目前正在生產的先進半導體器件的尺寸明顯小于使用 ArF 浸沒式光刻技術可獲得的約 50 nm 最小半間距。這需要開發越來越復雜的工藝技術方案。例如,根據最近的 TechInsights 分析結果,三星 5 納米 LPE 工藝使用了多種先進的光刻方法,包括 EUV,如表 1 所示。
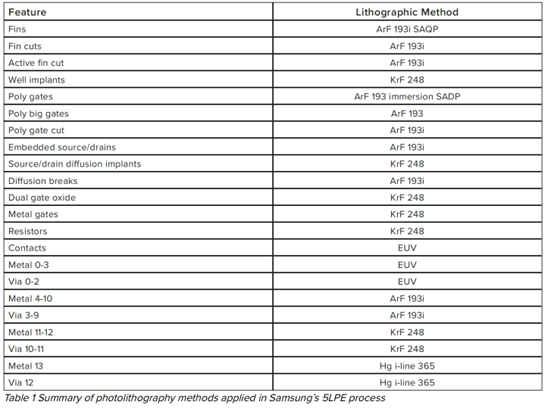
表 1
SAQP光刻技術可以產生非常精細的間距特征;但是,它僅限于創建沿單個方向定向的單軸結構( uniaxial structures)。線路末端需要特殊切割( Special cut)的掩模,以防止相鄰線路之間短路。EUV 光刻沒有這些限制,但成本較高。
圖 3 顯示了三星 5LPE 設備的 CPU 邏輯區域中metal 0 布局的平面圖 TEM 顯微照片。觀察到的最小金屬間距約為 44 nm。此外,布局包括在兩個正交方向上定向的線。這在使用 SADP 或 SAQP ArF 193i 光刻方法時通常是不可能的。
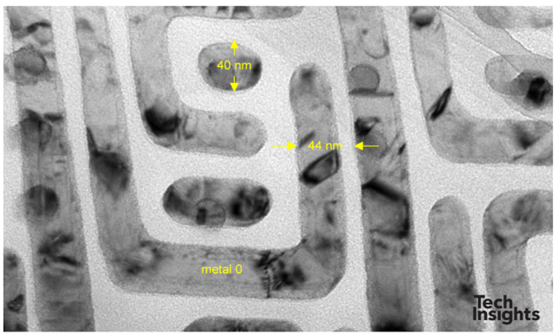
圖 3:Samsung 5LP Metal 0 Layout
納米壓印光刻和直接自組裝光刻
EUV 設備和工藝非常復雜和昂貴,因此業界一直在研究替代品。三個主要競爭者是:
1. 納米壓印光刻 (NIL:Nano-Imprint Lithography)
2. 直接自組裝 (DSA:Direct Self-Assembly) 光刻
3. 電子束光刻 (EBL:Electron Beam Lithography)
其中,EBL 提供非常高的空間分辨率(優于 10 nm),但配置和執行速度較慢,本文將不作進一步考慮。EBL 確實有商業應用,但不是在大批量先進節點制造中。
納米壓印光刻技術最早由明尼蘇達大學的Stephen Chu 提出。該技術基于聚甲基丙烯酸甲酯 (PMMA) 的壓縮成型。Chu 和他的合著者在 1996 年發表在《科學》雜志上的一篇論文中報告了 25 nm 分辨率的圖案化。他們于 1995 年發布了開創性專利 US5772905A。NIL 技術于 2003 年被添加到 ITRS 路線圖中,該領域一直是持續研究和開發的領域。佳能是全球主要的光刻設備供應商之一,并且他們現在提供 NIL 產品線,東芝是他們的早期客戶之一,建議的應用是 NAND 閃存生產。
直接自組裝光刻取決于嵌段共聚物(block-copolymers)在預圖案化基板上的直接定向。該技術類似于 SADP 和 SAQP,因為使用較粗的間距模板(coarser pitch template)來創建較細的間距結構( finer pitch structure)。DSA 技術于 1990 年代首次提出,并于 2007 年成為 ITRS 路線圖的一部分。DSA 的主要支持者是 IMEC 的一個研究小組。2021 年,他們展示了使用 DSA 形成 18 納米間距線圖案。據我們所知,直接自組裝尚未被任何主要半導體代工廠用于大批量生產。在過去的二十年里,這項技術進行了大量的研發和專利活動,但還沒有商業用途。
先進光刻的創新專利
TechInsights與 Cipher 合作,一直在探索先進光刻市場的創新。目前,基于光學光刻的技術主導著半導體市場,其中 ArF 193i 是用于圖案化細間距特征的主要方法。基于 EUV 的光刻開始出現在最先進的 CMOS 技術中,例如上一節中討論的三星 5LPE。
不幸的是,EUV 方法非常昂貴,并且可能存在與 ASML 交付 EUV 硬件相關的供應鏈問題。我們預計該行業將積極尋求替代方案。Cipher 一直與 TechInsights 合作開發專利分類器,可用于監控特定領域的創新步伐,例如 EUV、NIL 和 DSA 光刻。
Cipher 專利分類器使 TechInsights 能夠繪制出 EUV、NIL 和 DSA 先進光刻專利的概況。圖 4 顯示了按技術排名前 5 位的專利組織的表格。

圖 4:Top 5 Companies by NIL, EUV and DSA Patent Holdings
表格顯示:
? 佳能顯然對 NIL 技術寄予厚望;
? ASML 對 EUV 的投資最多,但也積極參與 NIL 和 DSA 研究;
? 從先進光刻研發的角度來看,臺積電顯然是領先的代工廠。他們是對 EUV 投資最多,但在 NIL 和 DSA 方面也很活躍;
? 三星排在第五位,也在兩面下注,盡管他們的專利活動水平遠低于臺積電;
? Karl-Zeiss 排在第四位,他們作為光刻供應商的主要關注點是 EUV 也就不足為奇了;
該表未顯示包括GlobalFoundries、IBM 和 Intel 在內的北美主要組織,它們的排名更靠后,分別位于第 16 位、第 17 位和第 32 位。
圖 5 根據 Cipher 專利分類器獲得的結果,將中國排名前 10 位實體的專利格局與世界其他地區進行比較,按組織和光刻技術類型列出了當前活躍專利家族的數量。

圖 5:Counts of Current Active Patent Families by Organization and Technology for China
圖 6顯示了按年份和先進光刻技術提交的專利族數量僅供中國公司使用的空間。專利總數相當少,但有持續的EUV、DSA 和 NIL 這三個技術領域的專利活動呈上升趨勢。

圖 6:Number of Patent Families Filed by Year and Technology for China
相比之下,圖 7顯示了世界其他地區(不包括中國)在先進光刻領域按年份和技術提交的專利族數量。

圖 7:Number of Patent Families Filed by Year and Technology for Rest of World
當然,世界其他地區的專利數量要多于中國。數據顯示 EUV 專利活動呈持續上升趨勢;然而,大約在 2013 年之后,DSA 專利活動和 NIL 技術專利活動在大約 2018 年之后有所下降。這也許并不奇怪,因為 ASML EUV 技術現已商用,從而減少了尋找替代品的動力。
結論
先進的光刻技術對于摩爾定律擴展的延續至關重要。該行業目前正在押注EUV,輔以先進的 193i 技術,如 SADP 和 SAQP,將繼續縮小到上面討論的 5 納米技術以下。不幸的是,EUV 取決于使用極其復雜和昂貴的設備,因此該行業繼續尋找替代品,例如作為 NIL 或 DSA,這可能會提供一條替代途徑。
審核編輯 :李倩
-
摩爾定律
+關注
關注
4文章
640瀏覽量
80905 -
光刻技術
+關注
關注
1文章
151瀏覽量
16529 -
EUV
+關注
關注
8文章
615瀏覽量
88807
原文標題:EUV光刻的兩大挑戰者,誰扛大旗?
文章出處:【微信號:光刻人的世界,微信公眾號:光刻人的世界】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
中國打造自己的EUV光刻膠標準!
俄羅斯亮劍:公布EUV光刻機路線圖,挑戰ASML霸主地位?

壟斷 EUV 光刻機之后,阿斯麥劍指先進封裝
澤攸科技 | EBL和EUV光刻機有何區別?如何影響半導體行業?

第三屆開放原子大賽OpenTenBase兩大賽項圓滿落幕
白光干涉儀在EUV光刻后的3D輪廓測量
【「AI芯片:科技探索與AGI愿景」閱讀體驗】+半導體芯片產業的前沿技術
EUV光刻膠材料取得重要進展
中科院微電子所突破 EUV 光刻技術瓶頸

改善光刻圖形線寬變化的方法及白光干涉儀在光刻圖形的測量

華為OceanProtect躋身Gartner?備份與數據保護平臺魔力象限“挑戰者”
ASML杯光刻「芯 」勢力知識挑戰賽正式啟動

DSA技術:突破EUV光刻瓶頸的革命性解決方案




 EUV光刻的兩大挑戰者,誰扛大旗?
EUV光刻的兩大挑戰者,誰扛大旗?






評論