原子層沉積 (AtomicLayer Deposition, ALD)是指通過單原子膜逐層生長的方式,將原子逐層沉淀在襯底材料上。典型的 ALD 采用的是將氣相前驅物(Precursor)交替脈沖式地輸人到反應器內的方式。
例如,首先將反應前驅物 1通入到襯底表面,并經過化學吸附,在襯底表面形成一層單原子層,接著通過氣泵抽走殘留在襯底表面和反應腔室內的前驅物1;然后通入反應前驅物2到襯底表面,并與被吸附在村底表面的前驅物1 發生化學反應,在耐底表面生成相應的薄膜材料和相應的副產物;當前驅物1完全反應后,反應將自動終止,這就是 ALD 的自限制 (Self-Limiting)特性,再抽離殘留的反應物和副產物,準備下一階段生長;通過不斷重復上述過程,就可以實現沉積逐層單原子生長的薄膜材料。
ALD與 CVD 都是通入氣相化學反應源在襯底表面發生化學反應的方式,不同的是 CVD 的氣相反應源不具有自限制生長的特性。由此可見,開發ALD 技術的關鍵是尋找具有反應自限制特性的前驅物。
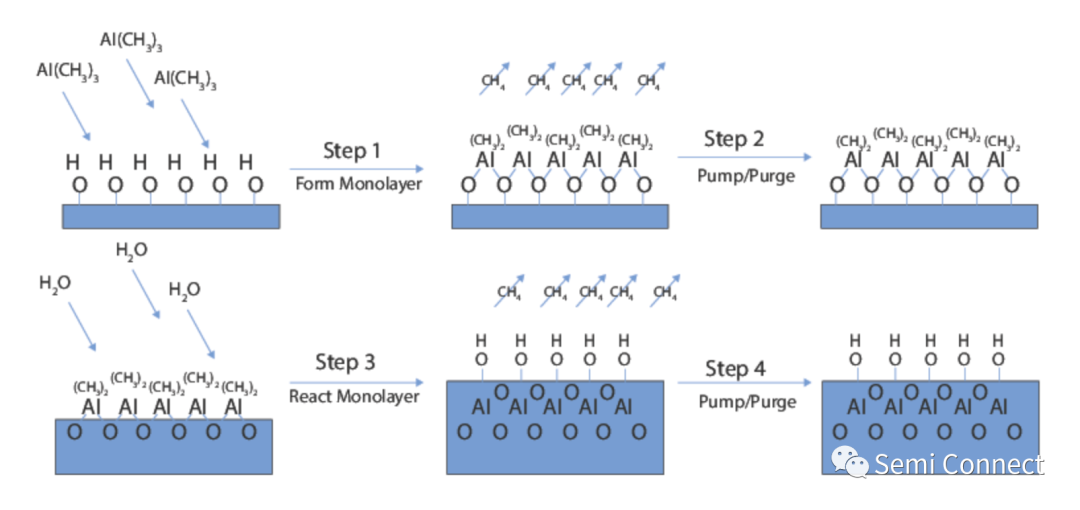
由于 ALD 技術逐層生長薄膜的特點,所以 ALD 薄膜具有極佳的合階覆蓋能力,以及極高的沉積均勻性和一致性,同時可以較好她控制其制備薄膜的厚度、成分和結構,因此被廣泛地應用在微電子領域。尤其是 ALD 具有的極佳的臺階覆蓋能力和溝槽填充均勻性,十分適用于棚極側墻介質的制備,以及在較大高寬比的通孔和溝槽中的薄膜制備。
ALD 技術在產業中的主要應用領域為柵極側墻生長、高k柵介質和金屬柵(Metal Gate)、銅互連工藝中的阻擋層 (BarierLayer)、微機電系統(MEMS)、光電子材料和器件、有機發光二極管 ( OrganieLight Eimiting Diode, OLED)材料、DRAM 及 MRAM 的介電層、嵌人式電容、電磁記錄磁頭等各類薄膜。
隨者集成電路的發展,器件的尺寸越來越小,生長的薄膜厚度不斷縮小且深槽深寬比不斷增加,使得 ALD 技術在先進技術節點的應用越來越多,如從平面器件轉到 FinFET 器件后,自對準兩次曝光技術的側墻采用 ALD 技術生長;從多晶硅柵轉向高k介質金屬柵技術,高k介質和金屬柵疊層生長過程也采用了 ALD 技術。
審核編輯 :李倩
-
原子
+關注
關注
0文章
89瀏覽量
20930 -
反應器
+關注
關注
2文章
105瀏覽量
12064
原文標題:原子層沉積(Atomic Layer Deposition,ALD)
文章出處:【微信號:Semi Connect,微信公眾號:Semi Connect】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
銣原子鐘與CPT原子鐘有哪些區別呢
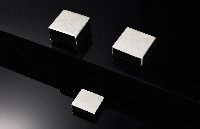
應用材料AMAT/APPLIED MATERIALS Producer? XP Precision? CVD系列二手薄膜沉積CVD設備拆機/整機|現場驗機評測
長春理工:飛秒激光輔助定域電化學沉積

混合沉積法制備效率26.46%的鈣鈦礦/有機疊層電池及其穩定性研究

中微公司重磅發布六大半導體設備新產品 覆蓋等離子體刻蝕(Etch)、原子層沉積(ALD)及外延(EPI)等關鍵

高性能、大面積NIR透明鈣鈦礦電池的制備與優化:基于ALD SnO?緩沖層策略結合橢偏光學分析

半導體外延和薄膜沉積有什么不同

K230上使用圖層layer = Display.LAYER_OSD2顯示完圖像后,怎么關閉這個圖層不再顯示?
低成本規模化的鈣鈦礦/硅疊層電池實現路徑:從溶液法PBL加工到MPPT效率驗證

金屬化后進行邊緣鈍化技術PET:減少硅太陽能電池分切損失,提升組件效率

Bluetooth LE Link Layer數據包全解析
原子層沉積(ALD)制備高透光摻鈮SnO?電子傳輸層(ETL)實現高效鈣鈦礦太陽能電池

詳解原子層沉積薄膜制備技術

質量流量控制器在薄膜沉積工藝中的應用
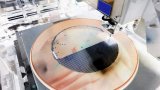



 原子層沉積(Atomic Layer Deposition,ALD)
原子層沉積(Atomic Layer Deposition,ALD)

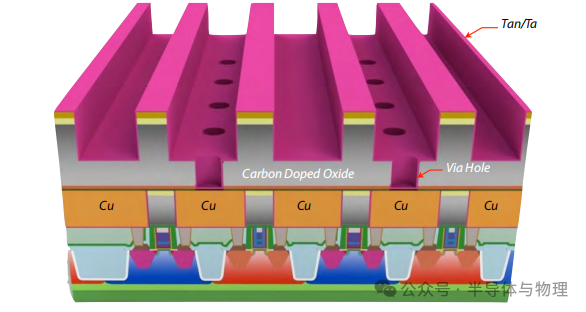



評論