摘要
在先進的p型金屬氧化物半導體場效應晶體管中,SiGe溝道可用于提高空穴遷移率和定制閾值電壓偏移。在這種器件的源極/漏極區中SiGe:B的低溫選擇性外延生長(SEG)之前,SiGe氧化物的有效去除是強制性的。SEG之前的H2烘烤通常在低于650°C的溫度下進行,以避免孤島效應或形狀變化,要求事先非常有效地去除表面污染物(如碳、氟、氧……)。由于鍺在空氣中非常活潑,Siconi原位表面制備方案很可能在具有這種熱預算約束的SiGe表面上使用。最近,評估了一種新的表面制備策略,該策略基于I)濕化學氧化物形成,然后ii)標準NH3/NF3遠程等離子體Siconi工藝。為了使用這樣的方案來制造器件,我們在此研究了表面制備對Si0.60Ge0.40在Si0.60Ge0.40膜上外延再生長的影響(在氧去除效率、所得形貌等方面)。我們表明,這種表面制備大大減少了界面污染,然而,在外延再生長后,表面可能是粗糙的。由于對表面制備和生長參數之間的相互作用進行了深入分析,因此我們華林科納半導體提出了一種創新的工藝順序,可生產出光滑、高質量的薄膜。
介紹
在先進的金屬氧化物半導體場效應晶體管(MOSFETs)中,電子和空穴遷移率比大塊無應變硅高幾倍,這是強制性的[1]。阿格濃度通常約為30%的壓縮應變SiGe例如用于14 nm技術節點p型完全耗盡絕緣體上硅器件的溝道中。在這種器件的源極/漏極(S/D)區中進行幾十nm的重度原位硼摻雜SiGe的選擇性外延生長(SEG)。它用于降低接觸電阻,具有足夠的鍺硅化材料,并保持(或增加)柵極下SiGe溝道中的壓縮應變。SiGe:B SEG之前的表面制備在SiGe表面上特別棘手,因為SiGe表面在空氣中非常容易發生反應。在外延之前,起始表面確實應該在原子尺度上是光滑的,并且沒有任何污染物(例如O、C或F)。因此,排隊時間(Q時間,即在單晶片濕法清洗工具中去除自然氧化物后在空氣中花費的時間)的最小化在SiGe上比在硅上更關鍵。
實驗細節
在這項工作中,15 nm厚的SiGe 40%層在600℃、20托下在300 mm大塊Si(001)晶片上外延生長。沉積厚度低于塑性松弛的臨界厚度;因此SiGe膜是完全壓縮應變的。標準300mm foup(ente gris)用于潔凈室中的晶片儲存。濕法處理在300 mm單晶片DNS SU 3100工具中進行。評估了基于標準前端化學與有效漂洗步驟的組合的各種濕法清洗順序(表1 ),例如1)稀釋的HF/HCl,2)稀釋的冷或熱標準清洗1 (SC1 ),即NH4OH:H2O2:H2O溶液,或3)臭氧化(O3)漂洗。

結果和討論
在下文中,我們已經在15 nm厚的Si0.6Ge0.4層上評估了不同的(I)濕法、(ii) Siconi和(iii)“濕法-Siconi”序列,在濕法清洗和Siconi工藝之間具有兩個Q時間,少于15分鐘或8小時。在沒有任何空氣中斷的情況下,Siconi工藝之后是在超純N2下將晶片轉移到外延室,在那里進行20托的H2烘烤(溫度低于或等于650°C ),并在600°C下再外延20托的另一種15 nm的Si0.6Ge0.4。這種低熱預算的目的是最小化其對污染物去除效率的影響,并允許對各種探測序列進行適當的基準測試。我們首先從界面污染(SIMS和XRR)和膜質量(霧度和AFM)方面量化了使用化學氧化物-Siconi序列(先前由XPS [8]證明)的興趣。本研究的第二個目標是在300毫米工業生產線(25個晶片的FOUP處理)的真實條件下證明這種序列的效率,然后在外延組合工具的惰性環境中,在濕清洗和裝載之間有幾十分鐘到幾個小時的Q-時間。8小時的Q-時間似乎是合理的,以顯示生產線中過程的穩健性。
3.1表面處理對界面污染的影響使用Q-時間= 15分鐘的表面處理
在各種化學處理(表1)之后,將Si0.60Ge0.40層裝載到外延組合設備的N2凈化的裝載室中,進行Siconi工藝,然后轉移(在N2下)到外延室,在那里進行再外延。在這些條件下,脫氧表面暴露在空氣中的時間(在濕處理和晶片裝載到裝載室之間)不超過15分鐘。在Si0.60Ge0.40外延再生長之后,通過X射線反射率測量晶片。在圖1中可以找到選擇的配置文件。在全外反射的臨界角以上(大約0.13°),X射線傳播到SiGe/Si疊層中。厚度條紋是由于表面反射的X射線和SiGe/Si界面處的相長干涉和相消干涉造成的。
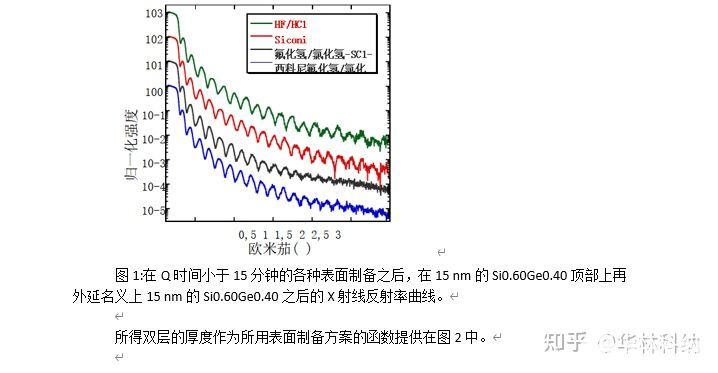

結論:
在這項研究中,我們華林科納已經展示了“化學氧化物-Siconi”序列去除SiGe自然氧化物的能力。這種順序產生低熱預算外延再生長,沒有任何延遲并且氧界面污染比標準的“HF-last”濕法清洗低10倍(在低于或等于650℃的溫度下H2烘烤2分鐘后)。然而,這種順序導致SiGe表面對島化更敏感。這可能是由于在SC1 (NH4OH/H2O2/H2O)或O3溶液中浸泡后,在化學二氧化硅層下形成了一些富鍺單層。為了避免島化問題,在低熱預算H2烘烤期間執行基于二氯硅烷的鈍化,以在SiGe上產生薄的覆蓋層(小于1nm)。所得的Si0.60Ge0.40 / Si / Si0.60Ge0.40疊層是光滑的,并且沒有任何顯著量的界面污染或延伸缺陷。
審核編輯:符乾江
-
生物
+關注
關注
0文章
50瀏覽量
16054 -
植物
+關注
關注
0文章
8瀏覽量
7239
發布評論請先 登錄
濕法清洗和干法清洗,哪種工藝更適合先進制程的硅片

革新半導體清洗工藝:RCA濕法設備助力高良率芯片制造
襯底清洗全攻略:從濕法到干法,解鎖半導體制造的“潔凈密碼”

外延片氧化清洗流程介紹

硅片濕法清洗工藝存在哪些缺陷

【新啟航】碳化硅外延片 TTV 厚度與生長工藝參數的關聯性研究

濕法清洗尾片效應是什么原理
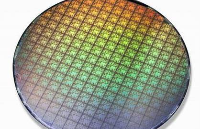
如何選擇合適的濕法清洗設備

晶圓清洗后表面外延顆粒要求

一文詳解外延生長技術
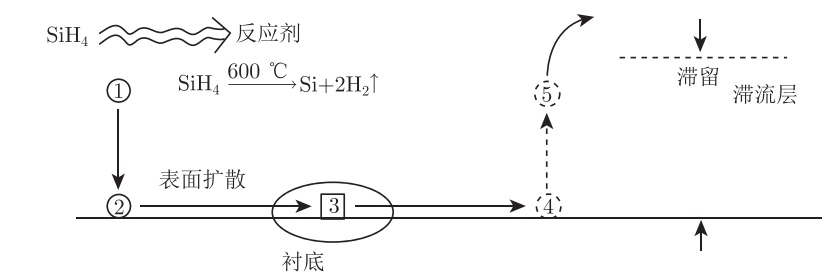
wafer清洗和濕法腐蝕區別一覽
半導體選擇性外延生長技術的發展歷史




 用于SiGe外延生長的濕法清洗序列
用于SiGe外延生長的濕法清洗序列





評論