本文提出了一種將垂直氮化鎵鰭式場(chǎng)效應(yīng)晶體管中的鰭式溝道設(shè)計(jì)成直而光滑的溝道側(cè)壁的新技術(shù)。因此,詳細(xì)描述了在TMAH溶液中的氮化鎵濕法蝕刻;我們發(fā)現(xiàn)m-GaN平面比包括a-GaN平面在內(nèi)的其他取向的晶面具有更低的表面粗糙度。還研究了溝道底部的溝槽和斜面(長(zhǎng)方體),攪動(dòng)長(zhǎng)方體的去除或晶面刻蝕速率的提高。最后,研究了有無(wú)紫外光照射下,紫外光對(duì)三甲基氯化銨中m和a-GaN晶面刻蝕速率的影響。因此,發(fā)現(xiàn)用紫外光將m-GaN平面蝕刻速率從0.69納米/分鐘提高到1.09納米/分鐘;在a-GaN平面蝕刻的情況下,紫外光將蝕刻速率從2.94納米/分鐘提高到4.69納米/分鐘。
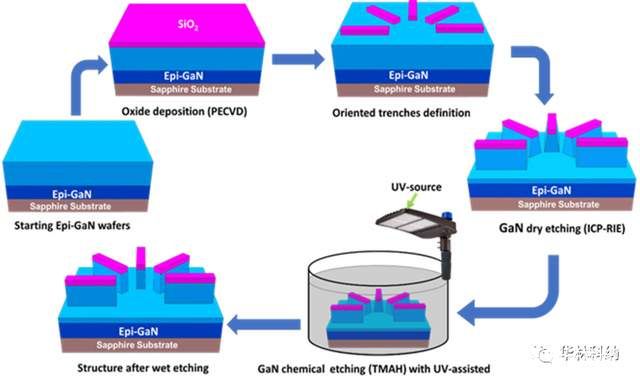
圖1
濕蝕刻法被用來(lái)揭示通道側(cè)壁上的晶體平面,制造過(guò)程如圖1所示,本實(shí)驗(yàn)采用金屬有機(jī)化學(xué)蒸汽沉積法(MOCVD)在藍(lán)寶石基質(zhì)上生長(zhǎng)的7微米厚的氮化鎵外層晶片,這個(gè)正方形樣品的大小是1厘米×1厘米。為此制作了180個(gè)15×2μm2尺寸的手指(圖2)。
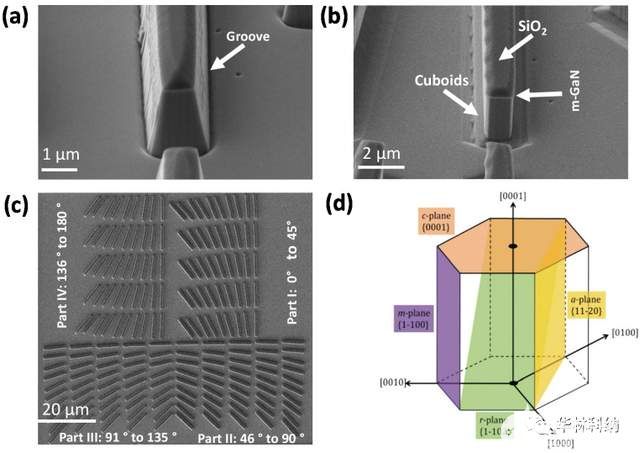
圖2
制造過(guò)程首先是在晶片上沉積一個(gè)1μm厚的二氧化硅(PECVD)層,作為一個(gè)掩模,然后用PMMA9%抗蝕劑進(jìn)行電子束光刻技術(shù),二氧化硅使用CF4/He混合氣體的干蝕刻進(jìn)行蝕刻,將圖案從抗蝕劑轉(zhuǎn)移到二氧化硅掩模,最后,使用TMAH溶液進(jìn)行氮化鎵濕式蝕刻。
通過(guò)電子束蒸發(fā)沉積的厚度分別為20納米/350納米/30納米的鈦/金/鎳金屬疊層,所研究的圖案具有星形形狀,由24個(gè)相同的鰭狀指組成,寬度為250納米,厚度為2.3微米,除了在第二個(gè)實(shí)驗(yàn)中是金屬的掩模之外,圖1所示的相同制造工藝已經(jīng)用于制造鰭狀指狀物,星形圖案的垂直指狀物在m-GaN平面上對(duì)齊,用三甲基氯化銨對(duì)m-氮化鎵和a-氮化鎵晶面進(jìn)行了研究。 實(shí)際上,為了確定適合器件制造工藝的金屬疊層,已經(jīng)進(jìn)行了幾項(xiàng)測(cè)試。最后,鉻/金/鉻金屬疊層被認(rèn)為是制造真實(shí)器件最可行的,這種金屬疊層將用于制造氮化鎵垂直器件。
首先,利用掃描電鏡對(duì)濕法刻蝕后的結(jié)構(gòu)進(jìn)行了表征,原子力顯微鏡和掃描電子顯微鏡被用來(lái)研究凹槽的蝕刻輪廓,最后,利用所提出的方向確定方法制作了垂直氮化鎵溝道指狀物,并對(duì)其進(jìn)行了表征和討論。在藍(lán)寶石晶片上的鎵氮的情況下,平坦區(qū)與氮化鎵平面預(yù)對(duì)準(zhǔn);因此m-GaN平面近似垂直于平面,在制造的結(jié)構(gòu)中,研究的角度范圍在0°和180°之間,步長(zhǎng)為1°。因此,我們以1度的精度研究了所有的m-GaN和a-GaN平面,以估計(jì)精確的GaN晶體取向。在TMAH溶液中化學(xué)蝕刻30分鐘后,使用掃描電鏡表征了在m-氮化鎵和a-氮化鎵平面上取向的溝道指狀物。
另外在濕蝕中,a-GaN平面?zhèn)缺谕耆怪保蟛辉侔l(fā)生進(jìn)一步平滑,a-GaN平面的蝕刻率相對(duì)較高,是由于其較低的蝕刻電阻率;另一方面,氮化鎵的蝕刻速率不僅僅由TMAH溶液參數(shù)決定;相反它是由多種因素決定的,如掩模選擇、摻雜水平和氮化鎵外延生長(zhǎng)條件產(chǎn)生的結(jié)晶質(zhì)量。
最后a和m-GaN平面晶體濕蝕刻的取向測(cè)定方法,這種對(duì)氮化鎵晶片非常有幫助,因?yàn)榇_切的平面內(nèi)晶體取向不能很好地識(shí)別為切片,利用所提出的程序,精確地識(shí)別了m平面和a-GaN平面,一種優(yōu)化的TMAH25%、85?C和uv輔助配方已被用于設(shè)計(jì)面向a-和m-GaN的鰭通道,m-GaN晶體面的蝕刻顯示出比a-GaN取向的Fins更光滑、更穩(wěn)定的通道側(cè)壁。通過(guò)進(jìn)行一些測(cè)試,仍然需要更多的研究來(lái)深入了解在TMAH蝕刻過(guò)程中產(chǎn)生的這些立方體的起源。而且紫外光利用對(duì)TMAH溶液中m和a-GaN平面蝕刻速率的影響,使m-GaN的蝕刻速率從0.69納米提高到1.09納米/分鐘,在a-GaN平面上,紫外光將蝕刻速率從2.94納米提高到4.69納米/分鐘。
審核編輯:符乾江
-
半導(dǎo)體
+關(guān)注
關(guān)注
339文章
30737瀏覽量
264197 -
蝕刻
+關(guān)注
關(guān)注
10文章
428瀏覽量
16622
發(fā)布評(píng)論請(qǐng)先 登錄
鋁合金電化學(xué)處理的粗糙度表征與粘接性能優(yōu)化

晶圓去膠后清洗干燥一般用什么工藝

濕法清洗機(jī)原理:化學(xué)溶解與物理作用的協(xié)同清潔機(jī)制

濕法蝕刻的最佳刻蝕條件是什么
硅片酸洗過(guò)程的化學(xué)原理是什么

SC2溶液可以重復(fù)使用嗎

晶圓蝕刻用得到硝酸鈉溶液

半導(dǎo)體金屬腐蝕工藝
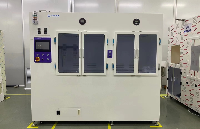
基于光譜橢偏術(shù)的多層結(jié)構(gòu)介質(zhì)衍射光柵表征研究

【「AI芯片:科技探索與AGI愿景」閱讀體驗(yàn)】+化學(xué)或生物方法實(shí)現(xiàn)AI
臺(tái)階儀在大面積硬質(zhì)涂層的應(yīng)用:精準(zhǔn)表征形貌與蝕刻 / 沉積結(jié)構(gòu)參數(shù)

半導(dǎo)體濕法去膠原理

晶圓蝕刻擴(kuò)散工藝流程

晶圓蝕刻后的清洗方法有哪些




 TMAH溶液進(jìn)行化學(xué)蝕刻后晶體平面的表征研究
TMAH溶液進(jìn)行化學(xué)蝕刻后晶體平面的表征研究




評(píng)論