摘要
準備好無缺陷掩模供應是將極端紫外線光刻(EUVL)應用于32納米半間距(HP)及更大的大批量半導體制造的關鍵挑戰之一。根據ITRS在2008年更新的數據,對于32納米的惠普,需要去除的缺陷尺寸為25納米。另一方面,在2008年發表的報告中,對于32納米高壓線和空間圖案,EUV掩模上吸收體缺陷的臨界缺陷尺寸被描述為大約24納米,這意味著必須去除具有相同尺寸的顆粒。在如此嚴格的缺陷要求下,清潔工藝必須發揮關鍵作用,以去除這些微小的顆粒缺陷。然而,由于缺乏薄膜保護,EUV掩模清洗面臨著與反射掩模結構、諸如釕(Ru)覆蓋層的新材料以及更頻繁的清洗相關的獨特挑戰。因此,它必須足夠溫和,不會損壞EUV掩模上的脆弱圖案和表面,特別是非常薄的釕覆蓋層。競爭的需求使得EUV口罩清潔更具挑戰性。
本文報告了使用靈敏度為80納米的空白檢測工具M1350對清潔相關問題的綜合評估。在本文中,我們使用靈敏度為50納米的新型空白檢測工具M7360,將我們的努力擴展到更小的缺陷。
介紹
濕法清洗過程中殘留在表面的小顆粒(所謂的添加劑)是擴展當前基于SPM(硫酸和過氧化氫混合物)的清洗過程以滿足EUV要求的主要問題。為了應對這一挑戰,我們評估了各種清潔工藝和化學物質的效果,并成功地在EUV掩模坯體上實現了零清潔添加和100%的顆粒去除效率。這些數據是使用80納米靈敏度的Lasertec M1350獲得的。今年,我們開始使用第二代檢測工具 M7360對清潔性能進行評估,該工具在EUV掩模坯件上的檢測靈敏度為50納米二氧化硅等效粒徑缺陷。這種高靈敏度的檢測工具使我們能夠改進清潔過程,并認識到在清潔更小顆粒方面的進一步挑戰,這些顆粒以前在M1350上是看不到的.在本文中,我們介紹了我們使用M7360和其他計量工具對較小顆粒的清潔性能和加法器分析的最新結果。
實驗
本研究采用的清洗工藝基于標準的SPM和SC1化學。我們選擇了處理過程中帶有顆粒和污染物的測試樣品,以代表實際使用過程中更真實的口罩污染情況。為了量化清潔性能,使用清潔前后M1350和M7360的缺陷圖計算清潔過程中的顆粒去除效率(PRE)和加法器。在我們的指標中,PRE定義為PRE= (n1 - n2) /n1×100.這里,n1是處理過程中添加的粒子數,n2是n1中未移動的粒子數.另一方面,通過比較清潔前后的缺陷位置來計算清潔加法器。
用M7360標記一些缺陷,以表征缺陷尺寸和成分。用原子力顯微鏡(AFM)測量高度,用掃描電子顯微鏡(SEM)測量橫向尺寸,用俄歇電子能譜(AES)測量成分,對缺陷進行表征。由于我們針對AES分析的缺陷尺寸非常小,因此我們通過仔細比較作為缺陷附近參考的光譜來確定缺陷成分。
結果和討論
本節使用M1350和M7360評估了處理顆粒和清潔加法器的性能,以量化整體清潔性能。圖1(a)中M1350測量的缺陷圖分別顯示了添加的處理顆粒和當前記錄(POR)清洗過程后的剩余顆粒。從這些評估中,我們得出結論,我們目前的POR清潔工藝能夠清潔50納米的顆粒,并且沒有大于80納米的添加劑。然而,對于更小的缺陷,我們認為工藝加法器是當前POR清洗工藝中需要解決的關鍵問題。
本節研究描述的下一步是我們在清洗后發現的添加物。表征的目的是確定加法器的來源,并開發減少它們的方法。圖3顯示了根據原子力顯微鏡圖像確定的加法器尺寸(面積和高度)的散點圖。
在分段測試中,整個清洗過程分為三個獨特的步驟,并針對該步驟中使用的相應化學品對加法器進行評估。這三個步驟是SPM化學,熱去離子水沖洗和SC1化學過程。M7360測量的加法器圖如圖6所示.觀察到最多的加法器是SPM化學過程,其次是熱水過程和SC1化學過程。這些結果表明,SPM化學導致大多數加法器。
如前所述,我們確定加法器為No。1。 EUV口罩清潔過程中的挑戰。如上所述,我們將加法器源隔離為SPM化學步驟。下一步是消除加法器。理想情況下,在運送到使用地點之前,人們希望過濾掉化學物質中的所有顆粒。我們解決加法器問題的方法是雙重的;一種是通過過濾從SPM化學品中去除顆粒,另一種是防止顆粒粘附在表面。事實上,我們通過改進過濾系統,在M1350檢測的基礎上,實現了大于80 nm缺陷的零加法器最終清洗。然而,基于M7360檢查,相同的清洗過程產生了約60個尺寸小于80納米的加法器。對于液體化學過濾來說,保持無顆粒是極其困難的,尤其是對于小顆粒。
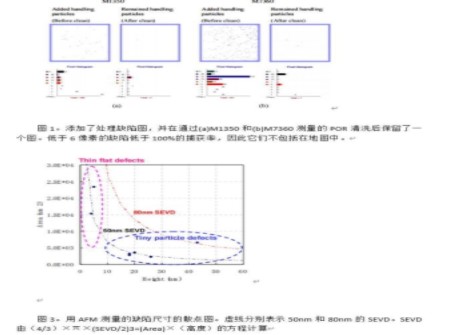

結論
我們使用50納米靈敏度的Lasertec M7360檢測系統研究了基于SPM的清潔性能。發現當前的清潔工藝對于50納米處理顆粒具有足夠高的顆粒去除效率。然而,我們觀察到許多小于80納米的加法器。加法器的來源被確定為來自SPM化學品的顆粒。我們認為過程加法器是第一個為EUV口罩清洗。
本文已經采取了兩種并行的方法來消除加法器:液體粒子過濾和過程優化來減輕加法器。我們已經證明了基于M7360檢查可以實現一位數的加法器。
審核編輯:湯梓紅
-
納米
+關注
關注
2文章
730瀏覽量
42412 -
微米
+關注
關注
0文章
15瀏覽量
11113 -
EUV
+關注
關注
8文章
615瀏覽量
88804
發布評論請先 登錄
奧迪威顆粒物感應方案:通過實時顆粒分析實現智能清潔

濕法刻蝕工作臺工藝流程
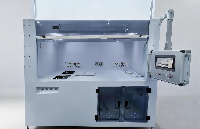
晶圓清洗機濕法制程設備:半導體制造的精密守護者

襯底清洗全攻略:從濕法到干法,解鎖半導體制造的“潔凈密碼”

濕法清洗機原理:化學溶解與物理作用的協同清潔機制

半導體濕法腐蝕工藝中,如何選擇合適的掩模圖形來控制腐蝕區域?
國內材料巨頭入主掩模版,空白掩模有望國產化(附投資邏輯)

半導體封裝清洗工藝有哪些

濕法刻蝕sc2工藝應用是什么

超聲波除油清洗設備是否可以有效去除難以清潔的油漬?
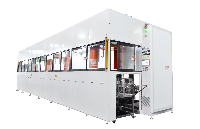



 使用標準濕法清潔從EUV掩模空白中去除納米顆粒
使用標準濕法清潔從EUV掩模空白中去除納米顆粒


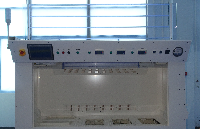



評論