功率型封裝基板作為熱與空氣對流的載體,其熱導(dǎo)率對散熱起著決定性作用。DPC陶瓷基板以其優(yōu)良的性能和逐漸降低的價格,在眾多電子封裝材料中顯示出很強(qiáng)的競爭力,是未來封裝發(fā)展的趨勢。
隨著科學(xué)技術(shù)的發(fā)展、新制備工藝的出現(xiàn),高導(dǎo)熱陶瓷材料作為新型電子封裝基板材料,應(yīng)用前景十分廣闊。
隨著芯片輸入功率的不斷提高,大耗散功率帶來的大發(fā)熱量給封裝材料提出了更新、更高的要求。在散熱通道中,封裝基板是連接內(nèi)外散熱通路的關(guān)鍵環(huán)節(jié),兼有散熱通道、電路連接和對芯片進(jìn)行物理支撐的功能。
對高功率產(chǎn)品來講,其封裝基板要求具有高電絕緣性、高導(dǎo)熱性、與芯片匹配的熱膨脹系數(shù)等特性。
樹脂基封裝基板:配套成本高普及尚有難度
EMC和SMC對模壓成型設(shè)備要求高,一條模壓成型生產(chǎn)線價格在1000萬元左右,大規(guī)模普及尚有難度。
近幾年興起的貼片式支架一般采用高溫改性工程塑膠料,以PPA(聚鄰苯二甲酰胺)樹脂為原料,通過添加改性填料來增強(qiáng)PPA原料的某些物理、化學(xué)性質(zhì),從而使PPA材料更加適合注塑成型及貼片式支架的使用。PPA塑料導(dǎo)熱性能很低,其散熱主要通過金屬引線框架進(jìn)行,散熱能力有限,只適用于小功率封裝。
隨著業(yè)界對散熱的重視,兩種新的熱固性塑膠料——環(huán)氧塑封料(EMC)和片狀模塑料(SMC)被引入貼片式支架中。
EMC是以高性能酚醛樹脂為固化劑、導(dǎo)熱系數(shù)較高的硅微粉等為填料、多種助劑混配而成的粉狀模塑料。SMC主要是由30%左右的不飽和樹脂、40%左右的玻璃纖維、無機(jī)填料以及其他添加劑組成。
這兩種熱固性模塑料熱固化溫度在150℃左右,經(jīng)過改性后導(dǎo)熱系數(shù)可達(dá)4W/(m·K)~7W/(m·K),與PPA塑膠相比有較大提高,但缺點(diǎn)是流動性與導(dǎo)熱性較難兼顧,固化成型時硬度過高,容易產(chǎn)生裂紋和毛刺。EMC和SMC固化時間長,成型效率相對較低,對模壓成型設(shè)備、模具及其他配套設(shè)備的要求相當(dāng)高,一條模壓成型及配套生產(chǎn)線價格在1000萬元左右,大規(guī)模普及尚有難度。
金屬芯印刷電路板:制造工藝復(fù)雜實(shí)際應(yīng)用較少
鋁基板的加工制造過程復(fù)雜、成本高,鋁的熱膨脹系數(shù)與芯片材料相差較大,實(shí)際應(yīng)用中較少采用。
隨著封裝向薄型化及低成本化方向發(fā)展,板上芯片(COB)封裝技術(shù)逐步興起。目前,COB封裝基板大多使用金屬芯印刷電路板,高功率封裝大多采用此種基板,其價格介于中、高價位間。
當(dāng)前生產(chǎn)上通用的大功率散熱基板,其絕緣層導(dǎo)熱系數(shù)極低,而且由于絕緣層的存在,使得其無法承受高溫焊接,限制了封裝結(jié)構(gòu)的優(yōu)化,不利于散熱。
如何提高環(huán)氧絕緣層的導(dǎo)熱系數(shù)成為現(xiàn)階段鋁基板的研究熱點(diǎn)。目前采用的是一種摻有高熱傳導(dǎo)性無機(jī)填充物(比如陶瓷粉末)的改性環(huán)氧樹脂或環(huán)氧玻璃布黏結(jié)片,通過熱壓把銅箔、絕緣體以及鋁板黏結(jié)起來。
目前國際上已經(jīng)開發(fā)出一種“全膠鋁基板”,采用全膠的鋁基板的熱阻可以做到0.05K/W。此外,我國臺灣的一家公司最近開發(fā)出一種類鉆碳材料DLC,并將其應(yīng)用于高亮度LED封裝鋁基板的絕緣層。
DLC有許多優(yōu)越的材料特性:高熱傳導(dǎo)率、熱均勻性與高材料強(qiáng)度等。因此,以DLC取代傳統(tǒng)金屬基印刷電路板(MCPCB)的環(huán)氧樹脂絕緣層,有望極大提高M(jìn)CPCB的熱傳導(dǎo)率,但其實(shí)際使用效果還有待市場考驗(yàn)。
一種性能更好的鋁基板是直接在鋁板上生成絕緣層,然后印制電路。采用這種方法的最大優(yōu)點(diǎn)是結(jié)合力強(qiáng),而且導(dǎo)熱系數(shù)高達(dá)2.1W/(m·K)。但這種鋁基板的加工制造過程復(fù)雜、成本高,而且,金屬鋁的熱膨脹系數(shù)與芯片材料相差較大,器件工作時熱循環(huán)常會產(chǎn)生較大應(yīng)力,最終可能導(dǎo)致失效,因此在實(shí)際應(yīng)用中較少采用。
硅基封裝基板:面臨挑戰(zhàn)良品率低于60%
硅基板在絕緣層、金屬層、導(dǎo)通孔的制備方面都面臨挑戰(zhàn),良品率不超過60%。
以硅基材料作為封裝基板技術(shù),近幾年逐漸從半導(dǎo)體業(yè)界引進(jìn)到業(yè)界。硅基板的導(dǎo)熱性能與熱膨脹性能都表明了硅是較匹配的封裝材料。
硅的導(dǎo)熱系數(shù)為140W/m·K,應(yīng)用于封裝時,所造成的熱阻只有0.66K/W;而且硅基材料已被大量應(yīng)用在半導(dǎo)體制程及相關(guān)封裝領(lǐng)域,所涉及相關(guān)設(shè)備及材料已相當(dāng)成熟。因此,若將硅制作成封裝基板,容易形成量產(chǎn)。
不過,硅基板封裝仍有許多技術(shù)問題。例如,材料方面,硅材容易碎裂,且機(jī)構(gòu)強(qiáng)度也有問題。結(jié)構(gòu)方面,硅盡管是優(yōu)良導(dǎo)熱體,但絕緣性不良,必須做氧化絕緣處理。
此外,其金屬層需采用濺鍍結(jié)合電鍍的方式制備,導(dǎo)電孔需采用腐蝕的方法進(jìn)行。總體看來,絕緣層、金屬層、導(dǎo)通孔的制備都面臨挑戰(zhàn),良品率不高。目前雖有一些臺灣企業(yè)開發(fā)出LED硅基板并量產(chǎn),但良品率不超過60%。
陶瓷封裝基板:提升散熱效率滿足高功率需求
配合高導(dǎo)熱的陶瓷基體,DPC顯著提升了散熱效率,是最適合高功率、小尺寸發(fā)展需求的產(chǎn)品。
陶瓷散熱基板具有新的導(dǎo)熱材料和新的內(nèi)部結(jié)構(gòu),彌補(bǔ)了鋁金屬基板所具有的缺陷,從而改善基板的整體散熱效果。
Al2O3陶瓷基片雖是目前產(chǎn)量最多、應(yīng)用最廣的陶瓷基片,但由于其熱膨脹系數(shù)相對Si單晶偏高,導(dǎo)致Al2O3陶瓷基片并不太適合在高頻、大功率、超大規(guī)模集成電路中使用。A1N晶體具有高熱導(dǎo)率,被認(rèn)為是新一代半導(dǎo)體基板和封裝的理想材料。
AlN陶瓷材料從20世紀(jì)90年代開始得到廣泛地研究而逐步發(fā)展起來,是目前普遍認(rèn)為很有發(fā)展前景的電子陶瓷封裝材料。AlN陶瓷基板的散熱效率是Al2O3基板的7倍之多,AlN基板應(yīng)用于高功率LED的散熱效益顯著,進(jìn)而大幅提升LED的使用壽命。
AlN基板的缺點(diǎn)是即使表面有非常薄的氧化層也會對熱導(dǎo)率產(chǎn)生較大影響,只有對材料和工藝進(jìn)行嚴(yán)格控制才能制造出一致性較好的AlN基板。
現(xiàn)階段應(yīng)用于封裝的陶瓷基板按制備技術(shù)可分為HTCC、LTCC、DBC、DPC4種。HTCC又稱高溫共燒多層陶瓷,其主要材料為熔點(diǎn)較高但導(dǎo)電性較差的鎢、鉬、錳等金屬,制作成本高昂,現(xiàn)在較少采用。
LTCC又稱為低溫共燒多層陶瓷基板,其熱傳導(dǎo)率為2W/(m·K)~3W/(m·K)左右,與現(xiàn)有鋁基板相比并沒有太大優(yōu)勢。此外,LTCC由于采用厚膜印刷技術(shù)完成線路制作,線路表面較為粗糙,對位不精準(zhǔn)。而且,多層陶瓷疊壓燒結(jié)工藝還有收縮比例的問題,這使得其工藝解析度受到限制,LTCC陶瓷基板的推廣應(yīng)用受到極大挑戰(zhàn)。
基于板上封裝技術(shù)而發(fā)展起來的直接覆銅陶瓷板(DBC)也是一種導(dǎo)熱性能優(yōu)良的陶瓷基板。DBC基板在制備過程中沒有使用黏結(jié)劑,因而導(dǎo)熱性能好,強(qiáng)度高,絕緣性強(qiáng),熱膨脹系數(shù)與Si等半導(dǎo)體材料相匹配。
然而,陶瓷基板與金屬材料的反應(yīng)能力低,潤濕性差,實(shí)施金屬化頗為困難,不易解決Al2O3與銅板間微氣孔產(chǎn)生的問題,這使得該產(chǎn)品的量產(chǎn)與良品率受到較大的挑戰(zhàn),仍然是國內(nèi)外科研工作者研究的重點(diǎn)。
斯利通DPC陶瓷封裝基板又稱直接鍍銅陶瓷板,DPC產(chǎn)品具備線路精準(zhǔn)度高與表面平整度高的特性,非常適用于LED覆晶/共晶工藝,配合高導(dǎo)熱的陶瓷基體,顯著提升了散熱效率,是最適合高功率、小尺寸LED發(fā)展需求的陶瓷散熱基板。
責(zé)任編輯:gt
-
封裝
+關(guān)注
關(guān)注
128文章
9258瀏覽量
148697 -
功率
+關(guān)注
關(guān)注
14文章
2120瀏覽量
75629 -
基板
+關(guān)注
關(guān)注
2文章
321瀏覽量
24062
發(fā)布評論請先 登錄
CINCON CFM04S系列與ARCH AOC(H) 4W電源模塊對比及替代方案分析
氮化硅陶瓷封裝基板:抗蠕變性能保障半導(dǎo)體長效可靠

IPC-6921有機(jī)封裝基板國際標(biāo)準(zhǔn)即將落地

不同類型的電能質(zhì)量在線監(jiān)測裝置在多維度統(tǒng)計報表功能上有哪些差異?
陶瓷基板、FPCB電路基板的激光微切割應(yīng)用

系統(tǒng)級封裝技術(shù)解析

陶瓷基板:突破大功率LED散熱瓶頸的關(guān)鍵材料

DBA基板:開啟高壓大功率應(yīng)用新時代的關(guān)鍵技術(shù)

TaskPool和Worker的對比分析
PEEK注塑電子封裝基板的創(chuàng)新應(yīng)用方案
電子封裝中的高導(dǎo)熱平面陶瓷基板及金屬化技術(shù)研究

精密劃片機(jī)在切割陶瓷基板中有哪些應(yīng)用場景
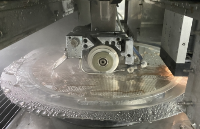
DPC、AMB、DBC覆銅陶瓷基板技術(shù)對比與應(yīng)用選擇




 功率型封裝基板的多種應(yīng)用類型的對比和分析
功率型封裝基板的多種應(yīng)用類型的對比和分析





評論