隨著手機(jī)越來越高級(jí), 內(nèi)部的集成程度也越來越高,而且現(xiàn)在的手機(jī)中幾乎都采用了球柵陣列封裝模塊,也就是我們通常所說的BGA。這種模塊是以貼片形式焊接在主板上的。BGA模塊利用封裝的整個(gè)底部來與電路板連接。不是通過管腳焊接,而是利用激光焊錫球來焊接。而BGA芯片激光錫球焊過程是如何植錫?
(1)清洗
首先在IC的錫腳那面加上適量的助焊膏,用電烙鐵將IC上的殘留焊錫去除,然后用天那水清洗干凈。
(2)固定
我們可以使用維修平臺(tái)的凹槽來定位BGA芯片,也可以簡單地采用雙面膠將芯片粘在桌子上來固定。
(3)上錫
選擇稍干的錫漿,用平口刀挑適量錫漿到植錫板上,用力往下刮,邊刮邊壓,使錫漿薄薄地、均勻地填充于植錫板的小孔中,上錫過程中要注意壓緊植錫板,不要讓植錫板和芯片之間出現(xiàn)空隙,以免影響上錫效果。如圖所示。
(4)吹焊植錫
將植錫板固定到IC上面,把錫漿刮印到IC上面之后,將熱風(fēng)槍風(fēng)量調(diào)大、溫度調(diào)至350℃左右,搖晃風(fēng)嘴 對(duì)著植錫板緩緩均勻加熱,使錫漿慢慢熔化。當(dāng)看見植錫板的個(gè)別小孔中已有錫球生成時(shí),說明溫度已經(jīng)到位,這時(shí)應(yīng)當(dāng)抬高熱風(fēng)槍的風(fēng)嘴,避免溫度繼續(xù)上升。過高的溫度會(huì)使錫漿劇烈沸騰,造成植錫失敗,嚴(yán)重的還會(huì)使IC過熱損壞。錫球冷卻后,再將植錫板與IC分離。這種方法的優(yōu)點(diǎn)是一次植錫后,若有缺腳、錫球過大或過小現(xiàn)象,可進(jìn)行二次處理,特別適合新手使用。
(5)調(diào)整
如果我們吹焊完畢后,發(fā)現(xiàn)有些錫球大小不均勻,甚至有個(gè)別引腳沒植上錫,可先用裁紙刀沿著植錫板的表面將過大錫球的露出部分削平,再用刮刃將錫球過小和缺腳的小孔中上滿錫漿,然后用熱風(fēng)槍再吹一次。
責(zé)任編輯:gt
-
芯片
+關(guān)注
關(guān)注
463文章
54320瀏覽量
468502 -
激光
+關(guān)注
關(guān)注
21文章
3699瀏覽量
69785 -
BGA
+關(guān)注
關(guān)注
5文章
585瀏覽量
51898
發(fā)布評(píng)論請(qǐng)先 登錄
焊錫激光器如何選擇?揭秘錫球與錫絲、錫膏焊接的波長差異

DSP717HF Wafer植球錫膏重磅推薦

你了解激光植球機(jī)嗎?半導(dǎo)體精密制造的“隱形工匠”

晶圓級(jí)封裝Bump制作中錫膏和助焊劑的應(yīng)用解析

BGA芯片陣列封裝植球技巧,助力電子完美連接

紫宸激光植球技術(shù):為BGA/LGA封裝注入精“芯”動(dòng)力

淺談激光噴錫焊工藝的主要應(yīng)用

解鎖WiFi芯片植焊西安品茶技術(shù)工作室電路板傳輸新潛能
激光錫焊系統(tǒng)和激光錫焊機(jī)的區(qū)別
激光焊接錫膏與常規(guī)錫膏有啥區(qū)別?

從工藝到設(shè)備全方位解析錫膏在晶圓級(jí)封裝中的應(yīng)用

激光錫球焊錫機(jī)為MEMS微機(jī)電產(chǎn)品焊接帶來新突破




 如何利用BGA芯片激光錫球進(jìn)行植錫
如何利用BGA芯片激光錫球進(jìn)行植錫

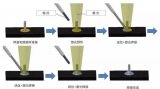




評(píng)論