如果說摩爾定律預言了前50年的半導體工藝技術發展路線,那么近兩年以來半導體工藝可謂被智能手機等智能終端設備的軍備競賽瘋狂驅動著向前。從28nm到22nm、14nm、10nm甚至7nm,在先進半導體工藝激烈競爭下,對數字電路越來越高的性能要求使半導體供應商面臨著更多的挑戰,基于這些要求,全行業的合作將成為一種必然,而EDA廠商、設備廠商等產業鏈均卯足全力因應客戶需求。
先進設計/工藝帶來的寄生提取挑戰
一代又一代的半導體晶圓工藝提升使不斷增加的IC設計密度、性能提升和功耗節省得以實現,但也為電路設計工程師帶來了許多新興的挑戰。包括創新的工藝特性,諸如FinFET晶體管等代表著向低功耗設計模式的轉變,這就需要EDA軟件在性能和精度方面也要有相應的飛躍提升。
在整個設計周期內,電路設計工程師必須在性能和精準度之間權衡取舍。寄生電路參數提取也不例外。在使用較為復雜的FinFET組件的先進工藝節點上,設計工程師始終致力于追求更為嚴苛的精準度,也需要更高的性能和容量來實現十億級晶體管設計。事實上,在現代 IC 中,所有制程節點都隨著內存、模擬電路、標準單元庫以及定制化數字內容的混合變得日益復雜,當工藝尺寸縮小到低于.35u或深亞微米(DSM)以下時,物聯連線所產生的互連寄生(電阻、電容等)變得越來越普遍的。這種復雜性為電路參數提取工具帶來了一系列不同的挑戰,設計人員需要必須平衡精度、性能和復雜性等多重因素。
Mentor Graphics代工廠項目總監Shu-Wen Chang解釋說:“在前段制程中,例如FinFET的推出標志著CMOS晶體管進入真正的三維器件時代。由于其源漏區以及與其周圍連接的三維結構方式(包括本地互連和接觸通孔),導致了復雜性和不確定性。更新更復雜的制造工藝以及更嚴格的設計規則,使得設計師和代工廠在建模時精確地捕獲FinFET器件內部的寄生電阻、電容,以及器件之間的相互作用是至關重要的。”她補充到,“又例如在后段制程,雙重乃至多重曝光工藝在先進節點工藝中發揮越來越重要的作用,互連corners的數量也將顯著增多。在28納米節點,可能存在5個互連corners,但在16納米節點,會看到11至15個corners。多層掩膜版之間對不準產生誤差,漂移等更多復雜情況,要求設計人員評估更多寄生參數提取的corners,以驗證集成電路的時間選擇和性能,為寄生參數提取工作帶來了更大的挑戰。”
為了應對這些挑戰,Mentor Graphics推出了全新 Calibre xACT寄生電路參數提取平臺。Shu-Wen Chang表示,Calibre xACT平臺可滿足包括 14nm FinFET 在內廣泛的模擬和數字電路參數提取需求,同時最大限度地減少 IC 設計工程師的猜測和設置功夫。 Calibre xACT 平臺可借由自動優化電路參數提取技術,針對客戶特定的工藝節點、產品應用、設計尺寸大小及電路參數提取目標,實現精準度和周轉時間 (TAT) 的最佳組合。采用 Calibre xACT 平臺進行電路寄生參數提取在滿足最嚴格的精準度要求的同時,還讓客戶體驗到了減少高達 10 倍的周轉時間。“xACT平臺采用了Mentor獨特的算法,擁有一個可擴展架構,能在現代化的計算環境中充分利用多個 CPU,在不同的情況下降計算分配到不同的CPU內核進行并行運算。”她解釋說,“然而,對于全芯片而言,我們需要處理數十億晶體管的設計,還包括頂層的數千萬條內部互連。經過客戶使用驗證,在使用8個CPU的情況下,通常每小時可提取4~8百萬個網表,比其他競爭產品快2~3倍。”
同時Shu-Wen Chang強調,CalibrexACT電路參數提取平臺與整個Calibre產品線整合,實現了無縫驗證流程,其中包括用于完整晶體管級模型的CalibrenmLVS 產品,以及用于針對極高精準度電路參數提取應用的CalibrexACT 3D 產品。此外,它還納入了第三方設計環境和格式,以確保與現有的設計和仿真流程相兼容。
用于先進封裝技術的檢測設備
物聯網和移動消費電子的爆發驅動了半導體市場的增長,而電子行業的最終驅動力來自于客戶對終端產品的需求。“消費類移動電子產品持續不斷地推動著生產更小、更快,且更強大的設備,消費者要求產品具有更長的續航能力,更低的價格,更豐富多彩的功能,以及更便捷的網絡連接。這對半導體技術提出了更多技術挑戰和風險。例如EUV等先進的光刻工藝,新材料存儲技術,2D到3D工藝轉換,工藝視窗控制以及先進封裝技術等挑戰。” KLA-Tencor(科天)銷售總經理任建宇表示。“對先進封裝技術而言,它可以帶來設備性能優勢,例如增加帶寬以及改善能效。但是,封裝生產方法則更為復雜,這涉及典型的前端 IC 生產工藝的實施如化學機械拋光和高縱橫比蝕刻,以及獨一無二的工藝如臨時焊接和晶圓再造。例如,在封裝中,最初的鍵合尺寸是100微米,后來逐漸發展到今天的10微米。同時,線寬和間距也在不斷的縮小,由之前的10微米一直發展到今天的1微米。更多新的封裝技術仍在不斷的涌現,比如TSV,3D封裝等。封裝復雜度在提升,導致封裝的成本在提高。諸如缺陷、良率等問題,‘找到才能解決’,‘能量測才能控制’,因此,在封裝技術中,檢測和量測也變得越來越重要。結合科天在前端半導體工藝控制中的專業技術,以及在與世界級的先進封裝研發公司和產業聯盟合作過程中取得的經驗,科天開發出了靈活而高效的缺陷檢測解決方案,可幫助解決從晶圓級至最終組件所遇到的封裝挑戰,例如提升良率,降低成本,縮短上市周期,降低風險等等。”
科天資深營銷總監Prashant Aji認為,在封裝技術領域面臨著如下轉折:由移動設備驅動的縮小尺寸,晶圓級封裝的出現,轉向OSAT(外包半導體封裝測試),采用工藝前端IC步驟,封裝成本等等。“消費電子產品一直朝著輕薄短小演進,這就要求硬件電路連線和空間、焊球尺寸和間距、產品封裝等尺寸等都要更小,而晶圓上做TSV越來越多,傳統的封裝過程被打破,復雜性提高,先進封裝被引入到中端制成過程。尺寸要求和封裝要求都越來越小,線寬越來越窄,硅片堆疊層數越來越多,在高成品率的要求下,檢測良測成了重中之重。他表示,KLA-Tencor是目前唯一一家擁有全線檢測裝置的廠商,晶圓級到RDL、TSV直到最后的封裝,KLA-Tencor都有相應的檢測設備可以使用。
為了滿足封裝市場逐漸上升的需求,科天推出兩款新產品CIRCL-AP和 ICOST830以支持先進半導體封裝技術檢測。據Prashant Aji介紹,CIRCL-AP 針對晶圓級封裝中多種工藝制程的檢測與工藝控制而設計,不僅擁有高產量,還能進行全表面晶圓缺陷檢測、檢查和測量。ICOS T830 可提供IC 封裝的全自動化光學檢測,利用高度靈敏的 2D 和 3D 來測量廣范的器件類型和不同尺寸的最終封裝品質。這兩款系統都可以幫助 IC 制造商和封測代工廠 (OSAT) 在采用創新的封裝技術時應對各類挑戰,例如更細微的關鍵尺寸和更緊密的間距要求。
這兩款系統都可以幫助 IC 制造商和封測代工廠在采用創新的封裝技術時應對各類挑戰,例如更細微的關鍵尺寸和更緊密的間距要求。Prashant Aji表示,中國已經成為世界最大的電子市場,未來也具有無限的潛力。”雖然現在中國封裝技術仍較落后,但是也看到一些封裝企業在快速成長,例如長電、南通富士通、天水華天等,我們與他們也有合作。整體封裝技術水平雖然仍有差距,但是我認為他們最大的挑戰是在取得市場方面。因為后進者意味著目前的市場已經被占有,而他們要經過客戶的測試驗證還需時間。但是對他們而言,反而更容易采用更先進的技術。未來,科天將與客戶一起,持續不斷的努力提升良率,改進技術,幫助客戶降低成本,更好的面對新的技術挑戰。
責任編輯:tzh
-
半導體
+關注
關注
339文章
30737瀏覽量
264135 -
IC
+關注
關注
36文章
6411瀏覽量
185634 -
eda
+關注
關注
72文章
3113瀏覽量
182912
發布評論請先 登錄
半導體先進封裝“Bumping(凸點)”工藝技術的詳解;

目前最先進的半導體工藝水平介紹
【「AI芯片:科技探索與AGI愿景」閱讀體驗】+半導體芯片產業的前沿技術
國內最大!長飛先進武漢基地投產,明治傳感助力半導體智造升級
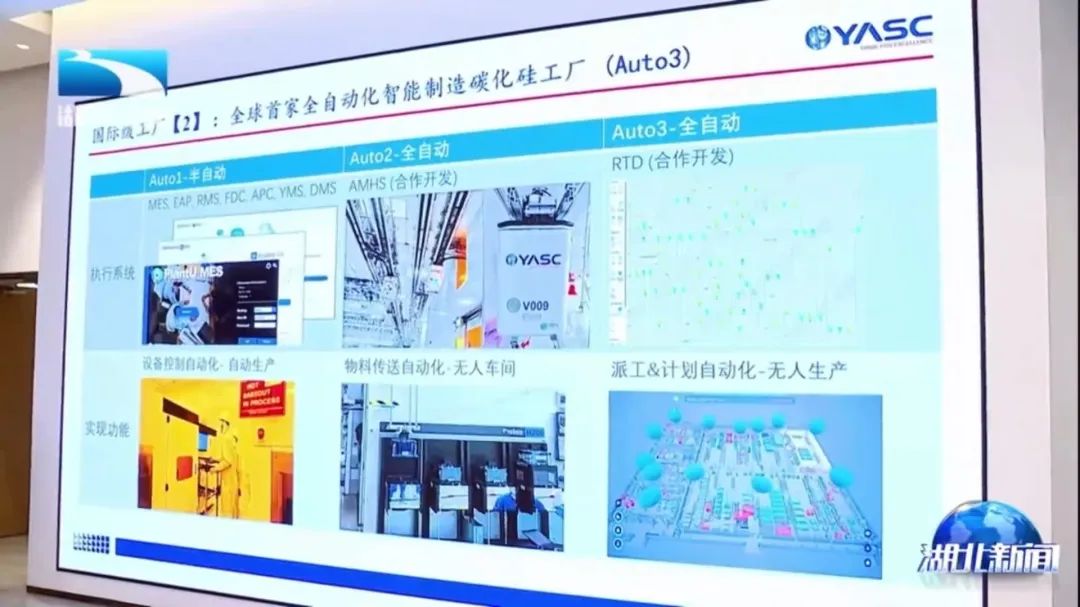



 先進半導體工藝面臨哪些挑戰?
先進半導體工藝面臨哪些挑戰?










評論