3月18日,盛美半導體發布適用于晶圓級先進封裝應用(Wafer Level Advance Package)的無應力拋光(Stree-Free-Polish)解決方案。
作為國際領先的半導體和晶圓級封裝設備供應商,盛美半導體全新發布的先進封裝級無應力拋光(Ultra SFP ap)設計用于解決先進封裝中,硅通孔(TSV)和扇出(FOWLP)應用金屬平坦化工藝中表層銅層過厚引起晶圓翹曲的問題。
據了解,新的先進封裝級無應力拋光技術來源于盛美半導體的無應力拋光技術(Ultra SFP),該技術整合了無應力拋光(SFP)、化學機械研磨(CMP)、和濕法刻蝕工藝(Wet-Etch)。
晶圓通過上述三步工藝,在化學機械研磨和濕法刻蝕工藝前,采用電化學方法無應力去除晶圓表面銅層,釋放晶圓的應力。此外,電化學拋光液的回收使用,和先進封裝級無應力拋光技術能顯著的降低化學和耗材使用量,保護環境的同時降低設備使用成本。
盛美半導體設備公司董事長王暉博士表示:“我們在2009年開發了無應力拋光技術,這一領先于時代的技術,隨著先進封裝硅通孔和扇出工藝的高速發展,對于環境保護和降低工藝運營成本的需求日益增長,為我們先進封裝級無應力拋光工藝提供了理想的應用市場。”
值得一提的是,盛美半導體同時還宣布,在2019年第四季度已交付一臺先進封裝級無應力拋光設備至中國晶圓級封裝龍頭企業。盛美半導體進一步指出,“在2020年度這臺設備將在先進封裝客戶端進行測試和驗證,我們期待在2020年中完成設備的首輪測試驗證,并進一步進入客戶端量產生產線進行量產驗證,并完成客戶驗收。”
-
晶圓
+關注
關注
53文章
5410瀏覽量
132300 -
盛美半導體
+關注
關注
1文章
20瀏覽量
8091
發布評論請先 登錄


是德科技Keysight B1500A 半導體器件參數分析儀/半導體表征系統主機
投資逆勢增長53.4%!半導體設備自主創新,三大上市公司最新進展揭秘

解鎖美新半導體光學防抖驅動芯片奧秘
廣汽高域GOVY AirCab首臺樣機成功交付
奧松半導體8英寸MEMS項目迎重大進展 首臺光刻機入駐

半導體國產替代材料 | CMP化學機械拋光(Chemical Mechanical Planarization)

防震基座在半導體晶圓制造設備拋光機詳細應用案例-江蘇泊蘇系統集成有限公司
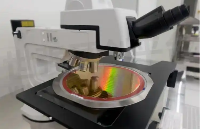
九家半導體設備企業Q1:最高營收破82億,研發暗戰升級

無應力計與應變計:原理差異及儀器技術解析




 盛美半導體不是首臺無應力拋光設備已交付
盛美半導體不是首臺無應力拋光設備已交付







評論