本文主要通過對EMC封裝成形的過程中常出現的問題(缺陷)一未填充、氣孔、麻點、沖絲、開裂、溢料、粘模等進行分析與研究,并提出行之有效的解決辦法與對策。
塑料封裝以其獨特的優勢而成為當前微電子封裝的主流,約占封裝市場的95%以上。塑封產品的廣泛應用,也為塑料封裝帶來了前所未有的發展,但是幾乎所有的塑封產品成形缺陷問題總是普遍存在的,也無論是采用先進的傳遞模注封裝,還是采用傳統的單注塑模封裝,都是無法完全避免的。相比較而言,傳統塑封模成形缺陷幾率較大,種類也較多,尺寸越大,發生的幾率也越大。
塑封產品的質量優劣主要由四個方面因素來決定:
A、EMC的性能,主要包括膠化時間、黏度、流動性、脫模性、粘接性、耐濕性、耐熱性、溢料性、應力、強度、模量等;
B、模具,主要包括澆道、澆口、型腔、排氣口設計與引線框架設計的匹配程度等;
C、封裝形式,不同的封裝形式往往會出現不同的缺陷,所以優化封裝形式的設計,會大大減少不良缺陷的發生;
D、工藝參數,主要包括合模壓力、注塑壓力、注塑速度、預熱溫度、模具溫度、固化時間等。
下面主要對在塑封成形中常見的缺陷問題產生的原因進行分析研究,并提出相應有效可行的解決辦法與對策。
1、封裝成形未充填及其對策
封裝成形未充填現象主要有兩種情況:一種是有趨向性的未充填,主要是由于封裝工藝與EMC的性能參數不匹配造成的;一種是隨機性的未充填,主要是由于模具清洗不當、EMC中不溶性雜質太大、模具進料口太小等原因,引起模具澆口堵塞而造成的。從封裝形式上看,在DIP和QFP中比較容易出現未充填現象,而從外形上看,DIP未充填主要表現為完全未充填和部分未充填,QFP主要存在角部未充填。未充填的主要原因及其對策:
(1)由于模具溫度過高,或者說封裝工藝與EMC的性能參數不匹配而引起的有趨向性的未充填。預熱后的EMC在高溫下反應速度加快,致使EMC的膠化時間相對變短,流動性變差,在型腔還未完全充滿時,EMC的黏度便會急劇上升,流動阻力也變大,以至于未能得到良好的充填,從而形成有趨向性的未充填。在VLSI封裝中比較容易出現這種現象,因為這些大規模電路每模EMC的用量往往比較大,為使在短時間內達到均勻受熱的效果,其設定的溫度往往也比較高,所以容易產生這種未充填現象。) 對于這種有趨向性的未充填主要是由于EMC流動性不充分而引起的,可以采用提高EMC的預熱溫度,使其均勻受熱;增加注塑壓力和速度,使EMC的流速加快;降低模具溫度,以減緩反應速度,相對延長EMC的膠化時間,從而達到充分填充的效果。
(2)由于模具澆口堵塞,致使EMC無法有效注入,以及由于模具清洗不當造成排氣孔堵塞,也會引起未充填,而且這種未充填在模具中的位置也是毫無規律的。特別是在小型封裝中,由于澆口、排氣口相對較小,所以最容易引起堵塞而產生未充填現象。對于這種未充填,可以用工具清除堵塞物,并涂上少量的脫模劑,并且在每模封裝后,都要用**和刷子將料筒和模具上的EMC固化料清除干凈。
(3)雖然封裝工藝與EMC的性能參數匹配良好,但是由于保管不當或者過期,致使EMC的流動性下降,黏度太大或者膠化時間太短,均會引起填充不良。其解決辦法主要是選擇具有合適的黏度和膠化時間的EMC,并按照EMC的儲存和使用要求妥善保管。 (4)由于EMC用量不夠而引起的未充填,這種情況一般出現在更換EMC、封裝類型或者更換模具的時候,其解決辦法也比較簡單,只要選擇與封裝類型和模具相匹配的EMC用量,即可解決,但是用量不宜過多或者過少。
2、封裝成形氣孔及其對策
在封裝成形的過程中,氣孔是最常見的缺陷。根據氣孔在塑封體上產生的部位可以分為內部氣孔和外部氣孔,而外部氣孔又可以分為頂端氣孔和澆口氣孔。氣孔不僅嚴重影響塑封體的外觀,而且直接影響塑封器件的可靠性,尤其是內部氣孔更應重視。常見的氣孔主要是外部氣孔,內部氣孔無法直接看到,必須通過X射線儀才能觀察到,而且較小的內部氣孔Bp使通過x射線也看不清楚,這也為克服氣孔缺陷帶來很大困難。那么,要解決氣孔缺陷問題,必須仔細研究各類氣孔形成的過程。但是嚴格來說,氣孔無法完全消除,只能多方面采取措施來改善,把氣孔缺陷控制在良品范圍之內。
從氣孔的表面來看,形成的原因似乎很簡單,只是型腔內有殘余氣體沒有有效排出而形成的。事實上,引起氣孔缺陷的因素很多,主要表現在以下幾個方面:
A、封裝材料方面,主要包括EMC的膠化時間、黏度、流動性、揮發物含量、水分含量、空氣含量、料餅密度、料餅直徑與料簡直徑不相匹配等;
B、模具方面,與料筒的形狀、型腔的形狀和排列、澆口和排氣口的形狀與位置等有關; C、封裝工藝方面,主要與預熱溫度、模具溫度、注塑速度、注塑壓力、注塑時間等有關。 在封裝成形的過程中,頂端氣孔、澆口氣孔和內部氣孔產生的主要原因及其對策:
(1)、頂端氣孔的形成主要有兩種情況,一種是由于各種因素使EMC黏度急劇-上升,致使注塑壓力無法有效傳遞到頂端,以至于頂端殘留的氣體無法排出而造成氣孔缺陷;一種是EMC的流動速度太慢,以至于型腔沒有完全充滿就開始發生固化交聯反應,這樣也會形成氣孔缺陷。解決這種缺陷最有效的方法就是增加注塑速度,適當調整預熱溫度也會有些改善。
(2)、澆口氣孔產生的主要原因是EMC在模具中的流動速度太快,當型腔充滿時,還有部分殘余氣體未能及時排出,而此時排氣口已經被溢出料堵塞,最后殘留氣體在注塑壓力的作用下,往往會被壓縮而留在澆口附近。解決這種氣孔缺陷的有效方法就是減慢注塑速度,適當降低預熱溫度,以使EMC在模具中的流動速度減緩;同時為了促進揮發性物質的逸出,可以適當提高模具溫度。
(3)、內部氣孔的形成原因主要是由于模具表面的溫度過高,使型腔表面的EMC過快或者過早發生固化反應,加上較快的注塑速度使得排氣口部位充滿,以至于內部的部分氣體無法克服表面的固化層而留在內部形成氣孔。這種氣孔缺陷一般多發生在大體積電路封裝中,而且多出現在澆口端和中間位置。要有效的降低這種氣孔的發生率,首先要適當降低模具溫度,其次可以考慮適當提高注塑壓力,但是過分增加壓力會引起沖絲、溢料等其他缺陷,比較合適的壓力范圍是8~10Mpa。
3、封裝成形麻點及其對策
在封裝成形后,封裝體的表面有時會出現大量微細小孔,而且位置都比較集中,看上去是一片麻點。這些缺陷往往會伴隨其他缺陷同時出現,比如未充填、開裂等。這種缺陷產生的原因主要是料餅在預熱的過程中受熱不均勻,各部位的溫差較大,注入模腔后引起固化反應不一致,以至于形成麻點缺陷。引起料餅受熱不均勻的因素也比較多,但是主要有以下三種情況:
(1)、料餅破損缺角。對于一般破損缺角的料餅,其缺損的長度小于料餅高度的1/3,并且在預熱機輥子上轉動平穩,方可使用,而且為了防止預熱時傾倒,可以將破損的料餅夾在中間。在投入料筒時,最好將破損的料餅置于底部或頂部,這樣可以改善料餅之間的溫差。對于破損嚴重的料餅,只能放棄不用。
(2)、料餅預熱時放置不當。在預熱結束取出料餅時,往往會發現料餅的兩端比較軟,而中間的比較硬,溫差較大。一般預熱溫度設置在84-88℃時,溫差在8~10℃左右,這樣封裝成形時最容易出現麻點缺陷。要解決因溫差較大而引起的麻點缺陷,可以在預熱時將各料餅之間留有一定的空隙來放置,使各料餅都能充分均勻受熱。經驗表明,在投料時先投中間料餅后投兩端料餅,也會改善這種因溫差較大而帶來的缺陷。
(3)、預熱機加熱板高度不合理,也會引起受熱不均勻,從而導致麻點的產生。這種情況多發生在同一預熱機上使用不同大小的料餅時,而沒有調整加熱板的高度,使得加熱板與料餅距離忽遠忽近,以至于料餅受熱不均。經驗證明,它們之間比較合理的距離是3-5mm,過近或者過遠均不合適。
4、封裝成形沖絲及其對策
在封裝成形時,EMC呈現熔融狀態,由于具有一定的熔融黏度和流動速度,所以自然具有一定的沖力,這種沖力作用在金絲上,很容易使金絲發生偏移,嚴重的會造成金絲沖斷。這種沖絲現象在塑封的過程中是很常見的,也是無法完全消除的,但是如果選擇適當的黏度和流速還是可以控制在良品范圍之內的。EMC的熔融黏度和流動速度對金絲的沖力影響,可以通過建立一個數學模型來解釋。可以假設熔融的EMC為理想流體,則沖力F=KηυSinQ,K為常數,η為EMC的熔融黏度,υ為流動速度,Q為流動方向與金絲的夾角。從公式可以看出:η越大,υ越大,F越大;Q越大,F也越大;F越大,沖絲越嚴重。
要改善沖絲缺陷的發生率,關鍵是如何選擇和控制EMC的熔融黏度和流速。一般來說,EMC的熔融黏度是由高到低再到高的一個變化過程,而且存在一個低黏度期,所以選擇一個合理的注塑時間,使模腔中的EMC在低黏度期中流動,以減少沖力。選擇一個合適的流動速度也是減小沖力的有效辦法,影響流動速度的因素很多,可以從注塑速度、模具溫度、模具流道、澆口等因素來考慮。另外,長金絲的封裝產品比短金絲的封裝產品更容易發生沖絲現象,所以芯片的尺寸與小島的尺寸要匹配,避免大島小芯片現象,以減小沖絲程度。)
5、封裝成形開裂及其對策
在封裝成形的過程中,粘模、EMC吸濕、各材料的膨脹系數不匹配等都會造成開裂缺陷。
對于粘模引起的開裂現象,主要是由于固化時間過短、EMC的脫模性能較差或者模具表面玷污等因素造成的。在成形工藝上,可以采取延長固化時間,使之充分固化;在材料方面,可以改善EMC的脫模性能;在操作方面,可以每模前將模具表面清除干凈,也可以將模具表面涂上適量的脫模劑。對于EMC吸濕引起的開裂現象,在工藝上,要保證在保管和恢復常溫的過程中,避免吸濕的發生;在材料上,可以選擇具有高Tg、低膨脹、低吸水率、高黏結力的EMC。對于各材料膨脹系數不匹配引起的開裂現象,可以選擇與芯片、框架等材料膨脹系數相匹配的
6、封裝成形溢料及其對策
在封裝成形的過程中,溢料又是一個常見的缺陷形式,而這種缺陷本身對封裝產品的性能沒有影響,只會影響后來的可焊性和外觀。溢料產生的原因可以從兩個方面來考慮,一是材料方面,樹脂黏度過低、填料粒度分布不合理等都會引起溢料的發生,在黏度的允許范圍內,可以選擇黏度較大的樹脂,并調整填料的粒度分布,提高填充量,這樣可以從EMC的自身上提高其抗溢料性能;二是封裝工藝方面,注塑壓力過大,合模壓力過低,同樣可以引起溢料的產生,可以通過適當降低注塑壓力和提高合模壓力,來改善這一缺陷。由于塑封模長期使用后表面磨損或基座不平整,致使合模后的間隙較大,也會造成溢料,而生產中見到的嚴重溢料現象往往都是這種原因引起的,可以盡量減少磨損,調整基座的平整度,來解決這種溢料缺陷。
7、封裝成形粘模及其對策
封裝成形粘模產生的原因及其對策:A、固化時間太短,EMC未完全固化而造成的粘模,可以適當延長固化時間,增加合模時間使之充分固化;B、EMC本身脫模性能較差而造成的粘模只能從材料方面來改善EMC的脫模性能,或者封裝成形的過程中,適當的外加脫模劑;C、模具表面沾污也會引起粘模,可以通過清洗模具來解決;D、模具溫度過低同樣會引起粘模現象,可以適當提高模具溫度來加以改善。
8、結語
總之,塑封成形的缺陷種類很多,在不同的封裝形式上有不同的表現形式,發生的幾率和位置也有很大的差異,產生的原因也比較復雜,并且互相牽連,互相影響,所以應該在分別研究的基礎上,綜合考慮,制定出相應的行之有效的解決方法與對策
-
封裝
+關注
關注
128文章
9259瀏覽量
148701 -
emc
+關注
關注
176文章
4394瀏覽量
191669
原文標題:EMC封裝成形常見缺陷
文章出處:【微信號:weixin21ic,微信公眾號:21ic電子網】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄

硅片超聲波清洗機操作過程中常見問題及解決辦法

大電流起弧過程中電弧聲壓/超聲波信號的特征提取與故障診斷

靜力水準儀在測量過程中遇到誤差如何處理?

使用AURIX進行調試的過程中,如果進入某個函數的時候出現問題,是配置項的問題還是函數中的變量的問題?
三防漆在噴涂過程中出現虹吸現象該怎么解決

深入剖析:SMT貼片加工中的封裝難題與解決方案

PLC在使用過程中常見的技術故障分析及維護




 EMC封裝成形的過程中常出現的問題
EMC封裝成形的過程中常出現的問題


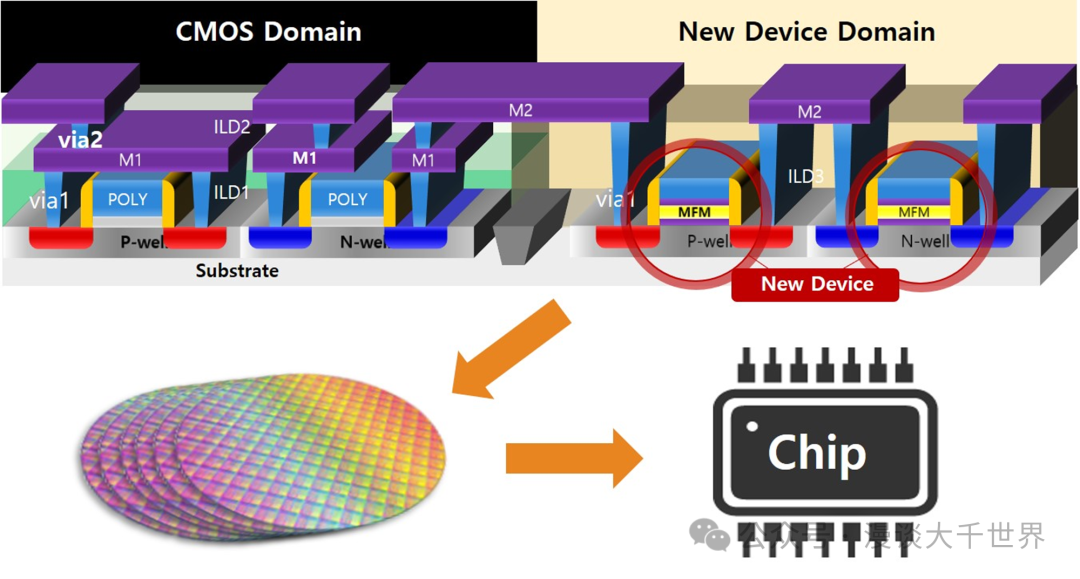



評論