傳統(tǒng)的SOT-23-6封裝是通過Wire-Bond( 打線,俗稱“邦定” )的方式將芯片內(nèi)核和封裝骨架上的導(dǎo)線架連接起來的,所用連接線通常是25至38μm的金線或銅線。
有時候,為了達(dá)成一定的性能指標(biāo),兩個連接點(diǎn)之間會同時打很多條線,這能改善性能,同時也提高了成本。下面的圖形可讓我們從不同的角度看到這樣的做法在IC的封裝內(nèi)部是如何實(shí)現(xiàn)的:
從上圖中可見連接芯片內(nèi)核和導(dǎo)線架的導(dǎo)線是細(xì)而長的。
我們都知道導(dǎo)體的電阻R和它的長度成正比、和它的橫截面積成反比,當(dāng)電流I流過導(dǎo)線時,它們集合起來形成的功率是I^2×R,由于此功率和電流的平方成正比,所以電流加大以后,功率就會以指數(shù)形式猛增,遺憾的是這部分功率是不能轉(zhuǎn)化為有用的輸出的,它們只能和芯片內(nèi)核發(fā)熱所形成的熱量一起升高封裝內(nèi)部的溫度。當(dāng)封裝內(nèi)部的溫度高于環(huán)境溫度以后,受溫度差的壓力,熱量才會向外傳遞。
在這里的熱量傳遞只能采用傳導(dǎo)的方式進(jìn)行,哪里的熱阻比較小,熱量就會向哪里傳導(dǎo)得比較多,這樣的傳遞過程會形成一個溫度的梯度,越是靠近熱源的地方,溫度越高,越是遠(yuǎn)離熱源的地方,溫度越低。這里說的遠(yuǎn)近不是距離的遠(yuǎn)近,而要理解為熱阻的大小,即熱阻大則距離遠(yuǎn)、熱阻小則距離短。在這種打線方式的SOT-23-6封裝中,由流過的電流形成的熱量在向外傳遞的過程中形成的溫度梯度是怎樣的呢?下面的模擬圖可以給出一點(diǎn)示意:
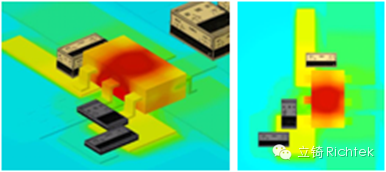
由圖可見,IC封裝中部的溫度是最高的,到了邊沿部分就低些了,到了引腳部分就更低了,PCB板上的溫度則非常接近常溫,這樣一來,就有大部分的熱量是通過封裝的中間部位向空氣中傳播的。很顯然,這樣的傳播效率是很低的,下面的實(shí)物熱成像照片可以驗(yàn)證這一點(diǎn):

這樣的溫度分布圖說明了傳統(tǒng)的SOT-23-6封裝是非常容易出現(xiàn)局部高溫的,而我們知道半導(dǎo)體器件對溫度是非常敏感的,過高的溫度很容易讓器件失去它應(yīng)有的功效,甚至可能造成火災(zāi)等危險,這就大大地限制了這種封裝的應(yīng)用空間。
我們在前面提到了熱阻的概念,它定義了熱量由一個地方向另一個地方傳遞時所受到的阻力的大小,其單位為℃/W,當(dāng)兩地的溫度指標(biāo)已經(jīng)確定時,熱阻的大小就確定了能夠在兩地之間傳遞的熱功率的大小。由這個概念,再加上芯片內(nèi)核能夠承受的最高溫度和環(huán)境溫度,我們就能夠得到這個芯片能夠承受的耗散功率,其計(jì)算公式為:

安裝在標(biāo)準(zhǔn)測試板上的傳統(tǒng)SOT-23-6封裝的θJA約等于250℃/W,芯片內(nèi)核的最高結(jié)溫為150℃,當(dāng)環(huán)境空氣溫度為25℃時,計(jì)算所得的P_D(MAX)=0.5W,這比我們規(guī)格書中標(biāo)示出來的0.4W大不了多少,但請你理解我們的規(guī)格書是不能虛標(biāo)的,但低標(biāo)總是可以的吧?這樣做是為了確保應(yīng)用的安全,避免用戶將它們用在不恰當(dāng)?shù)牡胤健?/p>
高熱阻的傳統(tǒng)SOT-23-6封裝有這里說到的缺陷,可它同時又是具有很多優(yōu)勢的,它很小,使用非常方便,生產(chǎn)規(guī)模很大,價格很低,如能針對它的缺陷進(jìn)行有針對性的改變,就有可能突破其限制,為它的應(yīng)用空間帶來突破。
我們在上面的封裝透視圖中看到的芯片內(nèi)核是平躺在骨架上的,焊點(diǎn)和導(dǎo)線架之間不在一個平面上,它們之間的連接必須依靠長長的導(dǎo)線來進(jìn)行連接。如果能將導(dǎo)線架金屬部分延伸到芯片下面,再將芯片內(nèi)核翻個面使其直接面對導(dǎo)線架并焊接在一起,則整個電流路徑就能大大地縮短而且變得很粗壯,這樣就可以將其R大大地降低,當(dāng)電流流過時形成的I^2×R就可以大大地減小了。與此同時,由于粗大的金屬具有遠(yuǎn)高于塑膠的熱傳導(dǎo)能力,由芯片內(nèi)核所產(chǎn)生的熱量也很容易透過骨架傳遞到PCB和空氣中,最后形成的溫度梯度就會表現(xiàn)得完全不一樣,從而為傳統(tǒng)的SOT-23-6封裝帶來新的生機(jī)。這種新的做法就是立锜投入巨大精力開發(fā)的全新的FCOL (Flip-Chip On Lead:在引腳上的芯片倒裝) 封裝技術(shù),它完全摒棄了傳統(tǒng)的連接線,而是將芯片內(nèi)核上的觸點(diǎn)直接和骨架的導(dǎo)線架焊接在一起,有效地降低了連接線的長度、電阻和熱阻,寄生電感也大大降低,使應(yīng)用它的產(chǎn)品有了更好的電性表現(xiàn)和優(yōu)化了的散熱能力,為傳統(tǒng)的SOT-23-6封裝注入了新的生命,大大拓展了它的生存空間。
下面的圖片展示了FCOL技術(shù)的實(shí)現(xiàn)方式:
它的熱表現(xiàn)會如何呢?先來看看模擬效果圖:
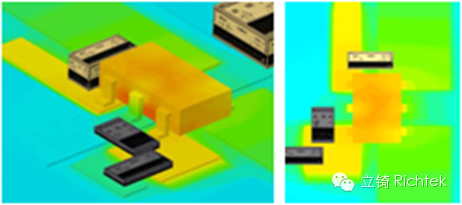
從中我們可以看到和傳統(tǒng)打線方式的溫度分布是很不一樣的,已經(jīng)表現(xiàn)得非常均勻了。如果模擬還不能說明問題,實(shí)物的熱成像圖就更有說服力了,直接看圖吧:

有了全新的FCOL封裝方式,SOT-23-6封裝的熱阻降到了很低的水平,安裝在標(biāo)準(zhǔn)測試板上時測得的θJA=70℃/W,依此計(jì)算出的 P_D(MAX)=1.78W,規(guī)格書中的標(biāo)示數(shù)據(jù)為1.429W,是傳統(tǒng)封裝的耗散功率的3.57倍,這就使得它的應(yīng)用空間大大擴(kuò)展了。目前,立锜科技的ACOTTM Buck器件中的一個子系列已大量使用SOT-23-6封裝,其電流輸出能力分別有1.5A、2.5A和3.5A,而且還有更大的提升空間等在后面。要知道在沒有這種FCOL封裝以前,這樣大的電流只能在類似SOP-8這樣的封裝里才能實(shí)現(xiàn),所以這樣的技術(shù)進(jìn)步是非常有價值的。
-
芯片
+關(guān)注
關(guān)注
463文章
54010瀏覽量
466149 -
導(dǎo)線
+關(guān)注
關(guān)注
5文章
422瀏覽量
25781 -
功率
+關(guān)注
關(guān)注
14文章
2120瀏覽量
75584
發(fā)布評論請先 登錄
探索MAXIM的SOT23封裝放大器:高效設(shè)計(jì)與卓越性能
LT1880:SOT - 23封裝的精密運(yùn)算放大器的卓越之選
低成本單聲道/立體聲1.4W差分音頻功率放大器MAX9718/MAX9719的設(shè)計(jì)與應(yīng)用
探索MAX9716/MAX9717:低成本單聲道1.4W BTL音頻功率放大器的卓越性能
探索MAX98309/MAX98310單聲道1.4W AB類音頻放大器:性能、應(yīng)用與設(shè)計(jì)要點(diǎn)
探索MAX5491:SOT23封裝的精密匹配電阻分壓器
MAX5490:SOT23封裝的100kΩ精密匹配電阻分壓器
低成本SOT23封裝電壓輸出高端電流檢測放大器MAX4173的應(yīng)用與特性解析
P6KE7.5A單向 TVS瞬態(tài)抑制二極管:600W功率DO-15封裝參數(shù)規(guī)格介紹

森國科推出SOT227封裝碳化硅功率模塊




 分享SOT-23-6封裝達(dá)成1.4W功率耗散能力的方法介紹
分享SOT-23-6封裝達(dá)成1.4W功率耗散能力的方法介紹






評論