濕氣如何進入塑封體并影響材料性能
在半導體器件的塑封結構中,主要使用的環氧塑封料和底填膠都是以環氧樹脂為基體的復合材料。這些材料中加入了無機填充顆粒、固化劑、催化劑、偶聯劑等成分,其中環氧樹脂的質量占比約為10%到20%。無機填料通常采用表面經過特殊處理的球形二氧化硅顆粒,這些顆粒能夠提高材料的熱傳導能力、增加機械強度、減少固化過程中的收縮,并改善材料與芯片之間的熱匹配性。
從微觀結構來看,環氧樹脂的分子鏈之間并不是完全致密的狀態,內部存在著比水分子尺寸更大的微小孔隙。同時,分子鏈上含有羥基、羧基、胺基等容易與水分子結合的極性官能團。在濕熱環境下,外界環境中的水分子可以通過材料表面或者填料與樹脂之間的界面,逐漸向塑封材料內部擴散。水分子進入后會與這些極性官能團形成氫鍵吸附,在材料中主要以自由水和結合水兩種形式存在。
自由水分布在高分子鏈之間的孔隙、微裂紋及界面處,具有一定流動性,可在適當溫度下遷移或揮發。結合水通過氫鍵與極性基團牢固結合,難以脫附。水分吸附和滯留會引起濕膨脹、降低界面結合強度,并影響電學性能,最終降低器件長期可靠性。
濕熱環境引起的應力問題
塑封料和底填膠吸收水分后會發生濕膨脹,而在溫度升高過程中材料又會產生熱膨脹。在濕熱環境中,芯片、基板、塑封料等不同材料之間的熱膨脹系數和濕膨脹系數存在差異,這種不匹配會導致器件出現過大的翹曲變形。由于不同材料的變形受到相互約束,在芯片邊緣、鍵合引線以及塑封料與基板的界面等位置容易產生較高的應力,增加了材料分層和斷裂的風險。
對球柵陣列封裝器件在吸濕及回流焊過程中的分析表明,吸濕對可靠性的影響甚至大于回流熱應力本身。通過有限元分析對三維芯片堆疊塑封結構進行濕熱研究,發現邊角位置的焊球存在高應力,下層芯片互連焊球的應力高于上層焊球。針對系統級封裝模組的濕-熱-力耦合模型研究表明,基板厚度變化對內部濕熱應力影響較為敏感。
界面分層失效的形成機制
濕氣在材料界面聚集會破壞化學鍵與偶聯劑網絡,水分子與極性官能團形成競爭性氫鍵,降低界面結合能力。隨著水分子持續吸附,局部斷裂強度下降。對于金屬界面,濕氣可能引發化學反應,促進金屬間化合物快速生長,使界面局部厚度增加,形成微裂紋和空洞,進一步弱化界面結合。當界面結合力難以抵抗濕熱應力時,出現微裂紋萌生和擴展,最終導致界面分層。濕擴散一方面弱化界面,另一方面吸濕膨脹與熱膨脹產生的剪切應力和剝離應力是界面失效的主要驅動力。濕熱環境下,界面分層受到斷裂強度降低、濕熱失配應力及快速升溫導致水分蒸發產生的蒸氣壓共同影響。針對倒裝芯片封裝結構在回流焊條件下的仿真研究發現,塑封料、硅芯片與粘結劑的交界處應力和能量釋放率最大,界面裂紋最容易擴展,且能量釋放率與內部濕濃度和熱沖擊程度正相關。此外,界面富集的水分在回流焊等高溫過程中會在界面微孔隙中迅速汽化形成蒸氣壓,當蒸汽壓力與濕熱膨脹應力共同作用、超過界面斷裂強度時,裂紋沿界面快速擴展,即爆米花效應。蒸氣壓對含空腔器件影響顯著,吸濕器件空腔內蒸氣壓飽和后與濕熱應力共同作用,顯著增加界面分層可能性。
焊點的電化學腐蝕與性能劣化
金屬焊點本身不吸濕,但濕氣擴散至焊點周邊的吸濕材料及界面時,會影響焊點受力狀態,并可能形成電化學腐蝕環境。當界面分層擴展至焊點區域時,蒸汽壓與濕熱應力疊加可能加速焊點微裂紋的產生與擴展,甚至導致斷裂。通電下,焊點表面水膜和離子雜質形成原電池。陽極金屬溶解,陰極析氫,生成氧化物/氫氧化物,破壞焊點完整性。濕熱下應力與化學環境協同,提高焊點對濕度、電場、載荷的敏感性。應力集中區成為腐蝕起點,腐蝕降低承載能力,加速裂紋擴展,引發短路或接觸不良。通過鹽霧試驗表明,銅焊盤與錫存在電偶腐蝕,氯離子加速錫溶解。潮濕環境下焊料表面水膜為電解介質,陽極溶解生成亞錫離子,向陰極遷移還原成錫枝晶。濕熱越嚴苛,枝晶生長越快,氯離子顯著促進腐蝕,導致可靠性失效。
吸濕引起的電性能退化
塑封器件內部高分子復合材料吸濕會引起整體電學參數變化。濕擴散為局部電場集中和離子遷移提供條件,可能誘發材料電性能退化。塑封料吸濕使界面和吸濕富集區的介電常數升高,并伴隨介電損耗增加。介電常數升高改變器件內部電場分布,使界面或缺陷區域產生局部高場點,增加擊穿風險。介電損耗增加導致電能轉化為熱能的比例加大,加劇局部溫升,產生額外熱管理問題。吸濕導致界面水膜和孔隙中溶解離子在電場下遷移,漏電流增大,并可能誘發電化學腐蝕。長期服役表現為絕緣電阻下降、電場畸變、功能失效。濕擴散、介電變化、離子遷移、腐蝕多因素耦合。研究發現,濕擴散不僅導致塑封料介電常數和耗散因數上升,還降低了臨界電場強度,使絕緣層耐壓性能減弱。吸濕引起的局部電場畸變增加漏電流與擊穿風險,尤其在填料-基體界面處,濕氣富集形成電弱化區域,進一步削弱整體絕緣性能。
總結
綜上所述,在濕熱環境中,塑封半導體器件首先受到濕擴散及濕氣在界面上的富集影響,導致局部膨脹、翹曲以及內部應力集中,這類力學效應會削弱界面完整性,并提高界面分層與裂紋擴展的發生概率。與此同時,水分在界面及互連區域的存在會改變局部環境條件,使焊點等關鍵部位更容易暴露于電化學腐蝕風險之中。當濕氣進入互連與焊區后,水膜與溶解離子在電場作用下可能引發離子遷移及絕緣性能退化,表現為漏電流升高和電學性能劣化。此外,吸濕引起的材料電學參數變化也會對局部電場分布產生影響,進一步加劇電性能退化過程。因此,濕熱環境下塑封器件的失效并非由單一原因主導,而是濕膨脹應力、界面劣化、焊點腐蝕及電學退化等多種機制并行作用、相互耦合的結果。對于塑封半導體器件的可靠性設計和評估,需要綜合考慮這些因素,通過理論分析、實驗驗證和仿真模擬等手段進行系統評估,以指導可靠性設計工作。
-
材料
+關注
關注
3文章
1577瀏覽量
28688 -
半導體器件
+關注
關注
12文章
809瀏覽量
34253
發布評論請先 登錄
元器件失效分析方法
半導體失效分析項目介紹
半導體塑封設備
提升功率半導體可靠性:推拉力測試機在封裝工藝優化中的應用

濕熱環境下的隱患:如何避免聚氨酯灌封膠水解風險? | 鉻銳特實業




 塑封半導體器件在濕熱環境下的失效風險分析
塑封半導體器件在濕熱環境下的失效風險分析


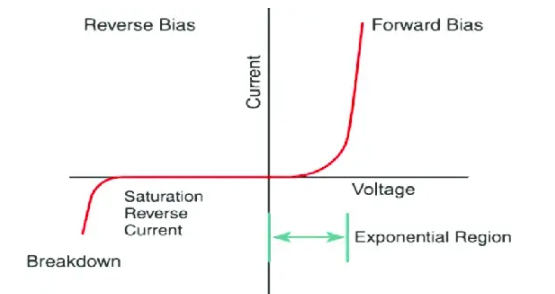





評論