文章來源:十二芯座
原文作者:MicroX
本文圖解介紹了GAAFET(Gate-All-Around FET)的制造流程。
隨著集成電路制程邁向3nm及以下節(jié)點,F(xiàn)inFET(鰭式場效應(yīng)晶體管)由于三面柵控能力的局限,難以抑制嚴重的短溝道效應(yīng)。
GAAFET(Gate-All-Around FET)通過將柵極完全包裹在納米片(Nanosheet)通道四周,實現(xiàn)了近乎完美的電子控制。

超晶格生長(Superlattice Epitaxy)
制造始于在硅襯底上交替生長Si(硅)和SiGe(硅鍺)的多層外延結(jié)構(gòu)。
工藝細節(jié):使用化學(xué)氣相沉積(CVD)精確控制每層厚度。
邏輯:SiGe層僅作為“犧牲層”,為后續(xù)騰出空間;Si層則是最終的電子通道。

鰭片刻蝕與淺溝槽隔離(Fin Etch & STI)
與FinFET類似,通過光刻和干法刻蝕將超晶格結(jié)構(gòu)切割成條狀。
挑戰(zhàn):刻蝕必須保持極高的垂直度,確保多層Si/SiGe堆疊結(jié)構(gòu)的側(cè)壁平整。



Dummy Gate 形成

內(nèi)側(cè)墻形成(Inner Spacer Formation)
這是GAA工藝中最獨特的一步。在沉積 Dummy Gate 后,需要側(cè)向刻蝕掉一部分SiGe層,并填充介電材料形成內(nèi)側(cè)墻。
作用:內(nèi)側(cè)墻將源/漏極(Source/Drain)與金屬柵極隔離開,極大降低了寄生電容(Cgs/Cgd)。
技術(shù)難點:必須使用極高選擇比的各向同性刻蝕,確保只移除預(yù)定深度的SiGe,而不損傷Si層。


源漏區(qū)外延
SiGe/ SiP EPI




納米片釋放(Channel Release)
在替換金屬柵(RMG)工藝中,通過高選擇比的濕法或干法刻蝕徹底清除所有的SiGe層,使Si納米片如同“懸空的橋”一般懸掛在源漏之間。
物理瓶頸:此時納米片極其脆弱,表面張力可能導(dǎo)致納米片塌陷粘連(Stiction)。

高K金屬柵(HKMG)沉積
最后,利用原子層沉積(ALD)技術(shù),將高K電介質(zhì)和金屬柵極材料“塞進”納米片之間的極小縫隙(通常小于10nm)。
均勻性要求:ALD必須保證在納米片的頂面、底面和側(cè)面均勻成膜,實現(xiàn)全環(huán)繞包裹。




Contact 形成

-
集成電路
+關(guān)注
關(guān)注
5462文章
12659瀏覽量
375512 -
晶體管
+關(guān)注
關(guān)注
78文章
10431瀏覽量
148435 -
FinFET
+關(guān)注
關(guān)注
12文章
262瀏覽量
92346
原文標(biāo)題:GAAFET(全環(huán)繞柵極晶體管)制造流程圖解
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
應(yīng)用材料公司以技術(shù)助力極紫外光和三維環(huán)繞柵極晶體管實現(xiàn)二維微縮
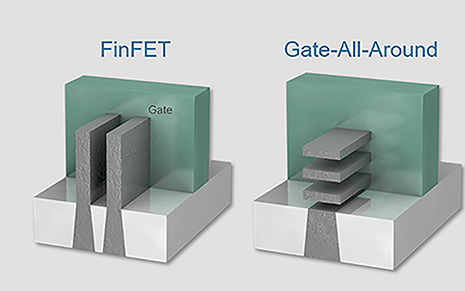
互補場效應(yīng)晶體管的結(jié)構(gòu)和作用

下一代高速芯片晶體管解制造問題解決了!
雙面板制作流程及鍍金、噴錫和FPC板流程圖解

鍍金、噴錫和FPC板流程圖解
三星推GAAFET技術(shù) 將基于它打造3nm芯片
如何生產(chǎn)3納米以下全環(huán)繞柵極晶體管?
臺積電2nm芯片計劃于2025年實現(xiàn)量產(chǎn)
臺積電2nm芯片將采用GAAFET技術(shù)
全環(huán)繞柵極晶體管將如何改變半導(dǎo)體行業(yè)
鰭式場效應(yīng)晶體管制造工藝流程




 GAAFET全環(huán)繞柵極晶體管制造流程圖解
GAAFET全環(huán)繞柵極晶體管制造流程圖解



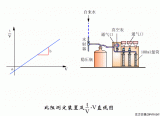



評論