想象一下:一輛智能汽車在高速公路上以120公里/小時(shí)疾馳,突然,發(fā)動(dòng)機(jī)控制芯片因高溫失效,動(dòng)力瞬間中斷;或者自動(dòng)駕駛芯片因振動(dòng)導(dǎo)致焊點(diǎn)開裂,車輛失去感知能力。這些場(chǎng)景并非危言聳聽——隨著汽車智能化、電動(dòng)化進(jìn)程加速,一輛現(xiàn)代汽車搭載的芯片數(shù)量已超過1000顆,從發(fā)動(dòng)機(jī)控制到自動(dòng)駕駛,從座艙娛樂到車身穩(wěn)定,芯片已成為名副其實(shí)的汽車“生命線”。
車規(guī)級(jí)芯片與消費(fèi)級(jí)芯片的最大區(qū)別,不在于性能高低,而在于可靠性——它必須在-40℃至150℃的極端溫度、持續(xù)振動(dòng)、高濕度、電磁干擾等惡劣環(huán)境下,保持15年乃至整個(gè)汽車壽命期的零失效運(yùn)行。這就是車規(guī)級(jí)芯片可靠性檢測(cè)的核心使命。
車規(guī)級(jí)芯片可靠性檢測(cè),是指通過一系列標(biāo)準(zhǔn)化的應(yīng)力測(cè)試和環(huán)境模擬,驗(yàn)證芯片在汽車全生命周期內(nèi)能否承受各種極端工況的綜合性驗(yàn)證體系。其核心依據(jù)是AEC-Q系列標(biāo)準(zhǔn)——由克萊斯勒、福特和通用汽車于1994年聯(lián)合發(fā)起的汽車電子委員會(huì)(AEC)制定的行業(yè)規(guī)范,如今已成為全球汽車供應(yīng)鏈的強(qiáng)制性準(zhǔn)入門檻。
簡(jiǎn)單來說,沒有通過AEC-Q認(rèn)證的芯片,幾乎不可能進(jìn)入主流汽車供應(yīng)鏈。
車規(guī)級(jí)芯片可靠性檢測(cè)是確保芯片在汽車復(fù)雜、惡劣環(huán)境下長(zhǎng)期穩(wěn)定工作的核心環(huán)節(jié),其標(biāo)準(zhǔn)遠(yuǎn)高于消費(fèi)級(jí)和工業(yè)級(jí)芯片,需通過一系列嚴(yán)苛測(cè)試驗(yàn)證芯片的環(huán)境適應(yīng)性、耐久性及功能安全性。
車規(guī)級(jí)芯片的可靠性檢測(cè)是一套覆蓋極端環(huán)境、電氣性能、機(jī)械應(yīng)力與功能安全的全生命周期驗(yàn)證體系,核心目標(biāo)是在芯片裝車前暴露所有潛在缺陷,確保其在10-15年使用周期內(nèi)零故障運(yùn)行?。該檢測(cè)不僅關(guān)乎性能,更直接關(guān)系到行車安全,因此標(biāo)準(zhǔn)遠(yuǎn)嚴(yán)于消費(fèi)級(jí)芯片。
核心目標(biāo)
車規(guī)級(jí)芯片需滿足汽車全生命周期(通常15年/20萬公里)的可靠性要求,檢測(cè)目標(biāo)包括:
- 環(huán)境耐受性:適應(yīng)極端溫度、濕度、振動(dòng)、沖擊及電磁干擾。
- 長(zhǎng)期穩(wěn)定性:在老化、應(yīng)力作用下保持性能穩(wěn)定,避免突發(fā)失效。
- 功能安全:符合ISO 26262等標(biāo)準(zhǔn),確保芯片故障不會(huì)導(dǎo)致汽車安全風(fēng)險(xiǎn)(如剎車失靈、自動(dòng)駕駛誤判)。
· 關(guān)鍵檢測(cè)項(xiàng)目 ·
01環(huán)境應(yīng)力測(cè)試
模擬汽車實(shí)際使用中的極端環(huán)境,確保芯片在以下條件下的穩(wěn)定性:
①溫度測(cè)試
- 高低溫循環(huán)(TC):在-40℃~125℃(部分場(chǎng)景達(dá)150℃)之間循環(huán),驗(yàn)證芯片在溫度劇烈變化下的電氣性能(如參數(shù)漂移、開路/短路)。
- 高溫存儲(chǔ)(HTSL):在150℃下存儲(chǔ)數(shù)百小時(shí),評(píng)估材料老化和封裝開裂風(fēng)險(xiǎn)。
- 低溫啟動(dòng)測(cè)試:-40℃下啟動(dòng)芯片,確保低溫環(huán)境下的初始化和功能正常。
②濕度與腐蝕測(cè)試
- 溫濕度偏壓(THB):85℃/85%RH下施加偏壓,加速腐蝕和絕緣失效。
- 鹽霧測(cè)試:模擬沿海或工業(yè)環(huán)境,檢測(cè)引腳和封裝的抗腐蝕能力。
③機(jī)械應(yīng)力測(cè)試
- 振動(dòng)測(cè)試:隨機(jī)振動(dòng)(1Hz~2000Hz)或正弦振動(dòng),模擬行駛中的顛簸,檢測(cè)引腳焊點(diǎn)和內(nèi)部結(jié)構(gòu)強(qiáng)度。
- 沖擊測(cè)試:?jiǎn)吸c(diǎn)或多軸沖擊(如1000g加速度),模擬碰撞或劇烈顛簸,避免芯片移位或引腳變形。
02壽命與老化測(cè)試
通過加速老化模擬長(zhǎng)期使用,預(yù)測(cè)芯片壽命:
- 高溫工作壽命(HTOL):在125℃下持續(xù)工作(如1000小時(shí)),評(píng)估電路穩(wěn)定性、功耗變化及參數(shù)漂移。 根據(jù)阿倫尼烏斯模型,溫度每升高10℃,反應(yīng)速率約翻倍。1000小時(shí)125℃測(cè)試,相當(dāng)于常溫下多年運(yùn)行,每24小時(shí)采集一次電參數(shù),對(duì)比測(cè)試前后偏差。
- 加速壽命測(cè)試(ALT):通過提高溫度、電壓或應(yīng)力(如HAST高加速溫濕度偏壓測(cè)試),縮短測(cè)試時(shí)間以加速失效,推算實(shí)際使用壽命。
03電學(xué)與抗干擾測(cè)試
①靜電放電(ESD)測(cè)試:符合AEC-Q100要求,通過人體模型(HBM)和充電裝置模型(CDM)測(cè)試,確保芯片抗靜電能力。
- 輻射/傳導(dǎo)發(fā)射:檢測(cè)芯片對(duì)外部設(shè)備的電磁干擾。
- 電磁敏感度:驗(yàn)證芯片在電磁環(huán)境中的抗干擾能力,避免信號(hào)失真或功能異常。
③電學(xué)參數(shù)驗(yàn)證:測(cè)試輸入輸出電壓范圍、電流消耗、工作頻率及信號(hào)響應(yīng),確保芯片在正常工作條件下的性能一致性。
04封裝與工藝測(cè)試
- 封裝可靠性:焊點(diǎn)可靠性、封裝材料耐久性及環(huán)境應(yīng)力下的封裝完整性(如氣密性、引線鍵合強(qiáng)度)。
- 晶圓制程測(cè)試:控制制程參數(shù)、材料質(zhì)量及缺陷篩查,減少制造缺陷(如晶圓廠配合的WLR測(cè)試)。
05功能安全與缺陷篩查
- 缺陷篩查:通過燒錄測(cè)試、故障定位、信號(hào)完整性測(cè)試等發(fā)現(xiàn)潛在缺陷。
- 功能安全驗(yàn)證:符合ISO 26262 ASIL等級(jí)要求,確保芯片故障可檢測(cè)、可控制,避免安全風(fēng)險(xiǎn)(如冗余設(shè)計(jì)、錯(cuò)誤檢測(cè)機(jī)制)。
06HAST測(cè)試:高加速濕熱測(cè)試
這是模擬潮濕環(huán)境的最嚴(yán)酷測(cè)試之一:
- 測(cè)試條件:130℃/85%RH/33.3psia,持續(xù)96小時(shí)或更長(zhǎng)
- 偏置電壓:施加80%額定電壓,在相鄰pad間建立電勢(shì)差
- 失效機(jī)制:
- 電化學(xué)腐蝕:濕氣侵入后形成電解液,導(dǎo)致鋁鍵合線腐蝕
- 離子遷移:金屬離子在電場(chǎng)下遷移形成枝晶短路
- 封裝分層:樹脂吸濕后水解,引發(fā)界面分層
車規(guī)級(jí)芯片的可靠性檢測(cè)所需設(shè)備01溫度相關(guān)測(cè)試
溫度循環(huán)測(cè)試
?設(shè)備:高低溫交變?cè)囼?yàn)箱(如上海簡(jiǎn)戶、成都中冷低溫的TS560熱流儀)
高溫存儲(chǔ)壽命測(cè)試
?設(shè)備:高溫老化箱
高溫高濕偏壓測(cè)試
?設(shè)備:HAST高加速壽命試驗(yàn)箱(可施加高溫、高濕、高壓三應(yīng)力)
高溫工作壽命測(cè)試
?設(shè)備:帶電老化系統(tǒng) + 高溫老化箱 + 電源負(fù)載板
02機(jī)械應(yīng)力測(cè)試
振動(dòng)與沖擊測(cè)試
?設(shè)備:電磁振動(dòng)臺(tái)、沖擊試驗(yàn)機(jī)
03電氣與電磁兼容性測(cè)試
電壓波動(dòng)與瞬態(tài)干擾測(cè)試
?設(shè)備:電源擾動(dòng)模擬器、瞬態(tài)脈沖發(fā)生器
電磁干擾/抗擾度測(cè)試(EMC/EMI)
?設(shè)備:EMC測(cè)試系統(tǒng)、屏蔽室、頻譜分析儀
04靜電與放電防護(hù)測(cè)試
?人體模型(HBM)、機(jī)器模型(MM)、充電器件模型(CDM)ESD測(cè)試
?設(shè)備:ESD測(cè)試儀(如Hanwa & RKD 的 C5000R CDM測(cè)試機(jī))
05晶圓級(jí)與封裝級(jí)可靠性測(cè)試
晶圓級(jí)可靠性測(cè)試
?設(shè)備:高性能WLR測(cè)試機(jī)(如廣立微推出的WLR設(shè)備)
?創(chuàng)芯在線檢測(cè) / 電參數(shù)測(cè)試
?設(shè)備:自動(dòng)測(cè)試設(shè)備(ATE)、參數(shù)分析儀
06綜合環(huán)境模擬平臺(tái)
?車規(guī)芯片可靠性測(cè)試系統(tǒng)(集成微控制器、驅(qū)動(dòng)板、環(huán)境模擬電路)
?可模擬真實(shí)車載工況,實(shí)現(xiàn)多應(yīng)力耦合測(cè)試
補(bǔ)充說明
?所有測(cè)試需嚴(yán)格遵循 AEC-Q100(針對(duì)IC)、AEC-Q101(分立器件)、AEC-Q200(無源器件) 等汽車電子委員會(huì)標(biāo)準(zhǔn)。
?實(shí)驗(yàn)室建設(shè)常采用“國產(chǎn)為主+關(guān)鍵進(jìn)口”策略,例如國產(chǎn)高低溫箱搭配進(jìn)口CDM或EMC設(shè)備。
車規(guī)級(jí)芯片的可靠性驗(yàn)證的具體步驟
前期準(zhǔn)備階段
PART.01
明確應(yīng)用場(chǎng)景與溫度等級(jí)
根據(jù)芯片在整車中的位置(如座艙、車身控制、動(dòng)力總成、ADAS等),確定其工作環(huán)境要求,并選擇對(duì)應(yīng)的 AEC-Q100 溫度等級(jí):
?Grade 0:–40°C ~ +150°C(用于發(fā)動(dòng)機(jī)艙)
?Grade 1:–40°C ~ +125°C(主流車用)
?Grade 2:–40°C ~ +105°C
?Grade 3:–40°C ~ +85°C
注:Grade 1 是最常見要求。
PART.02
功能安全需求分析(如適用)
若芯片用于安全關(guān)鍵系統(tǒng)(如剎車、轉(zhuǎn)向、電池管理),需同步滿足 ISO 26262 功能安全標(biāo)準(zhǔn),定義 ASIL 等級(jí)(A~D),并開展安全機(jī)制設(shè)計(jì)(如雙核鎖步、ECC、自檢等)。
二
可靠性設(shè)計(jì)階段
PART.03
可靠性導(dǎo)向的電路與版圖設(shè)計(jì)
?采用抗老化、抗電遷移(EM)、抗熱載流子注入(HCI)的器件模型
?增加冗余設(shè)計(jì)、去耦電容、ESD保護(hù)結(jié)構(gòu)
?封裝設(shè)計(jì)考慮熱膨脹系數(shù)匹配(CTE)、散熱路徑優(yōu)化
PART.04
選用車規(guī)級(jí)工藝與材料
?晶圓廠提供符合 AEC-Q100 的 PDK(工藝設(shè)計(jì)套件)
?封裝材料需耐高溫、低吸濕(如模塑料、底部填充膠)
三
可靠性測(cè)試驗(yàn)證階段(核心)
PART.05
執(zhí)行AEC-Q100全套可靠性測(cè)試
AEC-Q100 包含 7 大類、41+ 項(xiàng)測(cè)試項(xiàng)目,典型項(xiàng)目如下:
?環(huán)境應(yīng)力測(cè)試:溫度循環(huán)(TC)、高溫高濕存儲(chǔ)(THB/HAST)、高溫存儲(chǔ)壽命(HTSL),驗(yàn)證材料熱脹冷縮、腐蝕、分層等
?電氣壽命測(cè)試:高溫工作壽命(HTOL)、早期失效率(ELFR),模擬長(zhǎng)期帶電運(yùn)行下的退化
?機(jī)械應(yīng)力測(cè)試:振動(dòng)、機(jī)械沖擊、焊球剪切力,驗(yàn)證封裝與焊點(diǎn)可靠性
?靜電防護(hù)測(cè)試:HBM、CDM、MM ESD,防止制造/裝配過程靜電損傷
?可焊性與封裝完整性:可焊性、引線鍵合強(qiáng)度、密封性(如適用),確保組裝良率與長(zhǎng)期密封
?軟錯(cuò)誤率測(cè)試(SER):中子輻照或加速測(cè)試,評(píng)估宇宙射線導(dǎo)致單粒子翻轉(zhuǎn)風(fēng)險(xiǎn)(對(duì)MCU/存儲(chǔ)器重要)
所有測(cè)試必須使用 量產(chǎn)工藝、量產(chǎn)封裝、量產(chǎn)晶圓批次 的樣品,通常要求 3 個(gè)批次(lots),每批至少 77 顆芯片(部分項(xiàng)目要求更多)。
PART.06
失效分析(FA)與根因定位
?若測(cè)試中出現(xiàn)失效,需進(jìn)行 物理/電性失效分析(如SEM、FIB、X-ray、TDR)
?確認(rèn)是設(shè)計(jì)缺陷、工藝波動(dòng)還是測(cè)試誤判
?必要時(shí)迭代設(shè)計(jì)或工藝參數(shù)
四
認(rèn)證與量產(chǎn)階段
PART.07
提交AEC-Q100認(rèn)證報(bào)告
?由第三方實(shí)驗(yàn)室(如SGS、TüV、德塏、廣電計(jì)量)或原廠實(shí)驗(yàn)室出具完整測(cè)試報(bào)告
?報(bào)告需包含測(cè)試條件、樣本信息、通過/失敗判定、FA結(jié)果(如有)
注意:AEC-Q100 不是認(rèn)證證書,而是“自我聲明符合性”,但行業(yè)普遍要求提供完整測(cè)試數(shù)據(jù)。
PART.08
建立長(zhǎng)期供貨與質(zhì)量管控體系
?承諾 10~15 年供貨周期
?實(shí)施 零缺陷管理(如SPC、8D、PPAP)
?任何工藝/材料變更需重新做 PCN并可能重測(cè)部分項(xiàng)目
五
持續(xù)監(jiān)控(生命周期內(nèi))
PART.09
市場(chǎng)反饋與可靠性追蹤
?收集現(xiàn)場(chǎng)失效率
?定期進(jìn)行 可靠性再驗(yàn)證(如年度抽樣HTOL)
?更新壽命預(yù)測(cè)模型
典型應(yīng)用場(chǎng)景
?動(dòng)力域:MCU、SiC/GaN功率器件
?電源管理:LDO、DC-DC轉(zhuǎn)換器
主要檢測(cè)標(biāo)準(zhǔn)
車規(guī)級(jí)芯片可靠性檢測(cè)以AEC-Q系列為核心,輔以ISO、JEDEC等標(biāo)準(zhǔn),具體包括:
- AEC-Q100:針對(duì)集成電路(IC)的可靠性標(biāo)準(zhǔn),涵蓋溫度、濕度、機(jī)械應(yīng)力等測(cè)試(如溫度循環(huán)、高溫工作壽命)。
- ISO 26262:功能安全標(biāo)準(zhǔn),要求芯片滿足ASIL(汽車安全完整性等級(jí))要求(如ASIL B/D)。
- IATF 16949:質(zhì)量管理標(biāo)準(zhǔn),確保生產(chǎn)過程的穩(wěn)定性和一致性。
- JEDEC標(biāo)準(zhǔn):補(bǔ)充環(huán)境和壽命測(cè)試方法(如JESD22系列)。
- ISO 21434:信息安全標(biāo)準(zhǔn),針對(duì)芯片數(shù)據(jù)加密、防篡改能力。
重要性
車規(guī)級(jí)芯片的可靠性直接關(guān)系到汽車安全,檢測(cè)通過后芯片方可進(jìn)入汽車供應(yīng)鏈。嚴(yán)格的可靠性測(cè)試可提前暴露設(shè)計(jì)缺陷、制造問題或環(huán)境敏感性,確保芯片在15年/20萬公里的汽車生命周期內(nèi)“萬無一失”,支撐智能駕駛、新能源汽車等技術(shù)的安全落地。
-
可靠性測(cè)試
+關(guān)注
關(guān)注
1文章
144瀏覽量
14740 -
汽車
+關(guān)注
關(guān)注
15文章
4182瀏覽量
41166 -
車規(guī)級(jí)芯片
+關(guān)注
關(guān)注
2文章
292瀏覽量
13410
發(fā)布評(píng)論請(qǐng)先 登錄
[原創(chuàng)]提供可靠性及安規(guī)檢測(cè)服務(wù)
車電零部件可靠性驗(yàn)證
板階 (BLR) 車電可靠性驗(yàn)證
車電零部件可靠性驗(yàn)證(AEC-Q)
兆易創(chuàng)新全系列車規(guī)級(jí)存儲(chǔ)產(chǎn)品累計(jì)出貨1億顆
高可靠、高性能車規(guī)MCU, 滿足車身控制多元應(yīng)用
艾為電子LED驅(qū)動(dòng)芯片通過AEC-Q100車規(guī)級(jí)可靠性認(rèn)證
什么樣的電子元件才是車規(guī)級(jí)的器件呢?車規(guī)級(jí)芯片有哪些可靠性要求?
SGS受邀參加Ansys車規(guī)芯片功能安全和可靠性研討會(huì)
極海再獲多張車規(guī)可靠性和功能安全產(chǎn)品認(rèn)證證書
從AEC-Q100看車規(guī)芯片的可靠性設(shè)計(jì)要點(diǎn)
富捷科技打造高可靠性車規(guī)級(jí)電阻解決方案

車規(guī)級(jí)與消費(fèi)級(jí)芯片的可靠性、安全性與成本差異

車規(guī)級(jí)與消費(fèi)級(jí)芯片的差異與影響
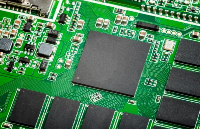



 車規(guī)級(jí)芯片可靠性檢測(cè):為汽車“大腦”構(gòu)筑安全底線全維驗(yàn)證體系
車規(guī)級(jí)芯片可靠性檢測(cè):為汽車“大腦”構(gòu)筑安全底線全維驗(yàn)證體系




評(píng)論