文章來源:Jeff的芯片世界
原文作者:Jeff的芯片世界
在半導體制造的發展歷程中,金屬互連技術的演進至關重要。
早期集成電路主要使用鋁作為互連材料,但隨著制程工藝邁入0.18微米時代,鋁互連的局限性日益凸顯。首先,鋁與硅在577℃下會發生共熔,可能破壞淺結導致短路,即“結尖刺”現象。其次,隨著導線尺寸縮小,電流密度增大,鋁原子在電場和熱作用下容易發生遷移,導致導線斷裂或形成空洞,即“電遷移”失效,這會顯著增加芯片的RC延遲并限制其運行速度。因此,業界迫切需要一種性能更優的替代材料。
銅互連的優勢與挑戰
銅因其優異的性能成為鋁的理想替代品。銅的電阻率(1.7μΩ·cm)低于鋁(2.8μΩ·cm),能有效降低信號延遲,提升芯片速度。同時,銅具有更高的抗電遷移能力,能夠承載更大電流,保證了高電流密度下的可靠性。此外,采用銅互連還有助于減少工藝步驟、降低功耗并實現更高的集成密度。然而,銅互連的推廣面臨一個巨大的工藝障礙:銅無法像鋁那樣采用傳統的等離子體干法刻蝕進行圖形化,因為其反應產物不易揮發,難以從表面有效去除。
大馬士革工藝的原理
這一難題最終通過借鑒古老工藝得到了巧妙解決,即“大馬士革工藝”。該工藝得名于古代敘利亞大馬士革城的工匠在金屬上進行鑲嵌雕刻的技術。在半導體制造中,大馬士革工藝的基本思路與傳統鋁互連相反:不再是對金屬層進行刻蝕,而是先在介電層上刻蝕出所需的導線溝槽和通孔,然后再向這些凹痕中填充金屬銅,最后通過化學機械平坦化(CMP)去除多余的銅,從而形成嵌入式互連結構。這種方法巧妙地避開了銅難以刻蝕的難題。
隨著技術的發展,為了進一步提高集成度,業界發展出了“雙大馬士革”工藝。該工藝的核心是同時形成用于層間垂直連接的通孔和用于平面布線的溝槽,然后一次性填充銅,從而簡化了流程。根據通孔和溝槽形成的先后順序,雙大馬士革工藝主要有三種路徑選擇:先通孔后溝槽、先溝槽后通孔以及自校準同步形成。其中,先通孔后溝槽工藝因光刻工藝相對容易控制,成為目前應用最廣泛的方法。在該流程中,首先在Low-k介質層上涂覆光刻膠,曝光顯影后干法刻蝕出通孔,隨后進行第二次光刻和刻蝕以形成溝槽。整個過程對光刻精度、刻蝕參數的控制要求極高,以避免出現側壁彎曲、階梯等缺陷。

銅互連的配套技術與應用
盡管大馬士革工藝解決了銅的圖形化問題,但銅互連本身仍面臨其他挑戰。一是銅在低溫下(低于200℃)容易氧化;二是銅極易向周圍的二氧化硅或硅中擴散,污染器件并導致性能下降。為了解決這些問題,大馬士革工藝在填充銅之前,需要先在刻蝕好的溝槽和通孔內沉積一層薄的阻擋層(如TaN、TiN等)。這層阻擋層既能有效阻止銅向介質中擴散,又能增強銅與介質的粘附性,是銅互連成功應用的關鍵保障。大馬士革工藝,特別是雙大馬士革工藝,通過與阻擋層技術、化學機械平坦化技術的結合,成功實現了銅在集成電路制造中的應用,成為目前唯一成熟且廣泛使用的銅圖形化方法。它為后段制程的微縮和多層立體布線奠定了堅實的技術基礎,深刻影響了半導體產業的發展。
-
集成電路
+關注
關注
5453文章
12585瀏覽量
374764 -
半導體
+關注
關注
339文章
30801瀏覽量
264592 -
工藝
+關注
關注
4文章
714瀏覽量
30331
原文標題:大馬士革工藝介紹
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
氣體檢測儀貫穿半導體制造:從安全生產到工藝控制的核心應用

半導體制造中晶圓清洗設備介紹

芯片制造過程中的布線技術

滾珠導軌如何定義半導體制造精度?

臺階儀在半導體制造中的應用 | 精準監測溝槽刻蝕工藝的臺階高度

半導體制造中的高溫氧化工藝介紹

半導體制冷機chiller在半導體工藝制程中的高精度溫控應用解析

2025年半導體制造設備市場:前景璀璨還是風云變幻?

超短脈沖激光加工技術在半導體制造中的應用

Chiller在半導體制程工藝中的應用場景以及操作選購指南

最全最詳盡的半導體制造技術資料,涵蓋晶圓工藝到后端封測
靜電卡盤:半導體制造中的隱形冠軍




 半導體制造中大馬士革工藝介紹
半導體制造中大馬士革工藝介紹



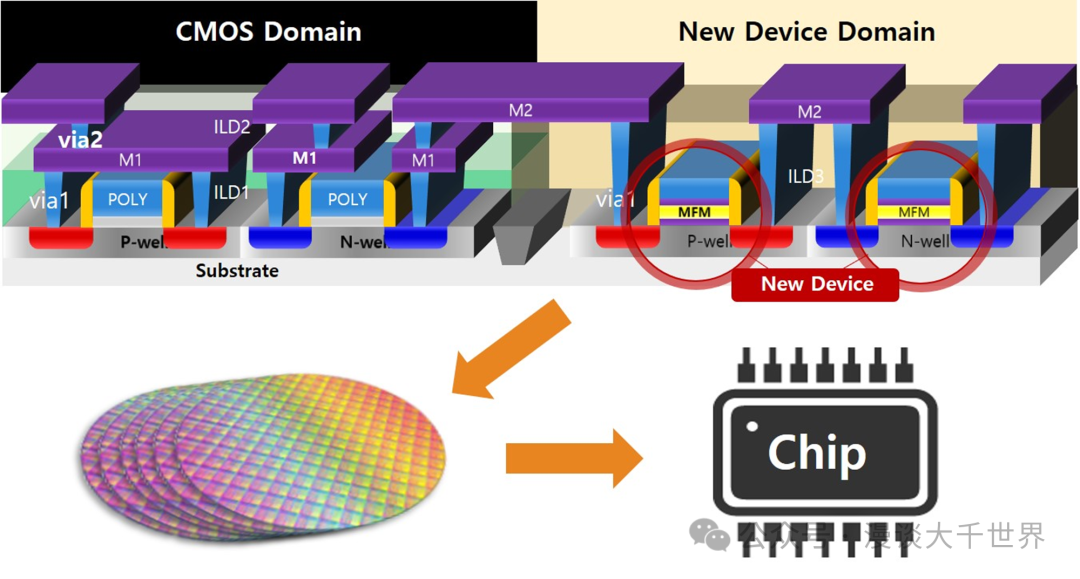



評論