SiC碳化硅 MOSFET 在逆變應用中的研究報告:體二極管脈沖電流能力的工程挑戰分析
BASiC Semiconductor基本半導體一級代理商傾佳電子(Changer Tech)是一家專注于功率半導體和新能源汽車連接器的分銷商。主要服務于中國工業電源、電力電子設備和新能源汽車產業鏈。傾佳電子聚焦于新能源、交通電動化和數字化轉型三大方向,代理并力推BASiC基本半導體SiC碳化硅MOSFET單管,SiC碳化硅MOSFET功率模塊,SiC模塊驅動板等功率半導體器件以及新能源汽車連接器。?

傾佳電子楊茜致力于推動國產SiC碳化硅模塊在電力電子應用中全面取代進口IGBT模塊,助力電力電子行業自主可控和產業升級!
傾佳電子楊茜咬住SiC碳化硅MOSFET功率器件三個必然,勇立功率半導體器件變革潮頭:
傾佳電子楊茜咬住SiC碳化硅MOSFET模塊全面取代IGBT模塊和IPM模塊的必然趨勢!
傾佳電子楊茜咬住SiC碳化硅MOSFET單管全面取代IGBT單管和大于650V的高壓硅MOSFET的必然趨勢!
傾佳電子楊茜咬住650V SiC碳化硅MOSFET單管全面取代SJ超結MOSFET和高壓GaN 器件的必然趨勢!
隨著寬禁帶(WBG)半導體技術的成熟,碳化硅(SiC)MOSFET 正迅速取代傳統的硅基 IGBT,成為固態變壓器SST、儲能變流器PCS、Hybrid inverter混合逆變器、戶儲、工商業儲能PCS、構網型儲能PCS、集中式大儲PCS、商用車電驅動、礦卡電驅動、風電變流器、數據中心HVDC、AIDC儲能、服務器電源、重卡電驅動、大巴電驅動、中央空調變頻器、光伏逆變器及高功率密度電機驅動系統的核心功率器件。然而,這種技術轉型并非簡單的器件替換,它給電力電子研發工程師帶來了一系列全新的可靠性挑戰與設計顧慮。

傾佳電子楊茜探討研發工程師在將 SiC MOSFET 應用于逆變側時的核心擔憂,并詳細剖析基本半導體(BASIC Semiconductor)規格書中 Figure 26 Pulsed Diode Current vs. Pulse width(脈沖二極管電流 vs. 脈沖寬度) 這一關鍵圖表的工程價值。
傾佳電子楊茜分析表明,盡管體二極管的穩態電流能力(Current Capability)是一個基礎限制,但工程師最大的擔憂并非單純的“電流數值不夠”,而是體二極管在故障工況下的瞬態熱穩定性。Figure 26 的價值在于,它量化了器件在極短時間內的熱極限,為工程師提供了評估“死區時間續流”、“電機堵轉”及“短路保護配合”等極端工況的依據,是決定是否省去外部并聯肖特基二極管(SBD)的關鍵決策工具。
2. 引言:電力電子變換的范式轉移與新挑戰

2.1 從 Si IGBT 到 SiC MOSFET 的演進邏輯
在過去三十年中,電壓源逆變器(VSI)的主流設計主要依賴于硅基 IGBT 與反向并聯的快恢復二極管(FRD)組成的功率模塊。這種組合不僅技術成熟,而且分工明確:IGBT 負責正向主動開關,FRD 負責反向續流。
SiC MOSFET 的引入打破了這一范式。由于 SiC MOSFET 是單極性器件,其自身結構中天然寄生了一個 P-i-N 體二極管。這一體二極管在理論上具備反向續流能力,使得“無外并聯二極管”的拓撲成為可能,從而大幅降低系統成本和體積。然而,這也將原本由獨立 FRD 承擔的應力轉移到了 MOSFET 芯片內部,引發了關于器件內部物理機制穩定性的深刻擔憂。
2.2 逆變側應用的特殊應力環境
逆變側(Inverter Side)不同于 DC/DC 變換器,其負載通常是感性的(如電機繞組或變壓器),且工況極其復雜:
硬開關(Hard Switching): 器件在開通和關斷瞬間承受高電壓和大電流的重疊,對反向恢復特性要求極高。
死區時間(Dead Time): 在橋臂上下管切換的間隙,感性負載電流必須通過“續流二極管”流通。對于 SiC MOSFET,這意味著電流被迫流經體二極管。
故障沖擊: 電機啟動瞬間的沖擊電流(Inrush Current)或堵轉時的過流,往往數倍于額定電流。
在這些應力下,SiC MOSFET 的體二極管不僅是“輔助通道”,更是系統可靠性的“阿喀琉斯之踵”。
3. 核心議題一:研發工程師的最大擔憂是什么?
電力電子研發工程師對碳化硅MOSFET用于逆變側的最大擔憂是什么?體二極管的電流能力是否是主要顧慮?”
傾佳電子楊茜的結論是:體二極管的“電流能力”(Current Capability)本身并不是最大的擔憂,真正的擔憂在于“浪涌沖擊下的熱失控”。

3.1 擔憂層級分析
3.1.1 第一層級:浪涌電流耐受力(Surge Current Robustness)
相比于“電流能力”這個靜態指標,工程師更擔心動態的浪涌耐受力。
矛盾點: SiC 芯片面積通常僅為同規格 Si IGBT 的 1/3 到 1/5。雖然 SiC 材料熱導率高,但極小的芯片面積意味著**熱容(Thermal Capacitance)**極小。
風險: 在電機堵轉或短路發生的微秒級時間內,極高的能量密度可能瞬間熔化鋁金屬化層或導致柵氧失效,而此時外部保護電路可能尚未動作 。
3.1.2 第二層級:體二極管的高導通壓降

SiC 體二極管的開啟電壓(Knee Voltage)高達 3V-4V(Si FRD 僅為 0.7V-1.5V)。
擔憂: 在死區時間(Dead Time)內,極高的 VSD? 意味著巨大的導通損耗(P=VSD?×I)。如果死區時間設置不當或控制異常,這段時間的損耗可能導致結溫急劇升高。
3.2 結論:電流能力 vs. 可靠性穩定性
綜上所述,體二極管的標稱電流能力(如規格書中的 67A)通常是足夠的,甚至因為電導調制效應(Conductivity Modulation),其抗浪涌能力在物理上優于同級 SBD。研發工程師的主要顧慮不在于“能否流過這么大電流”,而在于“極小熱容能否扛住故障瞬間的熱沖擊”。
4. 核心議題二:Figure 26 的價值與意義深度解析
基本半導體(BASIC Semiconductor)B3M040065Z 規格書中的 Figure 26: Pulsed Diode Current vs. Pulse width(脈沖二極管電流 vs. 脈沖寬度) 是解答上述擔憂的關鍵鑰匙。這張圖表是連接器件物理極限與逆變器系統設計的橋梁。

4.1 圖表物理含義解析
Figure 26 通常展示的是體二極管在不同脈沖持續時間(tp?)下所能承受的最大峰值電流(IF,peak?)。
X軸(Pulse Width, tp?): 時間尺度,通常涵蓋 10μs(短路/開關瞬態)到 1s(電機過載/穩態)的對數坐標。
Y軸(Pulsed Diode Current, IF?): 允許流過的最大電流峰值。
限制條件: 曲線通常基于最高結溫 Tj,max?(如 175°C)繪制。即:在此電流和時間下,結溫將從殼溫(TC?)上升至 Tj,max?。
該曲線由瞬態熱阻抗(Transient Thermal Impedance, Zth(jc)?) 決定,遵循以下熱平衡方程:
ΔTj?=Ploss?(t)×Zth(jc)?(t)=VF?(I)×I×Zth(jc)?(t)
其中 ΔTj?=Tj,max??TC?。
4.2 對逆變側設計的四大核心價值

4.2.1 價值一:死區時間(Dead Time)的安全性校驗
在逆變器的高頻開關過程中,每個周期都會經歷兩次死區時間。
工況: 電流被迫流經體二極管。由于 VSD? 較高(B3M040065Z 典型值為 3.4V@10A,高溫下更高),瞬時功率極大。
圖表應用: 工程師查看 Figure 26 最左側(如 tp?<1μs)的電流值。由于時間極短,熱量主要由芯片自身熱容吸收,此時允許的脈沖電流通常極大(數倍于額定電流,如 >200A)。
意義: 這張圖告訴工程師:只要死區時間控制在微秒級,即使流過峰值負載電流,體二極管在熱學上也是絕對安全的。 這消除了對正常開關周期內二極管過熱的擔憂。
4.2.2 價值二:故障保護與熔斷器配合(Coordination)
這是 Figure 26 最具實戰意義的用途——定義保護電路的“生死時速”。
工況: 逆變器輸出短路或電機堵轉。電流以極高斜率(di/dt)上升。
圖表應用:
假設短路電流預測值為 300A。
工程師在 Figure 26 上找到 300A 對應的最大脈沖寬度,假設為 50μs。
設計約束: 這意味著驅動器的去飽和保護(Desat Protection)或過流保護必須在 50μs 內切斷電路。如果保護動作時間是 100μs,器件必炸無疑。
意義: Figure 26 劃定了保護電路設計的時序邊界。 對于 SiC 這種小熱容器件,這個時間窗口通常比 IGBT 窄得多,工程師必須依據此圖嚴格設計驅動電路。
4.2.3 價值三:電機啟動與沖擊電流(Inrush Current)評估
工況: 大功率電機啟動瞬間或電容預充電階段,可能出現持續數毫秒到數百毫秒的浪涌電流。
圖表應用: 工程師查看曲線中段(1ms?100ms)。此區域熱量開始向銅底板和散熱器擴散,電流能力顯著下降。
意義: 如果電機啟動沖擊電流為 150A,持續 10ms,而 Figure 26 顯示 10ms 時的能力僅為 100A,則說明該器件無法承受此工況。工程師需據此選擇更高規格的器件或優化軟啟動策略。
4.2.4 價值四:決定是否省去外部 SBD(Cost Down 決策)
這是研發總監最關心的成本問題。
決策邏輯: 傳統設計會在 MOSFET 旁并聯昂貴的 SiC SBD 以保護 MOSFET。但如果 Figure 26 顯示體二極管的浪涌耐受力(I2t)足以覆蓋所有極端工況,且廠家保證了 BPD 篩選(解決雙極性退化問題)。
意義: Figure 26 提供了省去 SBD 的理論依據。 對于 B3M040065Z 這類針對逆變器優化的器件,其強大的脈沖電流能力往往允許工程師采用“無二極管(Diode-Less)”拓撲,從而顯著降低 BOM 成本并提高功率密度。
5. 詳細技術分析:基于基本半導體 B3M040065Z 數據
基于提供的規格書片段 和相關 SiC 特性,我們對 B3M040065Z 進行具體分析。

5.1 器件關鍵參數解讀
型號: BASIC Semiconductor B3M040065Z
封裝: TO-247-4(帶開爾文源極,這對抑制高頻開關震蕩至關重要)。
額定電壓 VDS?: 650V。
連續漏極電流 ID?: 67A (TC?=25°C) / 47A (TC?=100°C)。
脈沖漏極電流 ID,pulse?: 108A(受 Tj,max? 限制)。
體二極管特性(Page 5):
VSD? (典型值): 3.4V @ 10A, VGS?=?4V。
反向恢復時間 trr?: 11ns (極快,優于 Si FRD)。
反向恢復電荷 Qrr?: 100nC。
5.2 Figure 26 的數據重構與應用推演

但根據 ID,pulse?=108A 和 SiC 的熱特性,我們可以推演 Figure 26 的形態及其對工程師的指導意義。
5.2.1 短脈沖區域 (<100μs)
在此區域,曲線應處于高位平臺。由于 SiC 優異的瞬態熱耐受性,體二極管在微秒級脈沖下可能承受 >200A 的電流(遠超 108A 的 MOSFET 通道限制)。
工程意義: 這證明在死區時間(通常 <1us)內,體二極管完全有能力處理 2-3 倍額定電流的負載波動,不會發生瞬態熱失效。
5.2.2 中長脈沖區域 (1ms?100ms)
曲線將呈現 1/t? 的下降趨勢。
工程意義: 假設電機堵轉導致 100A 電流流過二極管。
功率估算:P≈4V×100A=400W。
熱阻估算:若 10ms 時的瞬態熱阻 Zth?≈0.2K/W(估算值),則溫升 ΔT=400×0.2=80°C。
若初始溫度為 80°C,總結溫達到 160°C,接近 175°C 極限。
判斷: 工程師會根據 Figure 26 確認:在 100A 堵轉工況下,保護電路必須在 10ms 內切斷,否則器件燒毀。
5.3 為什么 B3M040065Z 特別強調此圖?

作為一款面向“光伏逆變器”和“電機驅動”的器件 ,其應用場景充滿了感性負載引起的續流和浪涌。
光伏逆變器: 必須具備低電壓穿越(LVRT)能力,要求器件在電網故障時短時過載。Figure 26 是驗證 LVRT 能力的核心依據。
電機驅動: 必須承受啟動沖擊。
基本半導體通過提供詳盡的 Figure 26,實際上是在向工程師通過數據背書: “我們的體二極管足夠強壯,你可以放心地在逆變橋臂中使用,無需外掛二極管。”
6. 深入探討:SiC MOSFET 逆變應用中的其他關鍵考量
本節將詳細展開熱設計模型及保護策略。

6.2 逆變器死區時間的熱管理模型
6.1.1 VF? 帶來的熱挑戰
SiC 體二極管的高 VF? 是一個不可忽視的缺點。
對比: Si FRD VF?≈1.5V vs. SiC Body Diode VF?≈3.5V?4.5V。
損耗計算:
Pdead?=2×fsw?×tdead?×VF?×Iload?
對于 20kHz, 500ns 死區, 40A 負載:
Si IGBT 方案:P≈2×20k×500n×1.5×40=1.2W。
SiC MOSFET 方案:P≈2×20k×500n×4.0×40=3.2W。
雖然 3.2W 看起來不大,但在高功率密度模塊中,這是集中在極小芯片面積上的熱點。
6.1.2 解決方案:同步整流(Synchronous Rectification)
為了規避體二極管的高損耗和潛在的 BPD 風險,現代 SiC 驅動策略普遍采用同步整流。
原理: 在死區時間結束后,迅速開通 MOSFET 通道,利用 RDS(on)? 進行反向導通(因為 MOSFET 是雙向導通的)。
效果: 將反向壓降從 4V 降低到 I×RDS(on)?≈40A×40mΩ=1.6V。
Figure 26 的角色: 即便使用了同步整流,死區時間內體二極管的導通仍是物理上不可避免的。因此,Figure 26 依然是系統安全的最底線保障。
6.2 浪涌工況下的失效模式分析
當電流超過 Figure 26 的限制時,SiC MOSFET 會發生什么?
熱致失效: 結溫超過鋁金屬熔點(660°C),源極金屬融化并滲入半導體,造成短路。
閉鎖效應(Latch-up): 盡管 SiC 抑制了寄生 BJT 的開啟,但在極端高溫和高 dv/dt 下,寄生晶閘管可能被觸發,導致器件失去控制。
柵氧失效: 高溫導致 Vth? 漂移或柵氧介質擊穿。
Figure 26 的紅線就是為了防止這些物理破壞的發生。
7. 結論與建議

7.1 總結
對于將 SiC MOSFET(如基本半導體 B3M040065Z)應用于逆變側的研發工程師而言:
最大擔憂 是 體二極管的熱穩定性。具體表現對“小芯片面積”在浪涌故障下瞬間熱失控的顧慮。
體二極管的電流能力 本身(指額定值)通常不是瓶頸,甚至優于競品,但其高導通壓降帶來的熱管理壓力和故障工況下的瞬態耐受時限是主要矛盾。
Figure 26 的價值 在于它是安全邊界的數學定義。它不只是一條曲線,它是保護策略設計、散熱系統設計以及“去外部二極管”成本決策的根本依據。
7.2 給研發工程師的建議
充分利用 Figure 26: 將系統可能出現的最惡劣短路電流和過載曲線疊加到 Figure 26 上,確保有 20%-30% 的安全裕量(Derating)。
重視驅動設計: 必須采用高精度的去飽和檢測(Desat)或羅氏線圈(Rogowski Coil)電流采樣,確保保護動作時間落在 Figure 26 允許的脈沖寬度內。
實施同步整流: 即使體二極管能力很強,也應盡量減少其導通時間,以降低發熱。
通過深入理解 Figure 26 并采取上述措施,工程師可以克服對 SiC 體二極管的恐懼,充分釋放 SiC MOSFET 在逆變應用中的高效能潛力。
審核編輯 黃宇
-
MOSFET
+關注
關注
151文章
9685瀏覽量
233761 -
SiC
+關注
關注
32文章
3738瀏覽量
69481 -
碳化硅
+關注
關注
26文章
3475瀏覽量
52402
發布評論請先 登錄
碳化硅 (SiC) MOSFET dv/dt 極限物理本質深度研究報告

國產低內阻SiC碳化硅MOSFET單管的產品矩陣特點與應用范疇研究報告

碳化硅(SiC)功率模塊替代IGBT模塊的工程技術研究報告

安森美10A、1200V碳化硅肖特基二極管NDSH10120C-F155解析

傾佳電子碳化硅SiC MOSFET驅動特性與保護機制深度研究報告

傾佳電子主流廠商碳化硅 (SiC) MOSFET 驅動 IC 產品及其技術特征深度研究報告

傾佳電子SiC碳化硅MOSFET開關行為深度解析及體二極管的關斷特性




 SiC碳化硅 MOSFET 在逆變應用中的研究報告:體二極管脈沖電流能力的工程挑戰分析
SiC碳化硅 MOSFET 在逆變應用中的研究報告:體二極管脈沖電流能力的工程挑戰分析





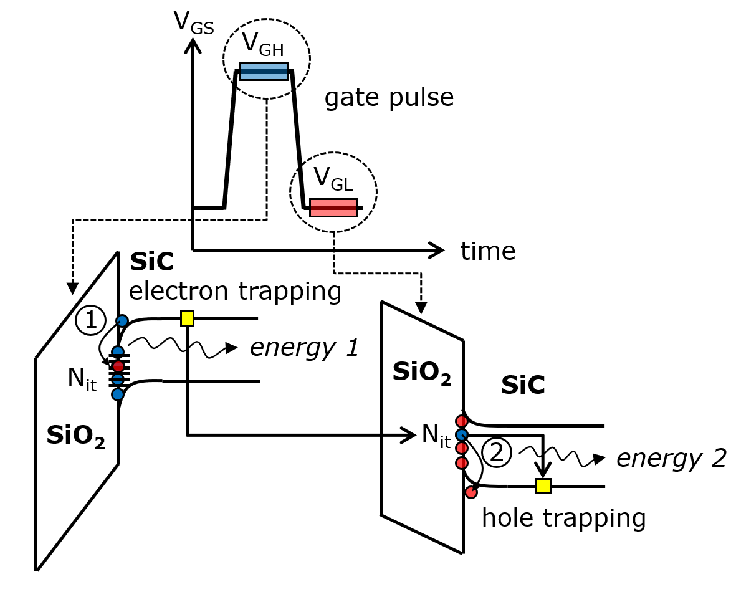
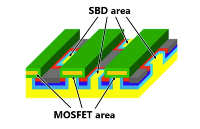



評論